來源:電子制造工藝技術(shù)
倒裝芯片(Flip chip)是一種無引腳結(jié)構(gòu),一般含有電路單元。設(shè)計(jì)用于通過適當(dāng)數(shù)量的位于其面上的錫球(導(dǎo)電性粘合劑所覆蓋),在電氣上和機(jī)械上連接于電路。

倒裝芯片原理:Flip chip又稱倒裝片,是在I/O pad上沉積錫鉛球,然后將芯片翻轉(zhuǎn)加熱利用熔融的錫鉛球與陶瓷基板相結(jié)合此技術(shù)替換常規(guī)打線接合,逐漸成為未來的封裝主流,當(dāng)前主要應(yīng)用于高時(shí)脈的CPU、GPU(Graphic Processor Unit)及Chipset 等產(chǎn)品為主。與COB相比,該封裝形式的芯片結(jié)構(gòu)和I/O端(錫球)方向朝下,由于I/O引出端分布于整個(gè)芯片表面,故在封裝密度和處理速度上Flip chip已達(dá)到頂峰,特別是它可以采用類似SMT技術(shù)的手段來加工,因此是芯片封裝技術(shù)及高密度安裝的最終方向。
倒裝片連接有三種主要類型C4(Controlled Collapse Chip Connection)、DCA(Direct chip attach)和FCAA(Flip Chip Adhesive Attachement)。但實(shí)際制造工藝分很多種如下:

毛細(xì)管底部填充(CUF)技術(shù)依賴毛細(xì)作用將材料填充在芯片和芯片載體之間。首先,在帶有凸點(diǎn)的基板上涂覆一層助焊劑,然后將芯片焊料凸點(diǎn)對(duì)準(zhǔn)基板焊盤,加熱使焊料回流,實(shí)現(xiàn)上下凸點(diǎn)的互連。
隨后,通過溶劑噴霧等方式清洗助焊劑,然后沿著芯片邊緣注入底部填充料。底部填充料借助毛細(xì)作用會(huì)被吸入芯片和基板的空隙內(nèi),最后進(jìn)行加熱固化。目前,市場上大部分底部填充料采用毛細(xì)管底部填充技術(shù),廣泛應(yīng)用于手機(jī)等許多電子器件的小尺寸芯片封裝中。
塑封底部填充(MUF)技術(shù)將底部填充料的填充和器件塑封兩個(gè)步驟合二為一。在進(jìn)行塑封的同時(shí),底部填充料進(jìn)入芯片和基板之間的空隙,在隨后的固化過程中完成填充和密封。相較于毛細(xì)管底部填充工藝,塑封底部填充工藝(MUF)更為簡便快速。
非流動(dòng)底部填充料(NUF)工藝不依賴于液體的毛細(xì)作用。在芯片和基板互連之前,首先在基板表面涂覆非流動(dòng)底部填充料,然后在焊料回流過程中同時(shí)完成焊球互連和底部填充料的加熱固化。這一工藝省去了毛細(xì)管底部填充工藝中助焊劑的涂覆和清除步驟,提高了生產(chǎn)效率。晶片級(jí)底部填充料(WLUF)是針對(duì)晶片級(jí)封裝而設(shè)計(jì)的填充方式。在晶圓上,通過適當(dāng)?shù)耐扛补に嚕ㄈ鐚訅夯蛲扛玻┨砑右粚拥撞刻畛淞希?duì)其進(jìn)行加熱以去除溶劑以進(jìn)行預(yù)固化。隨后,通過平整化處理露出互連凸點(diǎn),然后對(duì)晶圓進(jìn)行切割,以獲得帶有凸點(diǎn)的單個(gè)組件。最后,這些組件通過表面安裝工藝與基板連接起來。
非導(dǎo)電漿料(NCP)工藝可以通過熱壓的方式直接讓凸點(diǎn)和焊盤接觸,實(shí)現(xiàn)電互連,省去了與助焊劑相關(guān)的步驟。該材料在固化后主要用于形成機(jī)械連接,并維持凸點(diǎn)和焊盤的接觸壓力。
非導(dǎo)電膜(NCF)材料具有柔軟性,可作為卷材夾在塑料薄膜(如PET)中使用,適用于圓片級(jí)封裝。NUF與NCP/NCF有所不同,NUF的非流動(dòng)性在焊料回流過程中同時(shí)實(shí)現(xiàn)封裝材料和助焊劑等與焊球的互連。而NCP/NCF是一種非導(dǎo)電材料(膜),通過倒裝鍵合的熱壓方式完成焊球的互連和封裝材料的固化過程。
倒裝芯片的主要工藝步驟包括:底部金屬層UBM(Under Bump Metallurgy),凸點(diǎn)制作(Bumping),互連(Interconnection),底部填充(Underfilling)和固化(Curing)
總結(jié):倒裝芯片在產(chǎn)品成本,性能及滿足高密度封裝等方面 體現(xiàn)出優(yōu)勢,它的應(yīng)用也漸漸成為主流。由于倒裝芯片的 尺寸小,要保證高精度高產(chǎn)量高重復(fù)性,這給我們傳統(tǒng)的設(shè)備及工藝帶來了挑戰(zhàn),具體表現(xiàn)在以下幾個(gè)方面:
1.基板(硬板或軟板)的設(shè)計(jì)方面;
2.組裝及檢查設(shè)備方面;
3.制造工藝 ,芯片的植球工藝, PCB 的制造工藝,SMT 工藝;
4.材料的兼容性圖11 助焊劑浸蘸工藝
全面了解以上問題是成功進(jìn)行倒裝芯片組裝工藝的基礎(chǔ)
倒裝芯片算先進(jìn)封裝嗎?倒裝芯片可以算得上半個(gè)先進(jìn)封裝,一只腳踩在先進(jìn)封裝的門里,一只在門外,算是傳統(tǒng)封裝與先進(jìn)封裝的過渡產(chǎn)物。與當(dāng)今的2.5D/3D IC封裝相比,倒裝芯片仍是2D封裝,并不能垂直堆疊。但是與wire bonding相比又具有極大的優(yōu)勢。倒裝芯片有哪些封裝形式?FCBGA,F(xiàn)CCSP。
未來倒裝芯片技術(shù)發(fā)展:
近年來,隨著半導(dǎo)體技術(shù)的不斷發(fā)展,芯片的處理性能運(yùn)算能力提升得越來越快。以及2.5D與3.5D等3D異構(gòu)芯片的普及,正裝與倒裝及鍵合技術(shù)將會(huì)打破原有秩序,進(jìn)行重新組合與融合,形成新的3D立體異構(gòu)芯片智能制造工藝技術(shù)。如下圖
文章來源于網(wǎng)絡(luò)整理
聲明:本網(wǎng)站部分文章轉(zhuǎn)載自網(wǎng)絡(luò),轉(zhuǎn)發(fā)僅為更大范圍傳播。 轉(zhuǎn)載文章版權(quán)歸原作者所有,如有異議,請(qǐng)聯(lián)系我們修改或刪除。聯(lián)系郵箱:[email protected], 電話:0755-25988573
審核編輯 黃宇
-
倒裝芯片
+關(guān)注
關(guān)注
1文章
106瀏覽量
16605 -
Flip
+關(guān)注
關(guān)注
0文章
9瀏覽量
9996 -
先進(jìn)封裝
+關(guān)注
關(guān)注
2文章
474瀏覽量
623
發(fā)布評(píng)論請(qǐng)先 登錄
全面剖析倒裝芯片封裝技術(shù)的內(nèi)在機(jī)制、特性優(yōu)勢、面臨的挑戰(zhàn)及未來走向
倒裝芯片封裝:半導(dǎo)體行業(yè)邁向智能化的關(guān)鍵一步!


中美貿(mào)易戰(zhàn),國產(chǎn)芯片發(fā)展艱難,先進(jìn)封裝助力中國芯突圍!#芯片封裝 #先進(jìn)封裝 #華芯邦 #
倒裝封裝(Flip Chip)工藝:半導(dǎo)體封裝的璀璨明星!

什么是先進(jìn)封裝中的Bumping
BGA技術(shù)賦能倒裝芯片,開啟高密度I/O連接新時(shí)代

先進(jìn)封裝中互連工藝凸塊、RDL、TSV、混合鍵合的新進(jìn)展

探索倒裝芯片互連:從原理到未來的全面剖析

AI網(wǎng)絡(luò)物理層底座: 大算力芯片先進(jìn)封裝技術(shù)
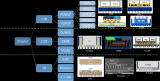





 倒裝芯片(flip chip)算先進(jìn)封裝嗎?未來發(fā)展怎么樣?
倒裝芯片(flip chip)算先進(jìn)封裝嗎?未來發(fā)展怎么樣?

















評(píng)論