文章來源:Semika
原文作者:賽米克電子技術(shù)
倒裝芯片是微電子電路先進封裝的關(guān)鍵技術(shù)。它允許將裸芯片以面朝下的配置連接到封裝基板上,芯片和基板之間通過導(dǎo)電“凸起”進行電氣連接。
半導(dǎo)體器件面朝下安裝,將電路和機械結(jié)構(gòu)連接到基板上(圖1)。IBM將這種制造過程稱為C4過程(受控折疊芯片連接)。

倒裝芯片組裝提供了許多優(yōu)勢。一個關(guān)鍵的優(yōu)點是改進了電氣性能。倒裝芯片互連的小凸起提供了短的電路徑,從而產(chǎn)生具有低電容,電感和電阻的優(yōu)異電性能。與其他互連方法(如襯底上的線鍵芯片)相比,這大大提高了高頻性能。倒裝芯片組裝的另一個重要優(yōu)勢是它的緊湊性,與傳統(tǒng)的電線粘合封裝相比,它減小了尺寸和重量。芯片和襯底表面上的電連接墊可以布置為一個區(qū)域陣列,而不是圍繞芯片的外圍,這是一種典型的線鍵配置設(shè)計。這種二維陣列結(jié)構(gòu)可以節(jié)省芯片空間,減少芯片在襯底上的占地面積。倒裝芯片結(jié)構(gòu)的低姿態(tài)和小的物理面積允許制造小的電子封裝。如今,倒裝芯片可以在電子表、計算器、移動電話、電子記事本、照相機、手持設(shè)備和許多其他產(chǎn)品中找到。
低成本倒裝芯片主板一般采用有機層壓板。這種板材料的一個缺點是和于硅基集成電路(IC)芯片的大熱膨脹系數(shù)(CTE)失配。如果組件在隨后的工藝步驟中受到高溫的影響,或者在設(shè)備上電和關(guān)閉時經(jīng)歷溫度循環(huán),則由于CTE不匹配,在凹凸接頭的界面上產(chǎn)生應(yīng)力。這些應(yīng)力,如果足夠大,可能導(dǎo)致一個或多個互連的機械故障。這種效應(yīng)被認為是導(dǎo)致倒裝芯片焊件失效的最常見原因。為了緩解CTE不匹配的問題,一般將具有相似CTE值的下填充封裝劑填充在芯片與有機電路板之間的間隙中。底部填充物沿著芯片的一個或多個邊緣分布,通過毛細管作用在芯片下流動,完全填充凸起周圍(圖2)。固化后,硬底部填充物通過機械粘合芯片和電路板,有助于補償熱膨脹差,提高整個封裝的可靠性。
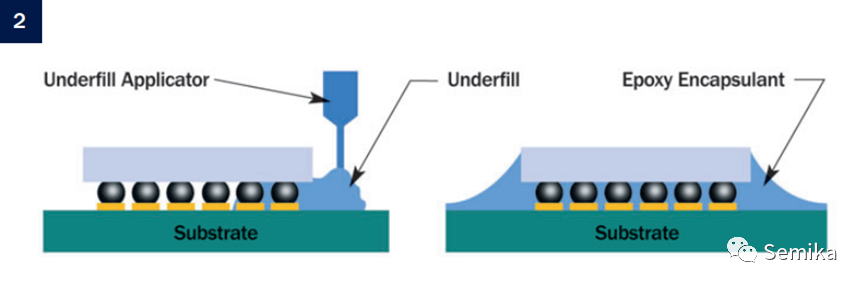
第一種類型的倒裝芯片(以及今天90%的市場)使用標準錫/鉛焊料凸起。其余10%的設(shè)備使用無鉛金屬,如金、金/錫、銦和粘合劑將芯片附著在基板上。選擇最合適的組裝工藝取決于芯片焊球材料、襯底材料(陶瓷、層壓板、玻璃)、模具尺寸和焊料特性(焊料尺寸、間距和數(shù)量)。下面討論一些倒裝芯片制造工藝及其優(yōu)點和缺點。
固晶膠(連接使用的粘合劑)通過絲網(wǎng)印刷或(點膠將粘合劑應(yīng)用于基材上,芯片以非常高的精度放置在基板上,并在低溫下固化。
用于倒裝芯片組件的粘合劑大致可分為導(dǎo)電粘合劑(CA)和非導(dǎo)電粘合劑(NCA)。導(dǎo)電膠又分為各向異性導(dǎo)電膠(ACA)和各向同性導(dǎo)電膠(ICA)。ACAs使用低水平的導(dǎo)電顆粒,如鍍金聚合物球,鍍固體金屬球或低熔點焊料,如SnBi。當粘合劑在模具放置過程中被壓縮時,填充顆粒形成連接。導(dǎo)電僅在z軸上,如圖3所示。
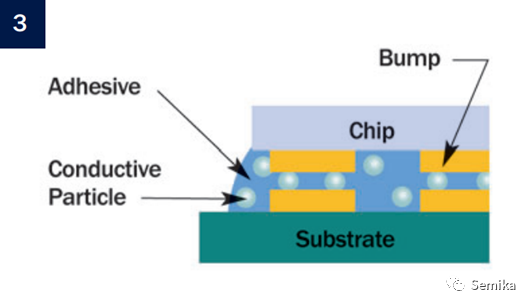
在各向同性導(dǎo)電膠的情況下,高濃度的導(dǎo)電顆粒,通常是銀片,在所有方向上提供導(dǎo)電性。在基材上的選定區(qū)域進行粘合劑的點膠或引腳轉(zhuǎn)移,以實現(xiàn)倒裝芯片的附著(圖4)。
在非導(dǎo)電膠粘劑的情況下,沒有導(dǎo)電顆粒(圖5)。在貼片過程中,通過施加壓力形成電連接。膠粘劑被置換,芯片凸起被機械地和電地附著在基板襯墊上。
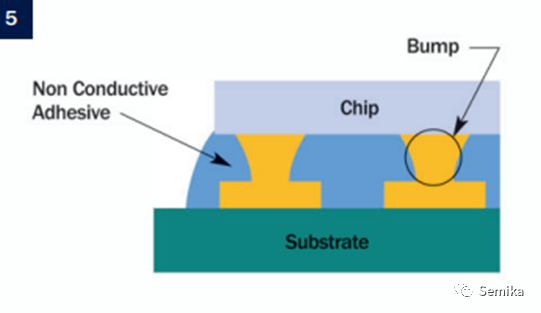
使用粘合劑的倒裝芯片附件最適合不用于惡劣環(huán)境(極端溫度循環(huán),高濕,高振動)的芯片。由于芯片已經(jīng)剛性地附著在基板上,因此永遠不需要任何底填。
倒裝芯片連接回流焊對于焊接鍵,焊料凸點和焊盤(或焊盤上的金屬凸點)之間的機械連接是在高于焊料熔點的溫度下通過焊料回流形成的。在放置倒裝芯片之前,通常將助焊劑涂在焊盤或焊點上,以去除任何可能阻止焊料潤濕焊面的金屬氧化物。助焊劑殘渣是助焊劑和金屬的反應(yīng)產(chǎn)物,殘留在部件上,需要清除;否則,它們會引起微電路的腐蝕,并引起長期可靠性問題。即使在不清潔的磁通系統(tǒng)中,磁通殘留也會影響光電器件的性能。焊劑殘留物的后清洗一直是基于焊料的倒裝芯片連接的一個大問題。有些助焊劑殘留物是水溶性的,而有些則必須用腐蝕性溶劑去除。對于細間距焊接,殘余焊劑可能存在于幾乎不可能檢查和清除殘余焊劑的區(qū)域。替代的無焊劑焊接(例如等離子處理,使用醋酸或甲酸蒸氣,或鹵素氣體)可能適用于某些應(yīng)用,但目前沒有單一的解決方案。
熱壓(TC)粘合通常要求溫度高于300°C。這種溫度會損壞一些貼片塑料、包裝材料和層壓板,以及一些敏感的芯片。
TC鍵合已在金和銦凹凸倒裝芯片組裝中得到應(yīng)用。凸起是使用電解電鍍或螺柱凸起方法在基板上制造的。在鍵合過程中,芯片被拾取并面朝下對準加熱基板上的凸起。當鍵合工具下壓時,金/銦凸起變形并與鍵合墊緊密接觸,從而產(chǎn)生純金屬與金屬的鍵合。
這種粘接方法需要金片粘接墊進行連接。鋁墊由于其表面氧化,不太適合。一般不需要下填。芯片通常被密封在一個密封的外殼中。TC鍵合要求倒裝芯片鍵合機能夠產(chǎn)生300°C的高鍵合溫度,高達100 cN/bump的力(每bump
0.22磅[1]力),以及芯片和襯底之間的高度平行度。為了實現(xiàn)高成品率的粘接,需要很好地控制粘接力和溫度。為了避免損壞半導(dǎo)體材料,必須以梯度施加結(jié)合力。結(jié)合力過大可能導(dǎo)致芯片鈍化產(chǎn)生裂紋,有時由于凸點的過度變形導(dǎo)致凸點在細間距陣列中橋接。
熱聲壓縮連接與熱壓縮類似,熱聲子壓縮使用來自超聲波振動的額外能量,從而減少所需的熱量和力(圖6)。熱聲子倒裝芯片技術(shù)越來越多地用于低引腳數(shù)應(yīng)用,如智能卡、發(fā)光二極管(LED)和電信應(yīng)用中的表面聲波(SAW)濾波器。
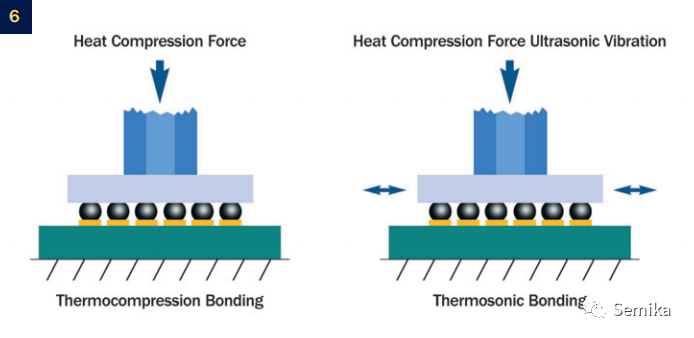
金凸釘?shù)寡b芯片比它的祖先焊料凸釘有許多優(yōu)點。金凹凸接觸放置在一個金屬絲粘合器上,可以放在任何可以金屬絲粘合的粘合墊上。它們可以放置在小至75微米的粘接板上,小至125微米的間距上。金凸起也比焊料更符合要求。
由于焊球可以在線鍵機上完成,因此不需要晶圓片或球下填料(UBM)。單個現(xiàn)成的芯片可以在沒有預(yù)處理的情況下進行連接。這使得倒裝芯片快速、高效、靈活,適用于產(chǎn)品開發(fā)、原型設(shè)計和中小批量生產(chǎn),同時可以通過自動化設(shè)備輕松擴展到大批量晶圓生產(chǎn)。由于植球是一個連續(xù)過程,因此所需的植球時間隨著植球次數(shù)的增加而增加。然而,高速設(shè)備現(xiàn)在每秒可以放置多達12個不球點。植球過程需要更精確的芯片放置設(shè)備,并且比自對準焊料組件更不能容忍放置錯誤。熱超聲倒裝芯片鍵合工藝已被證明對尺寸高達5 x 5 mm和高達68 I/ o的芯片非常有用。
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28599瀏覽量
232495 -
封裝
+關(guān)注
關(guān)注
128文章
8494瀏覽量
144780 -
Chip
+關(guān)注
關(guān)注
1文章
59瀏覽量
26787 -
倒裝芯片
+關(guān)注
關(guān)注
1文章
102瀏覽量
16523
原文標題:倒裝芯片F(xiàn)lip-Chip連接技術(shù)
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
什么是倒裝芯片 倒裝芯片技術(shù)的優(yōu)點 倒裝芯片封裝工藝流程


倒裝芯片和晶片級封裝技術(shù)及其應(yīng)用
技術(shù)資訊 | 通過倒裝芯片 QFN 封裝改善散熱

華為具有改進的熱性能的倒裝芯片封裝專利解析

半導(dǎo)體封裝技術(shù)簡介 什么是倒裝芯片技術(shù)?

倒裝芯片和芯片級封裝的由來
先進倒裝芯片封裝
倒裝封裝(Flip Chip)工藝:半導(dǎo)體封裝的璀璨明星!






 倒裝芯片封裝技術(shù)解析
倒裝芯片封裝技術(shù)解析














評論