從國家知識產(chǎn)權(quán)局官網(wǎng)獲悉,華為技術(shù)有限公司日前公開了一項(xiàng)名為“具有改進(jìn)的熱性能的倒裝芯片封裝”專利,申請公布號為CN116601748A。

截圖自國家知識產(chǎn)權(quán)局
據(jù)了解,該專利提供了一種倒裝芯片封裝、一種裝備有應(yīng)用封裝結(jié)構(gòu)的電路的裝置以及一種組裝封裝的方法,更直觀來說,就是一種提供芯片與散熱器之間的接觸方式,能幫助改善散熱性能。
摘要描述指出,倒裝芯片封裝在基板上,芯片頂部裸露,但四周有模制構(gòu)件包裹芯片的側(cè)面。散熱器底面通過熱界面材料,與芯片表面接觸。此外,芯片及構(gòu)件四周與散熱器之間,涂抹有粘合劑。
華為在專利中描述,近來,半導(dǎo)體封裝在處理性能方面的進(jìn)步對熱性能提出了更高的要求,以確保穩(wěn)定操作。就此而言,倒裝芯片封裝在熱性能方面具有優(yōu)勢,因?yàn)樗慕Y(jié)構(gòu)特征是芯片通過其下方的凸塊與基板連接,能夠?qū)⑸崞鞫ㄎ辉谛酒捻敱砻嫔稀榱颂岣呃鋮s性能,會將熱潤滑脂等熱界面材料(TIM)涂抹到芯片的頂表面,并夾在芯片和散熱器的至少一部分之間。從降低TIM中的熱阻以改善封裝的熱性能的角度來看,優(yōu)選使TIM的厚度更小。
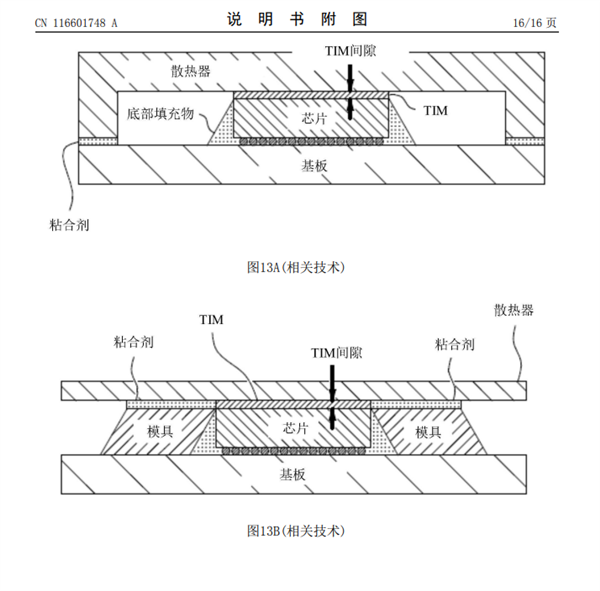
截圖自國家知識產(chǎn)權(quán)局
就此而言,倒裝芯片封裝在熱性能方面具有優(yōu)勢,因其結(jié)構(gòu)特征是芯片通過其下方凸塊與基板連接,能夠?qū)⑸崞鞫ㄎ辉谛酒捻敱砻嫔稀?/p>
據(jù)了解,相較此前難以精細(xì)控制TIM厚度的散熱方案,華為這項(xiàng)專利中的熱界面材料的厚度由模制構(gòu)件中的壁狀結(jié)構(gòu)的高度限定。
華為“具有改進(jìn)的熱性能的倒裝芯片封裝專利”摘要如下:
提供了一種倒裝芯片封裝(200),其中,所述倒裝芯片封裝包括:至少一個(gè)芯片(202),用于與基板(201)連接;形成在所述基板(201)上的模制構(gòu)件(209),以包裹所述至少一個(gè)芯片(202)的側(cè)部分并使每個(gè)芯片(202)的頂表面裸露,其中,所述模制構(gòu)件(209)的上表面具有與每個(gè)芯片(202)的頂表面連續(xù)的第一區(qū)域、涂抹粘合劑(210)的第二區(qū)域以及放置成包圍每個(gè)芯片(202)的頂表面的壁狀結(jié)構(gòu)(209a),并且第一區(qū)域和第二區(qū)域由壁狀結(jié)構(gòu)(209a)分隔;散熱器(206),放置在每個(gè)芯片(202)的頂表面上方,并通過填充在第二區(qū)域中的粘合劑(210)粘合到模制構(gòu)件(209);熱界面材料(205),所述熱界面材料(205)填充在由所述第一區(qū)域、所述每個(gè)芯片(202)的頂表面、所述散熱器(206)的底表面的至少一部分和所述壁狀結(jié)構(gòu)(209a)的第一側(cè)形成的空間區(qū)域中。(引自國家知識產(chǎn)權(quán)局公開公布信息)
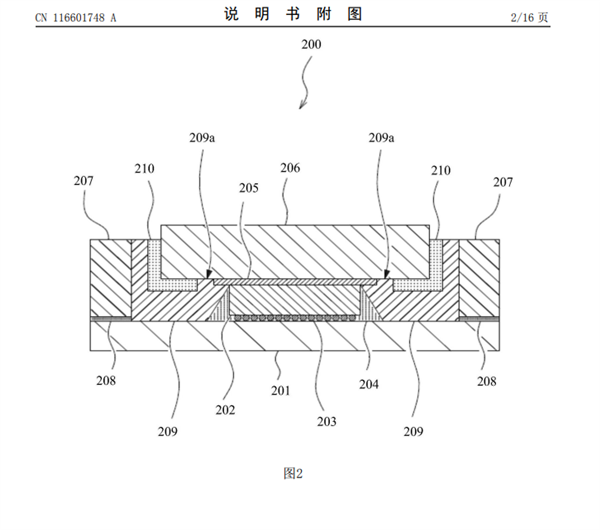
截圖自國家知識產(chǎn)權(quán)局
華為表示,由于新專利可以在模制過程中輕松控制由模具化合物組成的壁狀結(jié)構(gòu)的高度,因此可以將熱界面材料的厚度調(diào)節(jié)到所需的小厚度,從而實(shí)現(xiàn)改進(jìn)的熱性能。

截圖自國家知識產(chǎn)權(quán)局
該專利可應(yīng)用于CPU、GPU、FPGA(現(xiàn)場可編程門陣列)、ASIC(專用集成電路)等芯片類型,設(shè)備可以是智能手機(jī)、平板電腦、可穿戴移動(dòng)設(shè)備、PC、工作站、服務(wù)器等。
審核編輯:湯梓紅
-
華為
+關(guān)注
關(guān)注
216文章
35207瀏覽量
255852 -
封裝
+關(guān)注
關(guān)注
128文章
8662瀏覽量
145439 -
散熱器
+關(guān)注
關(guān)注
2文章
1086瀏覽量
38600 -
倒裝芯片
+關(guān)注
關(guān)注
1文章
106瀏覽量
16603 -
熱性能
+關(guān)注
關(guān)注
0文章
24瀏覽量
6605
原文標(biāo)題:華為最新公布“倒裝芯片封裝專利”
文章出處:【微信號:actSMTC,微信公眾號:actSMTC】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄

倒裝芯片和晶片級封裝技術(shù)及其應(yīng)用
Flip-Chip倒裝焊芯片原理與優(yōu)點(diǎn)
華為公布倒裝芯片封裝最新專利:改善散熱 CPU、GPU等都能用

華為公布一項(xiàng)倒裝芯片封裝技術(shù):能大幅改善CPU散熱
倒裝芯片和芯片級封裝的由來
芯片倒裝Flip Chip封裝工藝簡介

實(shí)現(xiàn)芯片級封裝的最佳熱性能

倒裝芯片的優(yōu)勢_倒裝芯片的封裝形式






 華為具有改進(jìn)的熱性能的倒裝芯片封裝專利解析
華為具有改進(jìn)的熱性能的倒裝芯片封裝專利解析














評論