據(jù)麥姆斯咨詢介紹,為了降低成本,半導(dǎo)體行業(yè)一直在致力于開發(fā)創(chuàng)新的解決方案。而終端客戶則一直在尋求具有更高性能的低成本封裝解決方案。
面板級(jí)封裝(PLP)就是一種從晶圓和條帶級(jí)向更大尺寸面板級(jí)轉(zhuǎn)換的方案。由于其潛在的成本效益和更高的制造效率,吸引了市場(chǎng)的廣泛關(guān)注。由于面板的大尺寸和更高的載具使用率(95%),它還帶來了遠(yuǎn)高于晶圓級(jí)尺寸扇出型晶圓級(jí)封裝(FOWLP)的規(guī)模經(jīng)濟(jì)效益,并且能夠?qū)崿F(xiàn)大型封裝的批量生產(chǎn)。
在應(yīng)用和市場(chǎng)方面,許多封裝技術(shù)可以被視為PLP,但由于FOWLP的成功和市場(chǎng)認(rèn)識(shí),使FOPLP吸引了更多關(guān)注,包括許多不同商業(yè)模式的廠商,例如外包半導(dǎo)體組裝和測(cè)試廠商(OSAT)、集成器件制造商(IDM)、代工廠、基板制造商和平板顯示(FPD)廠商。它們感覺有機(jī)會(huì)通過扇出型技術(shù)涉足先進(jìn)封裝業(yè)務(wù)。
經(jīng)過多年的發(fā)展,F(xiàn)OPLP已經(jīng)成功開發(fā),2018年至2020年期間將有多家廠商開始量產(chǎn)。FOPLP將成為增長(zhǎng)最快的封裝平臺(tái)之一:根據(jù)Yole在2018年發(fā)布的《板級(jí)封裝(PLP)技術(shù)及市場(chǎng)趨勢(shì)-2018版》報(bào)告,F(xiàn)OPLP市場(chǎng)將在2017~2023年期間以驚人的79%復(fù)合年增長(zhǎng)率(CAGR)在2023年增長(zhǎng)至約2.79億美元。
板級(jí)封裝平臺(tái)的市場(chǎng)驅(qū)動(dòng)因素
眾多涉足FOPLP業(yè)務(wù)的廠商中,三星電機(jī)(SEMCO)可能是最激進(jìn)的:這家領(lǐng)先的公司過去兩年來在該領(lǐng)域投資超過4億美元,并最終利用該技術(shù)為其新款消費(fèi)類產(chǎn)品——Galaxy Watch智能手表生產(chǎn)集成應(yīng)用處理器單元(APU)。
憑借這一高密度FOPLP的首次亮相,SEMCO率先宣布了FOPLP的到來。利用這項(xiàng)技術(shù),三星Galaxy Watch將電源管理集成電路(PMIC)、應(yīng)用處理器和動(dòng)態(tài)隨機(jī)存取存儲(chǔ)(DRAM)都集成在了同一個(gè)大型封裝中(稱為SiP-ePoP)。PMIC和應(yīng)用處理器芯片并排放置,利用一個(gè)嵌入式PCB基板實(shí)現(xiàn)封裝中頂部/底部的連接。
針對(duì)這款產(chǎn)品,麥姆斯咨詢合作伙伴——System Plus Consulting近期發(fā)布了一份題為《Exynos 9110:三星第一代扇出型面板級(jí)封裝(FOPLP)》的報(bào)告。
隨著FOPLP在智能手表中的應(yīng)用,三星顯然正準(zhǔn)備在消費(fèi)領(lǐng)域大展拳腳。除了智能手表,移動(dòng)市場(chǎng)應(yīng)該很快會(huì)受到FOPLP應(yīng)用的影響。憑借這一戰(zhàn)略性技術(shù)選擇,SEMCO明確瞄準(zhǔn)了臺(tái)積電(TSMC)在高密度扇出封裝領(lǐng)域的領(lǐng)導(dǎo)地位,并為FOPLP的技術(shù)開發(fā)制定了積極的發(fā)展路線圖。現(xiàn)在,巨頭之間在高端扇出型封裝領(lǐng)域的較量即將上演。
在此背景下,Yole韓國(guó)分部負(fù)責(zé)人兼首席分析師Santosh Kumar最近采訪了SEMCO副總裁兼企業(yè)戰(zhàn)略與規(guī)劃團(tuán)隊(duì)負(fù)責(zé)人Richard(KwangWook)Bae,了解了SEMCO近期的FOPLP發(fā)展情況,以及他們對(duì)FOPLP業(yè)務(wù)的愿景和未來趨勢(shì)的看法。
Santosh Kumar(以下簡(jiǎn)稱SK):請(qǐng)您簡(jiǎn)要介紹一下SEMCO及其業(yè)務(wù)。
Richard(KwangWook)Bae(以下簡(jiǎn)稱RB):SEMCO成立于1973年,是三星集團(tuán)的附屬子公司。SEMCO的全稱是Samsung Electro-Mechanics,是電子元件行業(yè)的領(lǐng)導(dǎo)者之一。
我們的總部位于韓國(guó)水原。海外工廠位于中國(guó)、泰國(guó)、菲律賓和越南。我們還在美國(guó)、歐洲、日本、中國(guó)和東南亞設(shè)有銷售辦事處。
SEMCO現(xiàn)在主要由三個(gè)業(yè)務(wù)部門組成:
元件解決方案,生產(chǎn)無源元件,如多層陶瓷電容(MLCC)和電感;
基板解決方案,生產(chǎn)高密度互連板(HDI)、封裝基板和RFPCB;
模組解決方案,生產(chǎn)攝像頭模組、WiFi模組。
2016年,我們成立了新的FOPLP部門,并建設(shè)了生產(chǎn)線。我們開始為2018年8月發(fā)布的Galaxy Watch制造用于應(yīng)用處理器(AP)的FOPLP產(chǎn)品。
SK:恭喜你們成為第一家FOPLP進(jìn)入量產(chǎn)的廠商。您能否介紹一下SEMCO的FOPLP技術(shù),包括面板尺寸和技術(shù)規(guī)格。
RB:我們使用510 x 415mm尺寸的面板制造FOPLP,但我們已經(jīng)開發(fā)出了高達(dá)800 x 600mm規(guī)格的面板。因此,面板尺寸可以根據(jù)客戶要求更改。
我們用于Galaxy Watch的FOPLP有3個(gè)重布線層(RDL)和1個(gè)背面RDL(Backside RDL)。我們將標(biāo)準(zhǔn)的層疊(PoP)結(jié)構(gòu)應(yīng)用于AP和PMIC的多芯片封裝。通過應(yīng)用FOPLP,我們可以將封裝的厚度減少20%以上,從而提高了電氣和熱性能,并有助于擴(kuò)大產(chǎn)品的電池容量。
SK:涉足扇出型封裝業(yè)務(wù),SEMCO進(jìn)入了由OSAT和一家大型代工廠主導(dǎo)的領(lǐng)域。您如何看待面臨的挑戰(zhàn)?您認(rèn)為誰將是你們?cè)谏瘸鲂头庋b領(lǐng)域更大的競(jìng)爭(zhēng)對(duì)手:代工廠還是OSAT?未來,你們是否計(jì)劃擴(kuò)展封裝服務(wù)組合?
RB:我認(rèn)為半導(dǎo)體行業(yè)未來將劃分為兩大板塊:
獨(dú)特的業(yè)務(wù)仍然存在:代工廠、OSAT、基板公司將維持自己的業(yè)務(wù);
供應(yīng)鏈的分工將逐漸變得模糊,前端和后端之間的邊界將不再那么分明。
從根本上來說,我們認(rèn)為未來代工廠、OSAT、基板公司自己的業(yè)務(wù)將繼續(xù)維持。但是,在前端和后端整合的部分,我認(rèn)為需要三個(gè)條件:
1、大規(guī)模投資;
2、克服技術(shù)障礙;
3、克服先進(jìn)節(jié)點(diǎn)晶圓的供應(yīng)問題。
SK:從經(jīng)濟(jì)角度來看,產(chǎn)業(yè)對(duì)于面板級(jí)扇出封裝的可行性存在一些疑慮。大多數(shù)廠商認(rèn)為,由于市場(chǎng)規(guī)模還不足以滿足產(chǎn)線的滿產(chǎn)運(yùn)行,因此,行業(yè)仍然沒有做好迎接扇出型面板級(jí)封裝的準(zhǔn)備。您對(duì)這種觀點(diǎn)有什么看法?
RB:首先,AP、PMIC等單芯片封裝需要大規(guī)模生產(chǎn),因此需求量預(yù)計(jì)已經(jīng)足夠了。我們正在與客戶合作以響應(yīng)它們的要求。此外,對(duì)于異構(gòu)集成和扇出型系統(tǒng)級(jí)封裝(FOSiP),多個(gè)芯片將被封裝到一個(gè)大型封裝中。
面板級(jí)比晶圓級(jí)更具競(jìng)爭(zhēng)力。隨著封裝尺寸的增長(zhǎng),晶圓面積的利用率正在降低。因此,對(duì)于FOSiP,來自面板的封裝數(shù)量多于來自晶圓的封裝數(shù)量。由于這些原因,F(xiàn)OPLP應(yīng)該有利于異構(gòu)集成或FOSiP。此外,各種應(yīng)用的市場(chǎng)需求也將繼續(xù)增長(zhǎng)。
SK:就芯片/封裝尺寸方面,扇出型面板封裝的優(yōu)勢(shì)在哪里體現(xiàn)?對(duì)于此類封裝尺寸,轉(zhuǎn)換到面板級(jí)封裝,您預(yù)計(jì)可以降低多少成本?
RB:目前FOPLP主要用于移動(dòng)應(yīng)用。但在不久的將來,F(xiàn)OPLP將擴(kuò)展到尺寸超過15 x 15的異構(gòu)集成。
到2020年或2021年,由于5G、人工智能(AI)、自動(dòng)駕駛和服務(wù)器需求,對(duì)模塊化和高速數(shù)據(jù)處理的需求將急劇增長(zhǎng)。FOPLP可以滿足這些需求,因此在多芯片封裝方面,F(xiàn)OPLP將成為主流。
FOPLP和FOWLP之間的比較,僅在成本方面進(jìn)行了討論。但是,我認(rèn)為FOPLP有兩種類型的應(yīng)用,一種是成本驅(qū)動(dòng)型,另一種是性能驅(qū)動(dòng)型。在成本驅(qū)動(dòng)的領(lǐng)域,F(xiàn)OPLP在生產(chǎn)方面具有優(yōu)勢(shì)。然而,就性能驅(qū)動(dòng)的應(yīng)用而言,由于SEMCO設(shè)計(jì)的架構(gòu),F(xiàn)OPLP在精細(xì)間距方面更勝一籌,同時(shí)改善了熱性能和電氣性能。因此,對(duì)于扇出系統(tǒng)級(jí)封裝和異構(gòu)集成它都能勝任。
Galaxy手表及Exynos 9110拆解與逆向分析
SK:SEMCO是主要的基板供應(yīng)商之一。您如何看待扇出型封裝的廣泛應(yīng)用對(duì)基板業(yè)務(wù)產(chǎn)生的不利影響?SEMCO的應(yīng)對(duì)策略是什么?
RB:SEMCO已經(jīng)為無源和有源器件的嵌入技術(shù)準(zhǔn)備了10余年。由于半導(dǎo)體節(jié)點(diǎn)在不斷縮小,我們認(rèn)為封裝基板應(yīng)該做出改變。
基于這些準(zhǔn)備,我們及時(shí)開發(fā)出了FOPLP,并積極響應(yīng)需要扇出封裝的市場(chǎng),例如高階AP、內(nèi)存和小型IC等。
我們專注于無源元件(包括MLCC、基板和模組)等電子元件。因此,我們可以通過其他組件的定制化來優(yōu)化FOSiP。
此外,還有一些應(yīng)用需要繼續(xù)使用現(xiàn)有的封裝基板。并非所有應(yīng)用都會(huì)從基板轉(zhuǎn)向PLP。因此,這不是一場(chǎng)零和游戲。此外,基板業(yè)務(wù)將支持FOPLP業(yè)務(wù)。
基于基板和PLP技術(shù),我們可以更好地響應(yīng)客戶需求和技術(shù)的變化。
SK:你們的FOPLP面向哪些細(xì)分應(yīng)用和器件?
RB:SEMCO為Galaxy Watch實(shí)現(xiàn)了FOPLP的全球首次量產(chǎn)。此外,我們期望將FOPLP不僅應(yīng)用于小型IC,還包括AI、5G、汽車和服務(wù)器等高性能計(jì)算(HPC)應(yīng)用。特別是,我們?yōu)楦鞣N應(yīng)用開發(fā)了下一代扇出型系統(tǒng)級(jí)封裝模組(FOSiP)。
SK:許多設(shè)備供應(yīng)商已經(jīng)開發(fā)了應(yīng)用于面板級(jí)扇出技術(shù)的機(jī)臺(tái)。在您看來,設(shè)備供應(yīng)鏈中存在哪些差距需要解決?
RB:SEMCO自2015年以來一直與全球設(shè)備公司共同開發(fā)FOPLP。我們得到了這些公司的充分支持,因此未來不會(huì)出現(xiàn)問題。
SK:面板尺寸的標(biāo)準(zhǔn)化是面板級(jí)扇出應(yīng)用的瓶頸之一。許多廠商正在研究不同的面板尺寸。您認(rèn)為這個(gè)問題將如何解決?
RB:我們使用415 x 510面板,因?yàn)樗俏覀儺?dāng)前應(yīng)用的最高效的尺寸。此外,在市場(chǎng)上,我們的面板尺寸被認(rèn)為足以滿足當(dāng)前的應(yīng)用。
由于SEMCO擁有基板業(yè)務(wù),我們已經(jīng)擁有更大面板的批量生產(chǎn)經(jīng)驗(yàn)。我們可以將這些積累用于FOPLP業(yè)務(wù)。我們可以靈活地響應(yīng)面板尺寸的變化,不會(huì)有任何問題。
對(duì)于成本驅(qū)動(dòng)的應(yīng)用,目前有幾家供應(yīng)商正在開發(fā)FOPLP。在這種情況下,如果面板尺寸、載具和材料是標(biāo)準(zhǔn)化的,我認(rèn)為這對(duì)FOPLP生態(tài)系統(tǒng)是有利的。
SK:與FOWLP相比,您是否看到FOPLP對(duì)模塑料、介電材料、電鍍化學(xué)等材料的特殊要求?
RB:基本上,F(xiàn)OWLP和FOPLP使用類似的PID材料、設(shè)備和條件。不同之處在于形狀和材料不同的載具類型。
SK:FOPLP面臨的主要技術(shù)挑戰(zhàn)是什么?你們?nèi)绾螒?yīng)對(duì)這些挑戰(zhàn)?
RB:FOPLP中的技術(shù)問題主要包括大面積RDL形成、焦深裕度(DoF margin)、芯片位移、翹曲處理和微粒控制。SEMCO已經(jīng)解決了這些挑戰(zhàn),掌握了控制技術(shù)。
SK:您認(rèn)為FOPLP市場(chǎng)將如何發(fā)展?更廣泛應(yīng)用的主要障礙是什么?
RB:到2020年或2021年,由于5G、AI、自動(dòng)駕駛和服務(wù)器等高性能計(jì)算需求,半導(dǎo)體器件將變得更加復(fù)雜。同時(shí),還將需要在存儲(chǔ)器和邏輯芯片之間進(jìn)行高速數(shù)據(jù)傳輸。由于FOPLP能夠通過多芯片封裝實(shí)現(xiàn)高速數(shù)據(jù)傳輸,因而將促進(jìn)FOPLP的更廣泛應(yīng)用。
SK:對(duì)于異構(gòu)集成和2/2 L/S或以下的封裝能力,您是否認(rèn)為面板級(jí)扇出路線圖和晶圓級(jí)扇出路線圖一致(甚至超過)?SEMCO未來5年的FOPLP路線圖(在封裝設(shè)計(jì)參數(shù)方面,如RDL L / S和層數(shù)、間距、厚度、尺寸等)將如何規(guī)劃?
RB:如前所述,F(xiàn)OWLP和FOPLP是類似的技術(shù)。所以路線圖和目標(biāo)應(yīng)用基本相似。
不過,PoP堆疊的間距規(guī)格有差異。由于結(jié)構(gòu)上的差異,我們的PLP可以獲得更好的間距。此外,PLP具有不需要芯片凸點(diǎn)的優(yōu)勢(shì)。
作為電子器件工程聯(lián)合委員會(huì)(JEDEC)標(biāo)準(zhǔn), 2/2 L/S足以滿足未來高性能計(jì)算或FOSiP等高端應(yīng)用的需求。很少需要低于2/2的L/S,那些僅是一些特殊產(chǎn)品的利基市場(chǎng)。
-
三星電子
+關(guān)注
關(guān)注
34文章
15885瀏覽量
182133 -
封裝
+關(guān)注
關(guān)注
128文章
8509瀏覽量
144798
原文標(biāo)題:三星先進(jìn)封裝戰(zhàn)略:扇出型面板級(jí)封裝(FOPLP)
文章出處:【微信號(hào):MEMSensor,微信公眾號(hào):MEMS】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
日月光斥資2億美元投建面板級(jí)扇出型封裝量產(chǎn)線
消息稱三星電子考慮直接投資玻璃基板,提升FOPLP先進(jìn)封裝競(jìng)爭(zhēng)力
下一代FOPLP基板,三星續(xù)用塑料,臺(tái)積青睞玻璃
三星與臺(tái)積電在FOPLP材料上產(chǎn)生分歧
三星電容的封裝形式有哪些選擇?
整合為王,先進(jìn)封裝「面板化」!臺(tái)積電、日月光、群創(chuàng)搶攻FOPLP,如何重塑封裝新格局?

AI芯片先進(jìn)封裝供應(yīng)緊張,臺(tái)企加速布局FOPLP技術(shù)
日月光FOPLP扇出型面板級(jí)封裝將于2025年二季度小規(guī)模出貨
臺(tái)積電布局FOPLP技術(shù),推動(dòng)芯片封裝新變革
FOPLP技術(shù)受AMD與英偉達(dá)推動(dòng),預(yù)計(jì)2027-2028年量產(chǎn)
大廠群創(chuàng)華麗轉(zhuǎn)型全球最大尺寸FOPLP廠!先進(jìn)封裝如此火熱,友達(dá)為何不跟進(jìn)?






 三星扇出型面板級(jí)封裝FOPLP戰(zhàn)略性技術(shù)選擇
三星扇出型面板級(jí)封裝FOPLP戰(zhàn)略性技術(shù)選擇


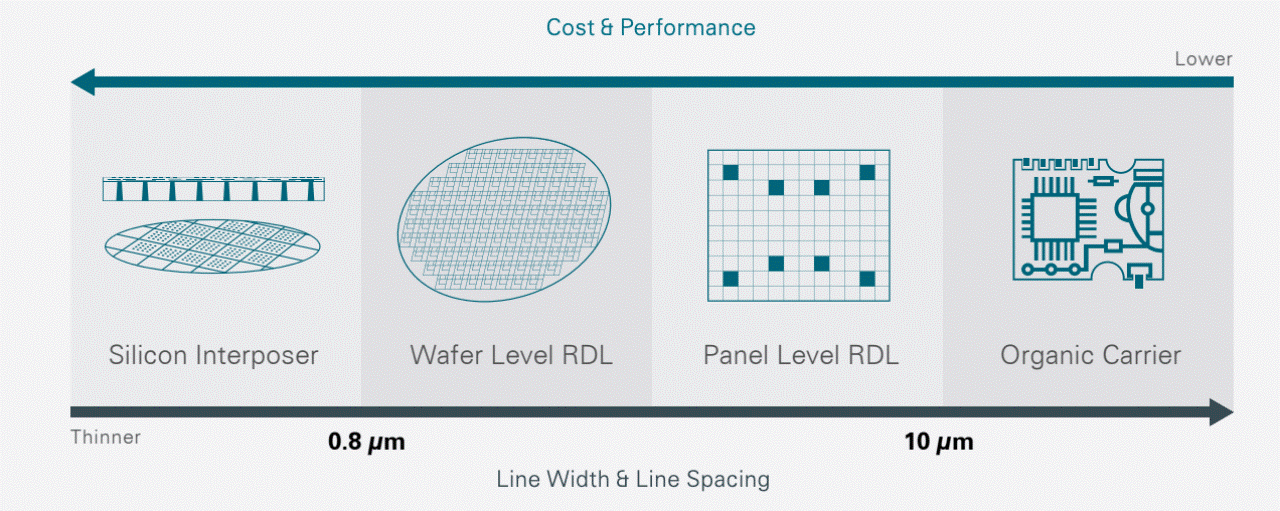










評(píng)論