半導體測試設備
1、橢偏儀
測量透明、半透明薄膜厚度的主流方法,它采用偏振光源發射激光,當光在樣本中發生反射時,會產生橢圓的偏振。橢偏儀通過測量反射得到的橢圓偏振,并結合已知的輸入值精確計算出薄膜的厚度,是一種非破壞性、非接觸的光學薄膜厚度測試技術。在晶圓加工中的注入、刻蝕和平坦化等一些需要實時測試的加工步驟內,橢偏儀可以直接被集成到工藝設備上,以此確定工藝中膜厚的加工終點。
2、四探針
測量不透明薄膜厚度。由于不透明薄膜無法利用光學原理進行測量,因此會利用四探針儀器測量方塊電阻,根據膜厚與方塊電阻之間的關系間接測量膜厚。方塊電阻可以理解為硅片上正方形薄膜兩端之間的電阻,它與薄膜的電阻率和厚度相關,與正方形薄層的尺寸無關。四探針將四個在一條直線上等距離放置的探針依次與硅片進行接觸,在外面的兩根探針之間施加已知的電流,同時測得內側兩根探針之間的電勢差,由此便可得到方塊電阻值。
3、熱波系統
測量摻雜濃度。熱波系統通過測量聚焦在硅片上同一點的兩束激光在硅片表面反射率的變化量來計算雜質粒子的注入濃度。在該系統內,一束激光通過氬氣激光器產生加熱的波使硅片表面溫度升高,熱硅片會導致另一束氦氖激光的反射系數發生變化,這一變化量正比于硅片中由雜質粒子注入而產生的晶體缺陷點的數目。由此,測量雜質粒子濃度的熱波信號探測器可以將晶格缺陷的數目與摻雜濃度等注入條件聯系起來,描述離子注入工藝后薄膜內雜質的濃度數值。
4、相干探測顯微鏡
套準精度測量設備。相干探測顯微鏡主要是利用相干光的干涉原理,將相干光的相位差轉換為光程差。它能夠獲得沿硅片垂直方向上硅片表面的圖像信息,通過相干光的干涉圖形可以分辨出樣品內部的復雜結構,增強了CMP后低對比度圖案的套刻成像能力。
5、光學顯微鏡
快速定位表面缺陷。光學顯微鏡使用光的反射或散射來檢測晶圓表面缺陷,由于缺陷會導致硅片表面不平整,進而表現出對光不同的反射、散射效應。根據對收到的來自硅片表面的光信號進行處理,光學顯微鏡就可以定位缺陷的位置。光學顯微鏡具有高速成像,成本經濟的特點,是目前工藝下的一種主要的缺陷檢測技術。
6、掃描電子顯微鏡
對缺陷進行精準成像。掃描電子顯微鏡的放大倍數能夠達到百萬倍,能夠提供尺寸更小缺陷的信息,其放大性能明顯高于光學顯微鏡。掃描電子顯微鏡通過波長極短的電子束來掃描硅片,通過收集激發和散射出的二次電子、散射電子等形成硅片表面的圖形,并得到不同材料間顯著的成分對比。
-
半導體
+關注
關注
335文章
28886瀏覽量
237514 -
半導體測試
+關注
關注
3文章
117瀏覽量
19658
發布評論請先 登錄
半導體高精度高低溫測試設備:多領域可靠性測試的溫度解決方案
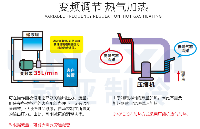
半導體測試可靠性測試設備

循環風控溫裝置在半導體設備高低溫測試中的深度應用解析

半導體測試的種類與技巧

國產半導體設備廠商,刷新成績單
半導體在熱測試中遇到的問題
芯片產業有望開啟新一輪繁榮周期,國產半導體設備如何乘風而起?
功率半導體雙脈沖測試方案






 半導體測試設備有哪些
半導體測試設備有哪些


















評論