FIB系統(tǒng)工作原理
1.工作原理
聚焦離子束(FIB)系統(tǒng)是一種高精度的納米加工與分析設(shè)備,其結(jié)構(gòu)與電子束曝光系統(tǒng)類似,主要由發(fā)射源、離子光柱、工作臺、真空與控制系統(tǒng)等組成,其中離子光學(xué)系統(tǒng)是核心部分,通常采用液態(tài)金屬離子源,如鎵離子源。針型液態(tài)金屬離子源的尖端是直徑約幾微米的鎢針,針尖正對著孔徑,在孔徑上加一外電場,同時加熱金屬,液態(tài)金屬浸潤針尖,在外加電場作用下形成離子束。
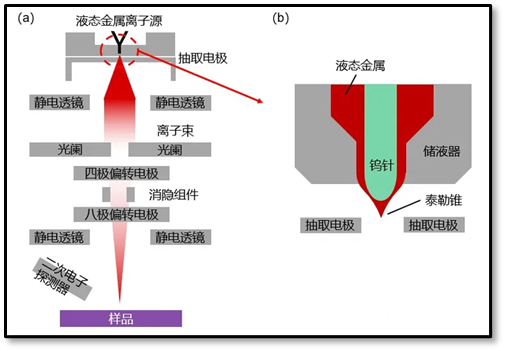
離子源發(fā)射出來的離子在通過第一級光闌之后,離子束被第一級靜電透鏡聚焦,四極偏轉(zhuǎn)電極用于調(diào)整離子束以減小像散。然后通過不同孔徑的可變光闌,靈活改變離子束束斑的大小,得到束流可控的離子束。次級八極偏轉(zhuǎn)電極使離子束根據(jù)被定義的加工圖形進行掃描加工,通過消隱偏轉(zhuǎn)器和消隱阻擋膜孔可實現(xiàn)離子束的消隱。最后,通過第二級靜電透鏡,離子束被聚焦到非常精細的束斑,分辨率可至約5 nm。被聚焦的離子束轟擊在樣品表面,產(chǎn)生的二次電子和離子被對應(yīng)的探測器收集并成像。
2.FIB - SEM雙束系統(tǒng)
由于離子轟擊襯底會產(chǎn)生二次電子,可通過掃描電子顯微鏡(SEM)監(jiān)測二次電子得到樣品表面的形貌圖。這樣同時具備FIB加工和觀測的系統(tǒng)通常稱為雙束系統(tǒng)(離子束和電子束),例如FIB - SEM雙束系統(tǒng)和FIB - TEM雙束系統(tǒng)。FIB - SEM雙束系統(tǒng)可以簡單理解為單束聚焦離子束系統(tǒng)與普通掃描電鏡的耦合。它將離子鏡筒和電子鏡筒以一定夾角方式集成為一體,實現(xiàn)在離子束進行加工的同時進行圖像的實時觀察。
FIB功能
1.基本功能及應(yīng)用
目前,F(xiàn)IB - SEM雙束系統(tǒng)已經(jīng)發(fā)展成為一個可用于各類固體樣品的微納加工和原位研究的綜合性樣品制備和測試分析平臺。最常用的是Ga離子雙束電鏡,通常包括透射電鏡(TEM)樣品制備,材料微觀截面截取與觀察、樣品微觀刻蝕與沉積以及材料三維成像,原子探針制備等等。
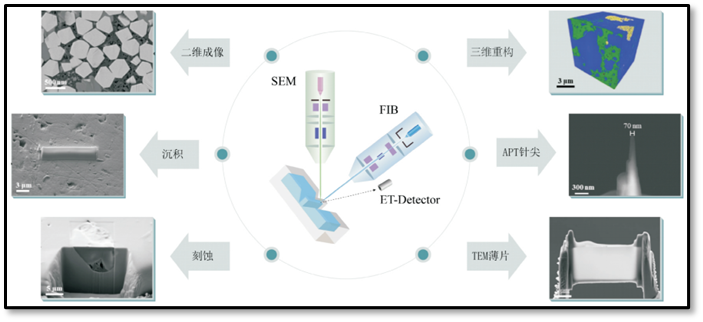
Ga離子束與樣品發(fā)生相互作用會產(chǎn)生多種信號,這是實現(xiàn)各種功能的基礎(chǔ)。其主要功能包括:首先,入射的Ga離子束轟擊到樣品上,會產(chǎn)生二次電子、背散射離子和二次離子等,這些信號主要用于對物質(zhì)表面形貌和成分的空間分布進行電子束成像,用于定位樣品,獲取微觀結(jié)構(gòu)和監(jiān)測加工過程;金鑒實驗室在進行試驗時,嚴(yán)格遵循相關(guān)標(biāo)準(zhǔn)操作,確保每一個測試環(huán)節(jié)都精準(zhǔn)無誤地符合標(biāo)準(zhǔn)要求。
Ga離子束可以通過透鏡系統(tǒng)和光闌將離子束直徑聚焦到5 nm以下,高能離子與樣品表面原子之間的碰撞會將其表面原子濺射出來,這樣就可以通過離子束的掃描軌跡來實現(xiàn)對樣品進行精細的微納米尺度刻蝕功能,用來進行截面觀察和特殊形狀加工;

離子束與氣體注入系統(tǒng)(GIS)結(jié)合可以實現(xiàn)沉積或者增強刻蝕。將含有金屬的有機前驅(qū)物加熱成氣態(tài)通過針管噴到樣品表面,當(dāng)離子或電子在該區(qū)域掃描時,可以將前驅(qū)物分解成易揮發(fā)性成分和不易揮發(fā)性成分,不易揮發(fā)性成分會殘留在掃描區(qū)域,產(chǎn)生的揮發(fā)性氣體隨排氣系統(tǒng)排出,這樣就實現(xiàn)了離子束 / 電子束誘導(dǎo)沉積氣體沉積,用于圖形加工和樣品制備。
目前常用的前驅(qū)物可以沉積Pt、C、W、SiO?等;還有顯微切割制備微米大小納米厚度的超薄片試樣(厚度小于100 nm),用于后續(xù)的TEM和同步輻射STXM等相關(guān)分析;顯微切割制備納米尺寸的針尖狀樣品,用于后續(xù)的APT分析,獲取其微量元素和同位素信息;綜合SEM成像,F(xiàn)IB切割及EDXS化學(xué)分析,對試樣進行微納尺度的三維重構(gòu)分析等。
2.FIB - SEM制備TEM超薄片過程
利用SEM分析找到感興趣的區(qū)域,表面盡量平整。選定目標(biāo)微區(qū)(長×寬約為15×2 μm),并在該微區(qū)內(nèi)選定一特征點置于畫面中心,傾轉(zhuǎn)樣品臺至樣品表面與離子束垂直(~54°)。為了避免在此過程中離子束對樣品表面的“誤傷”,通常還需利用電子束及離子束沉積的方式在該目標(biāo)微區(qū)表面預(yù)先沉積約~1 μm厚的Pt或C,作為保護層(配合氣體注入系統(tǒng),GIS)。
待樣品傾轉(zhuǎn)到合適角度并移動到視野中心位置后,利用離子束在保護層上下兩側(cè)緊鄰區(qū)域向縱深方向挖出兩個凹型槽,初步將目標(biāo)樣品暴露出來。這個過程通常先采用大束流進行粗切,當(dāng)靠近目標(biāo)樣品時需要降低離子束束流進行精細切割,直到寬度約1.5 μm。然后,通過轉(zhuǎn)動樣品臺的傾角至0~10°,并通過離子束繼續(xù)切割將目標(biāo)樣品的底部及其一個側(cè)邊與母樣斷開。此時,目標(biāo)樣品與母樣只有一個側(cè)邊相連。
移動納米操作手,使其尖端緩慢接近樣品,按針尖與樣品的距離選擇合適的速度(即保證移動相應(yīng)距離約需5~10秒)。待針尖輕輕接觸到目標(biāo)樣品頂部的端口位置,采用GIS系統(tǒng)對連接處進行Pt沉積(30 kV,20~50 pA),從而將目標(biāo)樣品與納米操作手相連。之后,采用離子束將目標(biāo)樣品與母樣從另一邊完全切離,并移動納米操作手將目標(biāo)樣品從母樣中緩慢提出。
將FIB專用的TEM載網(wǎng)豎直放入到專用樣品臺中,并在FIB中將載網(wǎng)傾轉(zhuǎn)和樣品同樣的角度,緩慢上移至優(yōu)中心處。移動納米操作手使目標(biāo)樣品緩慢下降,輕輕貼到載網(wǎng)上,利用GIS系統(tǒng)在目標(biāo)樣品與TEM載網(wǎng)的接觸點上沉積Pt并連接,連接牢固后利用離子束切割將操作手的針尖與目標(biāo)樣品進行斷開,撤出針尖。
對已經(jīng)固定在FIB專用TEM載網(wǎng)上的目標(biāo)樣品進行二次減薄和精修。為了保護樣品表面不被離子束很快刻蝕掉,樣品刻蝕角度需偏轉(zhuǎn)1.5°。隨著樣品減薄,其易受損傷程度增加,因此需要逐步降低束流,最終達到所需厚度(通常為~100 nm)(在電子束5 kV或3 kV透亮)。
-
fib
+關(guān)注
關(guān)注
1文章
102瀏覽量
11417 -
離子束
+關(guān)注
關(guān)注
0文章
94瀏覽量
7797
發(fā)布評論請先 登錄
Dual Beam FIB(雙束聚焦離子束)
聚焦離子束應(yīng)用介紹
聚焦離子束技術(shù)介紹
聚焦離子束技術(shù)的歷史發(fā)展

聚焦離子束雙束系統(tǒng)在微機電系統(tǒng)失效分析中的應(yīng)用
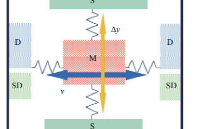
聚焦離子束技術(shù):納米加工與分析的利器

聚焦離子束(FIB)技術(shù):半導(dǎo)體量產(chǎn)中的高精度利器






 聚焦離子束技術(shù):微納加工與分析的利器
聚焦離子束技術(shù):微納加工與分析的利器


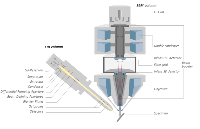

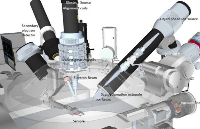
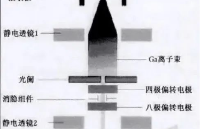
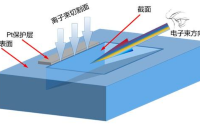
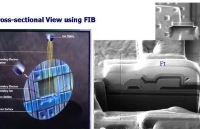
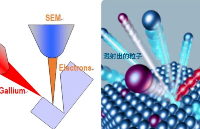










評論