聚焦離子束(FIB)技術是一種先進的納米加工和分析工具。其基本原理是在電場和磁場作用下,將離子束聚焦到亞微米甚至納米量級,通過偏轉和加速系統控制離子束掃描運動,實現微納圖形的監測分析和微納結構的無掩模加工。
聚焦離子束(FIB)技術的發展離不開液態金屬離子源的關鍵突破。
20世紀70年代初,來自美國阿貢國家實驗室、英國Cluham實驗室、美國俄勒岡研究中心等機構的科學家投身于液態金屬離子源研發,并將其引入FIB系統。1978年,美國加州休斯研究所成功搭建全球首臺基于Ga+液態金屬離子源的FIB加工系統,其離子束斑直徑僅100納米,束流密度達1.5安培/平方厘米,束亮度達3.3×10?安培/平方厘米·球面度,標志著FIB技術進入實用化階段。80年代和90年代,FIB技術在機理、設備和應用研究等方面取得顯著進步,不同功能的商用FIB系統批量面世,廣泛應用于研究實驗室和半導體集成電路制造廠。如今,FIB技術已成為微電子行業提升材料分析、工藝優化、器件檢測及修復精度與效率的關鍵技術。
FIB系統的核心技術
FIB技術的核心在于利用靜電透鏡將離子束聚焦至極小尺寸,實現高精度的顯微切割。
目前,商用FIB系統的離子束源自液態金屬離子源。液態金屬離子源具有高亮度、高穩定性和易于操作等優點,能夠提供高質量的離子束。在FIB系統中,離子源產生的離子束經過加速、聚焦等一系列操作后,被精確地引導至樣品表面。當離子束與樣品相互作用時,會發生多種物理和化學過程,如離子束轟擊樣品表面導致的材料去除(刻蝕),或者離子束與樣品表面原子相互作用后引發的二次電子發射等。通過檢測這些二次電子信號,可以獲得樣品表面的微觀形貌信息,從而實現對樣品的高分辨率成像。此外,FIB技術還可以通過控制離子束的能量、束流密度和作用時間等參數,實現對樣品的精確加工和改性。例如,在微納加工領域,FIB技術可用于制造納米尺度的結構和器件;在材料分析方面,FIB技術可用于制備透射電子顯微鏡(TEM)樣品,以便對材料的微觀結構進行深入研究。總之,FIB技術憑借其高精度、多功能的特點,在眾多領域展現出了廣闊的應用前景。
FIB技術在芯片設計及加工中的應用
1. IC芯片電路修改
在芯片設計與制造過程中,FIB技術發揮著至關重要的作用。通過FIB對芯片電路進行物理修改,芯片設計者能夠針對芯片問題區域進行針對性測試,從而更快速、更準確地驗證設計方案。當芯片的某些部分出現故障或性能不佳時,FIB可以對這些區域進行隔離或功能修正,幫助工程師迅速定位問題根源。此外,FIB還能在產品量產前提供樣片和工程片,加速終端產品的上市時間。利用FIB修改芯片,可有效減少不成功的設計方案修改次數,縮短研發周期,降低研發成本。例如,在一款復雜芯片的研發過程中,工程師發現其中的一個功能模塊存在性能瓶頸。通過FIB技術,他們可以對該模塊進行局部修改,改變其電路結構或連接方式,從而優化性能。這種精準的修改方式不僅節省了時間和資源,還提高了芯片設計的成功率。
FIB技術在芯片截面分析方面的應用同樣不可小覷。通過對IC芯片特定位置進行截面斷層切割,工程師可以清晰地觀察到芯片內部的材料截面結構和材質分布情況,進而對芯片的結構缺陷進行定點分析。這種截面分析方法為芯片制造過程中的質量控制和故障排查提供了有力支持。例如,在芯片制造過程中,可能會出現晶體管漏電、互連線短路等問題。
3.Probing Pad
在復雜IC線路中,FIB技術還可以用于在任意位置引出測試點。這些測試點可以與探針臺(Probe-station)或電子束(E-beam)直接連接,以便對IC內部信號進行進一步觀測和分析。這對于芯片的功能驗證和性能測試至關重要。例如,在一款高性能處理器芯片中,其內部電路結構復雜,信號分布密集。通過FIB技術在關鍵節點引出測試點,工程師可以實時監測信號的傳輸情況,檢查是否存在信號延遲、干擾等問題。這種精確的信號檢測方法有助于提高芯片的性能和穩定性,確保其在各種工作條件下都能正常運行。
在微納加工領域的應用
FIB技術在微納加工和半導體集成電路制造業中具有廣泛的應用前景,是當前該領域十分活躍的研究方向之一。它集材料刻蝕、沉積、注入、改性等多種功能于一身,有望成為高真空環境下實現器件制造全過程的主要加工手段。
TEM和STEM薄片試樣制備
FIB技術在透射電子顯微鏡(TEM)和掃描透射電子顯微鏡(STEM)薄片試樣制備方面也發揮著重要作用。
為了方便大家對材料進行深入的失效分析及研究,金鑒實驗室具備Dual Beam FIB-SEM業務,包括透射電鏡(TEM)樣品制備,材料微觀截面截取與觀察、樣品微觀刻蝕與沉積以及材料三維成像及分析等。TEM和STEM是研究材料微觀結構和性能的重要手段,而高質量的薄片試樣是獲得準確分析結果的關鍵。FIB技術可以精確地從樣品中切取厚度僅為幾十納米的薄片,滿足TEM和STEM的試樣要求。通過FIB制備的薄片試樣,研究人員可以清晰地觀察到材料的原子級結構,從而深入理解材料的物理和化學性質。例如,在研究新型半導體材料的晶體結構時,通過FIB制備的薄片試樣可以幫助研究人員準確地分析晶體的生長方向、缺陷類型等信息,為材料的優化和應用提供理論依據。
其他應用領域的探索與開發
除了上述主要應用,FIB技術還在多個新興領域展現出巨大的潛力。例如,掃描離子束顯微鏡(SIM)是一種基于FIB技術的新型顯微鏡,它利用離子束掃描樣品表面,可以獲得高分辨率的三維形貌圖像。FIB直接注入技術則可用于將特定的離子注入材料內部,實現材料的改性和摻雜。FIB曝光技術,包括掃描曝光和投影曝光,可用于制造納米尺度的圖案和結構。多束技術和全真空聯機技術則為FIB技術的進一步發展提供了新的思路和方向。
-
透鏡
+關注
關注
0文章
64瀏覽量
18179 -
fib
+關注
關注
1文章
96瀏覽量
11365 -
離子束
+關注
關注
0文章
88瀏覽量
7768
發布評論請先 登錄
FIB聚焦離子束電路修改服務
Dual Beam FIB(雙束聚焦離子束)
聚焦離子束顯微鏡(FIB-SEM)
聚焦離子束應用介紹
聚焦離子束技術:納米加工與分析的利器






 聚焦離子束技術的崛起與應用拓展
聚焦離子束技術的崛起與應用拓展


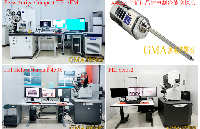




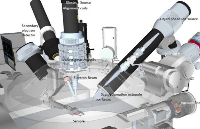
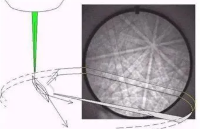










評論