技術原理與核心優勢
聚焦離子束雙束系統(FIB - SEM)是一種集成多種先進技術的高端設備,其核心構成包括聚焦離子束(FIB)模塊、掃描電子顯微鏡(SEM)模塊以及多軸樣品臺,這種獨特的結構設計使得它能夠實現加工與觀測的一體化操作,極大地提高了工作效率和分析精度。
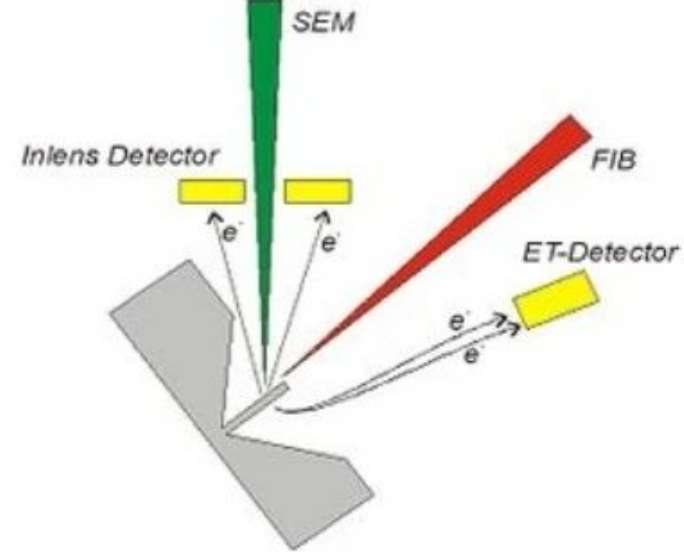
1.FIB 模塊的關鍵作用
FIB 模塊采用液態金屬離子源(LMIS)產生鎵離子束(Ga?),這種鎵離子束具備極高的能量和精度,能夠實現納米級的刻蝕、沉積以及樣品制備等一系列微加工操作。在半導體芯片等微觀領域的研究與制造過程中,這種納米級的加工能力至關重要,它可以對材料的微觀結構進行精準的改造和塑造,為后續的分析和應用奠定基礎。
2.SEM 模塊的實時監控功能
掃描電子顯微鏡(SEM)模塊則通過二次電子成像技術,能夠實時監控加工過程。它具有極高的定位精度,可達亞微米級,這意味著在進行微觀加工時,操作人員可以精確地觀察到加工部位的細節變化,從而及時調整加工參數,確保加工的準確性和質量。
3.雙束協同的綜合優勢
FIB - SEM 雙束系統最顯著的優勢在于雙束能夠同步工作。這種協同工作模式支持多種先進的分析和加工技術,例如三維重構、定點加工以及多模態分析等。
關鍵應用場景
FIB - SEM 雙束系統在多個領域都有著關鍵的應用,尤其是在半導體芯片的研發與失效分析中,發揮著不可替代的作用。
1.高精度截面分析與三維成像
定點切割與清晰斷面生成:
該系統能夠對芯片內部的復雜結構,如晶體管柵極、金屬互連層等進行定點切割,生成無應力損傷的清晰斷面。這種高精度的截面分析對于研究芯片內部結構的完整性、材料的分布情況以及不同層次之間的連接關系等都有著極其重要的意義。
結合連續切片技術的三維重構:
通過與連續切片技術相結合,FIB - SEM 可以重構出芯片的三維電路結構。這種三維重構不僅能夠更直觀地展示芯片的內部布局,還能夠輔助進行缺陷定位與設計驗證。在芯片的研發過程中,及時發現并定位缺陷是提高產品質量和性能的關鍵環節,而三維重構技術能夠從多個角度對芯片進行分析,更全面地發現潛在問題,從而為優化設計提供有力支持。
2.透射電鏡(TEM)樣品制備超薄樣品的制備:
利用離子束逐層減薄的原理,FIB - SEM 可以制備出厚度小于 100 納米的超薄樣品。這種超薄樣品能夠保留原子級的晶格信息,為透射電鏡(TEM)的高分辨率成像提供了理想的樣品。在微觀材料研究中,TEM 是一種極其重要的分析手段,它能夠觀察到材料的原子結構和晶體缺陷等微觀細節。而 FIB - SEM 制備的超薄樣品能夠滿足 TEM 對樣品厚度和質量的嚴格要求,使得 TEM 能夠充分發揮其高分辨率的優勢,為材料的微觀結構研究提供更深入、更準確的信息。
先進制程中的精準分析:
在 3 納米以下的先進制程中,芯片的結構和性能對材料的微觀特性要求極高。FIB - SEM 能夠精準分析柵極氧化層缺陷與界面特性,這對于提高芯片的性能和可靠性至關重要。柵極氧化層是晶體管中的關鍵結構之一,其質量直接影響著晶體管的開關性能和穩定性。通過 FIB - SEM 的精準分析,可以及時發現柵極氧化層中的缺陷,如厚度不均勻、雜質摻雜不均勻等,并對界面特性進行深入研究,從而為改進制程工藝、提高芯片質量提供有力的技術支持。
3.芯片線路修改線路切斷與修復:
FIB - SEM 可以切斷短路線路,同時也能沉積導電材料(如鉑、鎢)來修復斷路。這種線路修改功能對于多項目晶圓(MPW)的迭代優化具有重要意義。
氣體注入系統的輔助作用:
氣體注入系統(GIS)是 FIB - SEM 的一個重要組成部分,它能夠實現局部區域的金屬 / 絕緣層選擇性沉積。這種選擇性沉積技術可以根據需要在特定位置沉積不同材料,從而實現對芯片局部結構的精確改造。與傳統的沉積方法相比,GIS 的選擇性沉積能夠降低研發成本,因為它可以避免對整個芯片進行不必要的沉積操作,節省了材料和時間成本。同時,這種精確的沉積方式也能夠提高芯片的性能和可靠性,為芯片的研發和制造提供了更加靈活、高效的手段。
結語
聚焦離子束雙束系統 FIB - SEM 憑借其獨特的技術原理和強大的功能優勢,在半導體芯片研發與失效分析等領域展現出了巨大的應用潛力和價值。隨著技術的不斷發展和創新,FIB - SEM 系統將在更多的領域發揮重要作用,為微觀材料研究和高端制造業的發展提供有力的技術支撐。
-
SEM
+關注
關注
0文章
257瀏覽量
14790 -
fib
+關注
關注
1文章
91瀏覽量
11334 -
離子束
+關注
關注
0文章
83瀏覽量
7730
發布評論請先 登錄
聚焦離子束技術介紹
聚焦離子束掃描電鏡(FIB-SEM)技術原理、樣品制備要點及常見問題解答






 聚焦離子束雙束系統 FIB - SEM 的技術剖析與應用拓展
聚焦離子束雙束系統 FIB - SEM 的技術剖析與應用拓展

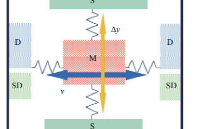


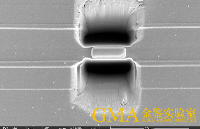


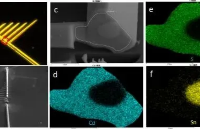
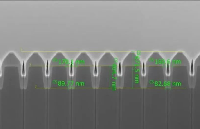










評論