在半導(dǎo)體產(chǎn)業(yè)持續(xù)追求高性能、小型化的進(jìn)程中,晶圓級(jí)封裝(WLP)憑借其卓越的電氣性能和尺寸優(yōu)勢(shì),已成為先進(jìn)封裝技術(shù)的關(guān)鍵領(lǐng)域。錫膏作為晶圓級(jí)封裝中實(shí)現(xiàn)電氣連接與機(jī)械固定的核心材料,其性能與應(yīng)用直接關(guān)乎封裝質(zhì)量與芯片可靠性。作為錫膏廠家,傲牛科技的工程師將在本文中,深入剖析晶圓級(jí)封裝中錫膏的應(yīng)用場(chǎng)景、類型選擇與性能要求,并介紹我司在該領(lǐng)域的前沿產(chǎn)品與解決方案。
一、晶圓級(jí)封裝工藝中的錫膏應(yīng)用環(huán)節(jié)
晶圓級(jí)封裝涵蓋多種先進(jìn)工藝,如扇入型(Fan - In)、扇出型(Fan - Out)、倒裝芯片(Flip Chip)及硅通孔(TSV)封裝等。在這些工藝中,錫膏主要應(yīng)用于以下關(guān)鍵環(huán)節(jié):
- 凸點(diǎn)(Bump)制作:在倒裝芯片和扇入型晶圓級(jí)封裝中,通過(guò)鋼網(wǎng)印刷將錫膏精確沉積在芯片焊盤(pán)或晶圓表面,經(jīng)回流焊形成具有特定高度與形狀的焊料凸點(diǎn),為芯片與基板的互連提供可靠接口。例如,在0.1mm以下細(xì)間距的倒裝芯片封裝中,錫膏印刷的精度與一致性對(duì)凸點(diǎn)質(zhì)量至關(guān)重要。
- 植球工藝:扇出型晶圓級(jí)封裝在重新布線層(RDL)制作完成后,需借助錫膏將錫球精確植于RDL焊盤(pán)上,實(shí)現(xiàn)芯片與外部電路的電氣連接。這一過(guò)程要求錫膏具備良好的觸變性與潤(rùn)濕性,以確保錫球在回流后位置準(zhǔn)確、焊點(diǎn)牢固。
- 芯片與基板互連:無(wú)論是何種晶圓級(jí)封裝形式,最終都需通過(guò)錫膏焊接實(shí)現(xiàn)芯片與基板(或載板)的可靠互連。在這一環(huán)節(jié),錫膏需在不同材料(如硅芯片、有機(jī)基板、陶瓷基板)表面形成良好的冶金結(jié)合,保障電氣信號(hào)高效傳輸與機(jī)械結(jié)構(gòu)穩(wěn)定。
二、晶圓級(jí)封裝常用錫膏類型
隨著無(wú)鉛化趨勢(shì)的推進(jìn),晶圓級(jí)封裝領(lǐng)域廣泛采用無(wú)鉛錫膏,主要體系包括:
- Sn-Ag-Cu(SAC)體系錫膏:以其優(yōu)良的機(jī)械性能、較高的熔點(diǎn)(217 - 221℃)和良好的潤(rùn)濕性,成為高端應(yīng)用的首選。例如,在5G通信芯片、高性能計(jì)算芯片的晶圓級(jí)封裝中,SAC體系錫膏能夠滿足高頻信號(hào)傳輸對(duì)焊點(diǎn)可靠性與穩(wěn)定性的嚴(yán)苛要求。
- Sn-Cu體系錫膏:成本相對(duì)較低,且具備較好的焊接性能,在對(duì)成本敏感的消費(fèi)電子芯片封裝中應(yīng)用廣泛。其熔點(diǎn)約227℃,在一些對(duì)工作溫度要求不高的場(chǎng)景中,能有效平衡成本與性能。
- Sn-Bi體系錫膏:具有較低的熔點(diǎn)(約139℃),適用于熱敏元件或多層堆疊封裝中的低溫焊接工藝。在可穿戴設(shè)備芯片封裝中,由于對(duì)功耗與散熱要求較高,Sn-Bi體系錫膏可在較低溫度下完成焊接,減少對(duì)周邊元件的熱影響。
三、晶圓級(jí)封裝對(duì)錫膏的性能要求
- 高精度印刷性能:針對(duì)晶圓級(jí)封裝的細(xì)間距(<0.2mm)、高密度特點(diǎn),錫膏需具備優(yōu)異的觸變性,在印刷過(guò)程中能迅速填充鋼網(wǎng)開(kāi)孔,并在印刷后保持形狀穩(wěn)定,避免塌落與橋連。例如,對(duì)于0.15mm間距的晶圓級(jí)CSP封裝,錫膏印刷的偏差需控制在±5μm以內(nèi)。
- 良好的潤(rùn)濕性:錫膏需在不同金屬表面(如銅、鎳、金)迅速鋪展,形成牢固的冶金結(jié)合,確保焊點(diǎn)的電氣與機(jī)械性能。潤(rùn)濕性不良會(huì)導(dǎo)致虛焊、開(kāi)路等缺陷,影響封裝成品率與可靠性。
- 高可靠性焊點(diǎn):在高溫、高濕、振動(dòng)等復(fù)雜工作環(huán)境下,焊點(diǎn)需保持長(zhǎng)期穩(wěn)定。錫膏應(yīng)具備低空洞率、高抗疲勞性能,以滿足汽車電子、航空航天等領(lǐng)域?qū)π酒煽啃缘膰?yán)苛要求。例如,汽車發(fā)動(dòng)機(jī)控制單元芯片的晶圓級(jí)封裝,焊點(diǎn)需經(jīng)受1000次以上的高低溫循環(huán)測(cè)試。
- 低殘留與易清洗性:焊接后,錫膏殘留應(yīng)盡量少,且易于清洗,避免殘留物質(zhì)對(duì)芯片性能產(chǎn)生影響,如腐蝕、漏電等。特別是在醫(yī)療電子芯片封裝中,對(duì)錫膏殘留的控制尤為嚴(yán)格。
四、傲牛科技錫膏產(chǎn)品在晶圓級(jí)封裝中的優(yōu)勢(shì)
作為專業(yè)的封裝材料生產(chǎn)企業(yè),傲牛科技深耕錫膏領(lǐng)域多年,為晶圓級(jí)封裝提供了一系列高性能產(chǎn)品,具有顯著優(yōu)勢(shì):
- 卓越的印刷精度:我公司采用先進(jìn)的配方與生產(chǎn)工藝,使錫膏具有極佳的觸變性與流動(dòng)性控制,在超精細(xì)間距印刷中表現(xiàn)出色。例如,針對(duì)0.1mm間距的倒裝芯片封裝,我司錫膏的印刷精度可達(dá)±3μm,遠(yuǎn)超行業(yè)平均水平,有效降低了印刷缺陷率。
- 優(yōu)化的潤(rùn)濕性配方:通過(guò)對(duì)合金成分與助焊劑體系的深入研究,我公司錫膏在多種金屬表面均能實(shí)現(xiàn)快速、充分的潤(rùn)濕,焊點(diǎn)飽滿、光亮,結(jié)合強(qiáng)度高。在實(shí)際應(yīng)用中,相比同類產(chǎn)品,我司錫膏的焊點(diǎn)抗剪切強(qiáng)度提升了20%,極大提高了封裝的可靠性。
- 高可靠性焊點(diǎn)保障:錫膏在研發(fā)過(guò)程中充分考慮了不同應(yīng)用場(chǎng)景的可靠性需求,通過(guò)添加特殊合金元素與優(yōu)化微觀結(jié)構(gòu),尤其是我公司最新與日本材料科技公司聯(lián)合開(kāi)發(fā)的低空洞抑制技術(shù),顯著降低了焊點(diǎn)空洞率,提高了抗疲勞性能。
- 低殘留與環(huán)保清洗方案:我公司致力于綠色環(huán)保封裝材料的研發(fā),錫膏焊接后殘留少,且采用環(huán)保型助焊劑體系,易于清洗。配套的清洗工藝與清洗劑,能在不損傷芯片與封裝結(jié)構(gòu)的前提下,徹底清除殘留,滿足醫(yī)療、航天等對(duì)清潔度要求極高的應(yīng)用場(chǎng)景。
在晶圓級(jí)封裝技術(shù)蓬勃發(fā)展的當(dāng)下,錫膏作為核心封裝材料的重要性不言而喻。憑借在錫膏研發(fā)、生產(chǎn)方面的深厚積累與技術(shù)創(chuàng)新,傲牛科技為客戶提供了全方位、高性能的解決方案,助力半導(dǎo)體產(chǎn)業(yè)邁向更高性能、更小尺寸、更可靠的封裝新時(shí)代。期待與廣大客戶攜手合作,共同探索晶圓級(jí)封裝的無(wú)限可能,為行業(yè)發(fā)展貢獻(xiàn)力量。
-
錫膏
+關(guān)注
關(guān)注
1文章
942瀏覽量
17458 -
晶圓級(jí)封裝
+關(guān)注
關(guān)注
5文章
41瀏覽量
11666 -
FOWLP
+關(guān)注
關(guān)注
1文章
16瀏覽量
10101 -
FOWLP封裝
+關(guān)注
關(guān)注
0文章
4瀏覽量
2923
發(fā)布評(píng)論請(qǐng)先 登錄
HRP晶圓級(jí)先進(jìn)封裝替代傳統(tǒng)封裝技術(shù)研究(HRP晶圓級(jí)先進(jìn)封裝芯片)

提供半導(dǎo)體工藝可靠性測(cè)試-WLR晶圓可靠性測(cè)試
晶圓級(jí)CSP的錫膏裝配和助焊劑裝配
晶圓級(jí)CSP元件的重新貼裝印刷錫膏
晶圓級(jí)CSP裝配工藝的錫膏的選擇和評(píng)估
教你判別固晶錫膏的品質(zhì)
Mini LED封裝時(shí)代,錫膏與共晶孰優(yōu)孰劣?
詳解晶圓級(jí)可靠性評(píng)價(jià)技術(shù)

錫膏在晶圓級(jí)封裝中容易出現(xiàn)什么問(wèn)題?從工藝到設(shè)備全解析?






 晶圓級(jí)封裝的 “隱形基石”:錫膏如何決定芯片可靠性?
晶圓級(jí)封裝的 “隱形基石”:錫膏如何決定芯片可靠性?


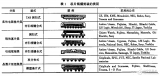













評(píng)論