部分國產(chǎn)碳化硅MOSFET廠商“避談柵氧可靠性”的本質(zhì):電性能的顯性參數(shù)與柵氧可靠性的隱性質(zhì)量的矛盾
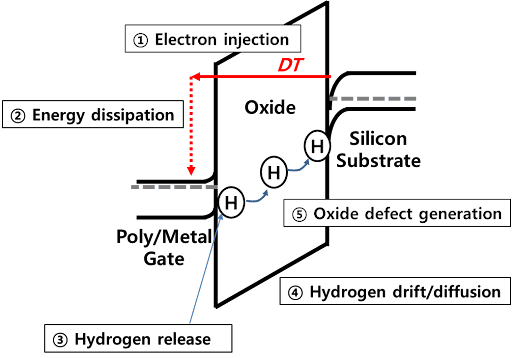
部分國產(chǎn)碳化硅MOSFET廠商鉆的空子正是大部分下游客戶沒有驗證SiC碳化硅MOSFET柵氧可靠性的能力比如HTGB實驗和TDDB實驗,而只能驗證電性能和關(guān)注成本,短期主義和長期價值的博弈就此開始。
HTGB實驗標準
測試條件:根據(jù)JEDEC JESD22-A-108標準,HTGB測試通常在高溫(如175°C)下施加最大額定柵極電壓(如+22V和-10V),持續(xù)1000小時以上。
判定標準:失效判據(jù)包括閾值電壓(Vth)漂移超過允許范圍(如±0.2V)、柵極漏電流超標等.
TDDB實驗流程
恒壓法:施加恒定柵壓(如35V),監(jiān)測柵極電流變化,直至電流驟增(擊穿發(fā)生)。
數(shù)據(jù)記錄:通過失效時間分布和電場強度關(guān)系擬合壽命模型,預(yù)測實際工況下的柵氧壽命
HTGB和TDDB實驗是碳化硅MOSFET可靠性驗證的核心手段,直接影響器件在高壓、高溫場景下的長期穩(wěn)定性。標準嚴格性(如JEDEC/AEC-Q101)、數(shù)據(jù)透明性(公開失效分布)及工藝優(yōu)化(柵氧厚度控制)是提升國產(chǎn)器件競爭力的關(guān)鍵。未來,隨著車規(guī)級需求增長,這兩項測試的重要性將進一步凸顯。
碳化硅MOSFET中柵氧可靠性與電性能參數(shù)矛盾的深層原因
在碳化硅(SiC)MOSFET設(shè)計中,柵氧可靠性如經(jīng)時擊穿壽命TDDB、閾值電壓穩(wěn)定性與電性能參數(shù)比如導(dǎo)通電阻 Rds(on)、開關(guān)損耗 Qg 等之間的矛盾,本質(zhì)上源于器件物理特性與工藝設(shè)計的權(quán)衡。在芯片面積(die size)固定的前提下,優(yōu)化電性能參數(shù)往往需要犧牲柵氧可靠性。
“避談柵氧可靠性”矛盾的本質(zhì)是物理規(guī)律與商業(yè)利益的博弈,部分國產(chǎn)碳化硅MOSFET廠商確實存在做賊心虛,在客戶面前決口不提柵氧可靠性,但是給客戶電力電子設(shè)備的長期運行埋下了無法排除的隱患!
在固定die size下,碳化硅MOSFET的柵氧可靠性與電性能參數(shù)的矛盾,是器件物理規(guī)律(如電場強度與壽命的指數(shù)關(guān)系)與市場短期需求(低成本、高參數(shù)競爭力)共同作用的結(jié)果。
一、SiC碳化硅MOSFET顯性電性能與隱性可靠性的技術(shù)矛盾
顯性參數(shù)的“表面優(yōu)勢”
部分國產(chǎn)碳化硅MOSFET廠商熱衷于宣傳導(dǎo)通電阻(Rds(on))、開關(guān)速度等可直接測量的參數(shù),這些指標直接影響效率和成本,是客戶采購時的核心考量。
工藝捷徑:部分國產(chǎn)碳化硅MOSFET廠商通過減薄柵氧厚度(如從50nm降至40nm)可顯著降低Rds(on),但導(dǎo)致柵極電場強度(Eox)超過4 MV/cm,加速TDDB失效。
參數(shù)競賽:部分國產(chǎn)碳化硅MOSFET廠商通過犧牲柵氧可靠性換取更低的比導(dǎo)通電阻,以此在價格戰(zhàn)中占據(jù)優(yōu)勢。
隱性質(zhì)量的“沉默成本”
國產(chǎn)碳化硅MOSFET柵氧可靠性如TDDB壽命、閾值電壓穩(wěn)定性需長期驗證,短期內(nèi)無法通過常規(guī)測試暴露問題,但一旦失效將引發(fā)災(zāi)難性后果如車載充電機OBC批量故障,充電樁電源模塊大規(guī)模召回,甚至是逆變焊機短時間批量故障退貨。
TDDB數(shù)據(jù):部分國產(chǎn)碳化硅MOSFETTDDB壽命僅約10?小時(≈1.14年),而頭部廠商通過嚴格工藝可達10?小時,但柵氧偷工減料的國產(chǎn)碳化硅MOSFET因電性能優(yōu)勢成本優(yōu)勢更易獲得訂單。
二、大部分國產(chǎn)碳化硅MOSFET廠商的“避談策略”與質(zhì)量意識缺失
選擇性信息披露
測試數(shù)據(jù)模糊化:僅宣稱“通過AEC-Q101認證”,但回避具體測試條件(如HTGB電壓、TDDB失效分布),掩蓋柵氧工藝缺陷。
技術(shù)文檔避重就輕:宣傳手冊強調(diào)電性能參數(shù),但對柵氧厚度、電場強度等關(guān)鍵指標諱莫如深。
短期利益驅(qū)動的價值取向
成本優(yōu)先于可靠性:為搶占充電樁、光伏逆變器、汽車OBC等對價格敏感的市場,采用低成本工藝(如減薄柵氧),但對電力電子應(yīng)用的長期風(fēng)險被忽視。
三、國產(chǎn)碳化硅MOSFET行業(yè)亂象的根源:市場機制與技術(shù)門檻的失衡
客戶認知偏差
下游企業(yè)如充電樁電源模塊廠商更關(guān)注“每瓦成本”而非“每瓦可靠性”,倒逼上游器件廠商優(yōu)先優(yōu)化顯性參數(shù)。
技術(shù)門檻與監(jiān)管缺位
車規(guī)認證漏洞:AEC-Q101未強制要求公開TDDB原始數(shù)據(jù)(如失效時間分布),部分廠商通過“擦邊”測試蒙混過關(guān)。
四、“避談柵氧可靠性”矛盾背后的選擇:短期利益與長期價值的博弈
國產(chǎn)碳化硅MOSFET廠商短期利益派
目標:快速占領(lǐng)市場,依賴低價策略。
代價:充電源電源模塊,車載等高可靠領(lǐng)域若干年后“爆雷”頻發(fā),品牌聲譽受損,最終被車企剔除供應(yīng)鏈。
國產(chǎn)碳化硅MOSFET廠商長期價值派
策略:堅守柵氧可靠性,通過工藝優(yōu)化平衡性能與壽命。
回報:在電力電子市場建立信任壁壘,實現(xiàn)可持續(xù)增長。
結(jié)論:電源客戶的質(zhì)量意識是分水嶺,行業(yè)亟待價值重構(gòu)
國產(chǎn)SiC MOSFET廠商“避談柵氧可靠性”的本質(zhì),是顯性參數(shù)與隱性質(zhì)量的技術(shù)矛盾,更是短期套利與長期主義的價值沖突。部分廠商為追求市場份額,將成本壓縮凌駕于可靠性之上,最終在充電樁電源模塊,車載OBC,甚至是逆變焊機等場景中付出代價。
未來破局關(guān)鍵:
客戶教育:推動下游電源企業(yè)從“唯成本論”轉(zhuǎn)向“全生命周期成本”評估;
標準升級:強制要求碳化硅MOSFET供應(yīng)商公開TDDB/HTGB詳細數(shù)據(jù),堵住認證漏洞;
技術(shù)深耕:通過碳化硅MOSFET工藝創(chuàng)新打破性能-可靠性權(quán)衡。
唯有如此,國產(chǎn)SiC產(chǎn)業(yè)才能從“低價內(nèi)卷”走向“高可靠賦能”的新階段。
審核編輯 黃宇
-
碳化硅MOSFET
+關(guān)注
關(guān)注
0文章
43瀏覽量
4552
發(fā)布評論請先 登錄
為何必須通過TDDB(時間相關(guān)介質(zhì)擊穿)方法檢驗國產(chǎn)SiC MOSFET的柵氧可靠性水平

老舊MPPT設(shè)計中+15V驅(qū)動下的部分國產(chǎn)SiC碳化硅MOSFET柵氧爆雷隱患

SiC碳化硅MOSFET驅(qū)動電壓的限制源于柵氧可靠性與器件性能之間的權(quán)衡
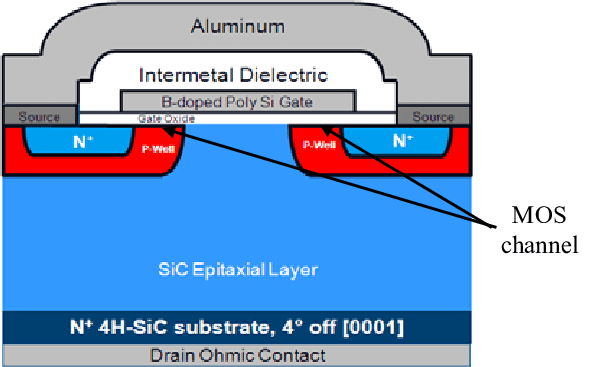
車載充電機(OBC)和熱泵空調(diào)等車載領(lǐng)域成為柵氧可靠性問題的“爆雷重災(zāi)區(qū)”
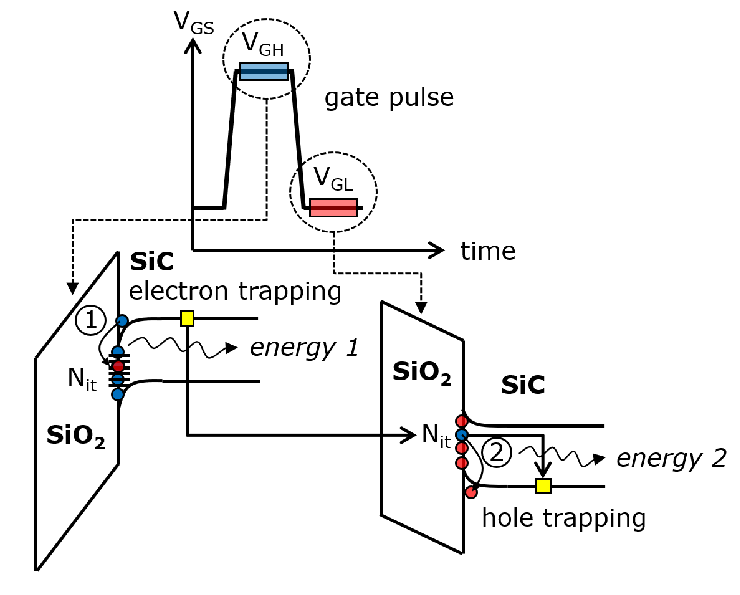
國產(chǎn)SiC碳化硅MOSFET廠商柵氧可靠性危機與破局分析

碳化硅(SiC)MOSFET的柵氧可靠性成為電力電子客戶應(yīng)用中的核心關(guān)切點
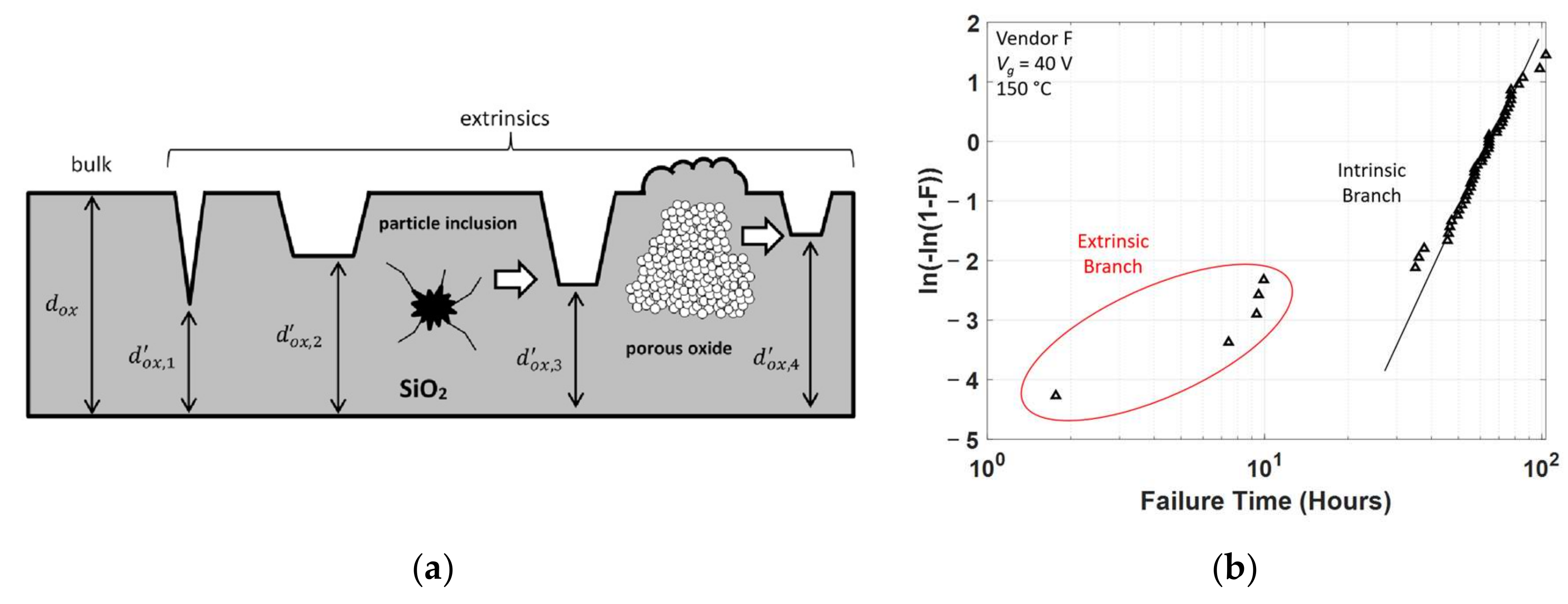
國產(chǎn)碳化硅MOSFET行業(yè)亂象給中國功率半導(dǎo)體行業(yè)敲響警鐘
長期工作的充電樁電源模塊中碳化硅MOSFET失效率越來越高的罪魁禍首:柵氧可靠性埋了大雷
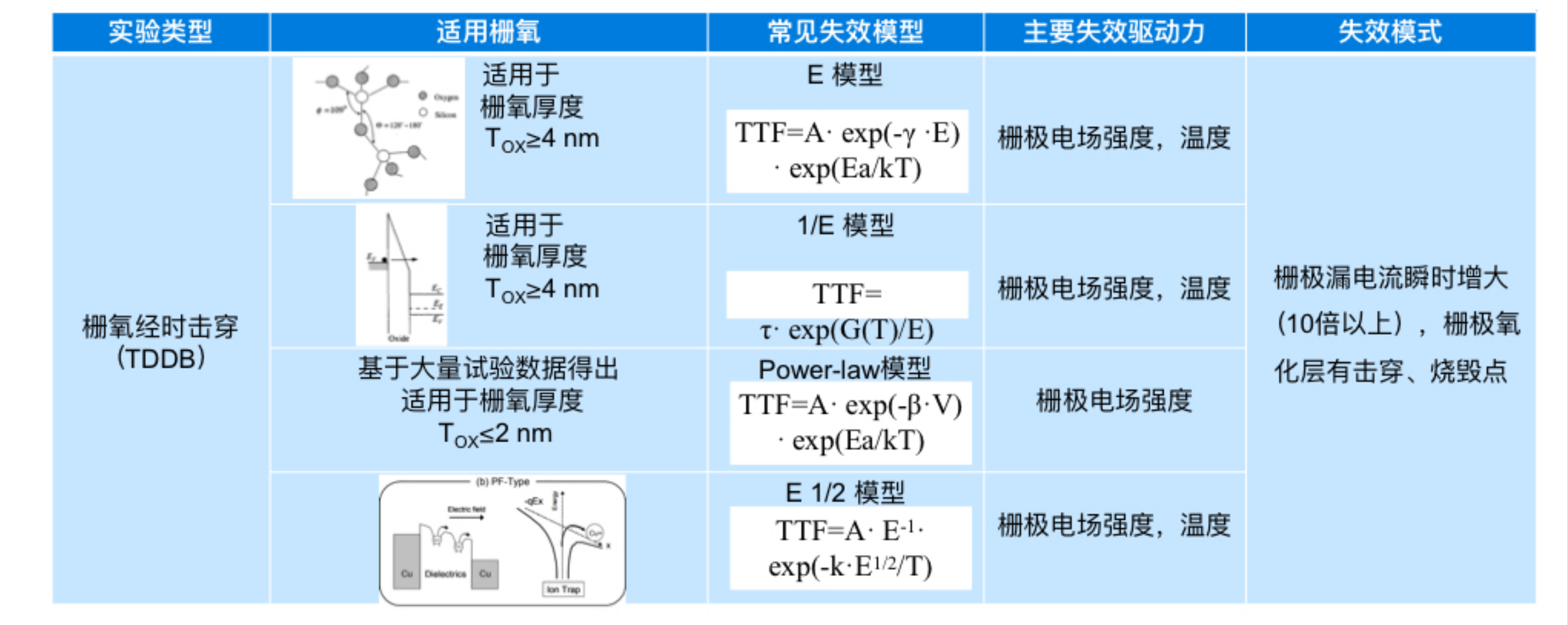





 做賊心虛:部分國產(chǎn)碳化硅MOSFET廠商“避談柵氧可靠性”的本質(zhì)
做賊心虛:部分國產(chǎn)碳化硅MOSFET廠商“避談柵氧可靠性”的本質(zhì)












評論