近期很多充電運(yùn)營(yíng)商反應(yīng)采用國(guó)產(chǎn)碳化硅MOSFET的工作僅僅一兩年的充電樁電源模塊故障頻率越用越高,結(jié)合常見碳化硅MOSFET的失效問(wèn)題,不難看出充電樁電源模塊中碳化硅MOSFET失效頻率越用越高罪魁禍?zhǔn)资遣糠謬?guó)產(chǎn)碳化硅MOSFET柵氧化層的可靠性埋了大雷:短期使用看不出問(wèn)題,長(zhǎng)期工作下來(lái)充電樁電源模塊失效率持續(xù)增加,尤其是在高溫環(huán)境下長(zhǎng)期服役的充電場(chǎng)景。
國(guó)產(chǎn)碳化硅MOSFET在充電樁電源模塊中隨著工作時(shí)間增加故障率升高的應(yīng)用痛點(diǎn),主要源于柵氧化層可靠性不足。以下為具體分析與解決方案:
國(guó)產(chǎn)碳化硅MOSFET在充電樁電源模塊中隨著工作時(shí)間增加失效率而增加原因分析
柵氧化層過(guò)薄
部分國(guó)產(chǎn)SiC碳化硅MOSFET廠商為降低比導(dǎo)通電阻(Rds(on)sp)和成本,在工藝條件受限的情況下,過(guò)度減薄柵氧化層厚度(如低于40nm)。根據(jù)TDDB實(shí)驗(yàn)數(shù)據(jù),薄柵氧在高電場(chǎng)下壽命顯著縮短(如103小時(shí)),導(dǎo)致長(zhǎng)期工作后易發(fā)生經(jīng)時(shí)擊穿(TDDB失效)。
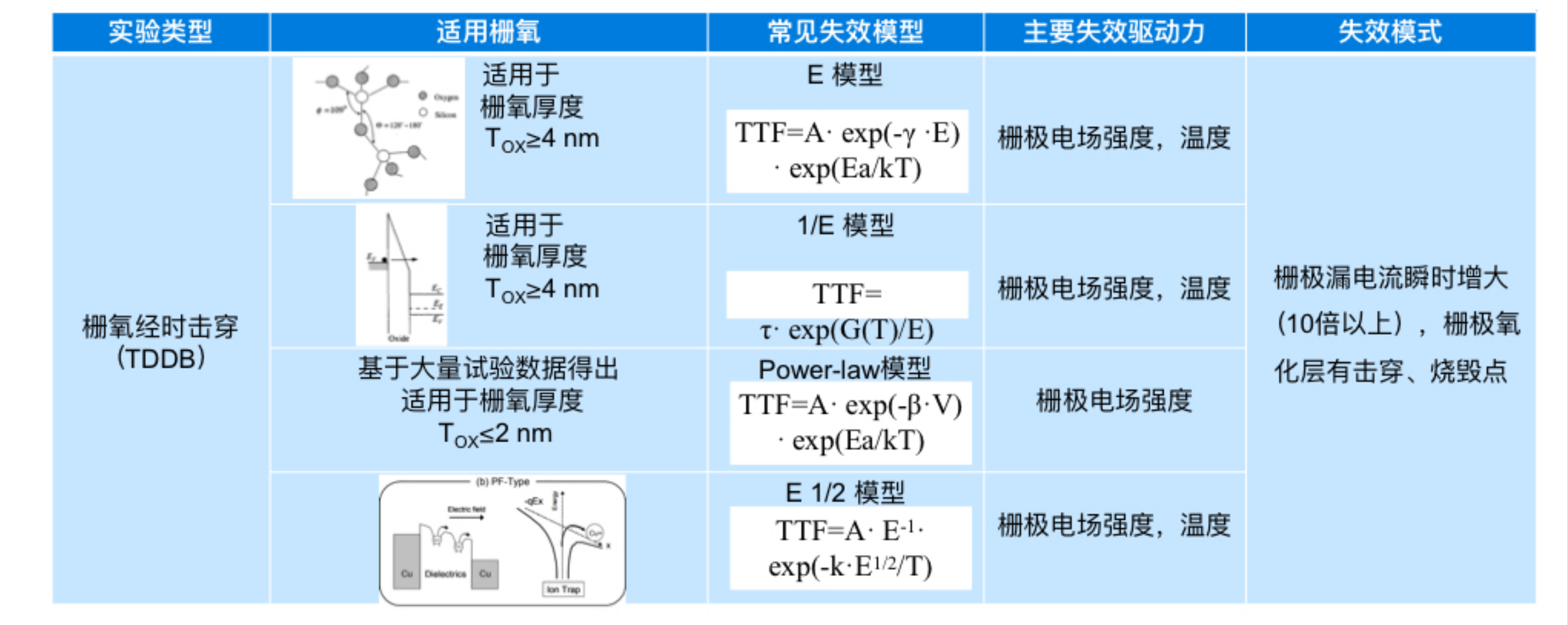
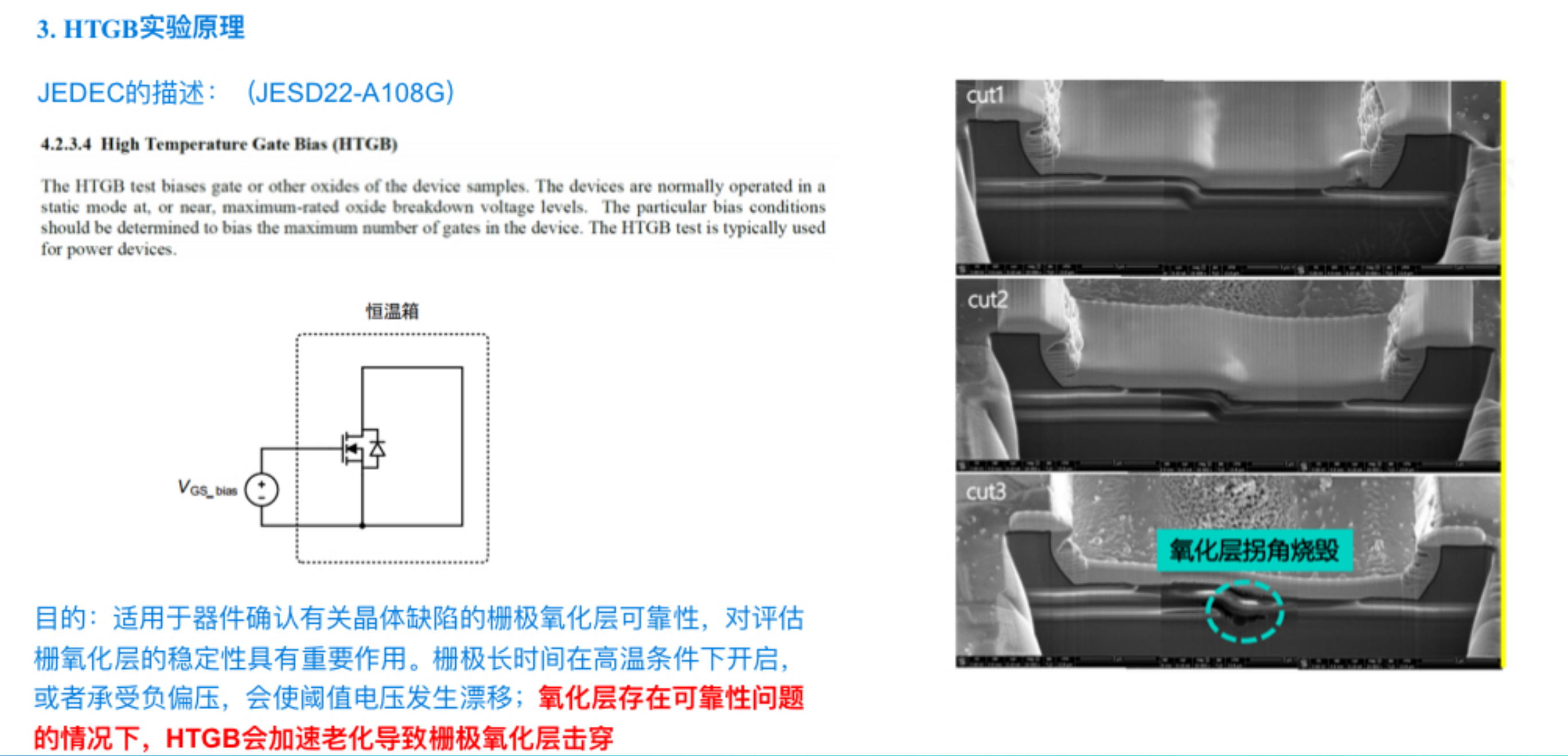
高溫高電場(chǎng)應(yīng)力
充電樁工作環(huán)境惡劣(高溫、高頻開關(guān)、高電壓),加速柵氧化層老化。若部分國(guó)產(chǎn)SiC碳化硅MOSFET器件未通過(guò)嚴(yán)格的HTGB(高溫柵偏)和TDDB測(cè)試,閾值電壓漂移(Vth shift)或氧化層擊穿風(fēng)險(xiǎn)大幅增加。
制造工藝缺陷
部分國(guó)產(chǎn)SiC碳化硅MOSFET柵氧生長(zhǎng)工藝不均勻或界面缺陷(如SiC/SiO?界面態(tài)密度高),在長(zhǎng)期應(yīng)力下缺陷積累,引發(fā)漏電流激增或局部擊穿。
解決方案
1. 國(guó)產(chǎn)碳化硅MOSFET器件設(shè)計(jì)與制造優(yōu)化
合理設(shè)計(jì)柵氧厚度
根據(jù)TDDB模型(如E模型或1/E模型),確保柵氧厚度以平衡導(dǎo)通電阻與可靠性,避免盲目追求低成本減薄。
改進(jìn)柵氧工藝
采用高質(zhì)量氧化層生長(zhǎng)技術(shù)(如熱氧化結(jié)合氮化退火),降低界面態(tài)密度,提升柵氧均勻性。
2. 強(qiáng)化國(guó)產(chǎn)碳化硅MOSFET可靠性測(cè)試
嚴(yán)格執(zhí)行HTGB與TDDB測(cè)試
參考JEDEC標(biāo)準(zhǔn)(如JESD22-A-108),在研發(fā)階段通過(guò)加速壽命實(shí)驗(yàn)(如175°C、22V HTGB 1000小時(shí))篩選可靠性不足的器件。
增加批次抽樣比例
對(duì)量產(chǎn)器件提高抽樣測(cè)試覆蓋率,確保每批次均滿足長(zhǎng)期可靠性要求(如TDDB壽命>10?小時(shí))。
3. 國(guó)產(chǎn)碳化硅MOSFET應(yīng)用端設(shè)計(jì)優(yōu)化
降額使用
實(shí)際應(yīng)用中,柵極電壓(Vgs)應(yīng)低于器件標(biāo)稱耐壓(如標(biāo)稱20V時(shí)限制在18V以下),并控制結(jié)溫(Tj≤175°C),延長(zhǎng)柵氧壽命。
優(yōu)化散熱設(shè)計(jì)
加強(qiáng)充電樁電源模塊散熱(如采用熱管或液冷),降低器件工作溫度,減緩碳化硅MOSFET柵氧化層熱退化。
4. 國(guó)產(chǎn)碳化硅MOSFET供應(yīng)鏈與失效分析
嚴(yán)選供應(yīng)商
優(yōu)先選擇通過(guò)AEC-Q101認(rèn)證的廠商,確保器件可靠性數(shù)據(jù)(如HTGB/TDDB報(bào)告)透明可追溯。
深度失效分析
對(duì)故障模塊進(jìn)行電鏡(SEM/TEM)和能譜分析(EDS),定位失效點(diǎn)是否為柵氧擊穿,針對(duì)性改進(jìn)工藝。
結(jié)論
國(guó)產(chǎn)碳化硅MOSFET的可靠性短板可通過(guò)設(shè)計(jì)優(yōu)化、工藝升級(jí)、嚴(yán)格測(cè)試及應(yīng)用端協(xié)同設(shè)計(jì)系統(tǒng)性解決。廠商需摒棄“犧牲可靠性換成本”的短視策略,而充電樁企業(yè)應(yīng)建立器件選型與可靠性驗(yàn)證體系,共同提升電源模塊的長(zhǎng)期穩(wěn)定性。
審核編輯 黃宇
-
MOSFET
+關(guān)注
關(guān)注
150文章
8593瀏覽量
220384 -
充電樁
+關(guān)注
關(guān)注
152文章
2728瀏覽量
86770
發(fā)布評(píng)論請(qǐng)先 登錄
為何必須通過(guò)TDDB(時(shí)間相關(guān)介質(zhì)擊穿)方法檢驗(yàn)國(guó)產(chǎn)SiC MOSFET的柵氧可靠性水平

老舊MPPT設(shè)計(jì)中+15V驅(qū)動(dòng)下的部分國(guó)產(chǎn)SiC碳化硅MOSFET柵氧爆雷隱患

B3M040120Z SiC MOSFET在充電樁中的應(yīng)用:低關(guān)斷損耗與高柵氧可靠性的技術(shù)優(yōu)勢(shì)
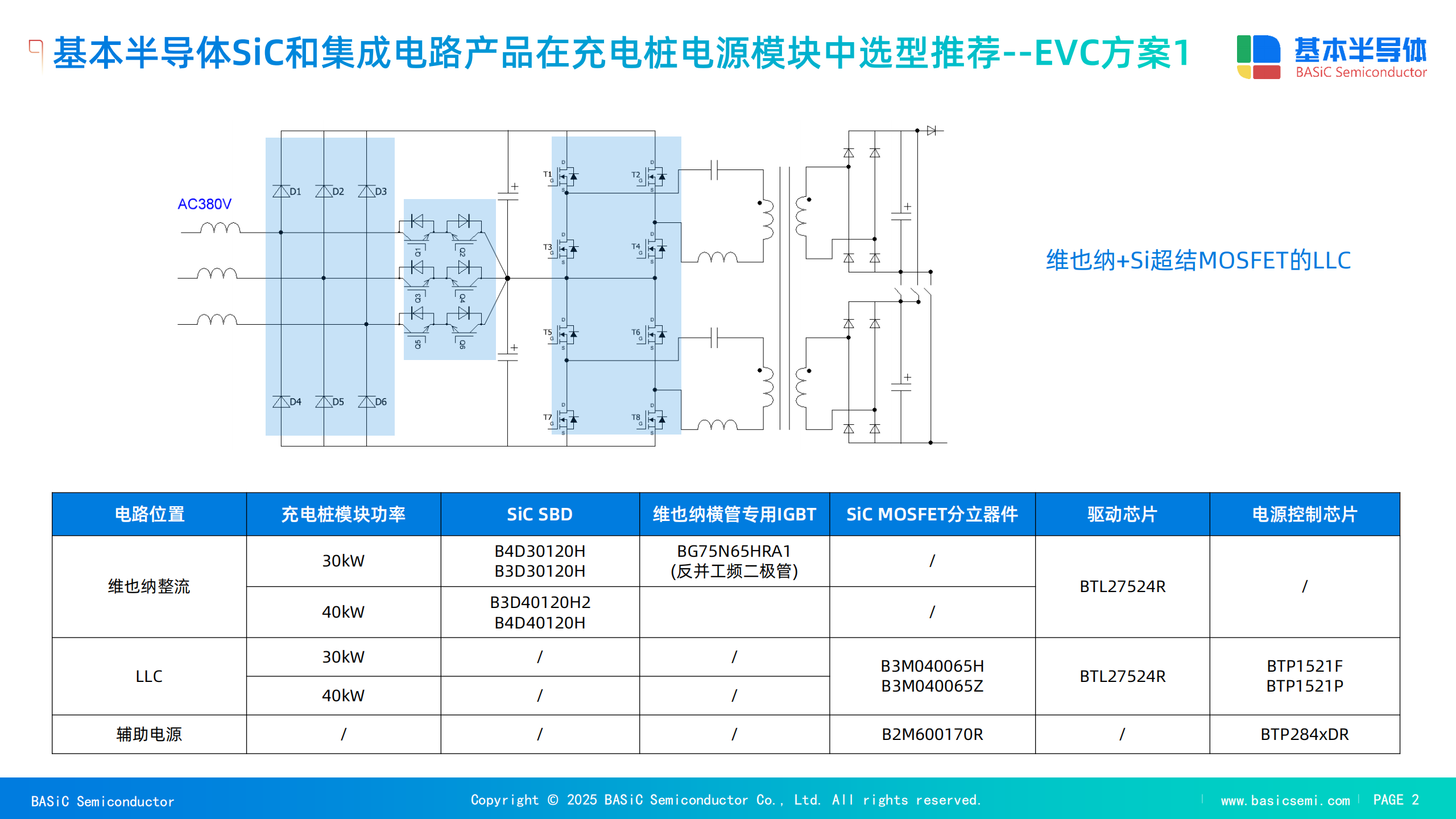
SiC碳化硅MOSFET驅(qū)動(dòng)電壓的限制源于柵氧可靠性與器件性能之間的權(quán)衡
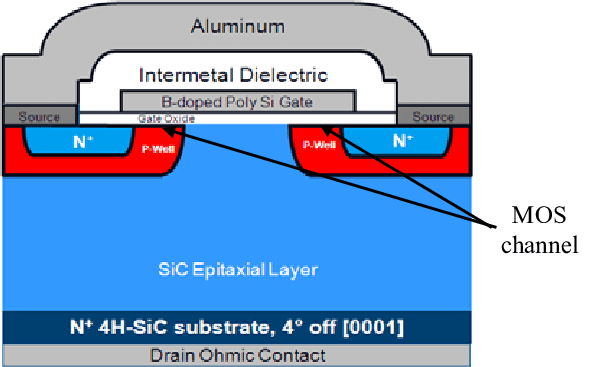
車載充電機(jī)(OBC)和熱泵空調(diào)等車載領(lǐng)域成為柵氧可靠性問(wèn)題的“爆雷重災(zāi)區(qū)”
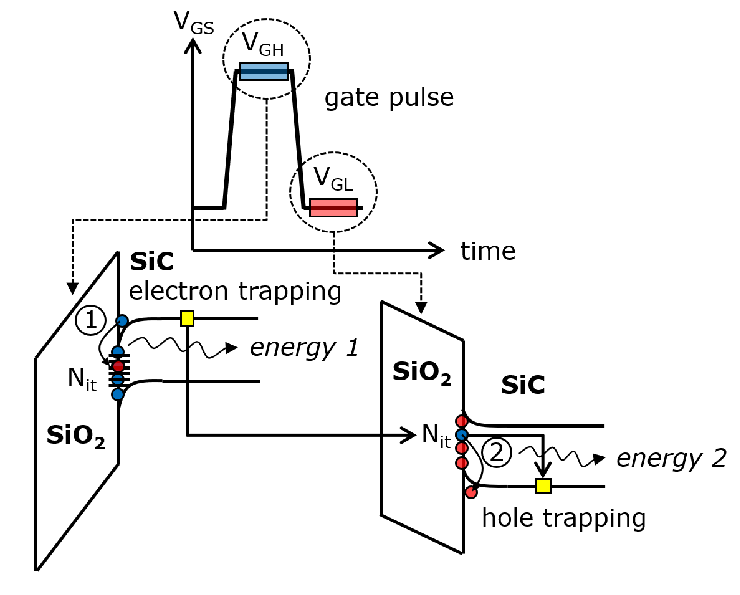
做賊心虛:部分國(guó)產(chǎn)碳化硅MOSFET廠商“避談柵氧可靠性”的本質(zhì)
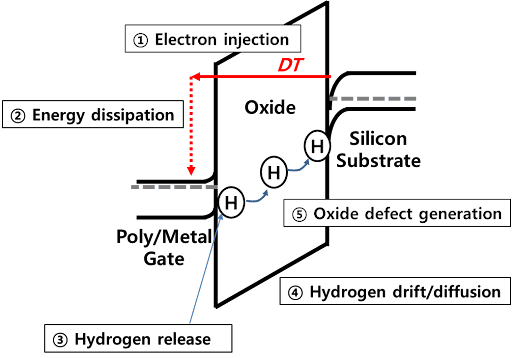
國(guó)產(chǎn)SiC碳化硅MOSFET廠商柵氧可靠性危機(jī)與破局分析

國(guó)產(chǎn)SiC碳化硅MOSFET廠商絕口不提柵氧可靠性的根本原因是什么
碳化硅(SiC)MOSFET的柵氧可靠性成為電力電子客戶應(yīng)用中的核心關(guān)切點(diǎn)
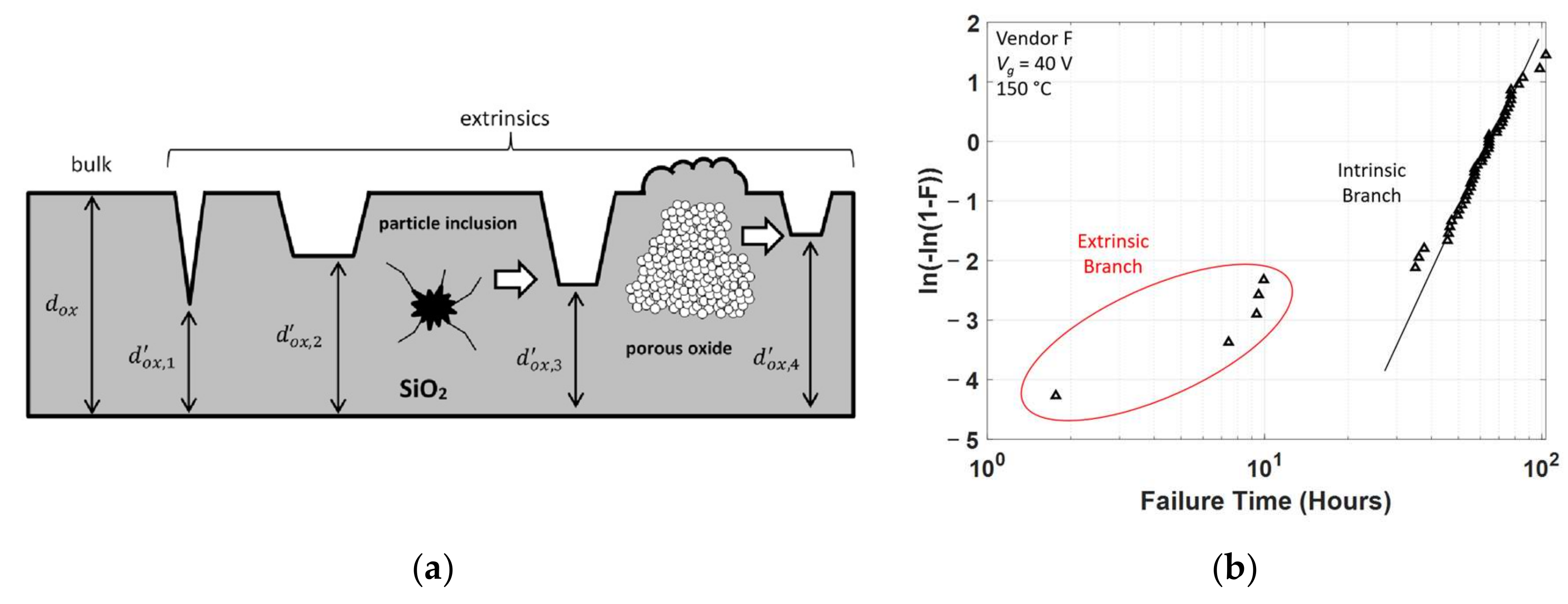
國(guó)產(chǎn)碳化硅MOSFET在OBC+DCDC及壁掛小直流樁中的應(yīng)用
國(guó)產(chǎn)碳化硅MOSFET“最低比導(dǎo)通電阻”宣傳噱頭背后隱藏的真相

40mR/650V SiC 碳化硅MOSFET,替代30mR 超結(jié)MOSFET或者20-30mR的GaN!
為何基本碳化硅MOSFET在充電樁電源單級(jí)拓?fù)鋵?shí)測(cè)效率高于進(jìn)口器件






 長(zhǎng)期工作的充電樁電源模塊中碳化硅MOSFET失效率越來(lái)越高的罪魁禍?zhǔn)祝簴叛蹩煽啃月窳舜罄?/h1>
長(zhǎng)期工作的充電樁電源模塊中碳化硅MOSFET失效率越來(lái)越高的罪魁禍?zhǔn)祝簴叛蹩煽啃月窳舜罄?/h1>













評(píng)論