在技術推動下,半導體領域不斷突破界限,實現(xiàn)人工智能(AI)、高性能計算(HPC)、5G/6G、自動駕駛、物聯(lián)網(IoT)等領域的變革性應用。
AI Server ASP比General Server高很多,2022~2027年AI服務器單元復合年增長率為73%,收入復合年增長率為39%.
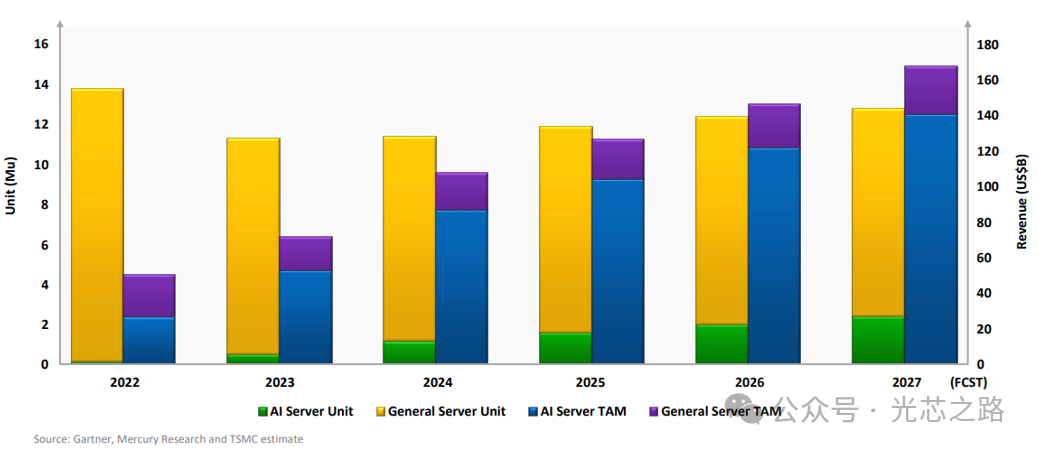
技術進步引發(fā)人工智能爆炸式增長,更多的計算,更高的內存帶寬,更大規(guī)模的異構集成。
先進的邏輯和封裝技術為人工智能加速器做出了關鍵貢獻,性能、內存帶寬和電源效率都不斷提升。
NVIDIA從V100升級到Blackwell,TSMC制程從N12到N4P,都是基于CoWoS封裝平臺,晶體管數(shù)量翻了近10倍,存儲帶寬容量翻了5倍,TFLOPS/W也越來越大。
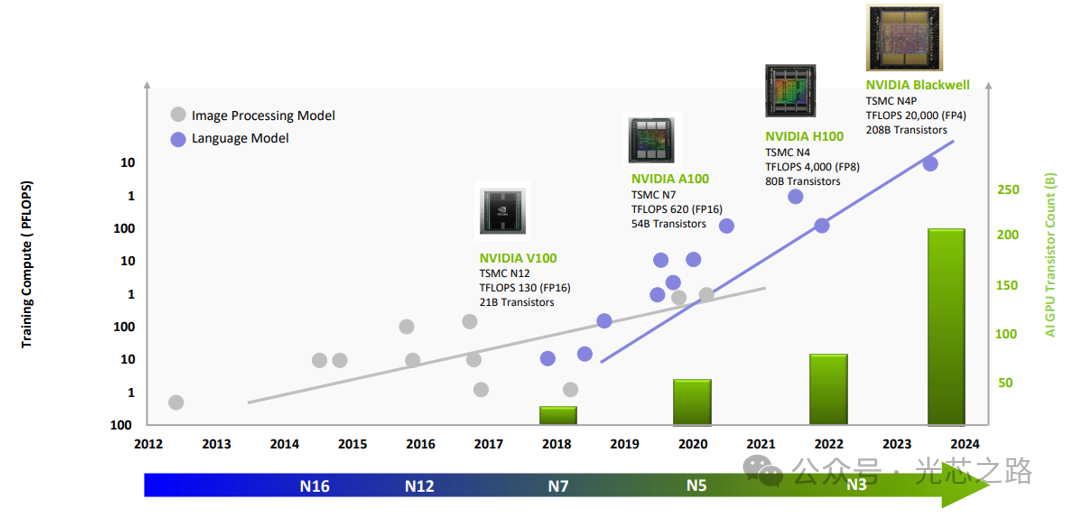
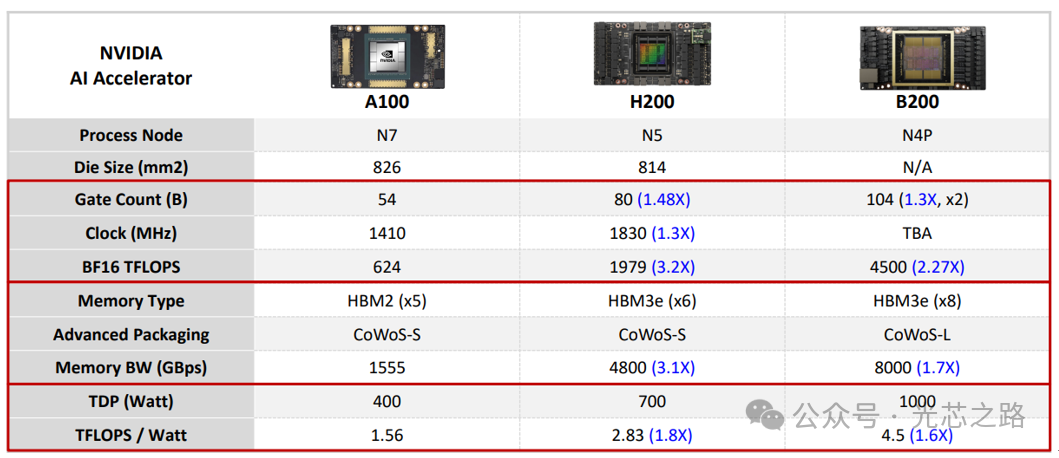
先進的邏輯和封裝技術在交換機產品做出了關鍵貢獻,SerDes性能、網絡帶寬和功耗方面不斷提升。
AI數(shù)據中心需要強大后端數(shù)據流來支持繁重并行GPU通信,需要更快數(shù)據速率和更低功耗的交換機解決方案。
Broadcom交換機容量已經發(fā)展到51.2T,基于N5的BCM78900的serdes雙向速率達到512*106G PAM4,雖然整體功耗為450W,但能耗0.88W/100G是降低的。
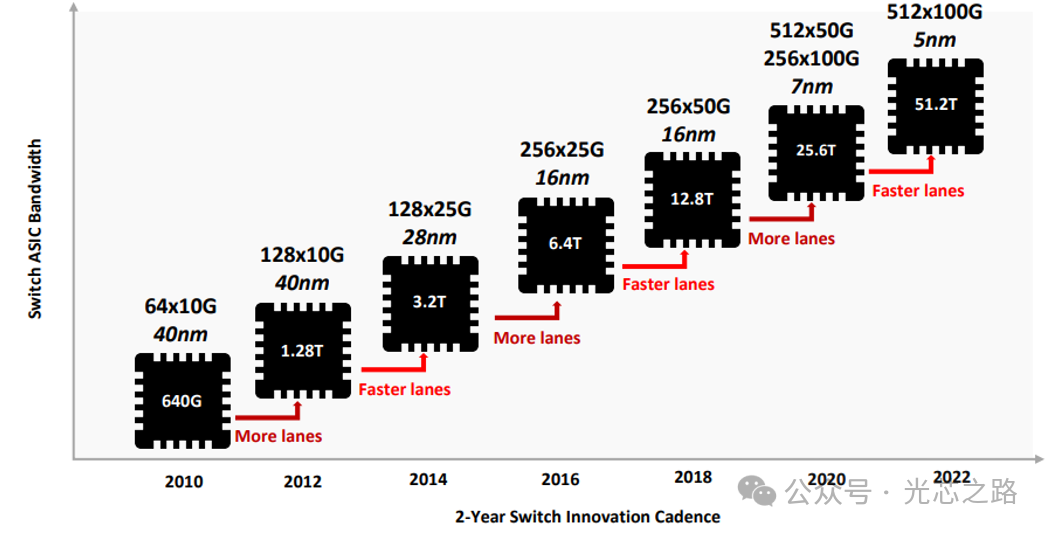
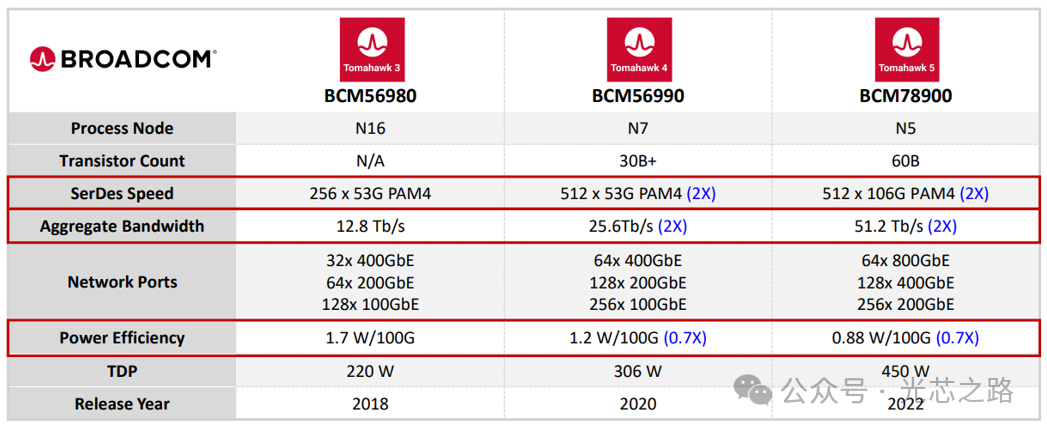
邏輯技術繼續(xù)穩(wěn)步發(fā)展,節(jié)點的減少意義重大,可以提高密度和能源效率。例如,7nm到5nm,可以增加1.83倍的邏輯密度和13%速率,同時能耗減少21%。如果進一步的,5nm到3nm,可以再次增加1.57倍的邏輯密度和11%速率,同時減少30% 能耗。

可以預見,如果把制程進一步減少,能獲得更大收益。7nm到3nm仍是基于FinFET。今天,業(yè)界繼續(xù)通過在3/2nm節(jié)點過渡到納米片場效應晶體管(NSFET)器件來縮放晶體管尺寸。為了最大限度地利用器件架構和光刻技術的進步,DTCO至關重要,DTCO不僅推動邏輯技術的性能、功率和面積(PPA),而且還被擴展到優(yōu)化系統(tǒng)級的性能和功率。
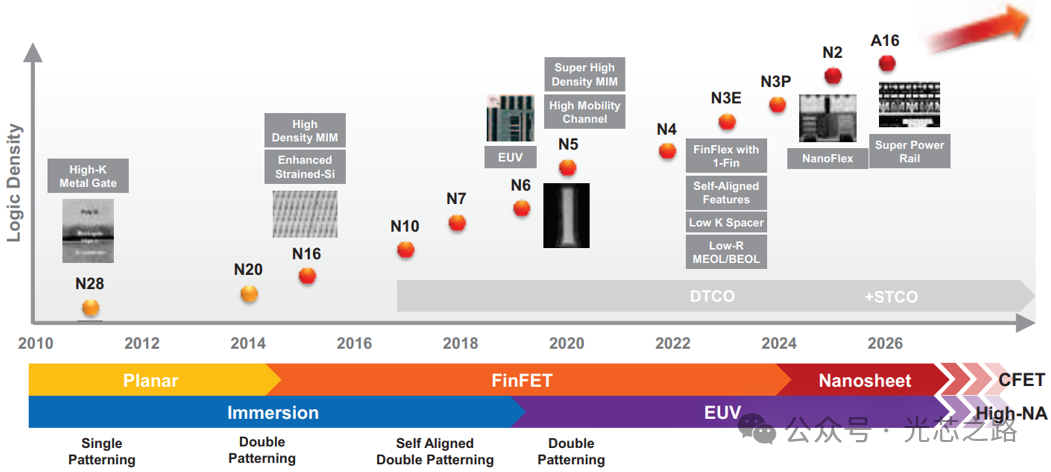
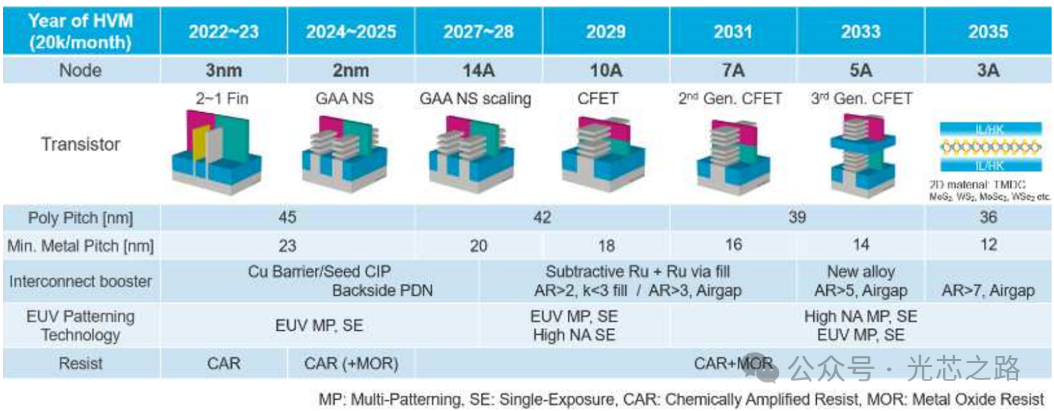
隨著FinFET技術和納米片架構的引入,互補場效應晶體管(CET)架構已經成為未來邏輯縮放的主要競爭者。雖然垂直堆疊的FET預計會增加工藝復雜性和制造成本,但它提供顯著的密度優(yōu)勢,與傳統(tǒng)CMOS結構相比,在相同柵極間距上,大約高1.5到2倍。
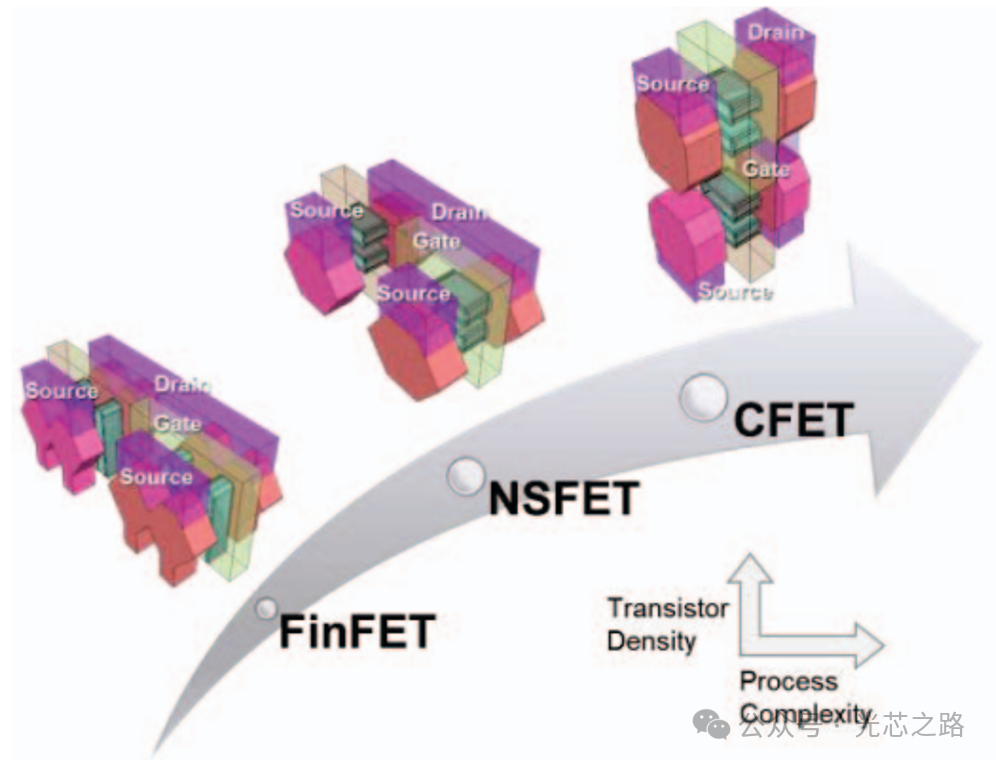
下圖展示最先進的CFET逆變器,具有業(yè)界領先的48nm柵極間距,強大的電壓轉移特性(VTC)響應VDD高達1.2 V。這標志著單片CFET技術的開創(chuàng)性突破,為推動未來邏輯技術擴展的工藝架構奠定基礎。

除了CEFET之外,對更高性能和更節(jié)能的邏輯技術的持續(xù)追求需要加速尋找超越硅基材料的通道材料。例如對于碳納米管來說,通過特定的摻雜技術可以實現(xiàn)與PMOS相當?shù)腘MOS性能,增強其高電流密度能力。
互聯(lián)創(chuàng)新是技術進步的另一個關鍵領域。下圖突出顯示該行業(yè)正在進行的幾個新開發(fā)。通過使用低電阻材料和先進界面工程,MOL電阻降低了40%。正在探索一種新的二維材料,作為銅互連的優(yōu)越替代品,這種材料在厚度減小的情況下,薄膜電阻率比銅低,提高整體性能。
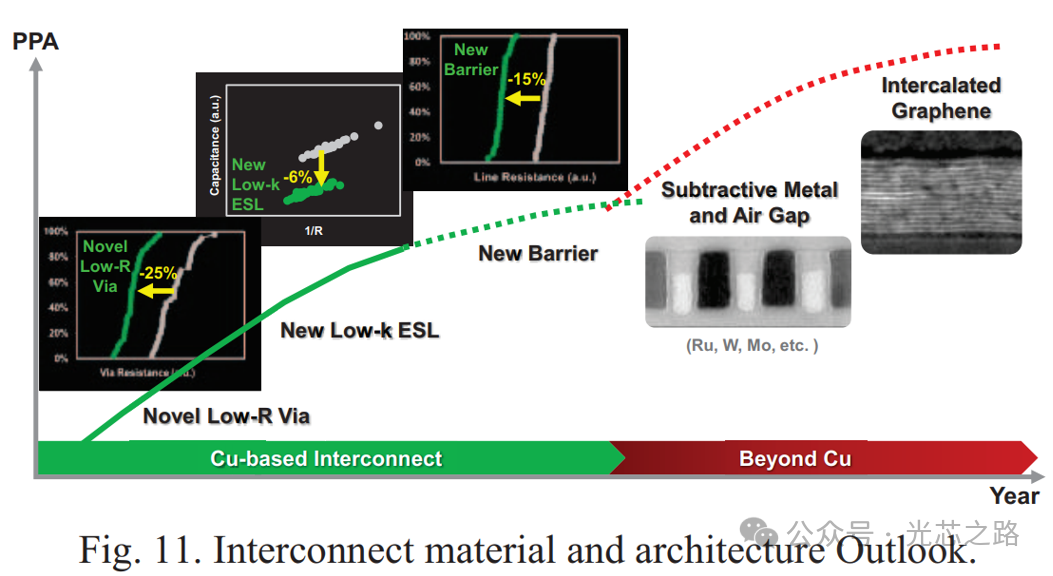
另一個關鍵技術是BEOL工藝和背面功率傳輸。
下圖展示最先進的2nm技術的橫截面,該技術具有納米片器件和背面功率傳輸。在晶圓的正面,納米片器件通過結構和DTCO創(chuàng)新提供出色的功率效率。BEOL工藝和材料的創(chuàng)新有助于將RC延遲減少10%,邏輯密度增加3%至4%。在晶圓的背面,直接與器件接觸可以保持柵極密度并保持器件寬度的靈活性。背面金屬化增強功率傳輸,通過將前端路由專用于信號路徑來提高芯片密度和性能。
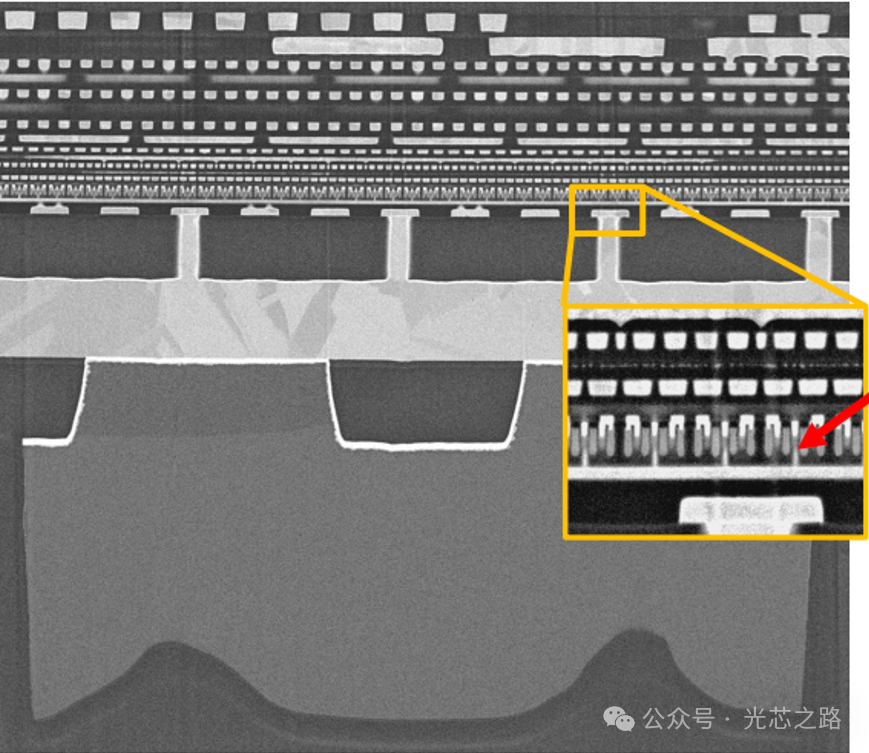
為了釋放異構集成的力量并將系統(tǒng)級性能提高十倍以上,3D堆疊和2.5D先進封裝技術已經相繼引入。TSMC提供CoWos先進2.5D封裝以及SOIC的3D芯片堆疊技術,以適應不同客戶需求。
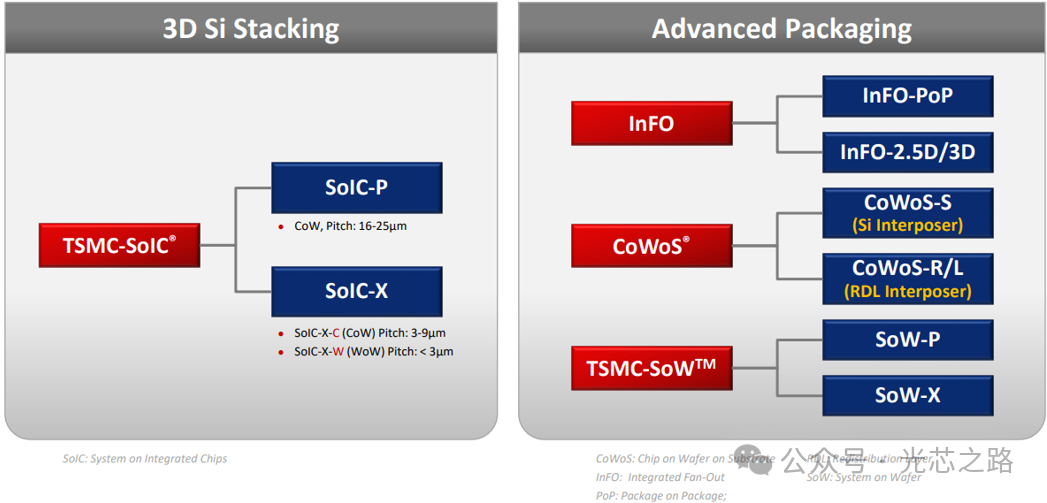
先進的硅堆疊和封裝技術,包括SoIC, InFO和CoWoS,繼續(xù)積極地縮小芯片到芯片的互連間距,提供將3D互連密度再提高六個數(shù)量級的潛力,這些高級集成功能可提高數(shù)據傳輸速率、減少延遲、優(yōu)化功耗并提高計算系統(tǒng)的整體性能。
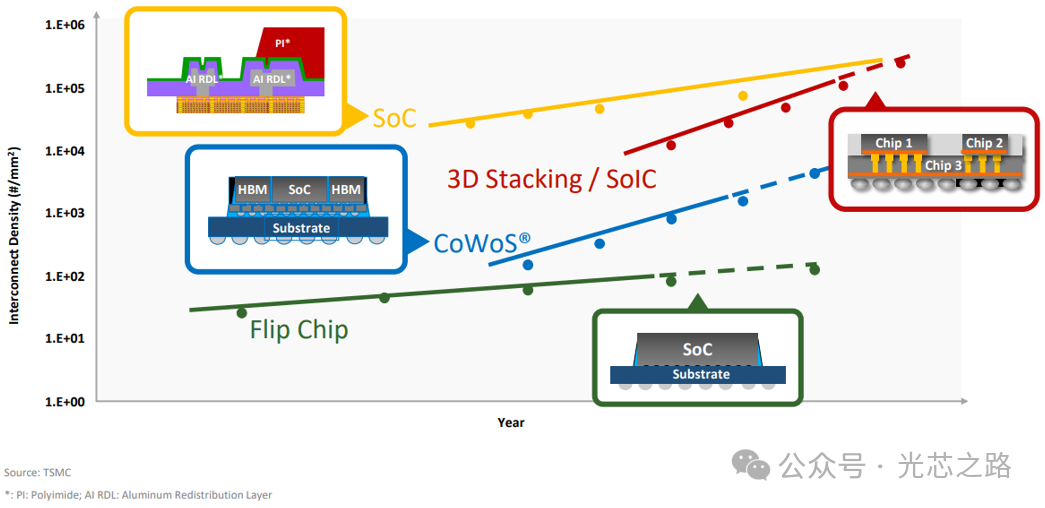
3D堆疊技術提供一個新的維度,可以幫助密度和能效縮放。首款基于3D堆疊技術的用于數(shù)據中心的CPU于2022年發(fā)布,AI GPU于2023年發(fā)布。未來TSMC基于SOIC-X技術,可將間距減少到3um,將D2D互聯(lián)達到100 million量級。
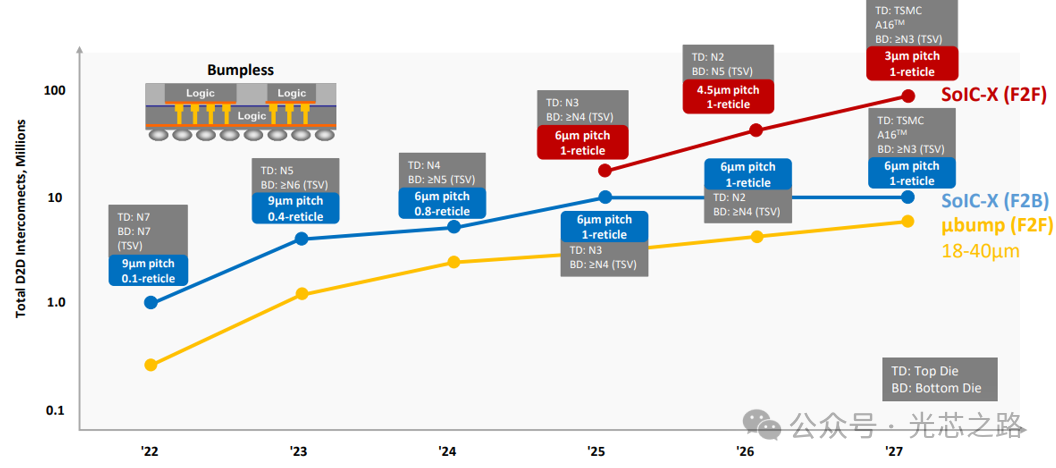
2.5D技術范圍正在迅速擴大,以滿足未來人工智能計算的集成需求。
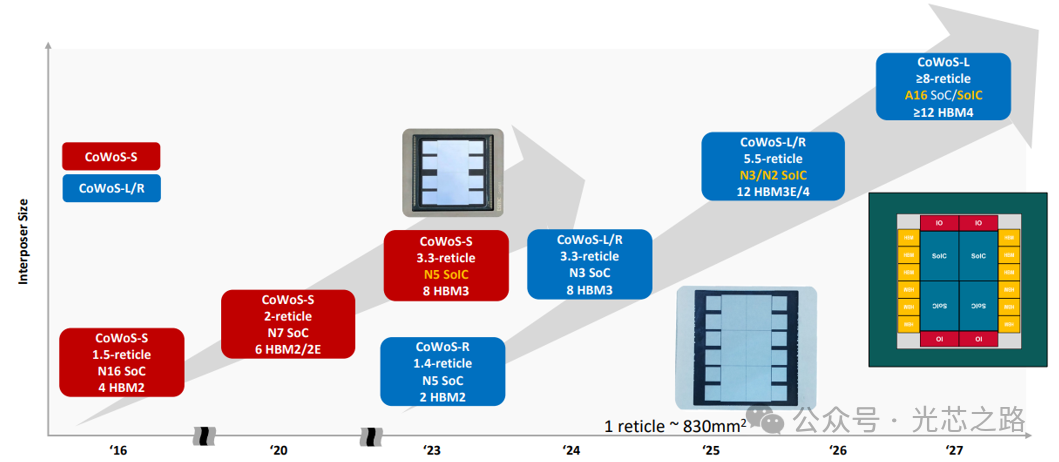
光收發(fā)器對于未來的人工智能系統(tǒng)至關重要,可以實現(xiàn)芯片之間高速、低能耗和可靠的數(shù)據傳輸。硅光為系統(tǒng)技術改變新的傳輸方式。緊湊型通用光子引擎(COUPE)技術采用創(chuàng)新的SoIC-X工藝無縫堆疊電子和光子芯片,顯著降低功耗和延遲。OE (Optical Engine)通過垂直堆疊,封裝密度高,在電路板、封裝和中介層相比在外形尺寸和功耗降低方面提供實質性好處.
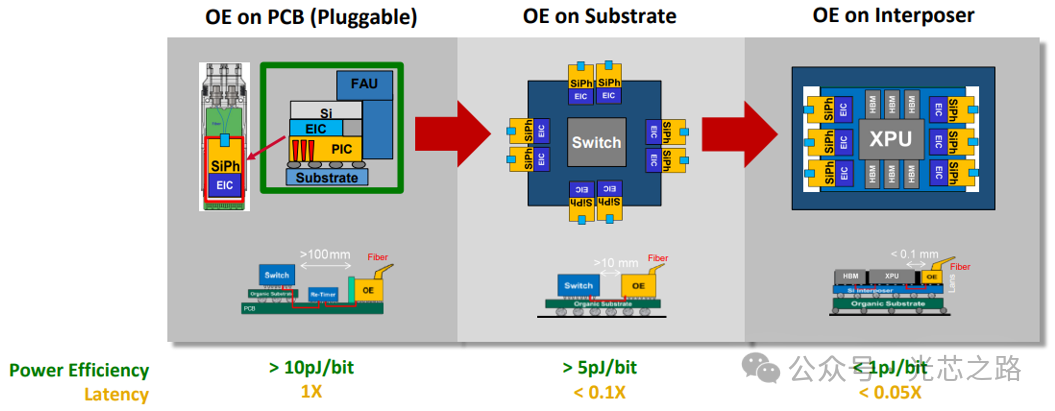
為簡化不同封裝結構和配置的3D IC設計,需要創(chuàng)建一個可以提供異構集成所需的全面覆蓋的技術平臺。該平臺包括先進邏輯技術,堆疊SoIC技術,集成嵌入式組件,連接到計算芯片和高性能存儲器的RDL中間體,以及硅光引擎,以提供足夠的I/O帶寬以滿足計算需求。
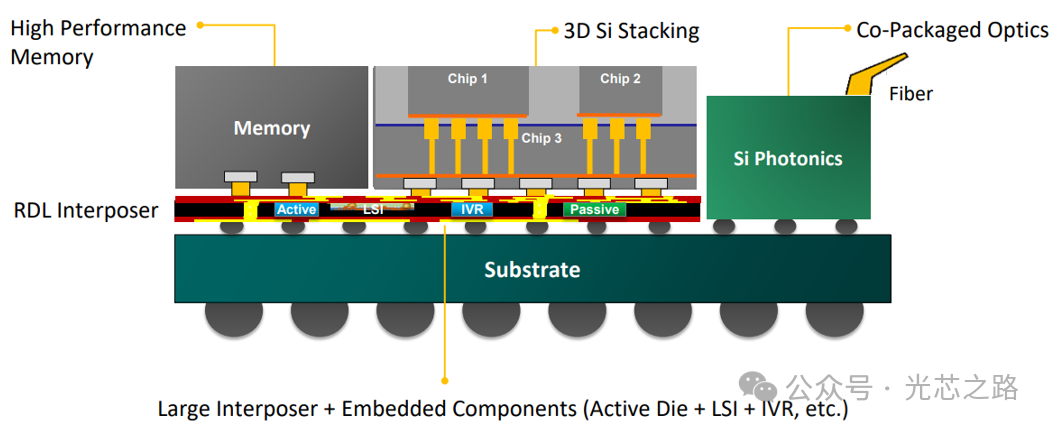
硅光技術將無源和有源光子器件集成到單個芯片中,包括光柵耦合器、調制器、波導和鍺(Ge)光電二極管等組件,但激光源除外。TSMC的硅光利用先進的12英寸工藝技術,提供卓越的工藝能力和可控性。為客戶能夠設計單芯片光學引擎(OE)。

總之,在人工智能的推動下,到2030年半導體產業(yè)規(guī)模將達到1萬億美元,人工智能對數(shù)據中心、邊緣設備、汽車和物聯(lián)網產品具有變革性影響。邏輯、內存和封裝技術的進步,為滿足人工智能驅動的需求,繪制一條持續(xù)密度和能效擴展的道路。
參考文獻
【1】SemiconductorIndustry Outlook and New Technology Frontiers Yuh-Jier Mii Taiwan SemiconductorManufacturing Company, Hsinchu, Taiwan. Contact email: [email protected]
-
半導體
+關注
關注
335文章
28599瀏覽量
232518 -
場效應晶體管
+關注
關注
6文章
394瀏覽量
19915 -
人工智能
+關注
關注
1804文章
48703瀏覽量
246468
原文標題:IEDM2024:TSMC關于未來整體半導體產業(yè)分析
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發(fā)布評論請先 登錄
砥礪創(chuàng)新 芯耀未來——武漢芯源半導體榮膺21ic電子網2024年度“創(chuàng)新驅動獎”
北京市最值得去的十家半導體芯片公司
IEDM 2024先進工藝探討(三):2D材料技術的進展及所遇挑戰(zhàn)
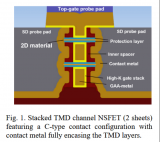
韓國半導體出口動態(tài):2024年對華出口下滑,對臺越出口增長
逐點半導體熊挺:AI技術賦能視覺處理,空間視頻未來可期

TI視角下的科技前沿:半導體產業(yè)新動向
英特爾代工在IEDM 2024展示多項技術突破
芯和半導體邀您相約ICCAD-Expo 2024
行芯受邀出席2024求是緣半導體產業(yè)峰會
造物數(shù)科數(shù)智成果亮相2024電子半導體產業(yè)創(chuàng)新發(fā)展大會

興森科技亮相2024電子半導體產業(yè)創(chuàng)新發(fā)展大會
第六屆意法半導體工業(yè)峰會2024
【ISES China 2024精彩回顧】半導體精英齊聚,共促產業(yè)創(chuàng)新發(fā)展

筑強半導體產業(yè)鏈,利爾達倡議成立未來科技城科創(chuàng)聯(lián)盟半導體專委會






 IEDM2024:TSMC關于未來整體半導體產業(yè)分析
IEDM2024:TSMC關于未來整體半導體產業(yè)分析










評論