HBM 對(duì)半導(dǎo)體產(chǎn)業(yè)鏈的影響1. HBM 的核心工藝在于硅通孔技術(shù)(TSV)和堆疊鍵合技術(shù) 硅通孔:TSV(Through-Silicon Via) 是一種能讓 3D 封裝遵循摩爾定律演進(jìn)的互連技術(shù),芯片與芯片之間(Chip to Chip)、芯片與晶圓之間(Chip to Wafer)、晶圓與晶圓之間(Wafer to Wafer)實(shí)現(xiàn)完全穿孔的垂直電氣連接,可像三明治一樣堆疊晶片。
這些垂直連接可用于互連多個(gè)芯片、存儲(chǔ)器、傳感器和其他模塊,硅通孔互連賦予了各種 2.5D/3D封裝應(yīng)用和架構(gòu)芯片縱向維度的集成能力,以最低的能耗/性能指標(biāo)提供極高的性能和功能,以打造更小更快更節(jié)能的設(shè)備。
通過(guò)更薄的硅芯片縮短互連長(zhǎng)度和短垂直連接,有助于減少芯片的整體面積和功耗、將信號(hào)傳播延遲減少幾個(gè)數(shù)量級(jí)。
同時(shí)可以實(shí)現(xiàn)異構(gòu)集成,將來(lái)自不同技術(shù)和制造商的多個(gè)芯片組合到一個(gè)封裝中,從而使它們能夠提供更好的功能和性能。這使其非常適合用于不同的高速應(yīng)用,如數(shù)據(jù)中心、服務(wù)器、圖形處理單元 (GPU)、基于人工智能 (AI) 的處理器和多種無(wú)線通信設(shè)備。
HBM 通過(guò) SIP 和 TSV 技術(shù)將數(shù)個(gè) DRAM 裸片像樓層一樣垂直堆疊,在 DRAM 芯片打上數(shù)千個(gè) 細(xì)微的孔,并通過(guò)垂直貫通的電極連接上下芯片的技術(shù),可顯著提升數(shù)據(jù)傳輸速度,適用于高存儲(chǔ)器帶寬需求,成為當(dāng)前 AI GPU 存儲(chǔ)單元的理想方案和關(guān)鍵部件。

HBM 通過(guò) TSV 技術(shù)內(nèi)部連接情況

英偉達(dá) A100 SEM 掃描圖 堆疊鍵合技術(shù):在 HBM 產(chǎn)品開(kāi)發(fā)之初,HBM 主要采用“TSV+Bumping”+TCB 鍵合方式堆疊(TSV 一般由晶圓廠完成,封測(cè)廠可在堆疊環(huán)節(jié)進(jìn)行配套)。其中,熱壓鍵合主要用于創(chuàng)建原子級(jí)金屬鍵合,它利用力和熱量來(lái)促進(jìn)原子在晶格之間遷移,從而形成清潔、高導(dǎo)電性和堅(jiān)固的鍵合。
通常,TCB 被用于垂直集成器件的 CMOS 工藝、金引線和表面之間固態(tài)鍵合的順應(yīng)鍵合(compliant bonding)、用于將芯片凸塊鍵合到基板的倒裝芯片應(yīng)用以及用于連接微型組件的熱壓鍵合。隨著層數(shù)變高,晶片會(huì)出現(xiàn)翹曲和發(fā)熱等因素,但又要滿足 HBM 芯片的標(biāo)準(zhǔn)厚度——720 微米(μm),這就對(duì)封裝工藝提出較高要求。
三星采用TC-NCF焊接法,在DRAM之間夾上一層不導(dǎo)電的粘合劑薄膜 (NCF),然后進(jìn)行熱壓,但隨著堆疊層數(shù)的增加散熱效率很差,TCB 不再滿足需求,但 TCB 技術(shù)仍有著一定的優(yōu)勢(shì),如其解決了標(biāo)準(zhǔn)倒裝芯片的基板翹曲問(wèn)題。同時(shí),這種鍵合方式確保均勻粘合,沒(méi)有間隙變化或傾斜;而且這種粘合幾乎沒(méi)有空隙,也沒(méi)有污染。
海力士從 HBM2e 開(kāi)始放棄了 TC-NCF 工藝,改用批量回流模制底部填充(MR-MUF)工藝,即芯片之間用液態(tài)環(huán)氧模塑料作為填充材料,導(dǎo)熱率比TC-NCF中的導(dǎo)熱率高出2倍左右,實(shí)現(xiàn)了更低的鍵合應(yīng)力和更優(yōu)的散熱性能,這無(wú)論對(duì)于工藝速度,還是良率等都有很大影響。預(yù)計(jì)海力士 HBM3e 將采用改進(jìn)的 MR-MUF 工藝,進(jìn)一步降低鍵合應(yīng)力,提升散熱性能, 增加堆疊層數(shù)。

SK 海力士 MR-MUF 技術(shù)

MR-MUF 比 NCF 導(dǎo)熱率高出 2 倍左右 然而,無(wú)論是 TCB 技術(shù)還是 MR-MUF 工藝均存在著一定的局限性,難以實(shí)現(xiàn)更小的間距,行業(yè)內(nèi)在嘗試用混合鍵合技術(shù)。混合鍵合互連方案,是指在一個(gè)鍵合步驟中同時(shí)鍵合電介質(zhì)(dielectric)和金屬鍵合焊盤(metal bond pads),可以顯著降低整體封裝厚度,在多芯片堆疊封裝中甚至可能高達(dá)數(shù)百微米。但混合鍵合對(duì)環(huán)境要求非常高,要達(dá)到 class1clean room(非常的清潔),這對(duì)廠商帶來(lái)較大的挑戰(zhàn)。
隨著 HBM 歷次迭代,HBM 中的DRAM 數(shù)量也同步提升,堆疊于 HBM2 中的 DRAM 數(shù)量為 4-8 個(gè),HBM3/3E 則增加到8-12 個(gè),HBM4 中堆疊的 DRAM 數(shù)量將增加到 16 個(gè)。
如 2024 年 4 月 7 日,三星電子先進(jìn)封裝團(tuán)隊(duì)高管 Dae Woo Kim 在 2024 年度韓國(guó)微電子與封裝學(xué)會(huì)年會(huì)上表示,三星電子成功制造了基于混合鍵合技術(shù)的 16 層堆疊 HBM3 內(nèi)存, 該內(nèi)存樣品工作正常,未來(lái) 16 層堆疊混合鍵合技術(shù)將用于 HBM4 內(nèi)存量產(chǎn)。

三星 HBM4 預(yù)計(jì)采用混合鍵合技術(shù) 2 HBM 對(duì)散熱材料 EMC 提出分散性和散熱性要求HBM 對(duì) EMC 提出分散性和散熱性要求,EMC和填料價(jià)值量大幅提升。環(huán)氧塑封料(EMC,Epoxy Molding Compound),是一種常見(jiàn)的半導(dǎo)體封裝外殼材料,也是半導(dǎo)體封裝中主要的包封材料,EMC 中主要組分來(lái)自填料,其中調(diào)料主要用于降低膨脹系數(shù)和內(nèi)應(yīng)力、提高散熱性能。 HBM 獨(dú)特的疊構(gòu)形態(tài)使得外圍用于塑封的 EMC 及內(nèi)部填料也需要相應(yīng)的升級(jí),具體邏輯在于: 1) HBM 采用芯片垂直疊構(gòu)的框架,使得塑封的高度顯著高于傳統(tǒng)單芯片的塑封高度,較高的高度要求外圍塑封料要有充分的分散性,則 EMC 就要從傳統(tǒng)注塑餅狀變?yōu)槿龇垲w粒狀的顆粒狀環(huán)氧塑封料(GMC,Granular Molding Compound)和液態(tài)塑封料(LMC,Liquid Molding Compound),對(duì)于 EMC 廠商,這樣的升級(jí)需要在配方中同時(shí)兼顧分散性和絕緣性,配方難度較大。

HBM 對(duì) EMC 性能提出新要求,所用填料也需要改變 2) 由于 1 顆 HBM 中將搭載 4-8 層甚至更多層的存儲(chǔ)芯片,單顆 HBM 中所涉及到的數(shù)據(jù)存 儲(chǔ)和數(shù)據(jù)運(yùn)輸量較大,將帶來(lái)發(fā)熱量大的問(wèn)題,散熱方案的優(yōu)劣將決定整顆 HBM 性能, 因此HBM的EMC中將開(kāi)始大量使用low α球鋁和球硅來(lái)保證快速散熱和控制熱膨脹問(wèn)題。
當(dāng)前運(yùn)用 TSV 技術(shù)的場(chǎng)景主要在 2.5D 硅中階層和 3D 垂直疊構(gòu),其中 3D TSV 的特點(diǎn) 在于通過(guò)垂直疊構(gòu)的方式縮短了芯片間通信距離,相較于傳統(tǒng)水平排布的方式,外圍用于塑封的 EMC 及內(nèi)部填料料也需要相應(yīng)的升級(jí)。
一方面垂直疊構(gòu)導(dǎo)致塑封的高度顯著高于傳統(tǒng)單芯片的塑封高度,較高的高度要求外圍塑封料要有充分的分散性,則EMC就要從傳統(tǒng)注塑餅狀變?yōu)槿龇垲w粒狀的顆粒狀環(huán)氧塑封料(GMC,GranularMolding Compound)和液態(tài)塑封料(LMC,Liquid Molding Compound),對(duì)于 EMC 廠商,這樣的升級(jí)需要在配方中同時(shí)兼顧分散性和絕緣性,配方難度較大。

HBM 封裝需要用到 GMC 和 LMC 兩類偏高端的 EMC
另一方面采用 TSV 方式連接的芯片需要一起塑封,則單個(gè)塑封體中的運(yùn)算量急劇上升,從而帶來(lái)較大的發(fā)熱問(wèn)題,需要大量使用low α球鋁和球硅來(lái)保證快速散熱和控制熱膨脹問(wèn)題。
以 HBM 為例,1 顆 HBM 中將搭載4-8 顆甚至更多芯片,封裝高度高且存儲(chǔ)帶寬大,需要用添加 low α球硅/球鋁的GMC/LMC 來(lái)做塑封外殼。
-
芯片
+關(guān)注
關(guān)注
459文章
52169瀏覽量
436100 -
DRAM
+關(guān)注
關(guān)注
40文章
2342瀏覽量
185166 -
HBM
+關(guān)注
關(guān)注
1文章
407瀏覽量
15104
原文標(biāo)題:AI時(shí)代核心存力 HBM(中)
文章出處:【微信號(hào):閃德半導(dǎo)體,微信公眾號(hào):閃德半導(dǎo)體】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
HBM4到來(lái)前夕,HBM熱出現(xiàn)兩極分化
算力即國(guó)力,比克電池如何為AI時(shí)代“蓄能

適用于數(shù)據(jù)中心和AI時(shí)代的800G網(wǎng)絡(luò)
DeepSeek推動(dòng)AI算力需求:800G光模塊的關(guān)鍵作用
當(dāng)我問(wèn)DeepSeek AI爆發(fā)時(shí)代的FPGA是否重要?答案是......
AI算力:智能時(shí)代的核心驅(qū)動(dòng)力

AI興起推動(dòng)HBM需求激增,DRAM市場(chǎng)面臨重塑
AI時(shí)代核心存力HBM(上)
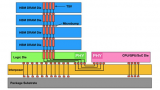





 AI時(shí)代核心存力HBM(中)
AI時(shí)代核心存力HBM(中)










評(píng)論