ASML再度宣布新光刻機計劃。據報道,ASML預計2030年推出的Hyper-NA極紫外光機(EUV),將縮小最高電晶體密度芯片的設計限制。
ASML前總裁Martinvan den Brink宣布,約在2030年將提供新的Hyper-NA EUV技術。目前仍處于開發初期階段的Hyper-NA將遵循High-NA系統,ASML今年初在英特爾奧勒岡廠首度安裝High-NA系統。
報導,van den Brink上月在比利時舉行的imecITF World演說指出,“長遠而言,我們必須改善我們的光源系統,而且我們也必須采用Hyper-NA。與此同時,我們必須使我們所有系統的生產率提高到每小時400至500片晶圓”。
高數值孔徑(High-NA)是將數值孔徑(NA)從早期EUV工具的0.33 NA提高到0.55 NA。約三年前,ASML稱,高數值孔徑將協助芯片制造商在至少10年內達到2nm以下制程節點。現在ASML表示,約在2030年該公司將提供Hyper-NA,達到0.75 NA。意味著或許可以支持到2埃米(0.2nm)以下的制程節點。
不過,ASML也澄清,這是van den Brink關于Hyper-NA的愿景,目前該公司仍在進行可行性研究。根據imec高級圖案化項目總監Kurt Ronse的說法,這是ASML首度將Hyper-NA納入其路線圖。他與ASML合作開發曝光機超過30年。
Kurt Ronse表示,“現在有許多研究要進行,我們能否提高超越0.55至0.75、0.85?Hyper-NA肯定會帶來一些新挑戰”。
聲明:本網站部分文章轉載自網絡,轉發僅為更大范圍傳播。 轉載文章版權歸原作者所有,如有異議,請聯系我們修改或刪除。
審核編輯 黃宇
-
光刻機
+關注
關注
31文章
1163瀏覽量
48030 -
EUV
+關注
關注
8文章
609瀏覽量
86860 -
ASML
+關注
關注
7文章
723瀏覽量
41992
發布評論請先 登錄
光刻機巨頭ASML業績暴雷,芯片迎來新一輪“寒流”?
組成光刻機的各個分系統介紹
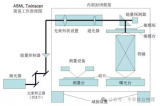
用來提高光刻機分辨率的浸潤式光刻技術介紹






 ASML擬于2030年推出Hyper-NA EUV光刻機,將芯片密度限制再縮小
ASML擬于2030年推出Hyper-NA EUV光刻機,將芯片密度限制再縮小


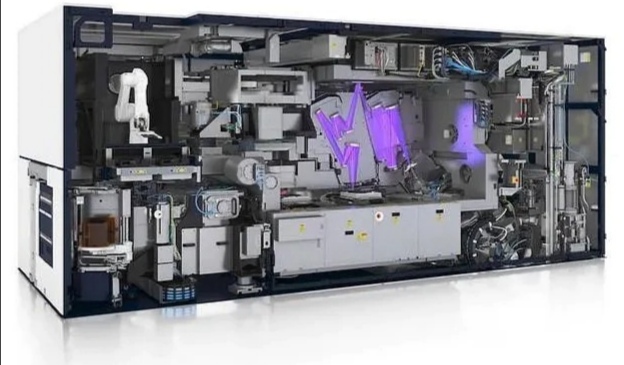











評論