近期,臺積電將其高性能計算與 AI 芯片封裝技術亮相于國際固態電路大會(簡稱 ISSCC 2024),據悉,此技術有望將芯片晶體管數目由現有的1000億級躍升至1萬億級。
臺積電高級研發副總裁張曉強指出,本項新技術主要針對AI芯片性能增強。新型HBM高帶寬存儲器與Chiplet架構小芯片的引入需求大量組件及IC基板,由此引發的連通性及能源消耗等問題難免產生。他特別強調,借助硅光科技與光纖替代傳統I/O電路,實現高效率的數據傳輸;此外,通過異質芯片堆疊和混合鍵合,最大限度優化I/O。值得注意的是,這項封裝技術將運用集成穩壓器應對供電問題,但具體商用時間尚未透露。
臺積電透露,當前全球前沿芯片最多可容納1000億晶體管,然而新的封裝平臺能使之增加到1萬億級別。盡管該封裝內將搭載集成穩壓器解決供電問題,但未來商業化仍待進一步確認。此外,張曉強還暗示臺積電的3nm制程技術很可能迅速應用于汽車領域。
-
存儲器
+關注
關注
38文章
7651瀏覽量
167373 -
AI芯片
+關注
關注
17文章
1983瀏覽量
35908 -
chiplet
+關注
關注
6文章
459瀏覽量
12996
發布評論請先 登錄
美國芯片“卡脖子”真相:臺積電美廠芯片竟要運回臺灣封裝?
下一代高速芯片晶體管解制造問題解決了!
臺積電超大版CoWoS封裝技術:重塑高性能計算與AI芯片架構
臺積電2納米制程技術細節公布:性能功耗雙提升
臺積電2nm制成細節公布:性能提升15%,功耗降低35%
臺積電分享 2nm 工藝深入細節:功耗降低 35% 或性能提升15%!
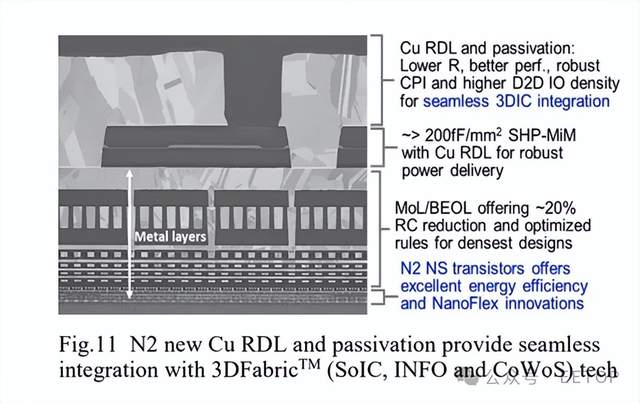





 臺積電創新推出萬億晶體管封裝平臺,專注于高性能計算和AI芯片應用
臺積電創新推出萬億晶體管封裝平臺,專注于高性能計算和AI芯片應用













評論