文章來源:芯云知
原文作者:Crane
本文介紹了干法刻蝕用到的設(shè)備的原理及結(jié)構(gòu)。
干法刻蝕技術(shù)是一種在大氣或真空條件下進行的刻蝕過程,通常使用氣體中的離子或化學(xué)物質(zhì)來去除材料表面的部分,通過掩膜和刻蝕參數(shù)的調(diào)控,可以實現(xiàn)各向異性及各向同性刻蝕的任意切換,從而形成所需的圖案或結(jié)構(gòu)。常見的干法刻蝕設(shè)備有反應(yīng)離子刻蝕機(RIE)、電感耦合等離子體刻蝕機(ICP)、磁性中性線等離子體刻蝕機(NLD)、離子束刻蝕機(IBE),本文目的對各刻蝕設(shè)備的結(jié)構(gòu)進行剖析,以及分析技術(shù)的優(yōu)缺點。
RIE
RIE設(shè)備的結(jié)構(gòu)通常比較簡單,一般由射頻電源、陽極、陰極、氣源和真空泵組成,其中,晶圓位于陰極上,射頻電源與陰極相連接,在刻蝕開始時,射頻電源施加電場到氣體上,氣體被電離為離子、電子、原子和分子,其中由于電子的運動速度遠大于其他離子,在刻蝕腔中會形成明顯的鞘區(qū),在晶圓上方會形成自偏壓的電場,RIE利用該效應(yīng)吸引并加速等離子體中的離子與被刻蝕材料產(chǎn)生物理化學(xué)作用,最終產(chǎn)生的副產(chǎn)物氣體揮發(fā)被排出。然而,這種由自偏壓效應(yīng)引起的刻蝕過程中各物質(zhì)的運動速度不同,造成了RIE刻蝕離子與反應(yīng)自由基的不匹配,在RIE刻蝕過程中,經(jīng)常產(chǎn)生的“黑硅”現(xiàn)象就是該原理造成的。

圖1 RIE刻蝕結(jié)構(gòu)示意圖
ICP
隨著工藝要求的不斷提高,研發(fā)人員開發(fā)了電感耦合等離子體刻蝕機(ICP),該設(shè)備克服了自由基、離子不匹配的問題,常用的ICP刻蝕機結(jié)構(gòu)如圖2所示,一般由頂部通入刻蝕氣體,經(jīng)過刻蝕腔側(cè)壁的RF線圈,被RF線圈施加的電場激發(fā)為等離子體,在腔體中形成明顯的輝光層;然后,通過在位于下電極上施加Bias的功率吸收等離子體中的刻蝕離子。相比RIE刻蝕技術(shù),ICP刻蝕腔體一般具有較低的氣壓,更高密度的等離子體,可以通過射頻線圈功率、氣體流量、Bias功率的調(diào)控,實現(xiàn)更高速率,更高精度以及更大深寬比的刻蝕。
圖2右給出了ICP用C4F8刻蝕石英的過程,其中射頻放電C4F8產(chǎn)生的氟碳自由基會自發(fā)的形成鈍化層沉積在表面,然后在施加在晶圓表面的Bias作用下,正離子具有較高的速率延垂直于晶圓表面轟擊鈍化層以及刻蝕石英,實現(xiàn)石英的高深寬比刻蝕。
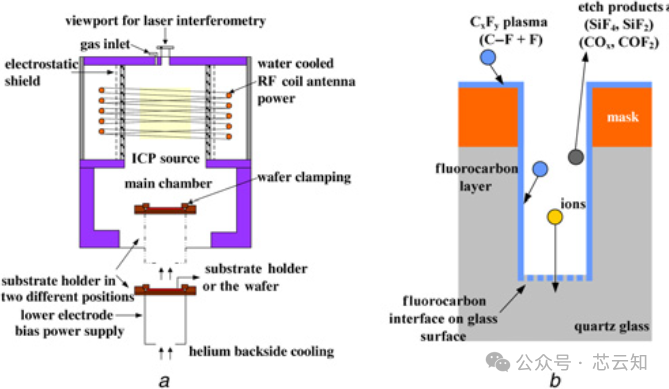
圖2 ICP刻蝕機構(gòu)成和刻蝕示例
NLD
傳統(tǒng)ICP刻蝕射頻線圈會對刻蝕腔中的磁場產(chǎn)生影響,使得徑向的等離子體密度不一致,并干擾刻蝕離子的運動,從而影響刻蝕均勻性。研發(fā)人員進一步開發(fā)了磁中性環(huán)路放電,該設(shè)備的結(jié)構(gòu)如圖3所示,其在ICP刻蝕線圈的外圍施加了三個控制磁場的線圈,通過控制三個線圈磁場的大小從而可以在刻蝕腔中形成磁中環(huán)強度為0的環(huán)境,從而產(chǎn)生更高密度以及分布均勻的等離子體。加以Bias的控制,NLD技術(shù)具有更好的刻蝕均勻性,更高的刻蝕速率。除常用的介質(zhì)層外,也經(jīng)常用于刻蝕碳化硅等耐刻蝕材料。
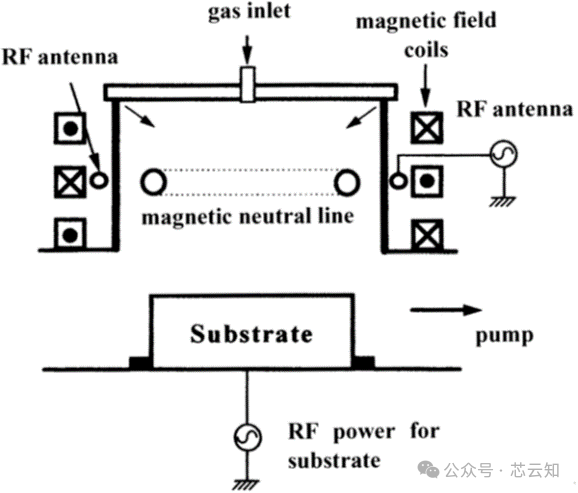
圖3 NLD刻蝕機結(jié)構(gòu)
IBE
IBE刻蝕為純物理轟擊刻蝕,常用于氟基或者氯基等離子體無法刻蝕的材料,例如,金、銅、鉑等。常規(guī)IBE刻蝕機的結(jié)構(gòu)如圖4所示,氬氣通過燈絲提供的電子將其離子化形成等離子體并離子源,然后通過電子引出加速系使離子均勻射向晶圓工件臺,最后通過轟擊固體表面原子,使材料原子發(fā)生濺射,達到刻蝕目的。
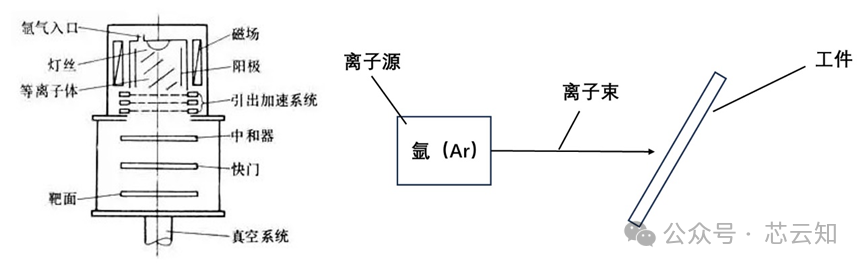
圖4 IBE刻蝕結(jié)構(gòu)和離子束路徑
IBE的特點主要有:1)高方向性的中性離子束能夠控制側(cè)壁輪廓,優(yōu)化刻蝕過程中的徑向均勻性和結(jié)構(gòu)形貌。2)通過調(diào)整工件臺的角度可以通過傾斜晶圓從而改變離子束的撞擊方向?qū)崿F(xiàn)側(cè)壁角度的控制。
審核編輯:湯梓紅
-
等離子體
+關(guān)注
關(guān)注
0文章
128瀏覽量
14479 -
晶圓
+關(guān)注
關(guān)注
52文章
5118瀏覽量
129161 -
刻蝕機
+關(guān)注
關(guān)注
0文章
53瀏覽量
4464
原文標(biāo)題:MEMS常用干法刻蝕設(shè)備結(jié)構(gòu)及原理
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
一文詳解干法刻蝕工藝

釋放MEMS機械結(jié)構(gòu)的干法刻蝕技術(shù)
【轉(zhuǎn)帖】干法刻蝕的優(yōu)點和過程
釋放MEMS機械結(jié)構(gòu)的干法刻蝕技術(shù)
干法刻蝕原理
兩種基本的刻蝕工藝:干法刻蝕和濕法腐蝕
GaN材料干法刻蝕工藝在器件工藝中有著廣泛的應(yīng)用

干法刻蝕之鋁刻蝕的介紹,它的原理是怎樣的

干法刻蝕工藝介紹
干法刻蝕解決RIE中無法得到高深寬比結(jié)構(gòu)或陡直壁問題
干法刻蝕和清洗(Dry Etch and Cleaning)
干法刻蝕與濕法刻蝕各有什么利弊?

干法刻蝕工藝的不同參數(shù)
晶圓表面溫度對干法刻蝕的影響

干法刻蝕側(cè)壁彎曲的原因及解決方法






 干法刻蝕常用設(shè)備的原理及結(jié)構(gòu)
干法刻蝕常用設(shè)備的原理及結(jié)構(gòu)










評論