文章來源:芯云知
原文作者:金末
膜厚測試在MEMS制造工藝中至關(guān)重要,它不僅關(guān)乎工藝質(zhì)量,更直接影響著最終成品的性能。為了確保每一片MEMS器件的卓越品質(zhì),精確測量薄膜厚度是不可或缺的一環(huán)。
MEMS工藝過程中常常需要用到一些非破壞性的測試方法來表征當(dāng)前工藝下的完成情況,以此判定工藝是否滿足設(shè)計(jì)要求,它是MEMS工藝監(jiān)控的重要環(huán)節(jié)。本文介紹的是膜厚測試。
鍍膜是MEMS制造工藝過程中三板斧之一。根據(jù)MEMS器件加工工藝需求,需要制作各種不同厚度的薄膜,薄膜厚度對(duì)工藝質(zhì)量、最后成型的器件性質(zhì)有至關(guān)重要的影響。因此,膜厚測試也是MEMS制造工藝過程中最重要的表征。根據(jù)薄膜的性質(zhì)及其厚度的大致范圍,可選擇不同原理的精密測量儀器對(duì)膜厚進(jìn)行測量。如果所選測量原理不適合,可能會(huì)導(dǎo)致薄膜厚度測量不準(zhǔn)確,而且有可能損傷薄膜,改變其性質(zhì),此類結(jié)果均會(huì)對(duì)后續(xù)的加工工藝產(chǎn)生很大影響,最終影響到所制作MEMS器件的性能。所以合理地選擇薄膜厚度的測量原理和測量儀器十分重要。
膜厚測試設(shè)備有輪廓儀、橢偏儀、膜厚儀、原子力顯微鏡和臺(tái)階儀。
輪廓儀
輪廓儀是以白光干涉技術(shù)為原理,對(duì)樣品進(jìn)行二維、三維形貌掃描,進(jìn)而測量表面高度形貌,一般用于測量高低差值30nm以上樣品。光學(xué)輪廓儀是非接觸式測試,在測試過程中不會(huì)損傷樣品表面;樣品高度小于4cm;待測樣品需要具備能夠形成干涉條紋等特征(表面不能太粗糙,樣品不能是全白或者全黑,會(huì)吸光導(dǎo)致不能形成干涉條紋。輪廓儀對(duì)100nm以下的透明薄膜分析精度較差。
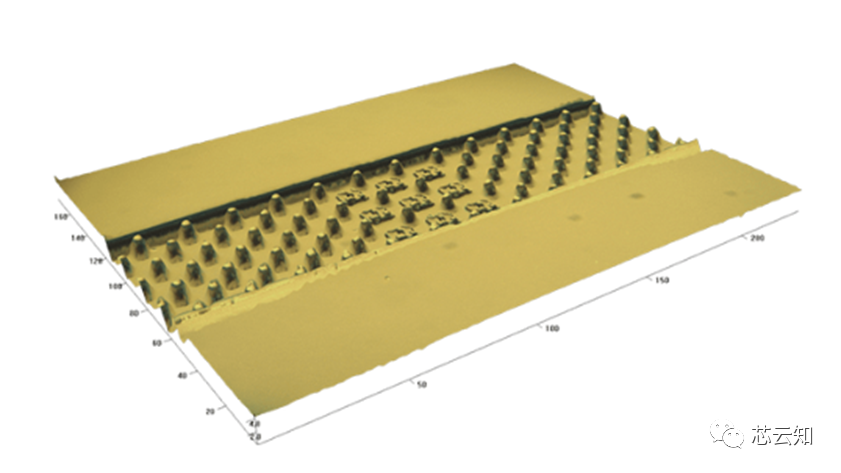
圖 輪廓儀輸出渲染形貌圖
反射式膜厚儀
白光反射光譜是測量從單層薄膜或多層薄膜堆疊結(jié)構(gòu)的一個(gè)波長范圍內(nèi)的反射量,入射光垂直于樣品表面,由于界面干涉產(chǎn)生的反射光譜被用來計(jì)算確定 (透明或部分透明或完全反射基板上) 薄膜的厚度。理論上來說,只有透明或半透明材料制成的薄膜才可被光波穿透,從而可用薄膜厚度測量儀來進(jìn)行測量。但是一些不透光材料,如金屬在某種情況下也能測量,當(dāng)金屬膜僅有幾百納米甚至是幾納米薄的情況下,也能被部分光波穿透,這時(shí)就能精確測量出膜的厚度。在MEMS制造工藝中,最大的優(yōu)勢(shì)是測試從Si基底上的Si3N4/SiO2堆疊反射光譜,通過擬合計(jì)算便能得到的Si3N4/SiO2的單層厚度。膜厚儀可以測量雙層及以上薄膜厚度的方法,可測量厚度范圍可從1nm到2mm。
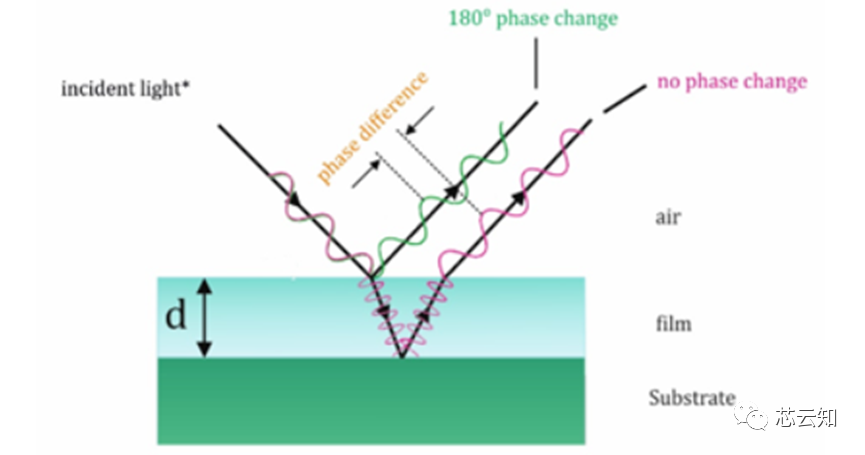
圖 膜厚儀測試原理

圖 膜厚儀擬合圖譜
橢偏儀
與膜厚儀膜厚儀是利用薄膜的反射、透射和散射等光學(xué)特性來測量其厚度不同,橢偏儀則是利用了光的偏振特性,薄膜的相位差、透過率和反射率等光學(xué)性質(zhì)來測量膜層的厚度參數(shù)。橢偏儀則可以用于金屬、氧化物等材料的膜層結(jié)構(gòu),更適合測量較薄膜層厚度,低至0.1nm,精度更高。
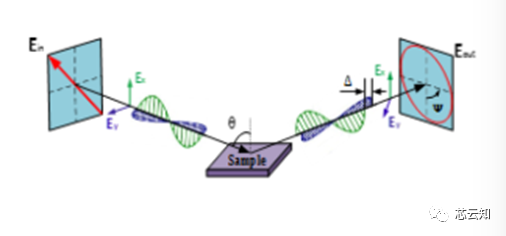
圖 橢偏儀結(jié)構(gòu)和光路
原子力顯微鏡
原子力顯微鏡AFM是一種利用探針與樣品表面之間的相互作用力來進(jìn)行測量的儀器。通過探針在樣品表面掃描,可以獲取樣品表面的拓?fù)鋱D像,并結(jié)合探針與樣品之間的力信號(hào),可以計(jì)算出薄膜的厚度。AFM具有高分辨率和高靈敏度的優(yōu)點(diǎn),適用于測量納米薄膜的厚度。
AFM可以測試薄膜范圍非常廣,有機(jī)薄膜、聚合物和光刻膠均可以,厚度最厚5mm。

圖 AFM膜厚測試圖譜和曲線
臺(tái)階儀
當(dāng)針尖沿被測表面輕輕劃過時(shí),由于表面有微小的峰谷使觸針在滑行的同時(shí),還沿峰谷作上下運(yùn)動(dòng)。觸針的運(yùn)動(dòng)情況就反映了表面輪廓的情況。傳感器輸出的電信號(hào)經(jīng)測量電橋后,輸出與觸針偏離平衡位置的位移信號(hào)成正比的調(diào)幅信號(hào)。垂直分辨率1nm,可測量臺(tái)階高度范圍0-300μm,有點(diǎn)類似低階版AFM。
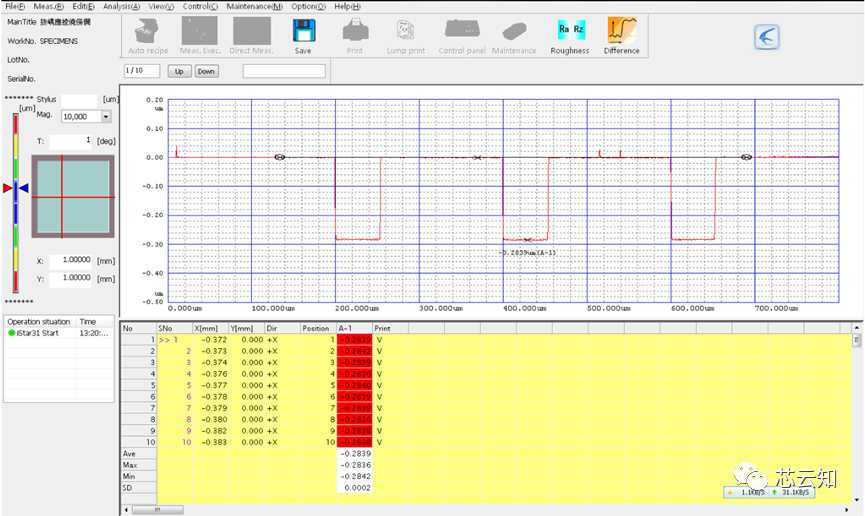
圖 臺(tái)階儀軟件界面
下面將五種膜厚測試方法進(jìn)行比較。

-
mems
+關(guān)注
關(guān)注
129文章
4061瀏覽量
192735 -
制造工藝
+關(guān)注
關(guān)注
2文章
198瀏覽量
20257 -
測量儀器
+關(guān)注
關(guān)注
3文章
835瀏覽量
43861 -
膜厚
+關(guān)注
關(guān)注
0文章
4瀏覽量
5002
原文標(biāo)題:盤點(diǎn)MEMS工藝過程中的測試項(xiàng)目:膜厚測試
文章出處:【微信號(hào):bdtdsj,微信公眾號(hào):中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
厚膜材料新技術(shù)趨勢(shì)研究——光刻型厚膜漿料
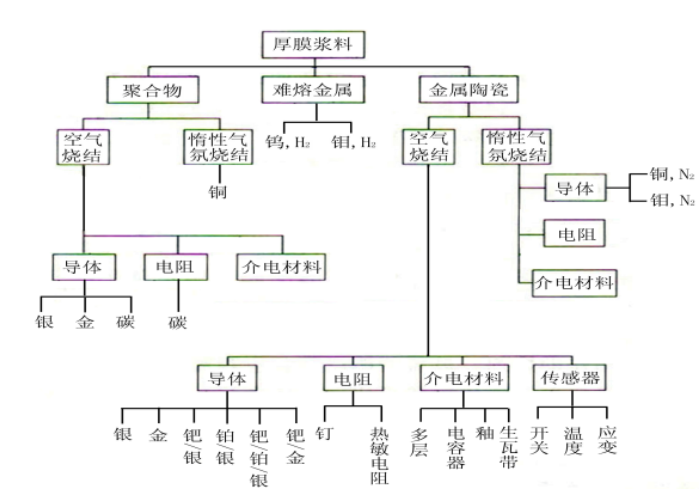
怎么區(qū)分電阻是薄膜還是厚膜
EAK研發(fā)制造片式厚膜高壓電阻
【「大話芯片制造」閱讀體驗(yàn)】+ 芯片制造過程和生產(chǎn)工藝

貼片電阻中厚膜和薄膜的區(qū)別
印刷電子制造中的厚膜光刻技術(shù)
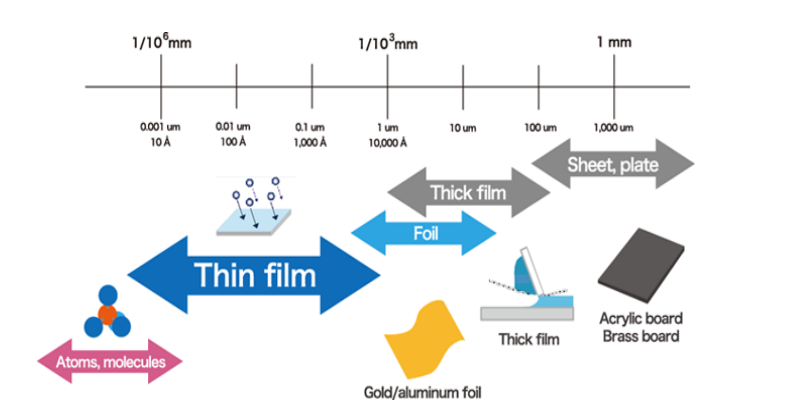
一文弄懂半導(dǎo)體掩膜版制造工藝及流程
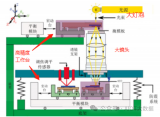
高效在線監(jiān)測POLY膜厚方案——POLY5000在線膜厚測試儀






 MEMS制造工藝過程中膜厚測試詳解
MEMS制造工藝過程中膜厚測試詳解











評(píng)論