什么是掩模版
掩模版(Photomask)又稱光罩、光掩模、光刻掩模版、掩膜版、掩膜板等,是光刻工藝中關(guān)鍵部件之一,是下游行業(yè)產(chǎn)品制造過程中的圖形“底片”轉(zhuǎn)移用的高精密工具,是承載圖形設(shè)計(jì)和工藝技術(shù)等知識(shí)產(chǎn)權(quán)信息的載體。掩模版用于下游電子元器件制造業(yè)批量生產(chǎn),是下游行業(yè)生產(chǎn)流程銜接的關(guān)鍵部分,是下游產(chǎn)品精度和質(zhì)量的決定因素之一。
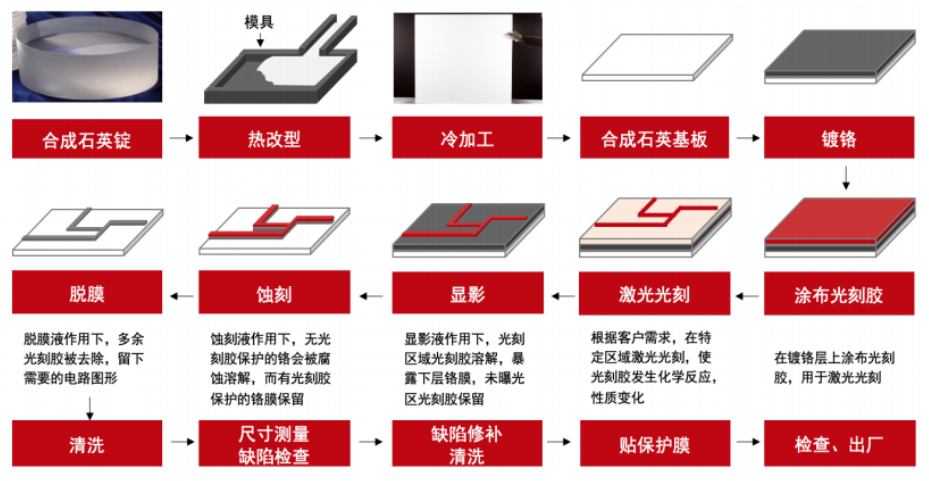
掩模版(石英)的制造過程掩模版的工作原理
作為光刻復(fù)制圖形的基準(zhǔn)和藍(lán)本,掩模版是連接工業(yè)設(shè)計(jì)和工藝制造的關(guān)鍵,掩模版的精度和質(zhì)量水平會(huì)直接影響最終下游制品的優(yōu)品率。
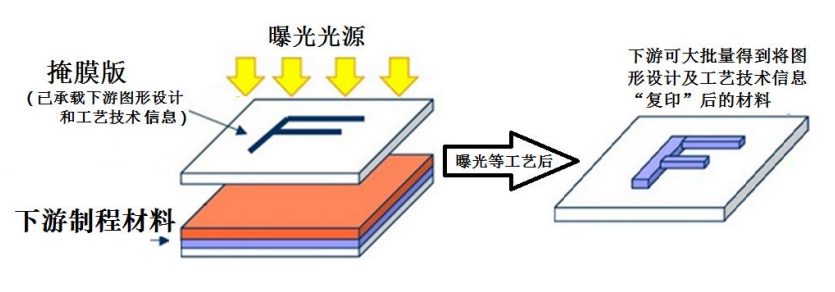
資料來源:清溢光電招股說明書
以TFT-LCD制造為例,利用掩模版的曝光掩蔽作用,將設(shè)計(jì)好的TFT陣列和彩色濾光片圖形按照薄膜晶體管的膜層結(jié)構(gòu)順序,依次曝光轉(zhuǎn)移至玻璃基板,最終形成多個(gè)膜層所疊加的顯示器件。

以集成電路為例,其制造過程需要經(jīng)過多次曝光工藝,利用掩模版的曝光掩蔽作用,在半導(dǎo)體晶圓表面形成柵極、源漏極、摻雜窗口、電極接觸孔等。
掩模版的分類
按光掩模版基板材料可分為透明樹脂基板和透明玻璃基板。透明樹脂基板易于大型化,但是易變形,相較而言玻璃基板更為常用,按照玻璃材質(zhì)又可細(xì)分為合成石英光掩模版、硼硅玻璃光掩模版和蘇打(鈉鈣玻璃)光掩模版三類。
按光掩模版遮光膜材料可分為乳膠遮光膜與硬質(zhì)遮光膜兩大類。硬質(zhì)遮光膜又可細(xì)分為鉻、硅、硅化鉬、氧化鐵四類,其中鉻質(zhì)材料具有涂覆均一性好、刻蝕精度高、且無毒無污染的優(yōu)點(diǎn),應(yīng)用最為廣泛。
按光掩模版的用途可分為鉻版、凸版、干版和液體凸版四類。其中,鉻版主要由鉻質(zhì)遮光膜與石英基板組成,由于其精度高、耐用性好,廣泛應(yīng)用于微電子制造領(lǐng)域。

石英掩模版使用石英玻璃作為基板材料,透光率高,熱膨脹系數(shù)低,比蘇打玻璃更平整耐磨,使用壽命更長(zhǎng),主要用于高精度掩模版;蘇打掩模版用蘇打玻璃作為基板材料,由于材料的原因,各方面性能都劣于石英掩模版,主要用于中低精度掩模版;樹脂基板由于透光率一般,不耐用,精度低,主要用于PCB掩膜。
掩模版是集成電路制造過程中的圖形轉(zhuǎn)移工具或者母板,也就是半導(dǎo)體芯片的母板,承載著圖形信息和工藝技術(shù)信息。掩模版的作用是將承載的電路圖形通過曝光的方式轉(zhuǎn)移到硅晶圓等基體材料上,從而實(shí)現(xiàn)集成電路的批量化生產(chǎn)。掩模版廣泛應(yīng)用于半導(dǎo)體、平板顯示、電路板、觸控屏等領(lǐng)域。
半導(dǎo)體掩模版市場(chǎng)需求分析
根據(jù)SEMI最新的《世界晶圓廠預(yù)測(cè)報(bào)告》(WorldFabForecast),預(yù)計(jì)全球2021年至2023年將新建84座大型芯片制造工廠,總投資額超5,000億美元;以新能源汽車為代表的細(xì)分市場(chǎng)持續(xù)推動(dòng)半導(dǎo)體需求增長(zhǎng),在高需求背景下預(yù)計(jì)2022年新增33家工廠、2023年新增28家工廠。《世界晶圓廠預(yù)測(cè)報(bào)告》顯示,2021年至2023年,中國(guó)大陸預(yù)計(jì)將建設(shè)20座支持成熟工藝的大型芯片制造工廠。
根據(jù)SEMI數(shù)據(jù)、CEMIA數(shù)據(jù),全球半導(dǎo)體材料市場(chǎng)規(guī)模呈現(xiàn)穩(wěn)步增長(zhǎng)態(tài)勢(shì),從2017年469億美元增長(zhǎng)至2022年的727億美元,年復(fù)合增長(zhǎng)率為9.16%,預(yù)計(jì)2023年規(guī)模為794億美元;中國(guó)大陸半導(dǎo)體材料市場(chǎng)規(guī)模快速增長(zhǎng),從2019年為87億美元增長(zhǎng)至2022年的129.7億美元,年復(fù)合增長(zhǎng)率為14.24%,預(yù)計(jì)2023年規(guī)模為148.2億美元,增速遠(yuǎn)超全球半導(dǎo)體材料市場(chǎng)。

根據(jù)SEMI數(shù)據(jù),作為半導(dǎo)體材料的重要組成部分,掩模版占半導(dǎo)體材料市場(chǎng)規(guī)模的比例約為12%,僅次于硅片和電子特氣,具體情況如下:

由此推算,2023年全球半導(dǎo)體掩模版市場(chǎng)規(guī)模為95.28億美元,2023年中國(guó)半導(dǎo)體掩模版的市場(chǎng)規(guī)模約為17.78億美元。未來隨著半導(dǎo)體行業(yè)容量的持續(xù)上升,半導(dǎo)體掩模版市場(chǎng)規(guī)模將不斷提升。
國(guó)內(nèi)第三方掩模版市場(chǎng)
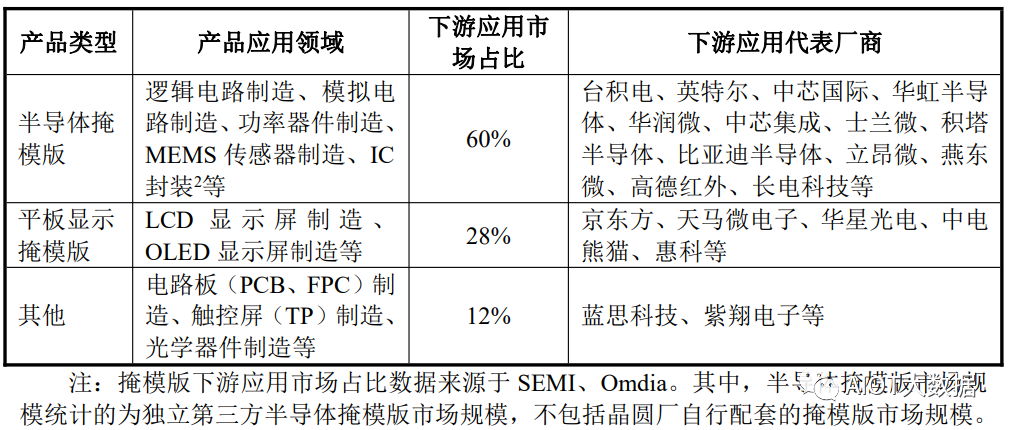
相比較而言,半導(dǎo)體掩模版在最小線寬、CD精度、位置精度等重要參數(shù)方面,均顯著高于平板顯示、PCB等領(lǐng)域掩模版產(chǎn)品。

(半導(dǎo)體為130nm工藝節(jié)點(diǎn)半導(dǎo)體掩模版關(guān)鍵參數(shù),平板顯示為高精度TFT-Array掩模版關(guān)鍵參數(shù))
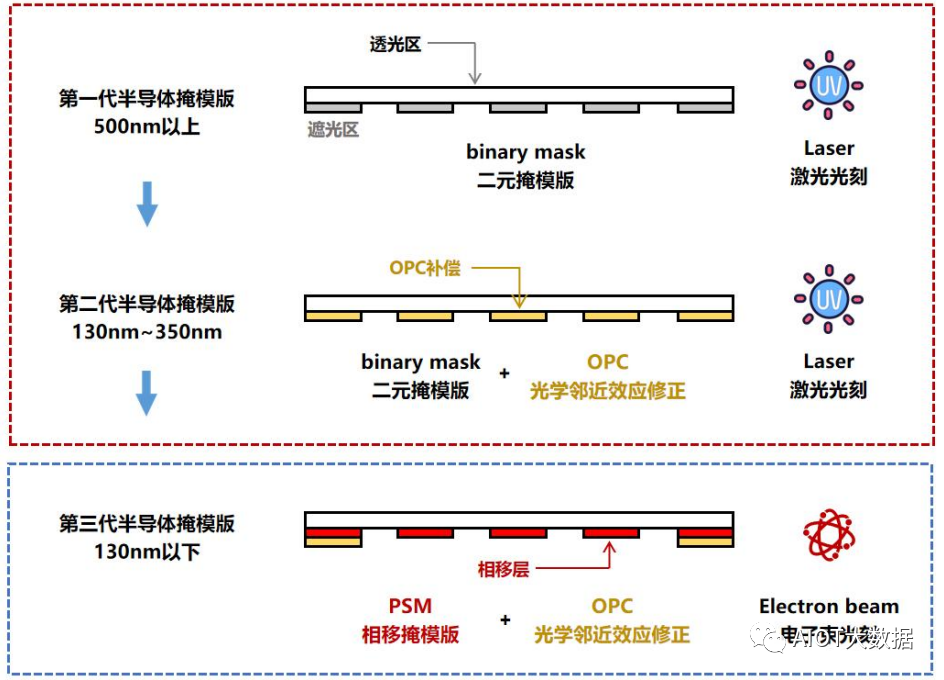
國(guó)產(chǎn)特色半導(dǎo)體掩模版產(chǎn)業(yè)鏈
掩模版是半導(dǎo)體制造工藝中的關(guān)鍵材料,用于半導(dǎo)體制造的光刻環(huán)節(jié)。半導(dǎo)體制造的光刻是指通過曝光工序,在晶圓表面的光刻膠上刻畫出電路圖形,然后通過顯影、刻蝕等工藝流程,最終將電路圖形轉(zhuǎn)移到晶圓上的過程。
掩模版在半導(dǎo)體生產(chǎn)中的應(yīng)用如下圖所示:
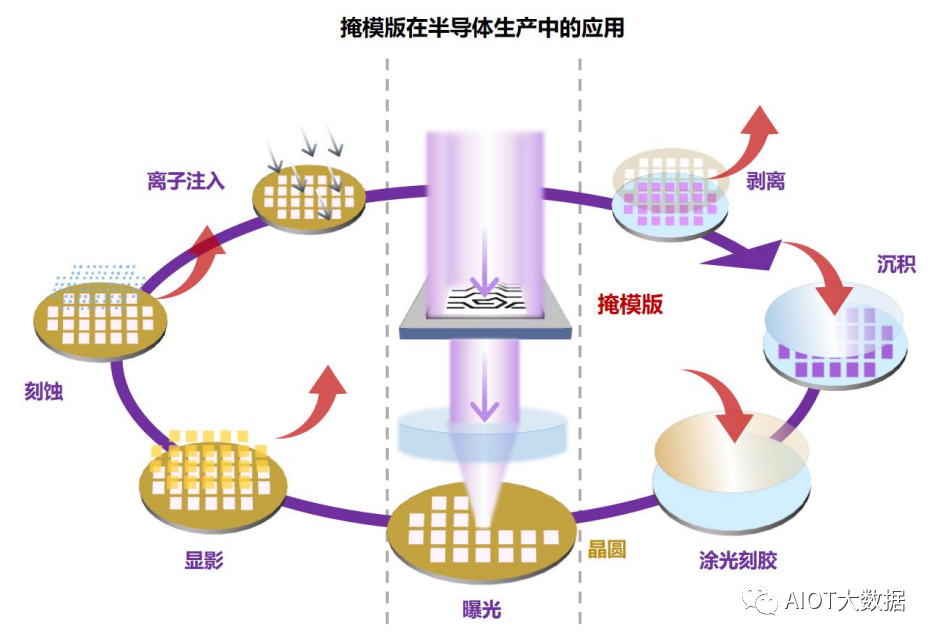
半導(dǎo)體器件和結(jié)構(gòu)是通過生產(chǎn)工藝一層一層累計(jì)疊加形成的,芯片設(shè)計(jì)版圖通常由十幾層到數(shù)十層圖案組成,芯片制造最關(guān)鍵的工序是將每層掩模版上的圖案通過多次光刻工藝精準(zhǔn)地轉(zhuǎn)移到晶圓上(如下圖所示)。半導(dǎo)體光刻工藝需要一整套相互之間能準(zhǔn)確套準(zhǔn)的、具有特定圖形的“光復(fù)印”掩模版,其功能類似于傳統(tǒng)相機(jī)的“底片”。掩模版是半導(dǎo)體制造工藝中最關(guān)鍵的材料之一,其品質(zhì)直接關(guān)系到最終產(chǎn)品的質(zhì)量與良率。

普通掩模版產(chǎn)品根據(jù)基板材質(zhì)的不同主要可分為石英掩模版、蘇打掩模版兩類:
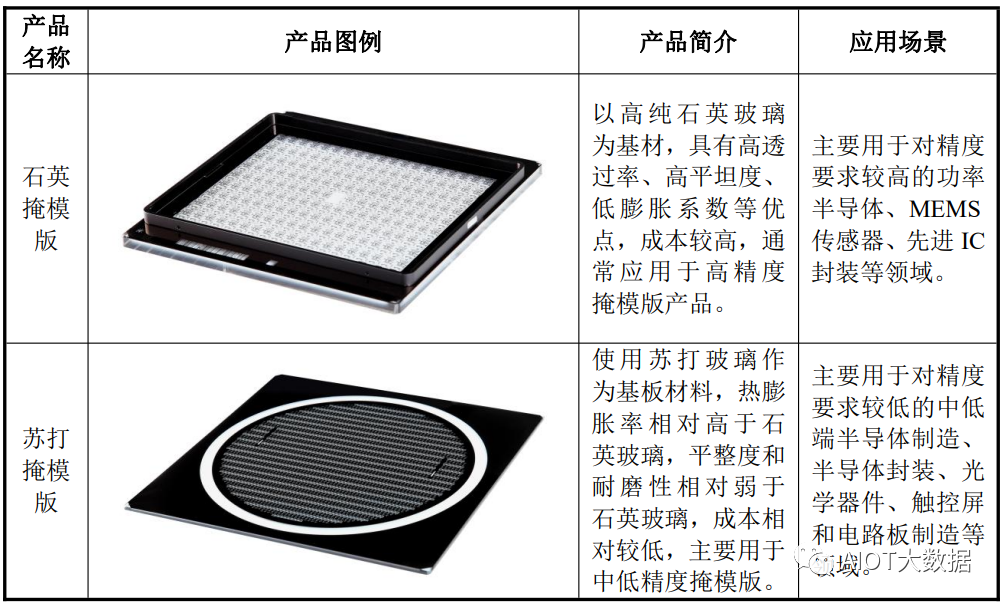
半導(dǎo)體掩模版的生產(chǎn)涉及CAM、光刻、檢測(cè)三個(gè)主要環(huán)節(jié),具體包括版圖處理、圖形補(bǔ)償、曝光、顯影、刻蝕、清洗、缺陷檢驗(yàn)、缺陷修補(bǔ)、參數(shù)測(cè)量、貼光學(xué)膜等多項(xiàng)復(fù)雜工藝,對(duì)補(bǔ)償算法、制程能力、精度水平、缺陷管控具有嚴(yán)格要求,技術(shù)壁壘較高。

 ? ?
? ?
獨(dú)立的第三方半導(dǎo)體掩模版生產(chǎn)商,需要根據(jù)上游芯片設(shè)計(jì)公司(Fabless)提供的設(shè)計(jì)版圖,及下游晶圓制造廠商(Foundry和IDM)提供的制作工藝要求,設(shè)計(jì)并制作出同時(shí)滿足芯片設(shè)計(jì)公司和晶圓制造廠要求的、用于晶圓加工的半導(dǎo)體掩模版。掩模版是上游芯片設(shè)計(jì)公司與下游晶圓制造廠商的中間橋梁,是芯片制作過程中至關(guān)重要的一環(huán),因此獨(dú)立第三方半導(dǎo)體掩模版廠商既需要快速理解并轉(zhuǎn)換上游芯片設(shè)計(jì)要求,又要充分了解下游晶圓制造工藝需求,制作出適配下游光刻機(jī)的掩模版。
當(dāng)前國(guó)內(nèi)芯片設(shè)計(jì)公司使用的EDA軟件多樣,各家公司設(shè)計(jì)圖檔缺乏統(tǒng)一標(biāo)準(zhǔn),存在大量非標(biāo)準(zhǔn)化設(shè)計(jì);下游光刻機(jī)臺(tái)二手設(shè)備流通普遍,型號(hào)眾多,不同光刻機(jī)的對(duì)位要求、工藝要求不同,相應(yīng)信息不全。在這種情況下,第三方半導(dǎo)體掩模版廠商需要有較強(qiáng)的上下游匹配能力。

半導(dǎo)體掩模版行業(yè)高度依賴專有技術(shù),具有鮮明的“Know-How”特點(diǎn),進(jìn)入門檻較高。第三方半導(dǎo)體掩模版行業(yè)的進(jìn)入門檻不僅體現(xiàn)在設(shè)備投入與人才投入,更是體現(xiàn)在專有技術(shù)積累上,這些專有技術(shù)是公司多年來針對(duì)不斷升級(jí)的客戶需求的技術(shù)創(chuàng)新成果,是上萬次各類試驗(yàn)的數(shù)據(jù)結(jié)晶,這也正是第三方半導(dǎo)體掩模版廠商的核心競(jìng)爭(zhēng)力,但往往該類技術(shù)不易于以專利形式保護(hù)。專有技術(shù)形成了第三方半導(dǎo)體掩模版廠商享有的技術(shù)紅利,同時(shí)也構(gòu)成了半導(dǎo)體掩模版較高的行業(yè)壁壘。
半導(dǎo)體掩模版作為半導(dǎo)體制造關(guān)鍵材料之一,由于其技術(shù)壁壘較高,國(guó)內(nèi)市場(chǎng)長(zhǎng)期由國(guó)際大廠所占據(jù),如美國(guó)Photronics、日本Toppan、日本DNP等,國(guó)內(nèi)廠商市場(chǎng)影響力尚低。
另外當(dāng)前國(guó)內(nèi)半導(dǎo)體產(chǎn)業(yè)的軟件、設(shè)備及關(guān)鍵材料等產(chǎn)業(yè)鏈環(huán)節(jié)均不完善。就半導(dǎo)體掩模版而言,上游芯片設(shè)計(jì)公司使用的EDA軟件多樣,存在大量非標(biāo)準(zhǔn)化設(shè)計(jì);下游晶圓制造廠商的核心設(shè)備,如光刻機(jī)同樣存在型號(hào)多、二手設(shè)備普遍等特點(diǎn)。從掩模版制造的核心原材料和設(shè)備來看,高精度半導(dǎo)體掩模版核心原材料石英基板仍被日韓企業(yè)壟斷,設(shè)備仍主要依賴進(jìn)口。
晶圓制造客戶認(rèn)證流程
掩模版作為下游晶圓制造廠商(Foundry和IDM)光刻環(huán)節(jié)極其重要的設(shè)計(jì)圖案轉(zhuǎn)移工具,是晶圓制造光刻環(huán)節(jié)不可或缺的光學(xué)模具,對(duì)晶圓制造和芯片產(chǎn)品品質(zhì)影響巨大。因此,下游晶圓制造廠商對(duì)掩模版廠的要求較為嚴(yán)格,一般情況下,晶圓制造廠商對(duì)掩模版工廠的驗(yàn)證和供應(yīng)商評(píng)估期在6至12個(gè)月甚至更長(zhǎng),準(zhǔn)入流程及持續(xù)考察評(píng)估主要如下:
①簽訂NDA協(xié)議(保密協(xié)議)。
由于掩模版的生產(chǎn)涉及芯片設(shè)計(jì)方案機(jī)密,晶圓制造廠商需評(píng)估第三方掩模版供應(yīng)商的信息安全管理體系和能力,并與其簽訂NDA協(xié)議。
②需求與能力評(píng)估。
主要考察掩模版廠的制版能力是否滿足晶圓制造廠商的制版等級(jí)需求,主要考核掩模版廠工藝的關(guān)鍵指標(biāo),如關(guān)鍵尺寸(CriticalDimension,CD)、關(guān)鍵尺寸精度均值偏差(CDMean-to-Target)、關(guān)鍵尺寸公差(CDTolerance)、位置精度(Registration)、套刻精度(Overlay)、缺陷尺寸(DefectSize)等。
③雙方工藝的匹配。
主要根據(jù)晶圓制造廠商的實(shí)際光刻工藝需求,驗(yàn)證掩模版廠制造工藝和關(guān)鍵指標(biāo)的測(cè)量方式是否與晶圓制造廠商相匹配。不同的晶圓制造廠商在光刻環(huán)節(jié)中的光刻設(shè)備、光刻膠、OPC工藝選擇不同,光刻工藝和設(shè)備調(diào)校習(xí)慣不同,同時(shí)晶圓制造廠商與掩模版廠的測(cè)量系統(tǒng)也存在差異,因此晶圓制造廠商需要實(shí)地考察掩模版廠的制造工藝、實(shí)際測(cè)量并驗(yàn)證掩模版的精度水平,以保證兩者光刻工藝的匹配,并消除因測(cè)量方式不同導(dǎo)致的系統(tǒng)性的精度誤差。
④數(shù)據(jù)處理驗(yàn)證。
這一環(huán)節(jié)是對(duì)掩模版的數(shù)據(jù)處理和JDV(制版圖形的在線檢查)確認(rèn)環(huán)節(jié)進(jìn)行驗(yàn)證。不同的芯片設(shè)計(jì)公司和晶圓制造廠商的數(shù)據(jù)設(shè)計(jì)的格式與規(guī)范存在差異,與掩模工廠之間的數(shù)據(jù)傳輸方式、JDV數(shù)據(jù)確認(rèn)方式都需要進(jìn)行驗(yàn)證和確認(rèn)。掩模工廠和設(shè)計(jì)公司需要分別對(duì)數(shù)據(jù)處理環(huán)節(jié)進(jìn)行可行性及準(zhǔn)確性驗(yàn)證,并且在這個(gè)過程中評(píng)估信息安全管理是否符合要求。
⑤掩模版測(cè)試樣品評(píng)估。
掩模版工廠設(shè)計(jì)一些標(biāo)準(zhǔn)化的、含有特定評(píng)估測(cè)試圖案的掩模版樣品,提供給晶圓制造廠商進(jìn)行樣品評(píng)估。晶圓制造廠商根據(jù)實(shí)際樣品測(cè)試結(jié)果來實(shí)測(cè)掩模版的關(guān)鍵指標(biāo)是否達(dá)到要求。
⑥產(chǎn)品測(cè)試與驗(yàn)證。
對(duì)掩模版廠提供的掩模版成品進(jìn)行流片測(cè)試。產(chǎn)品測(cè)試與驗(yàn)證是一個(gè)長(zhǎng)期跟蹤、全流程考察的過程,通常掩模工廠的驗(yàn)證和供應(yīng)商評(píng)估期在6至12個(gè)月甚至更長(zhǎng),對(duì)于產(chǎn)品的驗(yàn)證會(huì)持續(xù)追蹤到最終芯片的可靠性和功能測(cè)試。
⑦品質(zhì)體系審核。
晶圓制造廠商同樣需要對(duì)掩模工廠的品質(zhì)控制體系進(jìn)行審核,ISO9001(質(zhì)量管理體系認(rèn)證)、ISO14001(環(huán)境管理體系認(rèn)證)、ISO27001(信息安全管理體系)等品控體系審核通過后才可納入合格供應(yīng)商。
上述認(rèn)證周期一般在6至12個(gè)月甚至更長(zhǎng),工藝節(jié)點(diǎn)越高的掩模版產(chǎn)品認(rèn)證周期越久。晶圓制造廠商審核通過后才可納入合格供應(yīng)商名單,建立起正式的合作關(guān)系。由于下游客戶對(duì)半導(dǎo)體掩模版廠商要求高、認(rèn)證周期長(zhǎng),雙方建立合作關(guān)系后,不會(huì)輕易更換供應(yīng)商,合作穩(wěn)定性較好。
同時(shí)掩模版承載著芯片設(shè)計(jì)方案和圖形信息,涉及芯片設(shè)計(jì)方案機(jī)密,第三方掩模版工廠必須建立一套嚴(yán)密的安全控制機(jī)制,避免信息泄露,從而保障客戶的知識(shí)產(chǎn)權(quán)。
掩模版的工藝流程圖

1、建立客戶合作關(guān)系,客戶下達(dá)訂單,并將客戶文件(設(shè)計(jì)版圖)、規(guī)格書發(fā)送給公司。
2、CAM:收到客戶芯片設(shè)計(jì)版圖及規(guī)格書后,通過專業(yè)設(shè)計(jì)軟件將客戶的版圖進(jìn)行數(shù)據(jù)分層、實(shí)體處理、邏輯運(yùn)算、OPC等處理,并對(duì)處理過的版圖數(shù)據(jù)進(jìn)行數(shù)據(jù)檢查和JDV(制版圖形的在線檢查)確認(rèn),最后按照相應(yīng)的工藝參數(shù)將文件格式轉(zhuǎn)換為掩模版光刻設(shè)備專用的數(shù)據(jù)形式。
3、光刻:通過光刻機(jī)對(duì)掩模基材進(jìn)行直寫光刻,完成客戶圖形曝光。掩模版制造通常采用正性光刻膠,通過曝光作用使目標(biāo)區(qū)域的光刻膠內(nèi)部發(fā)生交聯(lián)反應(yīng),從而進(jìn)行圖像轉(zhuǎn)移。
4、顯影:將曝光完成后的掩模版顯影,以便進(jìn)行蝕刻。在顯影介質(zhì)的作用下,經(jīng)過曝光區(qū)域的光刻膠會(huì)溶解,而未曝光區(qū)域則會(huì)保留并繼續(xù)保護(hù)遮光膜層。
5、蝕刻:對(duì)遮光膜層進(jìn)行蝕刻,保留圖形。在蝕刻介質(zhì)的作用下,沒有光刻膠保護(hù)的區(qū)域會(huì)發(fā)生化學(xué)反應(yīng),而有光刻膠保護(hù)的區(qū)域的遮光膜則會(huì)保留。
6、脫膜:光刻膠的保護(hù)功能已經(jīng)完成,脫膜工序通過脫膜液去除多余光刻膠。
7、清洗:將掩模版正、反面的污染物清洗干凈,為缺陷檢驗(yàn)做準(zhǔn)備。
8、關(guān)鍵參數(shù)測(cè)量:對(duì)掩模版關(guān)鍵尺寸(CDSize)、CD精度(CDTolerance)、位置精度(Registration)、套刻精度(Overlay)等關(guān)鍵參數(shù)進(jìn)行測(cè)量,判定尺寸的準(zhǔn)確程度。
9、AOI掃描:對(duì)照客戶技術(shù)/品質(zhì)指標(biāo),使用自動(dòng)光學(xué)檢測(cè)設(shè)備(AOI)檢測(cè)掩模版制版過程產(chǎn)生的缺陷并記錄坐標(biāo)及相關(guān)信息。
10、缺陷修補(bǔ):利用激光物理作用或化學(xué)反應(yīng)相結(jié)合的方式,修復(fù)掩模版在生產(chǎn)過程產(chǎn)生的瑕疵(Defect)、微粒(Particle)等缺陷。
11、STARlight掃描:對(duì)掩模版制版過程附著的微粒(Particle)進(jìn)行檢查。
12、貼Pellicle膜:在掩模版上貼合Pellicle膜,避免微粒污染掩模版表面,降低下游客戶制造過程中微粒造成的不良率。
13、最終檢查:對(duì)掩模版做最后的檢測(cè)工作,以確保掩模版符合品質(zhì)指標(biāo)。
14、對(duì)掩模版進(jìn)行包裝,然后發(fā)貨。
核心技術(shù)主要涉及上述流程中CAM版圖處理、光刻(包括曝光、顯影、刻蝕及清洗環(huán)節(jié))及檢測(cè)(包括關(guān)鍵參數(shù)測(cè)量、缺陷修補(bǔ)等出貨前的檢測(cè)環(huán)節(jié))三大環(huán)節(jié),從而保證產(chǎn)品的精度和品質(zhì)水平。
半導(dǎo)體掩模版行業(yè)概況
半導(dǎo)體掩模版生產(chǎn)廠商可以分為晶圓廠自建配套工廠和獨(dú)立第三方掩模廠商兩大類。由于28nm及以下的先進(jìn)制程晶圓制造工藝復(fù)雜且難度大,各家用于芯片制造的掩模版涉及晶圓制造廠的重要工藝機(jī)密且制造難度較大,因此先進(jìn)制程晶圓制造廠商所用的掩模版大部分由自己的專業(yè)工廠內(nèi)部生產(chǎn),如英特爾、三星、臺(tái)積電、中芯國(guó)際等公司的掩模版均主要由自制掩模版部門提供。
對(duì)于28nm以上等較為成熟的制程所用的掩模版,芯片制造廠商為了降低成本,在滿足技術(shù)要求下,更傾向于向獨(dú)立第三方掩模版廠商進(jìn)行采購(gòu)。根據(jù)貝恩咨詢發(fā)布的《中國(guó)半導(dǎo)體白皮書》,全球晶圓制造代工收入中28nm以上制程的收入占比約為55.38%,占據(jù)晶圓代工大部分收入。
根據(jù)SEMI數(shù)據(jù),在全球半導(dǎo)體掩模版市場(chǎng),晶圓廠自行配套的掩模版工廠規(guī)模占比65%,獨(dú)立第三方掩模廠商規(guī)模占比35%,其中獨(dú)立第三方掩模版場(chǎng)主要被美國(guó)Photronics、日本Toppan和日本DNP三家公司所控制,三者共占八成以上的市場(chǎng)規(guī)模,市場(chǎng)集中度較高。

由于半導(dǎo)體掩模版具有較高的進(jìn)入門檻,國(guó)內(nèi)半導(dǎo)體掩模版主要生產(chǎn)商僅包括中芯國(guó)際光罩廠、迪思微、中微掩模、龍圖光罩、清溢光電、路維光電、中國(guó)臺(tái)灣光罩等。中芯國(guó)際光罩廠為晶圓廠自建工廠,產(chǎn)品供內(nèi)部使用;清溢光電、路維光電產(chǎn)品以中大尺寸平板顯示掩模版為主,半導(dǎo)體掩模版占比較低。龍圖光罩是國(guó)內(nèi)屈指可數(shù)的第三方半導(dǎo)體掩模版廠商,工藝水平、出貨量及市場(chǎng)占有率居國(guó)內(nèi)企業(yè)前列。
技術(shù)難度
掩模版是將虛擬的電子設(shè)計(jì)圖形批量轉(zhuǎn)化為芯片實(shí)體電路圖形的核心工具,是決定半導(dǎo)體制程水平和良率的關(guān)鍵因素之一。隨著半導(dǎo)體的制程工藝的不斷提升、芯片設(shè)計(jì)的不斷復(fù)雜,掩模版的研發(fā)、生產(chǎn)、制造難度也顯著提升。
1、CAM環(huán)節(jié):高制程節(jié)點(diǎn)下晶圓曝光存在圖形失真,需要對(duì)掩模版圖形進(jìn)行光學(xué)補(bǔ)償,存在較高的技術(shù)難度
隨著掩模版線縫水平的不斷提升,下游晶圓在使用光刻機(jī)曝光時(shí)光學(xué)效應(yīng)影響越發(fā)顯著,會(huì)出現(xiàn)實(shí)際光刻圖案與芯片設(shè)計(jì)圖案失真變形的現(xiàn)象,嚴(yán)重影響芯片的性能與良率。為解決上述問題,提高晶圓曝光的分辨率與精度,需要在CAM環(huán)節(jié)對(duì)掩模版圖形進(jìn)行二次加工(OPC),通過圖形補(bǔ)償來抵消圖形偏差,使得曝光后的圖形滿足設(shè)計(jì)要求。圖形補(bǔ)償(OPC)技術(shù)具有較高的技術(shù)難度,對(duì)圖形特征點(diǎn)識(shí)別、運(yùn)算速度、補(bǔ)償準(zhǔn)確度都有較高的要求。
(1)CAM版圖處理重要性
CAM版圖處理是掩模版生產(chǎn)制造的重要環(huán)節(jié),是芯片設(shè)計(jì)版圖到掩模版圖案的圖像轉(zhuǎn)移起點(diǎn),本質(zhì)是圖形數(shù)據(jù)的轉(zhuǎn)換與處理。半導(dǎo)體掩模版廠商需要獲取芯片設(shè)計(jì)公司提供的芯片設(shè)計(jì)版圖和晶圓制造廠商提供的制版要求,根據(jù)兩者信息轉(zhuǎn)換成可以被掩模版光刻機(jī)識(shí)別的掩模版圖形,這一制造轉(zhuǎn)換過程需要計(jì)算機(jī)輔助進(jìn)行,即計(jì)算機(jī)輔助制造(CAM)。CAM版圖處理的主要工序包含兩個(gè)層面:
①上游客戶芯片設(shè)計(jì)版圖數(shù)據(jù)的校對(duì)、實(shí)體處理、邏輯運(yùn)算、工藝補(bǔ)償、布圖、驗(yàn)證;
②根據(jù)下游晶圓制造廠商工藝需求的解讀及實(shí)現(xiàn),生成提供給客戶端的JDV(JobDeckView)數(shù)據(jù);結(jié)合內(nèi)部制造能力,出具提供給掩模版制造環(huán)節(jié)的掩模制作數(shù)據(jù)、AOI檢測(cè)數(shù)據(jù)及量測(cè)信息等。因此,CAM版圖處理是掩模版制造的起點(diǎn),這一工序?qū)ρ谀0娴闹圃熘陵P(guān)重要,如果CAM版圖處理無法滿足客戶需求或出現(xiàn)設(shè)計(jì)偏差則直接導(dǎo)致掩模版制造失敗。CAM版圖處理的主要流程如下圖所示:
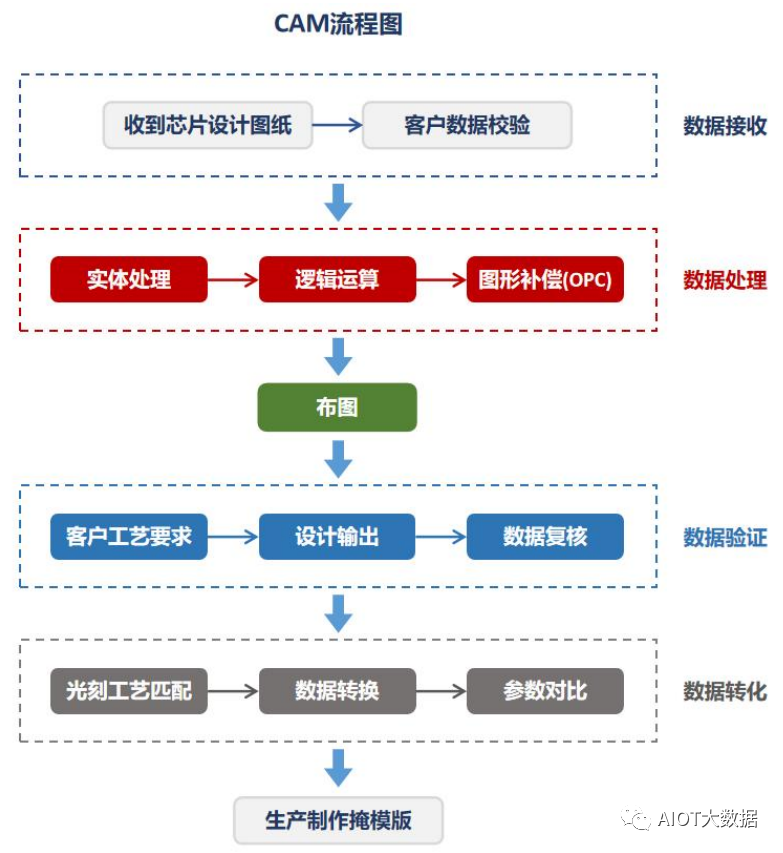
(2)CAM版圖處理技術(shù)難點(diǎn)
CAM版圖處理階段主要有以下難點(diǎn):
①原始芯片設(shè)計(jì)版圖存在大量非標(biāo)準(zhǔn)化數(shù)據(jù),無法直接進(jìn)行圖形轉(zhuǎn)換。不同上游領(lǐng)域的芯片設(shè)計(jì)公司使用的EDA軟件不同且設(shè)計(jì)習(xí)慣不同,導(dǎo)致提供的數(shù)據(jù)格式多種多樣,差異較大,存在大量非標(biāo)設(shè)計(jì)。非標(biāo)準(zhǔn)化的版圖數(shù)據(jù)無法直接轉(zhuǎn)換成掩模版圖形,需要掩模版制造商擁有快速識(shí)別并轉(zhuǎn)換成光刻機(jī)可識(shí)別圖形數(shù)據(jù)能力。
②半導(dǎo)體掩模版圖形補(bǔ)償難度大。隨著下游半導(dǎo)體芯片制程節(jié)點(diǎn)的提升,掩模版的線縫越來越窄,在半導(dǎo)體掩模版線縫水平提升過程中,由于光學(xué)衍射效應(yīng)的影響,掩模版用于下游晶圓生產(chǎn)時(shí)會(huì)出現(xiàn)圖形失真的情況,因此需要在版圖設(shè)計(jì)中加入OPC圖形補(bǔ)償,提升晶圓制造精度水平。
圖形補(bǔ)償(OPC)技術(shù)光學(xué)臨近效應(yīng)(OpticalProximityEffect,OPE)是指在曝光過程中,由于透過掩模版上相鄰圖形之間的光波發(fā)生衍射,導(dǎo)致投影到晶圓上的圖形和掩模版上的圖形不一致的現(xiàn)象。這種圖形的不一致主要表現(xiàn)在三個(gè)方面:圖形拐角的變化、線條寬度的變化和線條頂端的變化,而且隨著集成電路特征尺寸不斷地減小,這種光刻圖形的變形與偏差變得越來越嚴(yán)重,成為影響芯片性能和成品率的重要因素。為了解決光學(xué)臨近效應(yīng),一種有效的解決方案是在掩模圖案上增加光學(xué)鄰近效應(yīng)修正(OPC)算法,通過改變?cè)酒谀0鎴D形的形狀來減小光刻圖形的偏差。一般來說,當(dāng)晶圓上的線寬小于曝光波長(zhǎng)時(shí),必須對(duì)掩模上的圖形做光學(xué)鄰近效應(yīng)修正。
③下游光刻設(shè)備性能參數(shù)與對(duì)位信息缺失,導(dǎo)致半導(dǎo)體掩模版對(duì)位標(biāo)記困難。國(guó)內(nèi)晶圓制造廠商光刻設(shè)備高度依賴二手市場(chǎng)供給,種類多樣,性能參數(shù)與對(duì)位信息不全。每個(gè)光刻機(jī)設(shè)備商的對(duì)位標(biāo)記系統(tǒng)都自成一套,導(dǎo)致掩模版對(duì)位標(biāo)記困難。如果沒有精確的對(duì)位標(biāo)記,芯片的多層處理工藝便無法套合疊加,以至于無法進(jìn)行曝光制作,因此,需要掩模版廠商充分了解下游晶圓制造廠商光刻機(jī)性能參數(shù)與對(duì)位信息,形成自有處理規(guī)則確保掩模版對(duì)位標(biāo)記的準(zhǔn)確性。
精準(zhǔn)對(duì)位標(biāo)記技術(shù)下游晶圓制造廠商在光刻曝光環(huán)節(jié)用到的掩模版對(duì)位標(biāo)記主要包括:A.初對(duì)位標(biāo)記,作為曝光機(jī)的對(duì)準(zhǔn)系統(tǒng)快速定位掩模版的大概位置;B.精對(duì)位標(biāo)記,曝光機(jī)在找到初對(duì)位標(biāo)記大概確定掩模版的位置后,根據(jù)設(shè)計(jì)圖紙上初對(duì)位與精對(duì)位標(biāo)記的相對(duì)坐標(biāo)偏移找到精對(duì)位標(biāo)記,將掩模版的坐標(biāo)和曝光機(jī)的坐標(biāo)進(jìn)行高精度對(duì)準(zhǔn)的標(biāo)記;C.工作臺(tái)對(duì)位標(biāo)記,用于掩模版和晶圓的工作臺(tái)進(jìn)行對(duì)準(zhǔn)的標(biāo)記。每個(gè)曝光機(jī)設(shè)備商的對(duì)位標(biāo)記系統(tǒng)都自成一套,如果沒有精確的對(duì)位標(biāo)記,芯片的多層處理工藝便無法套合疊加,以至于無法進(jìn)行曝光制作。
2、光刻環(huán)節(jié):光刻環(huán)節(jié)的技術(shù)壁壘在于光刻多環(huán)節(jié)、多因素的精準(zhǔn)控制光刻環(huán)節(jié)的技術(shù)壁壘主要體現(xiàn)在以下兩點(diǎn):
①光刻機(jī)作為極其精密的設(shè)備,對(duì)環(huán)境要求極為苛刻,光刻環(huán)節(jié)中由于環(huán)境參數(shù)波動(dòng)引起的誤差因素對(duì)掩模版的精度水平會(huì)產(chǎn)生嚴(yán)重影響,因此能夠精細(xì)控制各類環(huán)境因素波動(dòng)是掩模版制造的一大難題。
②在使用光刻機(jī)對(duì)掩模版進(jìn)行曝光時(shí),曝光能量的控制對(duì)掩模版精度水平至關(guān)重要,曝光不足或者過量都會(huì)嚴(yán)重影響成像質(zhì)量。
(1)光刻環(huán)節(jié)重要性
光刻作為掩模版制造的核心工藝,對(duì)于掩模版產(chǎn)品的品質(zhì)影響極其重要。光刻環(huán)節(jié)主要包括曝光、顯影、刻蝕和清洗,光刻是將CAM版圖數(shù)據(jù)轉(zhuǎn)換成激光直寫系統(tǒng)控制數(shù)據(jù),由計(jì)算機(jī)控制高精度激光束掃描,利用激光對(duì)涂有光刻膠的掩模基板按照設(shè)計(jì)的圖檔進(jìn)行激光直寫,從而完成了集成電路信息從CAM設(shè)計(jì)版圖到掩模版圖形的轉(zhuǎn)移過程。
光刻環(huán)節(jié)直接決定了最小線/縫寬、邊緣粗糙度、關(guān)鍵尺寸均勻性(CDuniformity)、關(guān)鍵尺寸精度均值偏差(CDmeantoTarget)等圖案指標(biāo);同時(shí)光刻機(jī)平臺(tái)定位的精度也直接決定了掩模版位置精度(Registration)、套刻精度(Overlay)等指標(biāo)。
(2)光刻環(huán)節(jié)技術(shù)難點(diǎn)
光刻環(huán)節(jié)并非是對(duì)設(shè)備的簡(jiǎn)單運(yùn)用,而是結(jié)合公司長(zhǎng)期的自主研發(fā)成果積累,對(duì)光刻、顯影等環(huán)節(jié)的各個(gè)參數(shù)及影響因素進(jìn)行長(zhǎng)期系統(tǒng)性研究的綜合結(jié)果。光刻環(huán)節(jié)難點(diǎn)在于精度與缺陷控制,涉及多個(gè)環(huán)節(jié),不同環(huán)節(jié)之間又會(huì)相互影響。公司持續(xù)優(yōu)化光刻工藝,最大化發(fā)揮設(shè)備性能水平,實(shí)現(xiàn)了精度水平與缺陷控制的不斷突破。
(3)光刻環(huán)節(jié)核心技術(shù)及具體表征
針對(duì)半導(dǎo)體掩模版光刻環(huán)節(jié)中關(guān)于制程管控、套刻精度控制、曝光控制、工藝匹配、顯影刻蝕控制等難點(diǎn),主要有以下核心技術(shù):
①光刻制程管控技術(shù)
光刻環(huán)節(jié)對(duì)環(huán)境要求極其苛刻,曝光過程中,諸如溫度變化、濕度變化、氣流擾動(dòng)、微振動(dòng)等因素均將引起曝光圖形位置漂移,嚴(yán)重影響位置精度和套刻精度。具體來講,光刻機(jī)關(guān)鍵部件會(huì)由于空間溫度的漂移而產(chǎn)生形變進(jìn)而導(dǎo)致運(yùn)動(dòng)誤差,而以能量探測(cè)器為代表的測(cè)量?jī)x器會(huì)受溫度、濕度、壓力影響,參數(shù)異常勢(shì)必會(huì)造成測(cè)量結(jié)果的誤差進(jìn)而最終影響光刻精度。光刻機(jī)在步進(jìn)過程中,會(huì)在其運(yùn)動(dòng)區(qū)域形成氣流沖擊,使得光刻機(jī)腔體內(nèi)形成不均勻壓力場(chǎng),同時(shí)也會(huì)造成平臺(tái)的微小振動(dòng),進(jìn)而影響位置精度。對(duì)于極其精密的光刻設(shè)備來說,由環(huán)境參數(shù)波動(dòng)引起的誤差因素就成為限制其精度的一大障礙。
②位置精度光刻匹配技術(shù)
半導(dǎo)體設(shè)計(jì)版圖通常由幾十層圖案組成,芯片制造的關(guān)鍵工序是將每層掩模版上的圖案通過多次光刻工藝精準(zhǔn)地轉(zhuǎn)移到晶圓上,因此,半導(dǎo)體掩模版不僅需要能匹配多個(gè)不同的光刻機(jī)臺(tái),半導(dǎo)體掩模版之間也需要能夠相互套準(zhǔn)。
③曝光精細(xì)化控制技術(shù)
在對(duì)掩模版進(jìn)行曝光時(shí),需要使用光刻機(jī)將掩模基板表面的光刻膠進(jìn)行感光處理,從而獲得預(yù)期掩模圖形。進(jìn)行曝光時(shí),需要使用能量控制器精準(zhǔn)控制曝光能量,曝光不足或者過量都會(huì)嚴(yán)重影響成像質(zhì)量,光源的輸出功率、曝光時(shí)間、聚焦深度、束斑形狀都會(huì)直接影響到掩模產(chǎn)品的精度。
④精準(zhǔn)工藝匹配技術(shù)
光刻機(jī)的匹配使用是指同一掩模版可以分別在不同型號(hào)光刻機(jī)上進(jìn)行光刻,而不影響光刻工藝的質(zhì)量。在集成電路工藝生產(chǎn)線上,往往投入多臺(tái)光刻設(shè)備同時(shí)使用,不同光刻機(jī)往往規(guī)格不同、參數(shù)不同。同一掩模版需要分別在不同型號(hào)光刻機(jī)上進(jìn)行光刻,存在較高的匹配難度。
⑤顯影刻蝕控制技術(shù)
顯影是指通過化學(xué)作用,掩模版上經(jīng)過激光或電子束曝光區(qū)域的光刻膠會(huì)溶解,而未曝光區(qū)域則會(huì)保留并繼續(xù)保護(hù)遮光膜層。蝕刻是顯影的下一步工序,是通過蝕刻介質(zhì)對(duì)遮光膜層進(jìn)行蝕刻,保留圖形。在蝕刻介質(zhì)的作用下,沒有光刻膠保護(hù)的區(qū)域會(huì)發(fā)生化學(xué)反應(yīng),而有光刻膠保護(hù)的區(qū)域的遮光膜層則會(huì)保留,這樣就形成了掩模版的圖案。因此,在顯影與刻蝕的環(huán)節(jié)中,蝕刻速率、刻蝕選擇比、均勻性等參數(shù)控制至關(guān)重要,均會(huì)對(duì)掩模版的精度水平產(chǎn)生重要影響。同時(shí),顯影刻蝕環(huán)節(jié)對(duì)溫度、液流擾動(dòng)、AMC控制等制程參數(shù)控制要求極為苛刻。
3、檢測(cè)環(huán)節(jié):掩模版上的各類缺陷通常極為微觀,能夠精準(zhǔn)識(shí)別并修補(bǔ)具有較高的技術(shù)難度掩模版在制造過程中產(chǎn)生的各種缺陷及各類精度偏差,與生產(chǎn)、傳輸、儲(chǔ)存等環(huán)節(jié)中出現(xiàn)的污染物,會(huì)通過半導(dǎo)體曝光工藝傳遞到下游芯片上,嚴(yán)重影響芯片的性能與良率,且隨著制程的不斷提高,對(duì)缺陷尺寸的容忍度越來越低。能夠精準(zhǔn)檢測(cè)出掩模版上納米級(jí)缺陷,并在不產(chǎn)生二次污染的情況下進(jìn)行精準(zhǔn)修補(bǔ),技術(shù)難度較高。
檢測(cè)環(huán)節(jié)核心技術(shù)
(1)檢測(cè)環(huán)節(jié)的重要性及難點(diǎn)
掩模版在制造過程中因生產(chǎn)環(huán)境、材料異常等原因產(chǎn)生的各種缺陷及各類精度偏差,與生產(chǎn)、傳輸、儲(chǔ)存等環(huán)節(jié)中出現(xiàn)的污染物,會(huì)通過半導(dǎo)體曝光工藝傳遞到下游芯片上,并以影響芯片性能與可靠性的缺陷形式存在。掩模版的缺陷主要包括瑕疵(Defect)、微粒(Particle)、圖形CD精度偏差過大、位置精度偏差過大等。掩模版生產(chǎn)中主要缺陷及其危害如下表所示:

掩模版的缺陷通常來說是非常微觀的(亞微米級(jí)別),但由于半導(dǎo)體掩模版線縫和精度要求較高,即使是亞微米級(jí)別的缺陷對(duì)掩模版的品質(zhì)也影響巨大,會(huì)直接影響到下游芯片成品的性能與良率,因此能夠及時(shí)、準(zhǔn)確地對(duì)掩模版上的各類缺陷進(jìn)行測(cè)量,并在不產(chǎn)生二次污染的情況下對(duì)缺陷進(jìn)行精準(zhǔn)修補(bǔ),具備較高的技術(shù)難度。
(2)檢測(cè)環(huán)節(jié)核心技術(shù)及具體表征
①高精度測(cè)量技術(shù)
掩模版生產(chǎn)后,必須對(duì)關(guān)鍵參數(shù)進(jìn)行精準(zhǔn)測(cè)量,驗(yàn)證實(shí)際制作精度與設(shè)計(jì)精度的一致性,同時(shí)還要對(duì)掩模版上的各種缺陷進(jìn)行檢測(cè)。公司自研了一系列掩模版精度測(cè)量及缺陷檢測(cè)技術(shù),包括AOI初檢、高精度CD測(cè)量、Overlay測(cè)量、居中測(cè)量、貼膜后檢查、終檢等工序,能夠有效地測(cè)量出掩模產(chǎn)品的關(guān)鍵參數(shù)及瑕疵(Defect)、微粒(Particle)、圖形CD精度偏差過大、位置精度偏差過大等缺陷情況。具體檢測(cè)技術(shù)、檢測(cè)水平如下表所示:

②缺陷修補(bǔ)與異物去除技術(shù)
針對(duì)在檢測(cè)環(huán)節(jié)中檢測(cè)出的一系列缺陷及異物,利用激光物理作用與蝕刻液化學(xué)反應(yīng)相結(jié)合的方式,高效、準(zhǔn)確的修復(fù)掩模版在生產(chǎn)過程產(chǎn)生的缺陷,有效地消除了激光修復(fù)后所產(chǎn)生修復(fù)印痕,避免了因缺陷修復(fù)所帶來的二次損傷。
獨(dú)立第三方掩模版廠商市場(chǎng)份額將不斷增大
半導(dǎo)體掩模版行業(yè)具有顯著的資本投入大、技術(shù)壁壘高、高度依賴專有技術(shù)的特點(diǎn)。晶圓制造廠商自行配套掩模工廠,主要是出于制作能力的考量,但隨著制程工藝逐漸成熟及第三方掩模版廠商的制作水平的不斷提升,自建掩模工廠的諸多弊端逐漸體現(xiàn),如設(shè)備、人工投入巨大,生產(chǎn)環(huán)節(jié)過于復(fù)雜,成本過于昂貴等。第三方半導(dǎo)體掩模版廠商能充分發(fā)揮技術(shù)專業(yè)化、規(guī)模化優(yōu)勢(shì),具有顯著的規(guī)模經(jīng)濟(jì)效應(yīng)。在技術(shù)水平、產(chǎn)品性能指標(biāo)符合要求前提下,獨(dú)立第三方掩模版廠商對(duì)晶圓制造廠商的吸引力不斷增加。
由于掩模版承載著芯片設(shè)計(jì)方案和圖形信息,涉及到芯片設(shè)計(jì)公司的重要知識(shí)產(chǎn)權(quán),第三方半導(dǎo)體掩模版廠商作為芯片設(shè)計(jì)與芯片制造的中間橋梁,能夠更好地發(fā)揮信息隔離功能,芯片設(shè)計(jì)公司更傾向于將芯片設(shè)計(jì)版圖交給第三方掩模廠進(jìn)行掩模生產(chǎn)以保證自身的信息安全。總體來看,隨著技術(shù)水平不斷提高,第三方獨(dú)立掩模版廠商競(jìng)爭(zhēng)優(yōu)勢(shì)將不斷體現(xiàn),市場(chǎng)份額將持續(xù)增加。
半導(dǎo)體掩模版行業(yè)具有較高的需求穩(wěn)定性
由于掩模版產(chǎn)品在半導(dǎo)體生產(chǎn)中起到光刻模具的功能,可多次曝光、重復(fù)使用,因此掩模版產(chǎn)品需求不僅依賴于半導(dǎo)體行業(yè)的整體規(guī)模情況,更依賴于下游半導(dǎo)體行業(yè)的產(chǎn)品創(chuàng)新。半導(dǎo)體創(chuàng)新產(chǎn)品越多,掩模版需求量越大。國(guó)內(nèi)半導(dǎo)體掩模版需求推動(dòng)因素如下:
①半導(dǎo)體產(chǎn)品不斷迭代創(chuàng)新:隨著我國(guó)半導(dǎo)體芯片行業(yè)的國(guó)產(chǎn)替代推進(jìn),技術(shù)水平、工藝能力不斷進(jìn)步,芯片設(shè)計(jì)公司將會(huì)不斷推出新的產(chǎn)品,對(duì)于掩模版的產(chǎn)品需求不斷增加。
②半導(dǎo)體掩模版具有部分逆產(chǎn)業(yè)周期特性:當(dāng)半導(dǎo)體行業(yè)處于下行周期,晶圓制造廠商的產(chǎn)能利用率不足時(shí),為了提升產(chǎn)能利用率,晶圓制造廠商會(huì)向眾多的中小芯片設(shè)計(jì)公司提供晶圓代工服務(wù),從而生產(chǎn)的半導(dǎo)體產(chǎn)品類型亦會(huì)增多,相應(yīng)增加掩模版的需求量;同時(shí)當(dāng)下游需求低迷時(shí),芯片設(shè)計(jì)公司將通過設(shè)計(jì)新產(chǎn)品刺激市場(chǎng),提升銷量,新產(chǎn)品也會(huì)帶來對(duì)掩模版的增量需求。
③半導(dǎo)體產(chǎn)品種類繁多,應(yīng)用廣泛:與產(chǎn)品種類較為集中的平板顯示行業(yè)相比,半導(dǎo)體行業(yè)的產(chǎn)品種類繁多、工藝多樣、應(yīng)用廣泛,不同類型的產(chǎn)品應(yīng)用于不同的終端場(chǎng)景,如消費(fèi)電子、人工智能、汽車電子、新能源、工業(yè)制造、無線通信、物聯(lián)網(wǎng)等,掩模版的需求此消彼長(zhǎng),不容易因某單一行業(yè)波動(dòng)而產(chǎn)生較大的需求影響。綜上所述,半導(dǎo)體掩模版行業(yè)具有較強(qiáng)抗周期行業(yè)特性,需求穩(wěn)定性較高。
未來發(fā)展趨勢(shì)
1、邏輯工藝路線和特色工藝路線是半導(dǎo)體發(fā)展的兩大方向
邏輯工藝路線和特色工藝路線是當(dāng)今半導(dǎo)體工藝兩大方向,代表了兩種產(chǎn)品性能提升的方式(線寬縮小與功能集成)。
兩者發(fā)展趨勢(shì)如下圖所示:
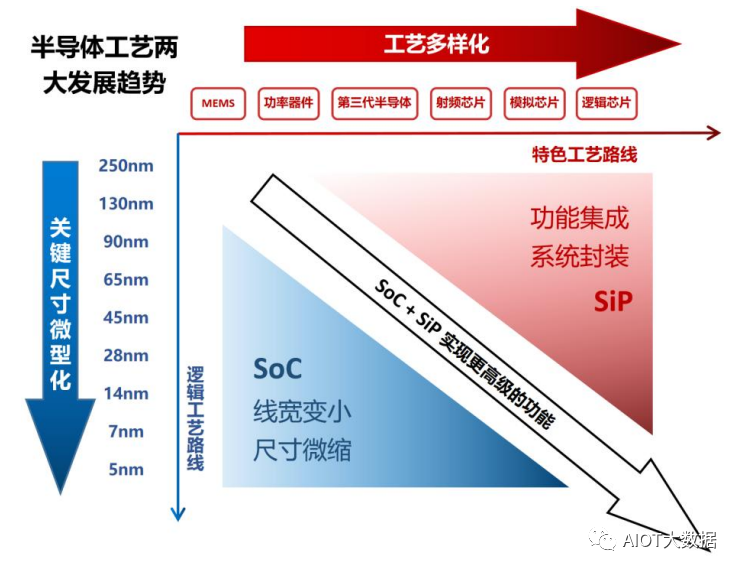
先進(jìn)邏輯工藝按照摩爾定律的規(guī)律,不斷追求工藝節(jié)點(diǎn)的縮小,從而滿足對(duì)于算力和速度提高的需求,以及功耗降低的需求;特色工藝路線是指以“超越摩爾定律(MorethanMoore)”為指導(dǎo),不完全依賴縮小晶體管特征尺寸,而是通過聚焦新材料、新結(jié)構(gòu)、新器件的研發(fā)創(chuàng)新與運(yùn)用,強(qiáng)調(diào)定制化和技術(shù)品類多元性的半導(dǎo)體晶圓制造工藝。特色工藝通過持續(xù)優(yōu)化器件結(jié)構(gòu)與制造工藝,最大化發(fā)揮不同器件的物理特性來提升產(chǎn)品性能及可靠性。特色工藝路線和邏輯工藝路線的相關(guān)對(duì)比如下表所示:

先進(jìn)邏輯工藝與特色工藝并非是相互割裂、非此即彼的關(guān)系,隨著對(duì)半導(dǎo)體性能需求的不斷提升,先進(jìn)邏輯芯片也會(huì)采用優(yōu)化器件結(jié)構(gòu)或集成其他工藝模塊的特色工藝技術(shù)來提升性能,如應(yīng)用于高性能CPU領(lǐng)域的3D封裝技術(shù);特色工藝芯片也會(huì)通過適當(dāng)?shù)乜s小晶體管線寬來實(shí)現(xiàn)更高的單位性能和能耗比。
以功率半導(dǎo)體為例,為了提高開關(guān)頻率和功率密度、降低功耗,功率半導(dǎo)體的制程工藝不斷進(jìn)步,從最初的10μm逐步縮小至目前主流的0.5μm~130nm左右;同時(shí),在器件結(jié)構(gòu)改進(jìn)方面,功率器件經(jīng)歷了平面、溝槽、超級(jí)結(jié)等器件結(jié)構(gòu)的變化,進(jìn)一步提高了器件的功率密度和工作頻率;而在材料方面,新興的第三代半導(dǎo)體功率器件采用了碳化硅、氮化鎵材料,進(jìn)一步提升了器件的開關(guān)特性、降低了功耗,也優(yōu)化了其耐高溫、耐高壓特性。功率半導(dǎo)體在多年的發(fā)展中,將線寬縮小與結(jié)構(gòu)、材料優(yōu)化相結(jié)合,實(shí)現(xiàn)了性能的飛躍。
由于摩爾定律不可避免地趨向物理極限,IC制造成本的不斷飆升使工藝尺寸的縮小變得愈發(fā)艱難。與開支大、折舊多、功能較為單一的邏輯工藝相比,特色工藝有著更強(qiáng)的盈利穩(wěn)定性和功能多樣性。因此,特色工藝路線是未來半導(dǎo)體制造發(fā)展的重要方向之一。
以臺(tái)積電為代表的先進(jìn)制程巨頭也在加快特色工藝布局,根據(jù)臺(tái)積電2022年技術(shù)論壇,臺(tái)積電特色工藝產(chǎn)能占臺(tái)積電成熟制程產(chǎn)能的比重將會(huì)從2018年的45%提升至2022年的63%,與2021年相比,2022年12寸晶圓的特色工藝產(chǎn)能會(huì)增長(zhǎng)14%;中芯國(guó)際也大力布局特色工藝,2018年中芯國(guó)際和紹興國(guó)資委等資本共同成立紹興中芯集成電路制造股份有限公司,專門面向MEMS、MOSFET和IGBT等特色工藝領(lǐng)域,致力于打造綜合性特色工藝基地。
2、半導(dǎo)體掩模版最小線寬及精度隨著半導(dǎo)體技術(shù)節(jié)點(diǎn)的進(jìn)步而不斷提升
半導(dǎo)體產(chǎn)品隨著工藝技術(shù)進(jìn)步和性能提升,線寬越來越窄,對(duì)上游掩模版的工藝水平和精度控制能力提出了更高要求。為了解決掩模版制作過程中由于線寬逐步縮小帶來的諸多難題,以O(shè)PC光學(xué)鄰近效應(yīng)修正技術(shù)、PSM相移掩模版技術(shù)、電子束光刻技術(shù)為代表的一系列圖形分辨率增強(qiáng)技術(shù)興起并快速發(fā)展。
3、特色工藝半導(dǎo)體快速發(fā)展,對(duì)掩模版定制化要求越來越高
特色工藝半導(dǎo)體主要包括功率半導(dǎo)體(含第三代半導(dǎo)體)、MEMS傳感器、先進(jìn)封裝、電源管理芯片、模擬芯片等工藝平臺(tái),近年來隨著新能源汽車、光伏發(fā)電、自動(dòng)駕駛、新一代移動(dòng)通信、人工智能等新技術(shù)的不斷成熟,工業(yè)控制、汽車電子等半導(dǎo)體主要下游制造行業(yè)的產(chǎn)業(yè)升級(jí)進(jìn)程加快,特色工藝半導(dǎo)體行業(yè)發(fā)展迅速。特色工藝不完全依賴縮小晶體管特征尺寸,而是聚焦于新材料、新結(jié)構(gòu)、新器件的研發(fā)創(chuàng)新與運(yùn)用,強(qiáng)調(diào)定制化和技術(shù)品類多元性。由于下游特色工藝半導(dǎo)體高度定制化,平臺(tái)繁多、種類龐雜、領(lǐng)域眾多,且通常會(huì)集成多種功能,這對(duì)于第三方掩模版廠商的定制化服務(wù)能力提出了更高的要求,掩模版廠商需要有足夠的技術(shù)儲(chǔ)備才能滿足快速發(fā)展的特色工藝半導(dǎo)體的定制化要求。
4、芯片光刻層數(shù)增加,導(dǎo)致掩模版的張數(shù)增加,數(shù)據(jù)處理難度加大,套刻精度控制要求更高
隨著終端產(chǎn)品的功能日趨復(fù)雜,半導(dǎo)體產(chǎn)品的集成度持續(xù)提高,晶圓制造的工藝不斷進(jìn)步。隨著芯片堆疊層數(shù)的增加,半導(dǎo)體器件與集成電路的電路圖也越發(fā)復(fù)雜,晶圓表面需要光刻的圖案由傳統(tǒng)的二維電路圖像發(fā)展成含有多層結(jié)構(gòu)的三維電路圖像,這也導(dǎo)致半導(dǎo)體掩模版的張數(shù)不斷增加,CAM版圖處理的難度進(jìn)一步加大,掩模版的套刻精度控制也更加困難。
面臨的機(jī)遇
(1)半導(dǎo)體受下游新興產(chǎn)業(yè)推動(dòng),產(chǎn)線持續(xù)擴(kuò)張,帶來半導(dǎo)體掩模版的大量需求
作為半導(dǎo)體行業(yè)可重復(fù)使用的光刻模板,掩模版產(chǎn)品直接需求與半導(dǎo)體產(chǎn)品的更新迭代與產(chǎn)線擴(kuò)充息息相關(guān)。當(dāng)半導(dǎo)體產(chǎn)品持續(xù)推出新工藝、新結(jié)構(gòu)、新材料等新的芯片設(shè)計(jì)或者需要產(chǎn)線擴(kuò)充時(shí),晶圓制造廠商需要使用新的掩模版來進(jìn)行半導(dǎo)體的大規(guī)模生產(chǎn),此時(shí)就會(huì)產(chǎn)生開版需求。因此,掩模版的市場(chǎng)需求與半導(dǎo)體更新?lián)Q代、產(chǎn)線擴(kuò)充直接相關(guān)。近年來受新能源汽車、光伏發(fā)電、工業(yè)自動(dòng)化、物聯(lián)網(wǎng)等下游新興產(chǎn)業(yè)推動(dòng),以功率器件為代表的特色工藝半導(dǎo)體發(fā)展迅速,不斷進(jìn)行產(chǎn)品迭代,為半導(dǎo)體掩模版創(chuàng)造了大量的市場(chǎng)需求。
以新能源汽車、光伏行業(yè)中的關(guān)鍵元件功率器件為例,根據(jù)IBS的統(tǒng)計(jì),2021年中國(guó)功率器件市場(chǎng)規(guī)模約為711億元,預(yù)計(jì)2025年市場(chǎng)規(guī)模將增長(zhǎng)至1,102億元,年平均復(fù)合增長(zhǎng)率為11.58%。國(guó)內(nèi)主要特色工藝晶圓廠均在積極擴(kuò)充產(chǎn)線,帶來國(guó)內(nèi)半導(dǎo)體掩模版的配套需求大幅增加。國(guó)內(nèi)主要特色工藝半導(dǎo)體廠商擴(kuò)產(chǎn)情況如下所示:

上述終端行業(yè)的繁榮發(fā)展推動(dòng)了半導(dǎo)體產(chǎn)線的持續(xù)擴(kuò)張,相應(yīng)持續(xù)帶來對(duì)配套掩模版的大量需求,未來半導(dǎo)體掩模版市場(chǎng)空間廣闊。
(2)特色工藝半導(dǎo)體受下游功能需求驅(qū)動(dòng),不斷進(jìn)行產(chǎn)品更新迭代,帶來半導(dǎo)體掩模版的大量需求
特色工藝半導(dǎo)體產(chǎn)品隨著下游應(yīng)用的功能需求不斷進(jìn)行更新迭代。以新能源汽車為例,隨著電動(dòng)汽車的續(xù)航不斷提升,動(dòng)力電池能量密度、充電模組的功率越來越高,而單個(gè)車輛對(duì)半導(dǎo)體的數(shù)量、體積等因素有一定的約束,因此功率半導(dǎo)體的功率密度、單位性能也要求越來越高。功率半導(dǎo)體必須通過結(jié)構(gòu)、制程、技術(shù)、工藝、集成度、材料等方面的不斷進(jìn)步,來實(shí)現(xiàn)功率密度及單位性能的提升。功率半導(dǎo)體的技術(shù)演進(jìn)如下表所示:

半導(dǎo)體的結(jié)構(gòu)、制程、技術(shù)、工藝、集成度、材料每發(fā)生一次迭代,就需要更換一套新的半導(dǎo)體掩模版。因此,在當(dāng)前新興行業(yè)的不斷驅(qū)動(dòng)下,功率半導(dǎo)體等半導(dǎo)體產(chǎn)品持續(xù)進(jìn)行更新迭代,帶來了大量的特色工藝半導(dǎo)體掩模版需求。
(3)半導(dǎo)體掩模版迎來國(guó)產(chǎn)替代機(jī)遇
半導(dǎo)體產(chǎn)業(yè)是信息技術(shù)產(chǎn)業(yè)的核心,也是經(jīng)濟(jì)發(fā)展的支柱性產(chǎn)業(yè),在實(shí)現(xiàn)制造業(yè)升級(jí)、保障國(guó)家安全等方面發(fā)揮著重要的作用,在當(dāng)前貿(mào)易摩擦、半導(dǎo)體產(chǎn)業(yè)逆全球化的背景下,加速進(jìn)口替代已上升到國(guó)家戰(zhàn)略高度。我國(guó)政府從財(cái)政、稅收、技術(shù)、人才、知識(shí)產(chǎn)權(quán)等多個(gè)方面對(duì)半導(dǎo)體產(chǎn)業(yè)及其關(guān)鍵材料給予了政策支持,為半導(dǎo)體行業(yè)創(chuàng)造了良好的經(jīng)營(yíng)環(huán)境,有力地推動(dòng)了我國(guó)半導(dǎo)體行業(yè)的發(fā)展。
掩模版作為半導(dǎo)體產(chǎn)業(yè)的上游核心材料,技術(shù)壁壘高,國(guó)內(nèi)自產(chǎn)率低,長(zhǎng)期依賴國(guó)外進(jìn)口,第三方半導(dǎo)體掩模版市場(chǎng)主要被美國(guó)Photronics、日本Toppan、日本DNP等國(guó)際掩模版巨頭所控制。隨著新能源汽車、光伏發(fā)電、自動(dòng)駕駛、物聯(lián)網(wǎng)等新一輪科技逐漸走向產(chǎn)業(yè)化,未來十年中國(guó)半導(dǎo)體行業(yè)尤其是特色工藝半導(dǎo)體有望迎來進(jìn)口替代與成長(zhǎng)的黃金時(shí)期。在貿(mào)易摩擦等宏觀環(huán)境不確定性增加的背景下,作為半導(dǎo)體核心原材料的國(guó)內(nèi)半導(dǎo)體掩模版行業(yè)發(fā)展迎來了歷史性的機(jī)遇。
半導(dǎo)體掩模版研發(fā)是一個(gè)不斷探索光學(xué)物理極限的過程
半導(dǎo)體生產(chǎn)工藝通常采用投影式光刻方法,在投影式光刻中,激光透過掩模版后,經(jīng)過投影物鏡成像到晶圓的光刻膠表面,通過掩模版對(duì)光線的遮擋或透過功能,實(shí)現(xiàn)掩模圖案向晶圓線路圖的圖形轉(zhuǎn)移。半導(dǎo)體掩模版的技術(shù)演進(jìn)的過程,正是不斷解決極限情況下光的干涉與衍射現(xiàn)象、克服物理極限的過程。
光刻方式通常根據(jù)曝光方式分為接觸式光刻、接近式光刻、投影式光刻三類。其中,對(duì)于曝光面積較大、分辨率要求相對(duì)較低的平板顯示類產(chǎn)品,通常使用接近式光刻的方法,能夠?qū)崿F(xiàn)掩模圖案與基底圖案的1:1復(fù)制;對(duì)于曝光面積相對(duì)較小、精度與分辨率要求極為苛刻的半導(dǎo)體類產(chǎn)品,通常使用投影式光刻方法,能夠?qū)崿F(xiàn)掩模圖案與基底圖案的4:1或5:1復(fù)制。
投影式光刻原理如下圖所示:
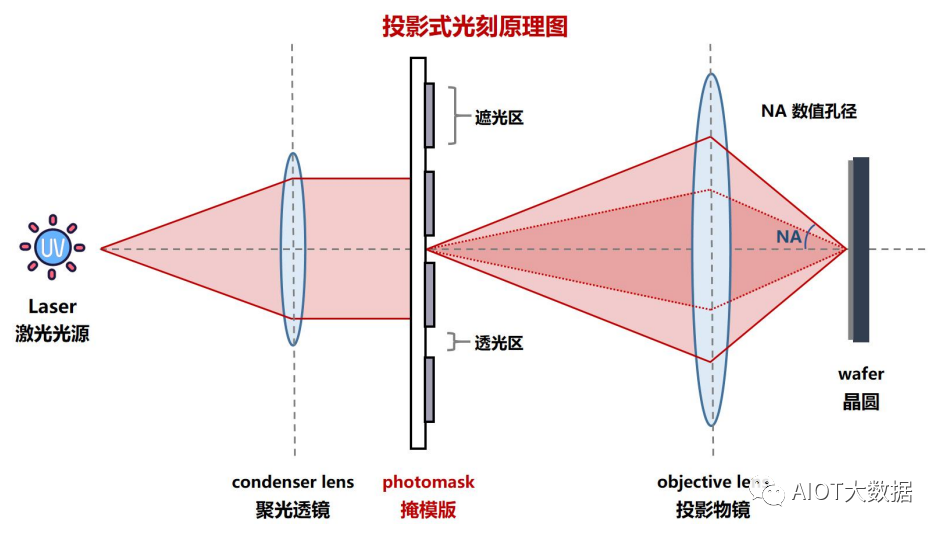
(1)光的衍射會(huì)降低曝光圖形分辨率,導(dǎo)致CD精度降低
隨著掩模版的線寬和線縫越來越小,當(dāng)尺寸逐漸接近光刻機(jī)的波長(zhǎng)時(shí),曝光過程中就會(huì)出現(xiàn)嚴(yán)重的衍射現(xiàn)象。光的衍射現(xiàn)象是指光在傳播過程中,遇到尺寸與波長(zhǎng)大小相近的障礙物時(shí),光會(huì)傳到障礙物的陰影區(qū)并形成明暗變化的光強(qiáng)分布情況。這種情況在投影式光刻中尤為明顯,激光通過掩模版的透光區(qū)和投影物鏡后會(huì)出現(xiàn)顯著的夫瑯禾費(fèi)衍射現(xiàn)象,導(dǎo)致曝光圖形邊緣的分辨率降低,圖案邊緣失真嚴(yán)重,CD精度大幅下降。因此,為了提高光刻環(huán)節(jié)曝光圖形的CD精度,必須要對(duì)掩模圖案進(jìn)行光學(xué)鄰近效應(yīng)修正(OPC)。
夫瑯禾費(fèi)衍射,又稱遠(yuǎn)場(chǎng)衍射,是波動(dòng)衍射的一種,在場(chǎng)波通過圓孔或狹縫時(shí)發(fā)生,導(dǎo)致觀測(cè)到的成像大小有所改變,成因是觀測(cè)點(diǎn)的遠(yuǎn)場(chǎng)位置,及通過圓孔向外的衍射波有漸趨平面波的性質(zhì)。
由于光的衍射造成的圖像失真及OPC效果對(duì)比情況如下圖所示。
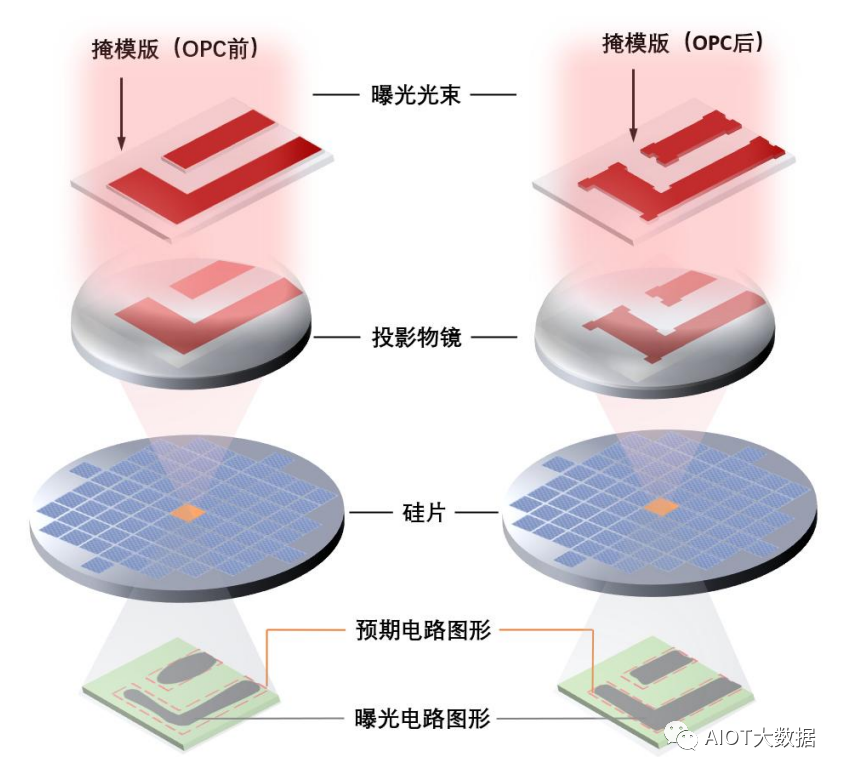
(2)光的干涉會(huì)降低曝光圖形對(duì)比度,導(dǎo)致CD精度降低
隨著掩模版圖形越來越復(fù)雜、線路密度越來越大,掩模版的透光區(qū)間距離便越來越短,此時(shí)曝光過程中就會(huì)出現(xiàn)顯著的干涉現(xiàn)象。光的干涉是指兩束相干光相遇而引起光的強(qiáng)度重新分布的現(xiàn)象。當(dāng)掩模版的透光區(qū)間位置趨于接近時(shí),從相鄰兩個(gè)透光區(qū)射出的光線頻率相同、振動(dòng)方向相近、相位差恒定,形成了相干光。兩列或多列相干光在空間相遇時(shí)相互疊加,光強(qiáng)在某些區(qū)域始終加強(qiáng),在另一些區(qū)域則始終削弱,出現(xiàn)了穩(wěn)定的強(qiáng)弱分布現(xiàn)象。上述現(xiàn)象會(huì)造成晶圓感光時(shí)遮光區(qū)域仍有曝光、透光區(qū)域光強(qiáng)不足的情況,導(dǎo)致整體的對(duì)比度降低,CD精度大幅下降,從而嚴(yán)重影響了晶圓的電路圖形質(zhì)量。當(dāng)半導(dǎo)體的最小線寬小于130nm后,傳統(tǒng)的二元掩模版(BinaryMask)會(huì)由于光的干涉現(xiàn)象而無法對(duì)晶圓進(jìn)行有效曝光,需要采用相移掩模版(PhaseShiftMask,PSM)來消除曝光光束中的干涉現(xiàn)象,提升CD精度水平。二元掩模版和PSM掩模版的原理如下圖所示:

(3)半導(dǎo)體掩模版的套刻層數(shù)越來越多,位置/套刻精度控制難度越來越大
隨著半導(dǎo)體功能的不斷進(jìn)步,制程能力的不斷提升,半導(dǎo)體器件與集成電路的細(xì)微電路圖也越發(fā)復(fù)雜,晶圓表面需要光刻的圖案由傳統(tǒng)的二維電路圖像發(fā)展成含有多層結(jié)構(gòu)的三維電路圖像(如下圖所示),這也導(dǎo)致半導(dǎo)體掩模版的層數(shù)不斷增加,對(duì)掩模版的套刻精度也提出了更高的要求。
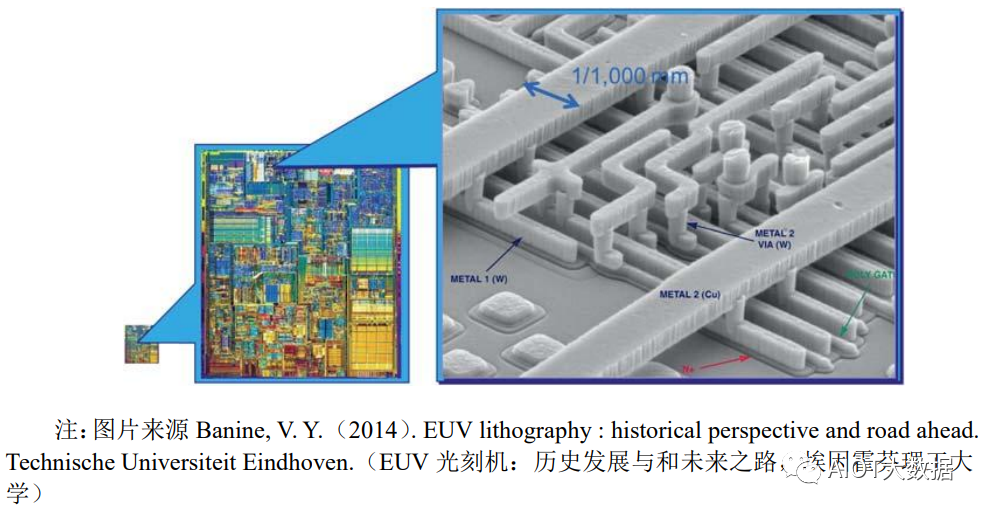
(4)電子束光刻技術(shù)
光刻機(jī)的最小分辨率由公式R=kλ/NA決定,其中R代表可分辨的最小尺寸,k是工藝常數(shù),λ是光刻機(jī)所用光源的波長(zhǎng)。因此,光刻機(jī)所用光源的波長(zhǎng)越短,分辨率越高。激光光刻中,光的波長(zhǎng)已經(jīng)趨于極限,難以制造更短波長(zhǎng)的光刻機(jī),因此為了達(dá)到更高的分辨率會(huì)使用電子束光刻技術(shù)。
電子束光刻是利用電子束在基板上進(jìn)行直寫的光刻技術(shù),相比于激光光刻能夠達(dá)到更高的分辨率,用于更高端半導(dǎo)體掩模版的制造。目前公司已開展電子束光刻技術(shù)研究及刻蝕、涂膠、烘烤、清洗等后制程相關(guān)研究工作,已取得一定的技術(shù)成果。
(5)PSM相移掩模版技術(shù)
隨著芯片設(shè)計(jì)圖形的特征尺寸不斷縮小,當(dāng)特征尺寸達(dá)到或者接近光刻機(jī)激光光源波長(zhǎng)的情況下,會(huì)出現(xiàn)明顯的干涉效應(yīng),由于已經(jīng)達(dá)到了曝光的分辨率極限,掩模圖案轉(zhuǎn)移到晶圓時(shí)會(huì)出現(xiàn)丟失和失真的現(xiàn)象,采用PSM技術(shù)可以解決這一問題。
PSM相移掩模版技術(shù)是一種利用光線的強(qiáng)度和相位來成像,得到更高分辨率的分辨率增強(qiáng)技術(shù),其基本原理是通過改變掩模結(jié)構(gòu),使得透過相鄰?fù)腹鈪^(qū)域的光波產(chǎn)生180度的相位差,二者發(fā)生相消干涉,消除因干涉效應(yīng)造成的光刻圖像邊緣模糊現(xiàn)象,提高光刻分辨率。相移掩模版在生產(chǎn)過程需要進(jìn)行兩次光刻圖形轉(zhuǎn)移過程,因此相移掩模版的生產(chǎn)周期會(huì)成倍增加;第一次光刻圖形為主要功能性圖形,第二次光刻圖形為輔助圖形,兩層圖形之間需要非常高的對(duì)位精準(zhǔn)度和相位角精準(zhǔn)度,存在較高的技術(shù)壁壘。
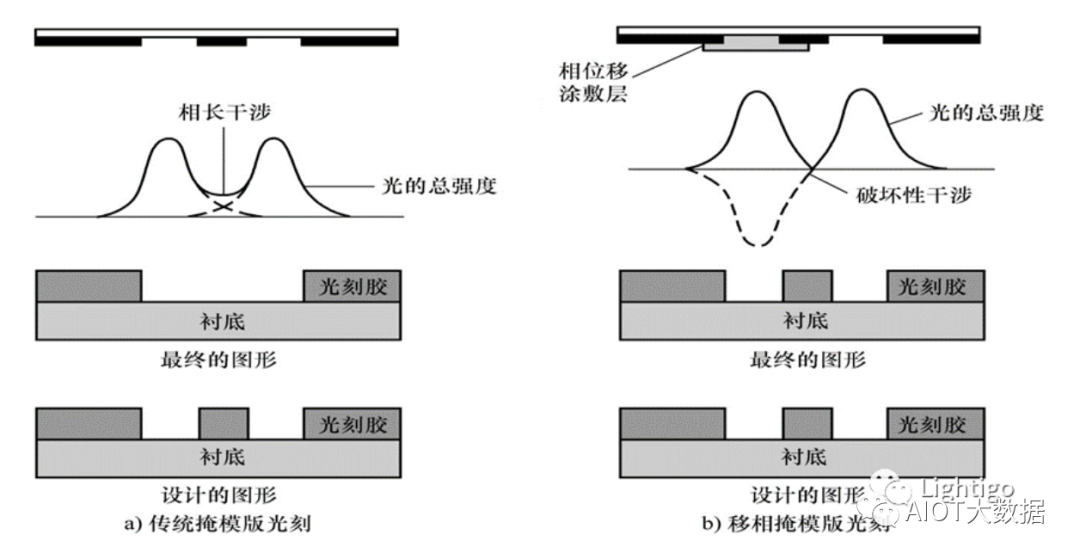
由于PSM相移掩模版制備難度大,通常應(yīng)用在130nm工藝制程以下節(jié)點(diǎn)的集成電路關(guān)鍵層的光刻工藝中,較多應(yīng)用在90nm節(jié)點(diǎn)以下大規(guī)模集成電路制造上。
關(guān)鍵指標(biāo):
掩模版產(chǎn)品的精度要求是與制程水平息息相關(guān)的,隨著掩模版制程水平的提高,掩模圖案繪制的最小線寬縮小,精度要求(包括CD精度、CD精度均值偏差、CD均勻性、位置精度、套刻精度)也隨著線寬的縮小而越來越高,因此,制程水平是衡量掩模版產(chǎn)品技術(shù)水平的最關(guān)鍵指標(biāo)。
半導(dǎo)體掩模版的關(guān)鍵指標(biāo)參數(shù)包括下游晶圓最小線寬(CDSize)、CD精度(CDTolerance)、CD精度均值偏差(CDMean-to-Target)、CD均勻性(CDUniformity/CDRange)、位置精度(Registration)、套刻精度(Overlay)、缺陷尺寸(DefectSize)。
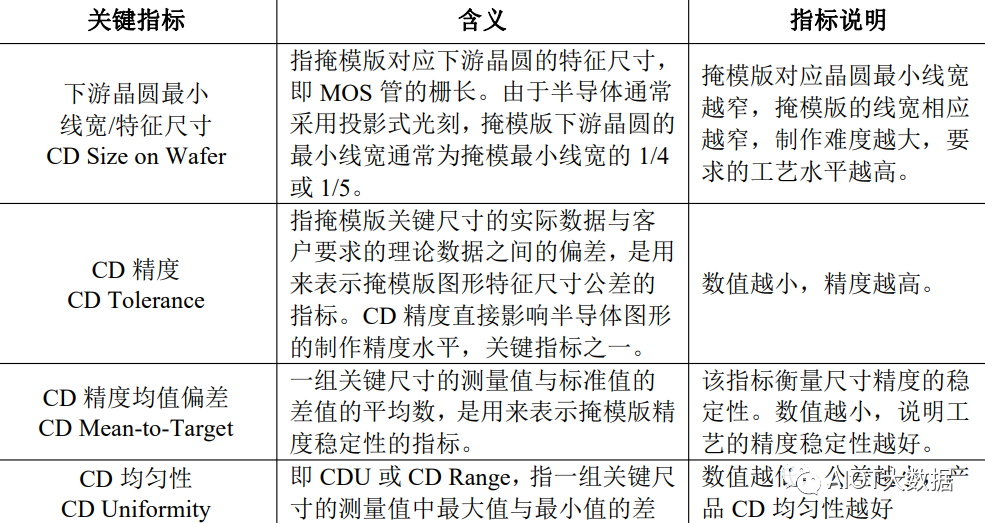
 ? ?
? ?
審核編輯:劉清
-
濾光片
+關(guān)注
關(guān)注
2文章
85瀏覽量
11156 -
TFT-LCD
+關(guān)注
關(guān)注
13文章
153瀏覽量
32305 -
薄膜晶體管
+關(guān)注
關(guān)注
1文章
30瀏覽量
9922 -
半導(dǎo)體芯片
+關(guān)注
關(guān)注
60文章
927瀏覽量
71223
原文標(biāo)題:技術(shù)前沿:掩模版(光罩MASK)——半導(dǎo)體芯片的母板
文章出處:【微信號(hào):AIOT大數(shù)據(jù),微信公眾號(hào):AIOT大數(shù)據(jù)】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
LCD段碼屏鉻版掩模版
2025年,全球集成電路(IC)光掩模市場(chǎng)總銷售有望達(dá)到1508.54百萬美元
掩模版主要廠商市場(chǎng)份額包括國(guó)外企業(yè)和國(guó)內(nèi)企業(yè)

***的簡(jiǎn)易工作原理圖 掩模版都有哪些種類?
一文解析EUV掩模版缺陷分類、檢測(cè)、補(bǔ)償

光刻可制造性檢查如何檢測(cè)掩模版質(zhì)量

上交所:龍圖光罩將于12月15日科創(chuàng)板首發(fā)上會(huì)

龍圖光罩科創(chuàng)板IPO獲批,募投項(xiàng)目技術(shù)和經(jīng)濟(jì)可行性是關(guān)鍵?
龍圖光罩科創(chuàng)板IPO獲證監(jiān)會(huì)批準(zhǔn)
龍圖光罩:致力于高端半導(dǎo)體掩模版國(guó)產(chǎn)化的先鋒






 什么是掩模版?掩模版(光罩MASK)—半導(dǎo)體芯片的母板設(shè)計(jì)
什么是掩模版?掩模版(光罩MASK)—半導(dǎo)體芯片的母板設(shè)計(jì)
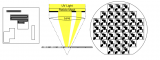










評(píng)論