前言
國產(chǎn)功率半導(dǎo)體已在眾多領(lǐng)域應(yīng)用,特別是低端產(chǎn)品,如二極管、三極管、晶閘管、低壓 MOSFET(非車規(guī))等,已初現(xiàn)“規(guī)模化效應(yīng)、國產(chǎn)化率相對較高”等特點。在中高端領(lǐng)域,如 SJ MOSFET、IGBT、碳化硅等,特別是車規(guī)產(chǎn)品,由于起步晚、工藝相對復(fù)雜以及缺乏車規(guī)驗證機會等問題,國內(nèi)廠家依然在追隨海外廠家技術(shù)發(fā)展路線。在2023年深圳國際電子展論壇上株洲中車時代半導(dǎo)體有限公司副總經(jīng)理肖強給大家介紹了《車規(guī)級功率半導(dǎo)體技術(shù)挑戰(zhàn)與整體解決方案》。主要圍繞車規(guī)級功率半導(dǎo)體器件的技術(shù)挑戰(zhàn)、技術(shù)發(fā)展、產(chǎn)品解決方案以及未來趨勢展望幾個方面做了詳細介紹。
車規(guī)級功率半導(dǎo)體器件的技術(shù)挑戰(zhàn)
國內(nèi)新能源汽車銷量快速增長——2030年預(yù)測將接近2000萬輛
市場規(guī)模持續(xù)增長:2023年上半年國內(nèi)新能源車銷量374.7萬輛,同比增長44.1%,市場滲透率達28.3%
電驅(qū)功率不斷抬升:≤70kW電驅(qū)占比縮小,≥130kW電驅(qū)占比增加
SiC器件替代率提高:預(yù)計2025年SiC替代率將達到~20%

高壓化
乘用車800V電壓平臺(泛指600V~900V電池電壓),實現(xiàn)電池快充
提升電池電壓,降低電流-減少互聯(lián)材料用量,降低整車重量,降本并節(jié)省空間
整車電氣架構(gòu)高壓化,要求器件耐壓能力提升,同時兼顧器件損耗

高功率
電驅(qū)和電控向大功率等級方向發(fā)展,短時峰值功率輸出能力越來越高,實現(xiàn)更好的用戶體驗 電驅(qū)和電控向高功率密度方向發(fā)展,節(jié)省整車空間,降低整車重量
高功率密度電驅(qū)系統(tǒng),要求功率器件出流能力更高,體積更小、重量更輕

高效率
時間效率——快速充電
快速充電對于減輕用戶的續(xù)航焦慮非常重要。主流快充技術(shù)目前充電速度在50-150kW,未來需要更高功率快充。
降低成本 更高的電驅(qū)效率,能夠節(jié)省更多的電池成本。
提高續(xù)航里程

目前大部分電動汽車的續(xù)航里程(NEDC)在300—500km。未來需要繼續(xù)提高電驅(qū)和電機傳動系統(tǒng)的效率,以延長續(xù)航里程

高可靠性
電驅(qū)系統(tǒng)壽命要求越來越長,需要功率器件可靠性高,使用壽命長
技術(shù)維度——功率循環(huán)能力需提升3倍以上,環(huán)境耐受能力、機械振動耐受能力需同步提升
可靠性維度——建立壽命預(yù)測模型,仿真結(jié)合實際應(yīng)用多應(yīng)力綜合評估,實現(xiàn)壽命精確計算
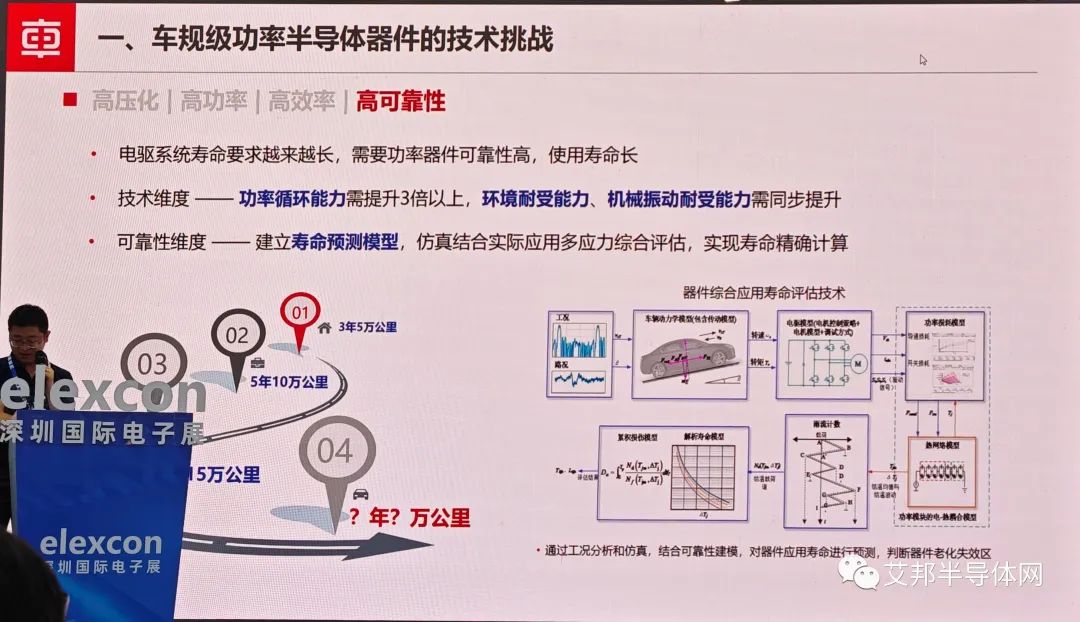
對功率器件需求"既要低損耗(高續(xù)航),又要高極限能力"
既要和又要”體現(xiàn)出對器件綜合性能要求更高,包括開關(guān)特性、通態(tài)特性和電壓能力

如何做到綜合性能的均衡性,是對器件設(shè)計和應(yīng)用的高挑戰(zhàn) 
車規(guī)級功率器件的技術(shù)發(fā)展
先進微細加工技術(shù)支持IGBT芯片技術(shù)逐步逼近硅材料極限
SiC技術(shù)在材料和工藝技術(shù)的基礎(chǔ)上發(fā)展,不斷演進
封裝技術(shù)圍繞“高載流、高散熱、高結(jié)溫”、“功率密度提升的熱電耦合設(shè)計”“可靠性保障的材料、工藝、結(jié)構(gòu)技術(shù)”三方面不斷演進。
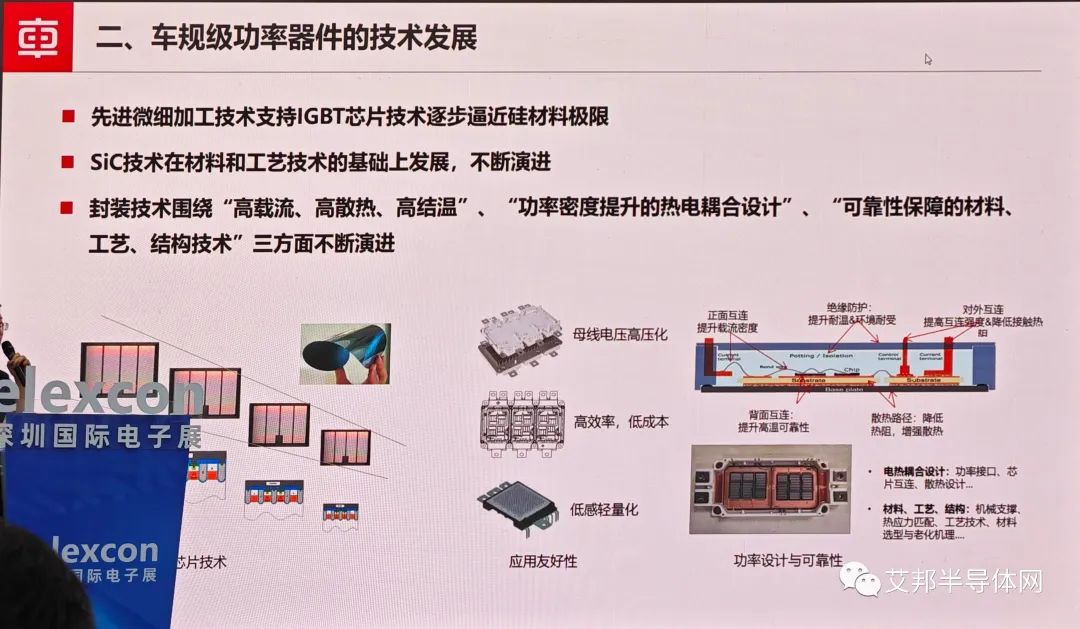
1、芯片技術(shù)發(fā)展趨勢
更低成本
更高功率密度
更高工作結(jié)溫
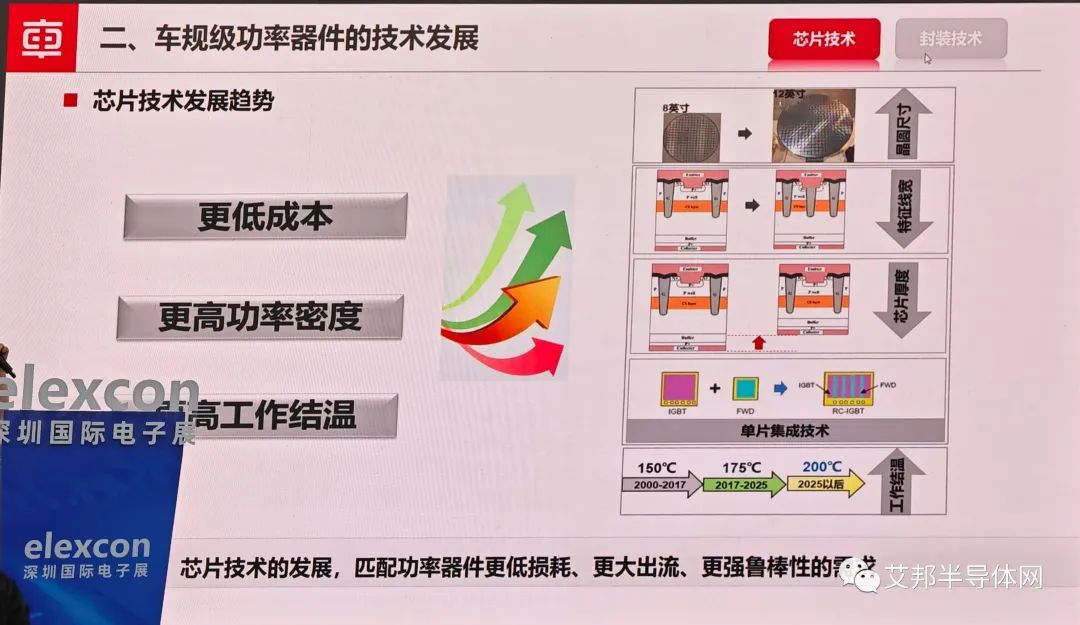
芯片技術(shù)的發(fā)展,匹配功率器件更低損耗、更大出流、更強魯棒性的需求
2、封裝技術(shù)發(fā)展趨勢
更高工作結(jié)溫:最高工作結(jié)溫至175°C以上,提升功率密度
更強正面載流:提升長期可靠性,滿足大電流應(yīng)用
更優(yōu)背面散熱:更優(yōu)散熱流道設(shè)計,結(jié)合低熱阻封裝方案,提升器件出流能力
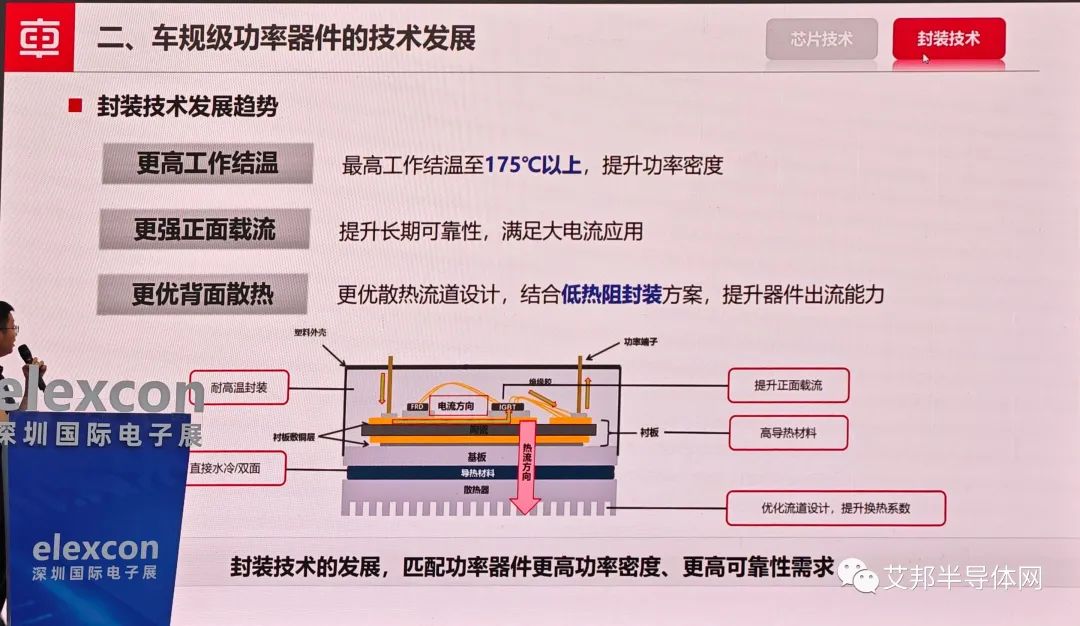
封裝技術(shù)的發(fā)展,匹配功率器件更高功率密度、更高可靠性需求。
更高工作結(jié)溫
特種焊接技術(shù)——Pin針+端子超聲,建立高質(zhì)量互連,避免更高結(jié)溫應(yīng)用PIN針脫落問題
轉(zhuǎn)模環(huán)氧樹脂——高Tg(>250°C),實現(xiàn)高溫絕緣保護;樹脂固化作用,PC能力提升3倍以上
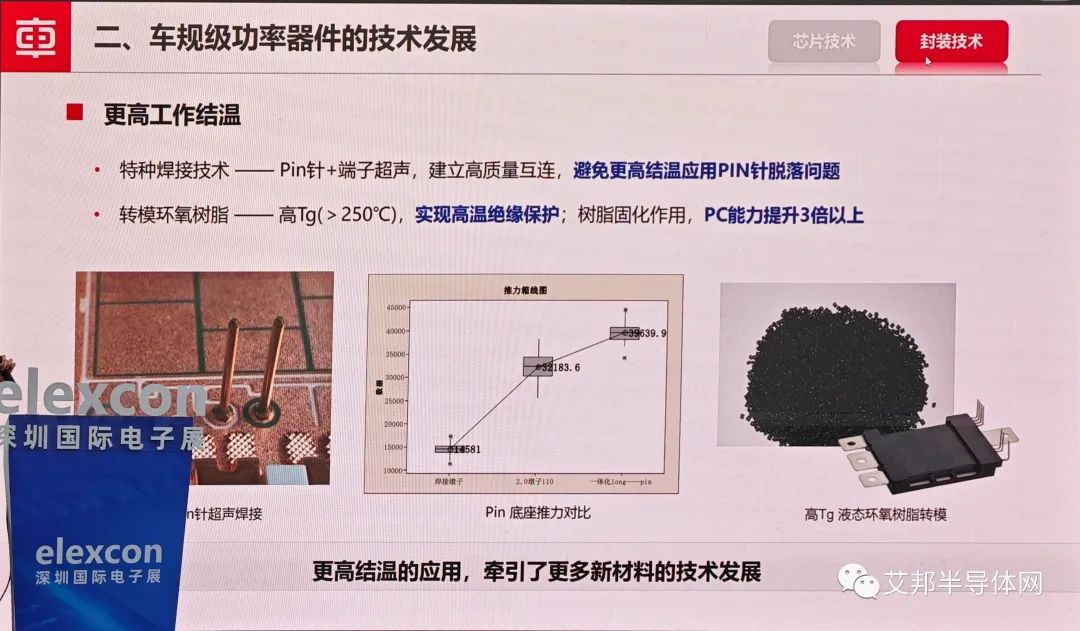
更高結(jié)溫的應(yīng)用,牽引了更多新材料的技術(shù)發(fā)展
更強正面載流
DTS技術(shù)——雙面銀燒結(jié)+銅線鍵合,熔點超過800°C,功率循環(huán)能力10倍以上
Cu-clip技術(shù)——減小模塊內(nèi)阻,降低靜態(tài)損耗,降低熱耦合,器件出流提升
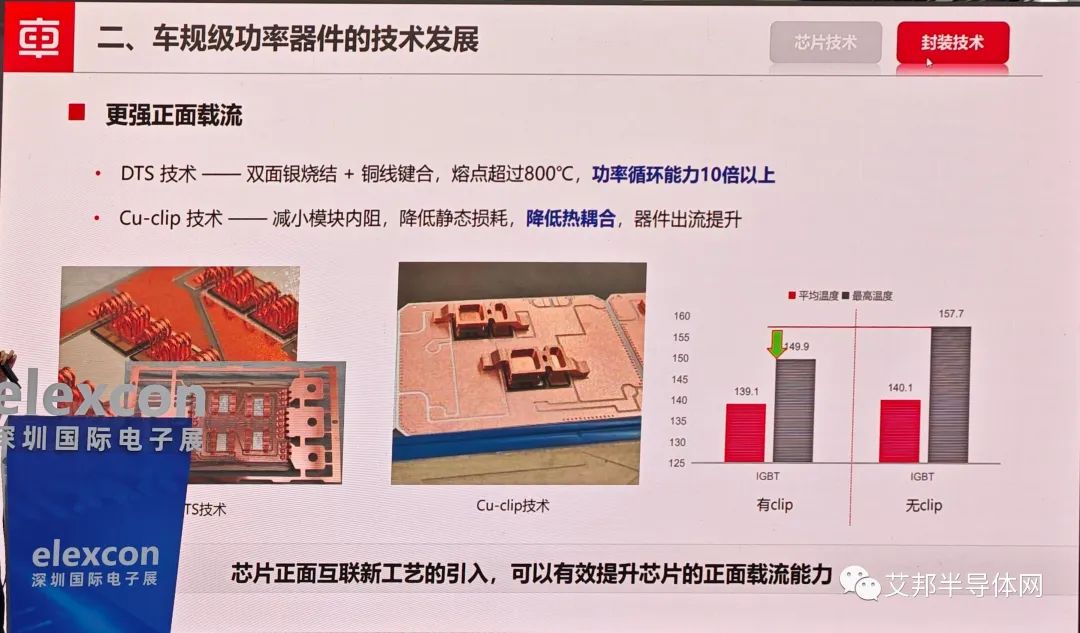
芯片正面互聯(lián)新工藝的引入,可以有效提升芯片的正面載流能力。
更優(yōu)背面散熱
降低接觸熱阻——銀燒結(jié)技術(shù)—界面熱阻降低10%以上
降低傳導(dǎo)熱阻——高導(dǎo)熱陶瓷技術(shù)—DBC層熱阻降低15%以上
新結(jié)構(gòu)增強換熱——高效基板散熱技術(shù)—模塊熱阻降低20%以上
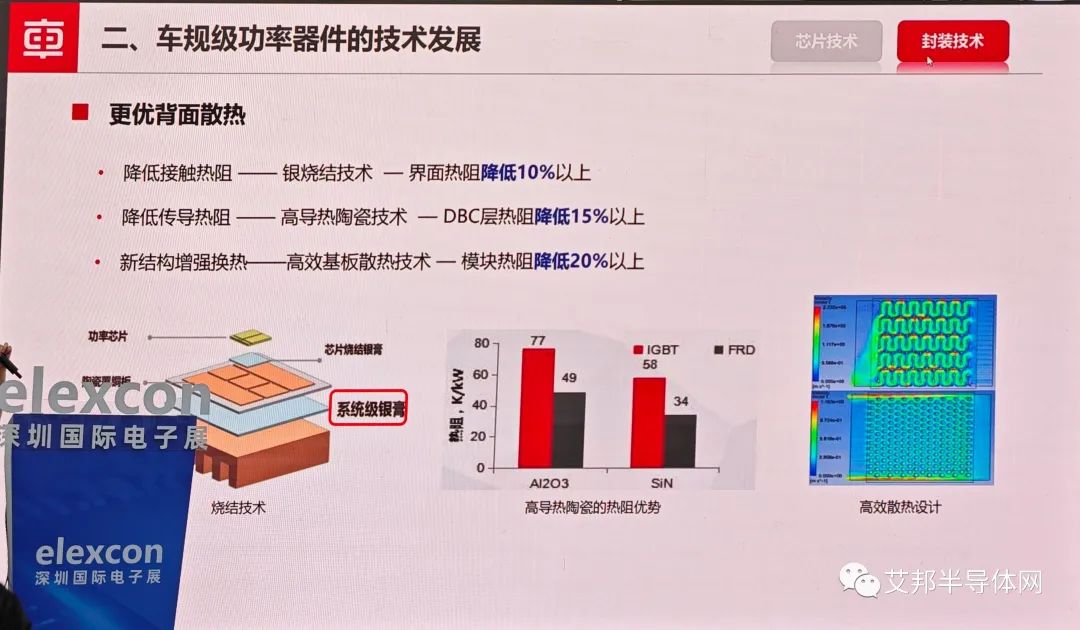
新封裝結(jié)構(gòu)
框架封裝——耐受更高溫度,更高功率密度,更小模塊體積,更低電感設(shè)計
轉(zhuǎn)模封裝——適用高結(jié)溫應(yīng)用(SiC芯片),高良率,低成本,滿足客戶定制化應(yīng)用場景(單管、半橋)

車規(guī)級產(chǎn)品解決方案
1、芯片產(chǎn)品
a)中車第七代超精細溝槽柵STMOSIGBT芯片
超薄片技術(shù):70μm 8英寸IGBT晶圓
亞微米精細元胞技術(shù):臺面寬度0.6μm ,接觸尺寸0.2μm
高可靠性復(fù)合金屬膜層技術(shù):功率循環(huán)能力提升40%以上
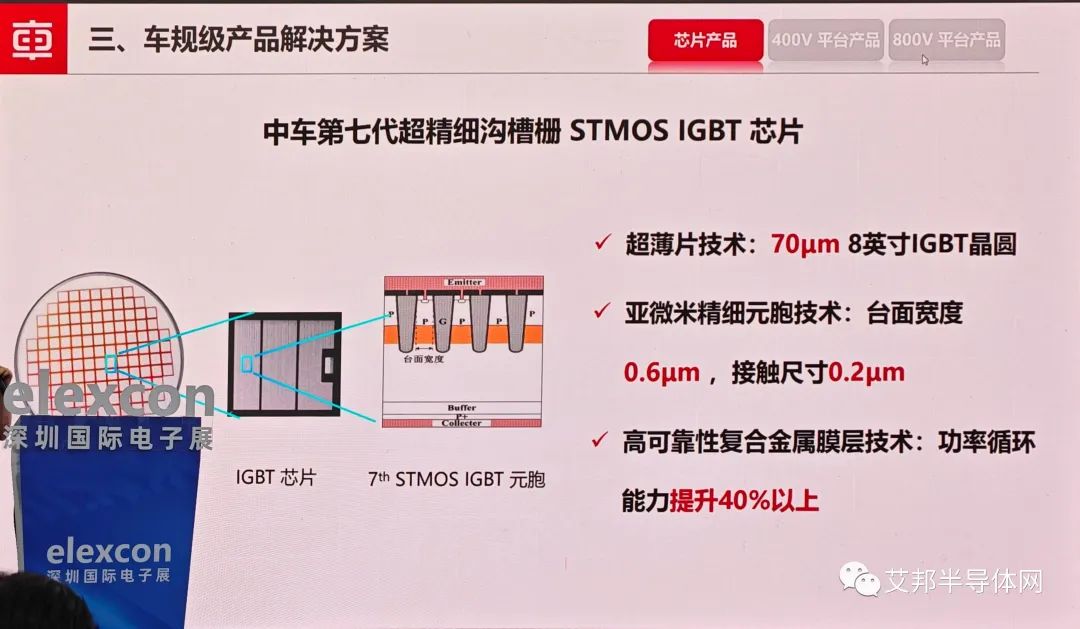
b)中車第二代精細平面柵SiC芯片
SiCMOSFET芯片技術(shù)
引入載流子擴展層技術(shù)、薄片技術(shù)及柵氧遷移率提升:比導(dǎo)通電阻降低至3.5mΩ·cm2以下
超高溫?zé)嵫趸夹g(shù):抑制柵氧界面缺陷,擴展柵極電壓窗口,提升產(chǎn)品可靠性水平
SiCSBD芯片技術(shù)
零反向恢復(fù)損耗
薄片技術(shù)提升電流密度至300A/cm2
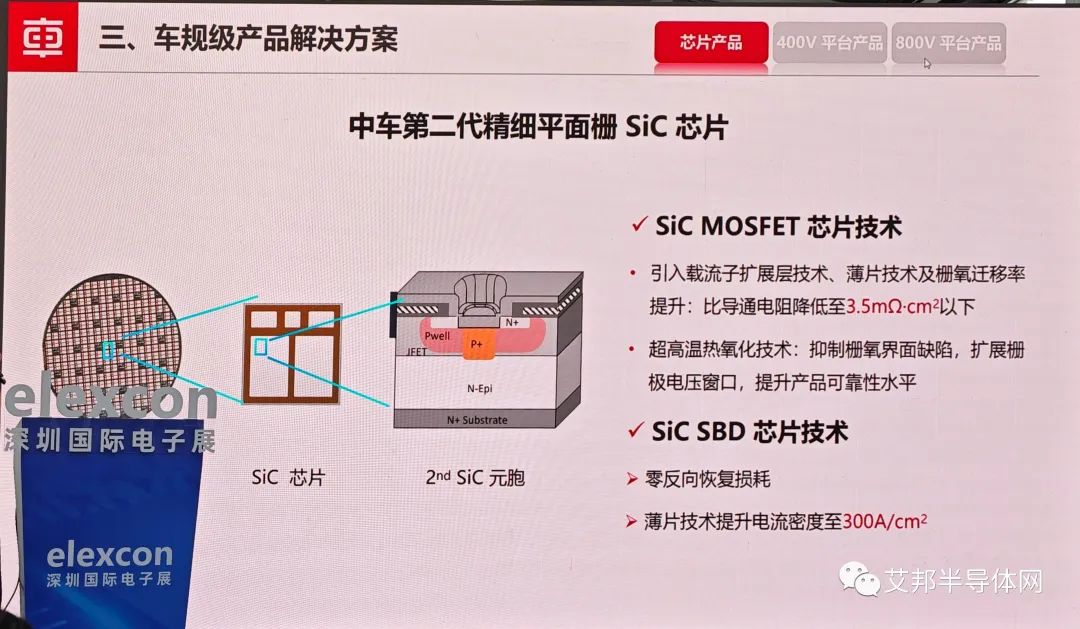
2、400V平臺產(chǎn)品
標稱電流:從 400A~1000A 等級
功率等級:覆蓋 40kW~200kW 等級
封裝形式:包括SO、S2 、S3以及定制化類型
芯片持續(xù)迭代,為器件出流能力&電控效率的提升提供解決方案
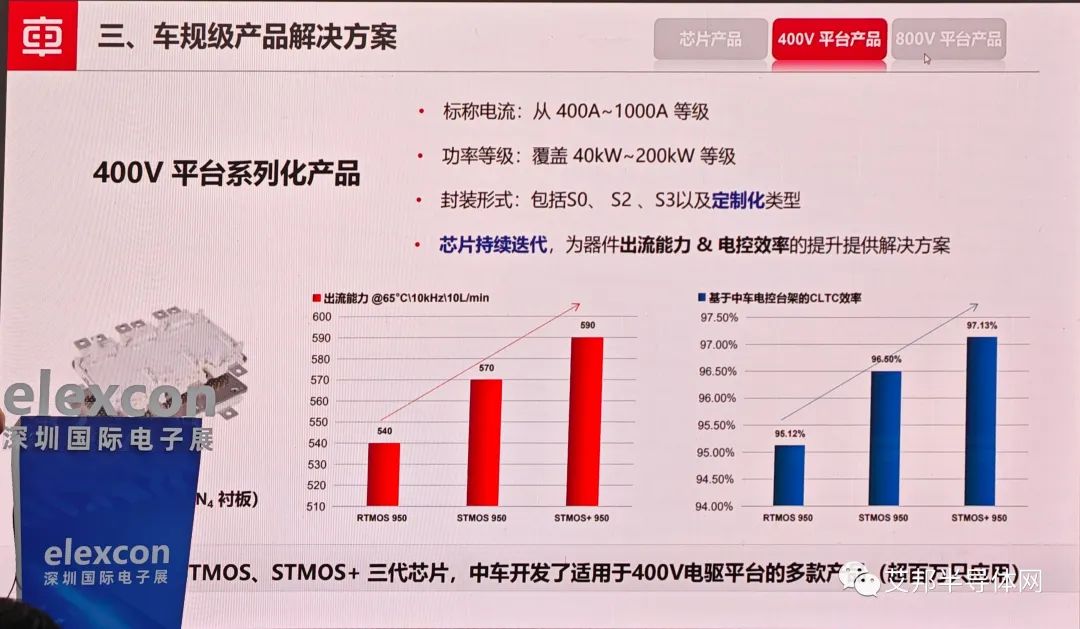
3、800V平臺產(chǎn)品
7thSTMOS1200V/600AS3+
出流:790V/400A/8K,@Tvjmax=150°C
魯棒性:可通過800V對管常開三溫短路測試(被測15V,陪測18V),保障系統(tǒng)安全
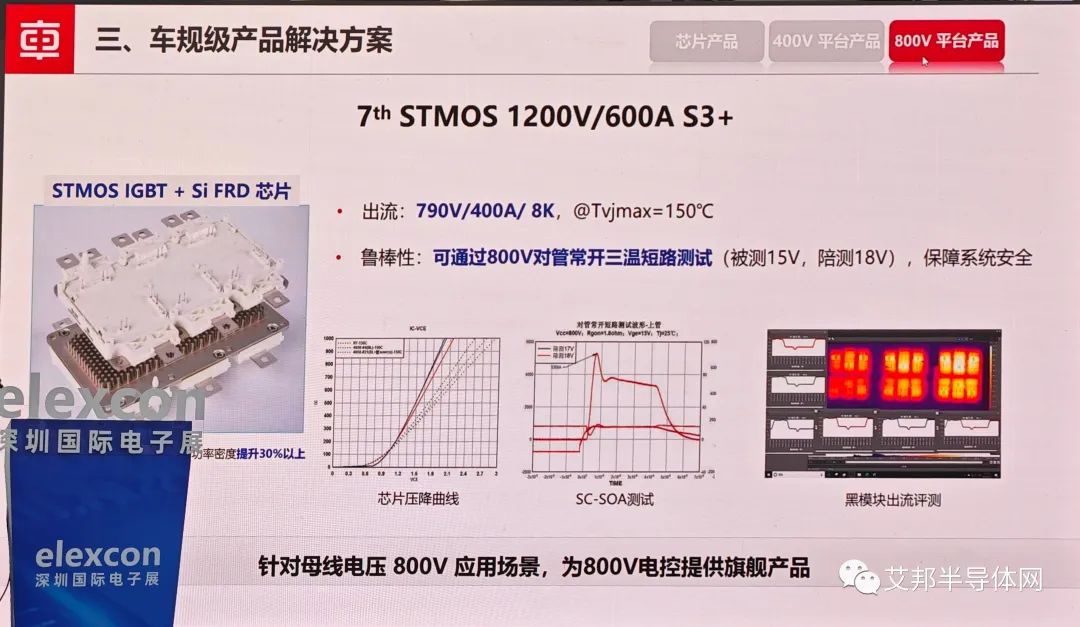
針對母線電壓800V應(yīng)用場景,為800V電控提供旗艦產(chǎn)品
7thSTMOS1300V/600AS3+
出流:880V/320A/10K,@Tvjmax=150°C
魯棒性:Vcepk、Vrrpk、SCSOA 安全裕量更大
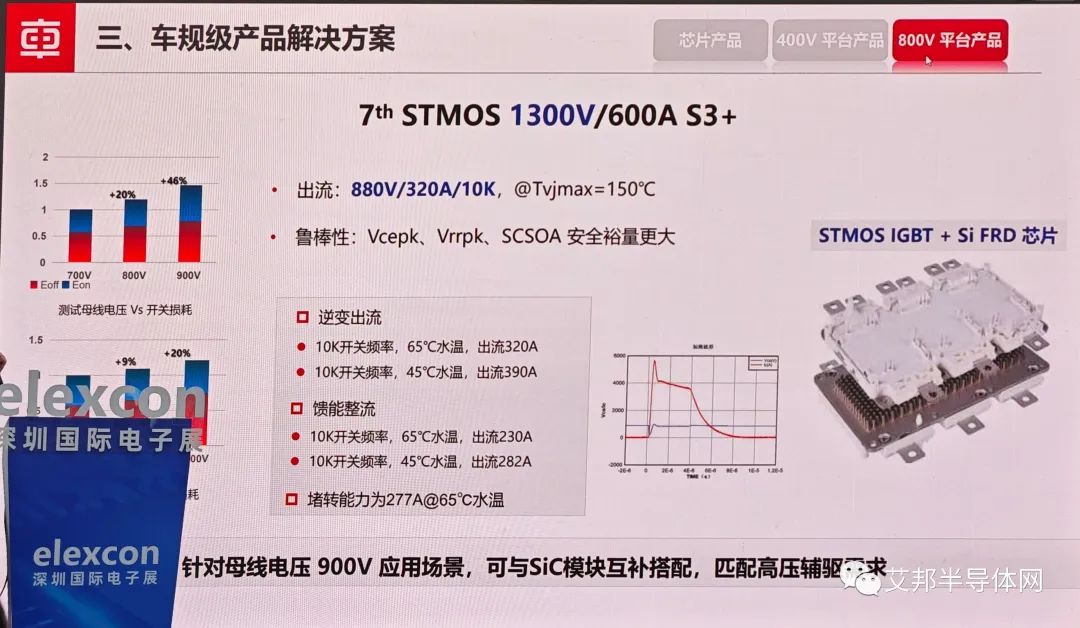
針對母線電壓900V應(yīng)用場景,可與Sic模塊互補搭配,匹配高壓輔驅(qū)需求
7thSTMOS1200V/600A混合SiCS3+
芯片:SiC SBD無反向恢復(fù)電流,器件動態(tài)損耗降低21%~27%(相比全SiGBT模塊)
出流:逆變輸出能力提升26.5%,整流能力提升21.9%
產(chǎn)品:出流能力提升,效率更高,滿足高壓平臺、更大功率平臺需求
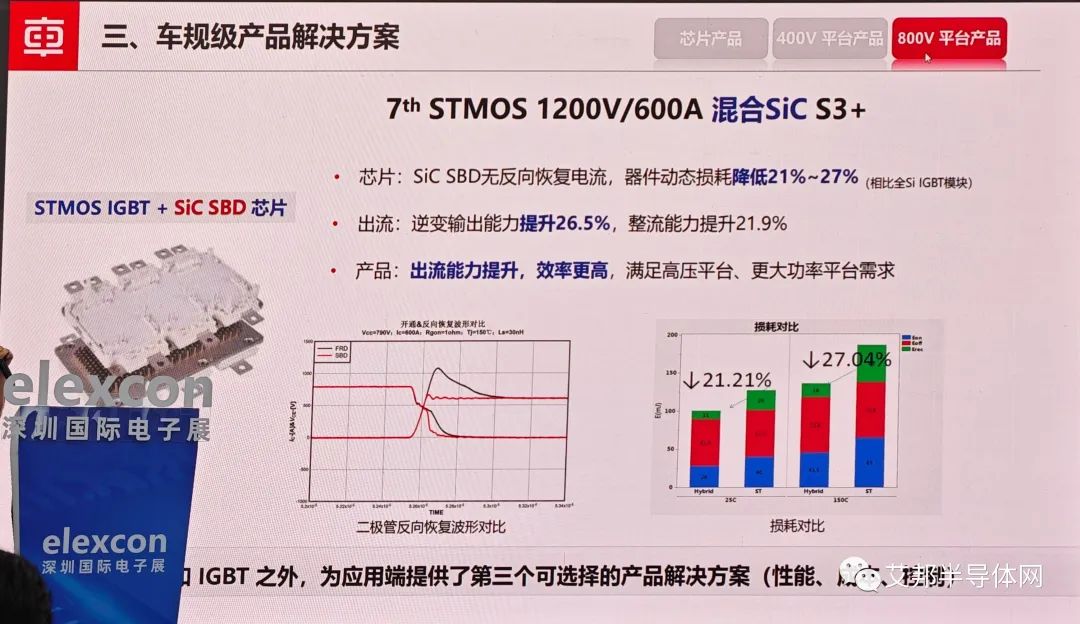
在SiC和IGBT之外,為應(yīng)用端提供了第三個可選擇的產(chǎn)品解決方案(性能、成本、控制)
1200V/660ASiCL5
芯片:中車自主SiC芯片,器件動態(tài)損耗降低56%~71%(相比全SiGBT模塊)
封裝:低熱阻,高均流,低寄生電感,界面高可靠,大幅提升器件壽命&PC能力
效率:800V/350A/10K,L5 SiC 功耗降低33%
出流:通過改變SiC芯片數(shù)量,支持不同功率等級需求,可擴展至250kW-400kW 峰值輸出
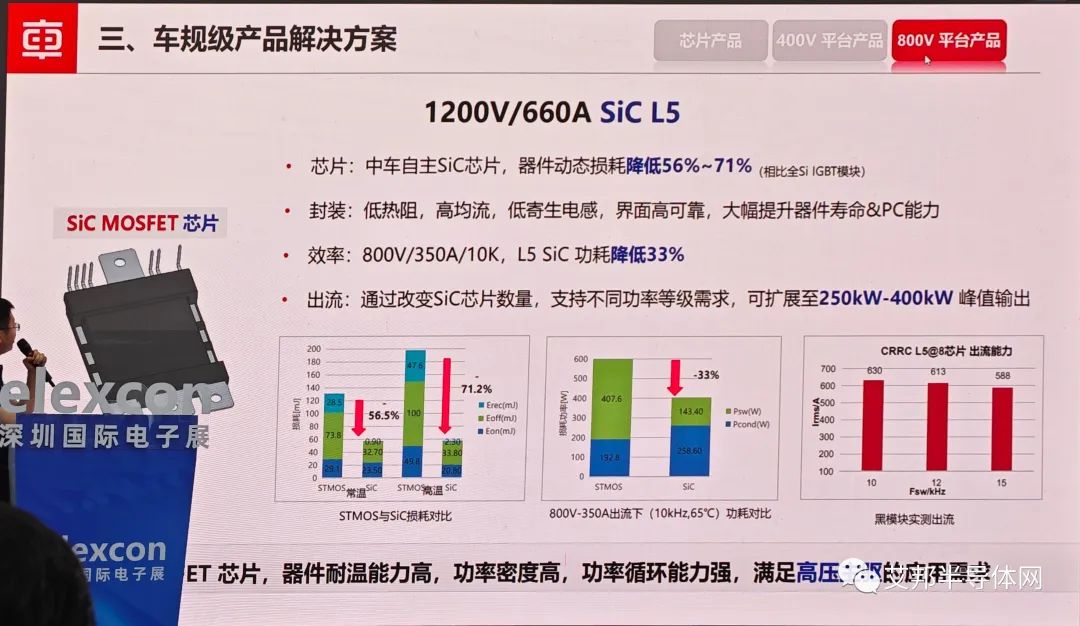
SiC MOSFET 芯片,器件耐溫能力高,功率密度高,功率循環(huán)能力強,滿足高壓主驅(qū)的應(yīng)用需求。
4、IGBT芯片
2023年7.5thSTMOS+
175°C結(jié)溫溝槽技術(shù)
電流密度330A/cm2
高溫漏電降低50%
工況效率提升1%
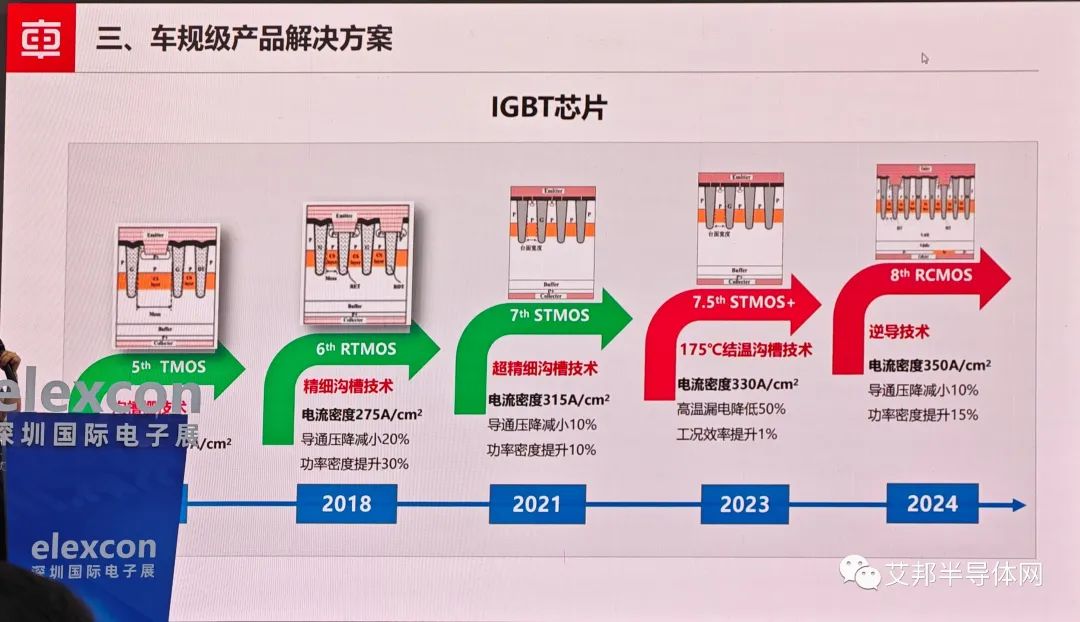
2024年8thRCMOS+
逆導(dǎo)技術(shù)
電流密度350A/cm2
導(dǎo)通壓降減小10%
功率密度提升15%
5、SiC芯片
2024年3rdSiCDMOS+
平面柵技術(shù)
比導(dǎo)通電陽3.2mΩ·cm2
2025年4thSiCTMOS
溝槽柵技術(shù)
比導(dǎo)通電阻2.5mΩ·cm2
2027年5thSiCTMOS+
精細溝槽柵技術(shù)
元胞尺寸1.8μm
比導(dǎo)通電阻1.8mΩ·cm2

未來趨勢展望
1、集成化,智能化
逆導(dǎo)型IGBT
低熱阻:IGBT熱阻低30%,F(xiàn)RD熱阻低60%
特性均衡:各工況(堵轉(zhuǎn)&整流與逆變)極限出流能力均較高
器件小型化,電流密度提升

芯片傳感集成
溫度傳感:精準檢測,溫差小于8C,響應(yīng)速度遠高于NTC
電流傳感:短路保護速度高于退飽和檢測(保護時間1~2μs內(nèi))
精準保護,模塊功率輸出能力提升20%
2、應(yīng)用突破,新拓撲
SiIGBT/SiCMOSFET并聯(lián)混合拓撲
優(yōu)勢
性能:MOSFET開關(guān)損耗優(yōu)勢+IGBT大電流導(dǎo)通優(yōu)勢
靈活:采用多種控制策略,實現(xiàn)損耗、結(jié)溫、效率的多目標優(yōu)化
成本:調(diào)控Si IGBT與SiC MOSFET數(shù)量,性能與成本最優(yōu)選擇
挑戰(zhàn)
驅(qū)動復(fù)雜:5種以上控制策略,驅(qū)動控制選擇及設(shè)計難度大
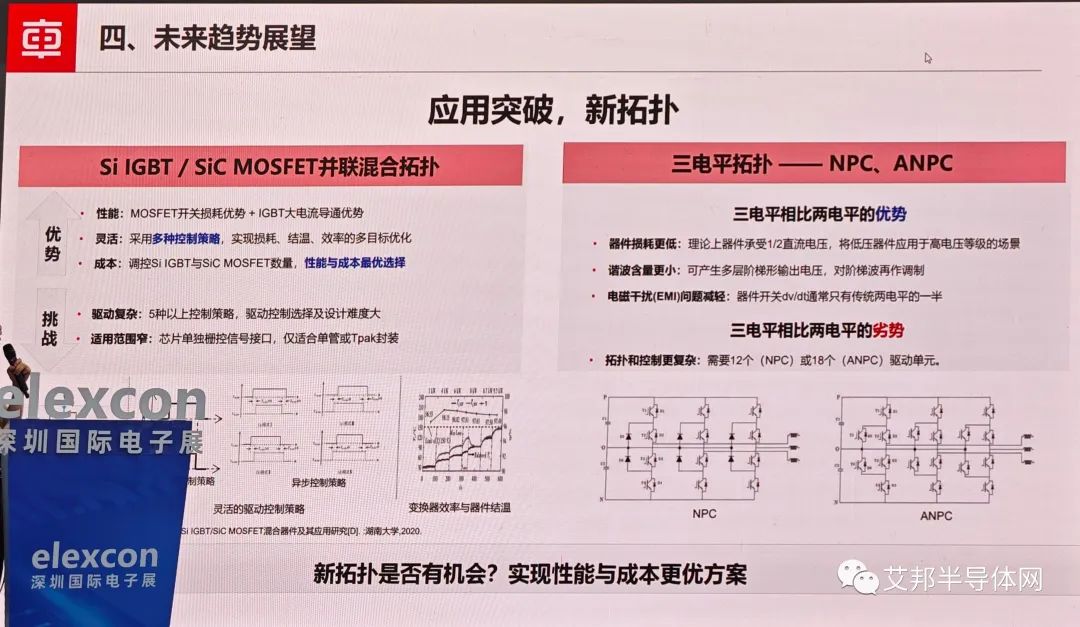
三電平拓撲-NPC、ANPC
三電平相比兩電平的優(yōu)勢
器件損耗更低:理論上器件承受1/2直流電壓,將低壓器件應(yīng)用于高電壓等級的場景
諧波含量更小:可產(chǎn)生多層階梯形輸出電壓,對階梯波再作調(diào)制
電磁干擾(EMI)問題減輕:器件開關(guān)dv/dt通常只有傳統(tǒng)兩電平的一半
三電平相比兩電平的劣勢
拓撲和控制更復(fù)雜:需要12個(NPC)或18個(ANPC)驅(qū)動單元。
逼近硅極限,超越摩爾,升級新材料開拓功率新局面
新材料、新工藝、新結(jié)構(gòu),在封裝上的變化與發(fā)展永不停步
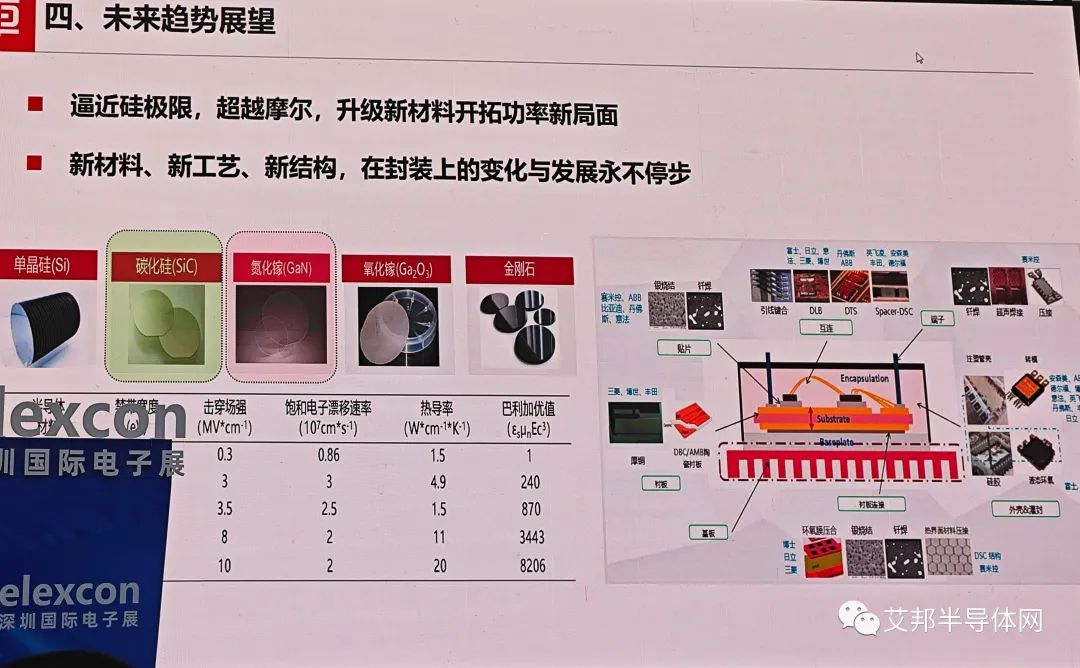
-
新能源汽車
+關(guān)注
關(guān)注
141文章
10898瀏覽量
101320 -
功率半導(dǎo)體
+關(guān)注
關(guān)注
23文章
1275瀏覽量
43836 -
碳化硅
+關(guān)注
關(guān)注
25文章
3015瀏覽量
50051
原文標題:中車時代:車規(guī)級功率半導(dǎo)體技術(shù)挑戰(zhàn)與整體解決方案
文章出處:【微信號:汽車半導(dǎo)體情報局,微信公眾號:汽車半導(dǎo)體情報局】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
美信檢測榮獲車規(guī)級功率半導(dǎo)體技術(shù)服務(wù)杰出供應(yīng)商
車規(guī)級芯片國產(chǎn)替代全景:覆蓋MCU、功率半導(dǎo)體智能座艙技術(shù)路線

會展動態(tài)|TMC2025車規(guī)級功率半導(dǎo)體論壇「初步日程+展覽」首發(fā)

SGS車規(guī)半導(dǎo)體設(shè)計培訓(xùn)深圳站成功舉行
南芯科技布局車規(guī)級芯片領(lǐng)域的戰(zhàn)略規(guī)劃
新聲半導(dǎo)體多款濾波器獲AEC-Q200車規(guī)認證
易沖半導(dǎo)體推出超簡車規(guī)USB-PD快充IC CPSQ8831
基本半導(dǎo)體碳化硅MOSFET通過AEC-Q101車規(guī)級認證
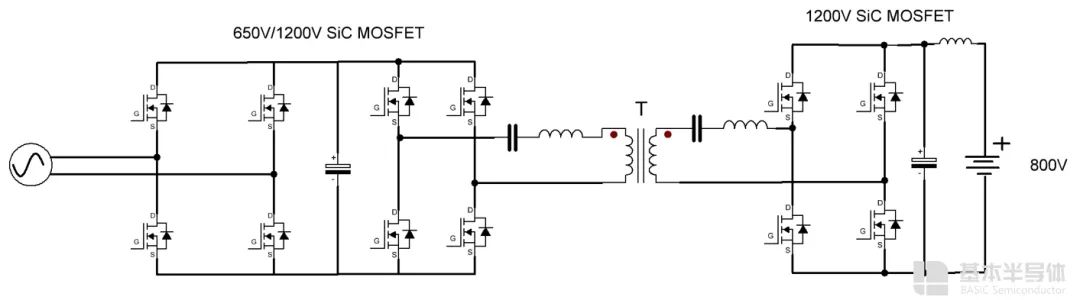
展會直擊 | 高云攜車規(guī)器件及方案精彩亮相elexcon2024深圳國際電子展

車規(guī)級IGBT模組:成本背后的復(fù)雜系統(tǒng)解析

車規(guī)級芯片車身空調(diào)控制方案Demo
基本半導(dǎo)體碳化硅MOSFET通過車規(guī)級認證,為汽車電子注入新動力
TMC2024丨車規(guī)級功率半導(dǎo)體論壇劇透二丨全球技術(shù)趨勢與主驅(qū)功率半導(dǎo)體應(yīng)用創(chuàng)新

TMC2024丨車規(guī)級功率半導(dǎo)體論壇劇透一丨SiC模塊特色封裝與半導(dǎo)體制造技術(shù)創(chuàng)新






 中車時代:車規(guī)級功率半導(dǎo)體技術(shù)挑戰(zhàn)與整體解決方案
中車時代:車規(guī)級功率半導(dǎo)體技術(shù)挑戰(zhàn)與整體解決方案











評論