陶瓷基板(銅箔鍵合到氧化鋁基片上的板)是指銅箔在高溫下直接鍵合到氧化鋁(Al2O3)或氮化鋁(AlN)陶瓷基片表面( 單面或雙面)上的特殊工藝板。所制成的超薄復合基板具有優良電絕緣性能,高導熱特性,優異的軟釬焊性和高的附著強度,并可像PCB板一樣能刻蝕出各種圖形,具有很大的載流能力。因此,陶瓷基板已成為大功率電力電子電路結構技術和互連技術的基礎材料。
二
陶瓷基板的特點
◆機械應力強,形狀穩定;高強度、高導熱率、高絕緣性;結合力強,防腐蝕。
◆ 較好的熱循環性能,循環次數達5萬次,可靠性高。
◆與PCB板(或IMS基片)一樣可刻蝕出各種圖形的結構;無污染、無公害。
◆使用溫度寬-55℃~850℃;熱膨脹系數接近硅,簡化功率模塊的生產工藝。
三
陶瓷基板的種類
一、按材料來分
1、 Al2O3
氧化鋁基板是電子工業中最常用的基板材料,因為在機械、熱、電性能上相對于大多數其他氧化物陶瓷,強度及化學穩定性高,且原料來源豐富,適用于各種各樣的技術制造以及不同的形狀。
2、BeO
具有比金屬鋁還高的熱導率,應用于需要高熱導的場合,但溫度超過300℃后迅速降低,最重要的是由于其毒性限制了自身的發展。
3 、AlN
AlN有兩個非常重要的性能值得注意:一個是高的熱導率,一個是與Si相匹配的膨脹系數。缺點是即使在表面有非常薄的氧化層也會對熱導率產生影響,只有對材料和工藝進行嚴格控制才能制造出一致性較好的AlN基板。不過隨著經濟的提升,技術的升級,這種瓶頸終會消失。
綜合以上原因,可以知道,氧化鋁陶瓷由于比較優越的綜合性能,在微電子、功率電子、混合微電子、功率模塊等領域還是處于主導地位而被大量運用。
二、 按制造工藝來分:
現階段較普遍的陶瓷散熱基板種類共有HTCC、LTCC、DBC、DPC、LAM五種,HTCC\LTCC都屬于燒結工藝,成本都會較高。而DBC與DPC則為國內近年來才開發成熟,且能量產化的專業技術,DBC是利用高溫加熱將Al2O3與Cu板結合,其技術瓶頸在于不易解決Al2O3與Cu板間微氣孔產生的問題以及開裂的問題,這使得該產品的量產能量與良率受到較大的挑戰,隨著新材料技術的發展以及制程工藝的不斷進步,DBC的空洞和開裂問題正在探索解決中而大幅度提高產品良率成為可能。而DPC技術則是利用直接鍍銅技術,將Cu沉積于Al2O3基板之上,其工藝結合材料與薄膜工藝技術,其產品為近年最普遍使用的陶瓷散熱基板。然而其材料控制與工藝技術整合能力要求較高,這使得跨入DPC產業并能穩定生產的技術門檻相對較高。LAM技術又稱作激光快速活化金屬化技術。
1、HTCC (High-Temperature Co-fired Ceramic):HTCC又稱為高溫共燒多層陶瓷,生產制造過程與LTCC極為相似,主要的差異點在于HTCC的陶瓷粉末并無加入玻璃材質,因此,HTCC的必須再高溫1300~1600℃環境下干燥硬化成生胚,接著同樣鉆上導通孔,以網版印刷技術填孔與印制線路,因其共燒溫度較高,使得金屬導體材料的選擇受限,其主要的材料為熔點較高但導電性卻較差的鎢、鉬、錳…等金屬,最后再疊層燒結成型。
2、 LTCC (Low-Temperature Co-fired Ceramic):LTCC 又稱為低溫共燒多層陶瓷基板,此技術須先將無機的氧化鋁粉與約30%~50%的玻璃材料加上有機黏結劑,使其混合均勻成為泥狀的漿料,接著利用刮刀把漿料刮成片狀,再經由一道干燥過程將片狀漿料形成一片片薄薄的生胚,然后依各層的設計鉆導通孔,作為各層訊號的傳遞,LTCC內部線路則運用網版印刷技術,分別于生胚上做填孔及印制線路,內外電極則可分別使用銀、銅、金等金屬,最后將各層做疊層動作,放置于850~900℃的燒結爐中燒結成型,即可完成。
3、 DBC (Direct Bonded Copper):直接敷銅技術是利用銅的含氧共晶液直接將銅敷接在陶瓷上,其基本原理就是敷接過程前或過程中在銅與陶瓷之間引入適量的氧元素,在1065℃~1083℃范圍內,銅與氧形成Cu-O共晶液, DBC技術利用該共晶液一方面與陶瓷基板發生化學反應生成 CuAlO2或CuAl2O4相,另一方面浸潤銅箔實現陶瓷基板與銅板的結合。
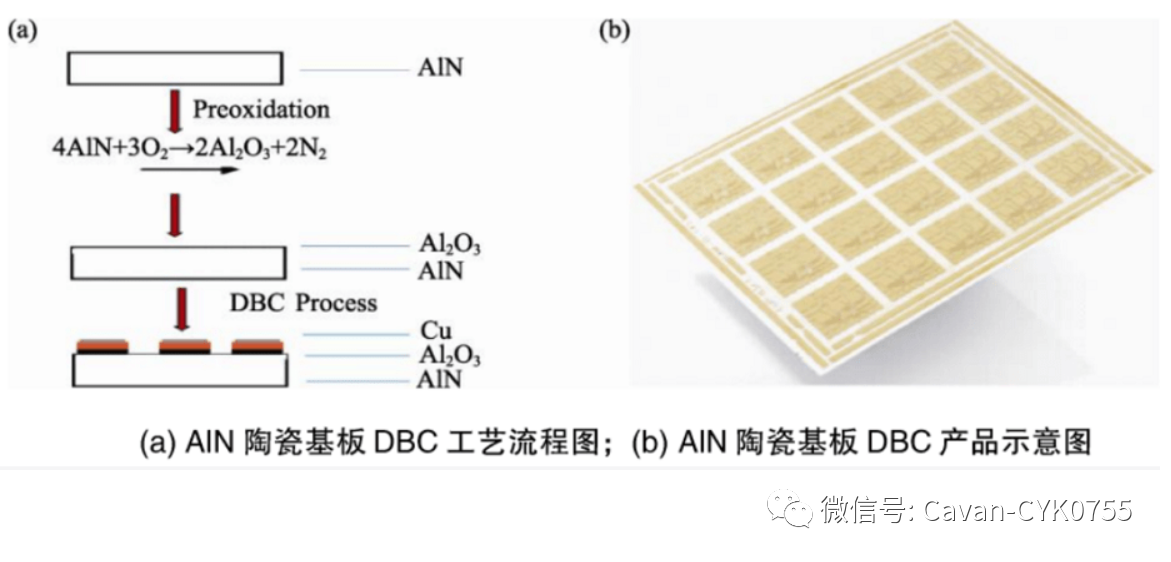
四
陶瓷基板的優越性
◆陶瓷基板的熱膨脹系數接近硅芯片,可節省過渡層Mo片,省工、節材、降低成本;
◆減少焊層,降低熱阻,減少空洞,提高成品率;
◆在相同載流量下 0.3mm厚的銅箔線寬僅為普通印刷電路板的10%;
◆ 優良的導熱性,使芯片的封裝非常緊湊,從而使功率密度大大提高,改善系統和裝置的可靠性;
◆ 超薄型(0.25mm)陶瓷基板可替代BeO,無環保毒性問題;
◆載流量大,100A電流連續通過1mm寬0.3mm厚銅體,溫升約17℃;100A電流連續通過2mm寬0.3mm厚銅體,溫升僅5℃左右;
◆熱阻低,10×10mm陶瓷基板的熱阻0.63mm厚度陶瓷基片的熱阻為0.31K/W ,0.38mm厚度陶瓷基片的熱阻為0.19K/W,0.25mm厚度陶瓷基片的熱阻為0.14K/W。
◆絕緣耐壓高,保障人身安全和設備的防護能力。
◆ 可以實現新的封裝和組裝方法,使產品高度集成,體積縮小。
五
陶瓷基板的性能要求
(1)機械性質:有足夠高的機械強度,除搭載元件外,也能作為支持構件使用;加工性好,尺寸精度高;容易實現多層化;表面光滑,無翹曲、彎曲、微裂紋等。
(2)電學性質:絕緣電阻及絕緣破壞電壓高;介電常數低;介電損耗小;在溫度高、濕度大的條件下性能穩定,確保可靠性。
(3)熱學性質:熱導率高;熱膨脹系數與相關材料匹配(特別是與Si的熱膨脹系數要匹配);耐熱性優良。
(4)其它性質:
化學穩定性好;容易金屬化,電路圖形與其附著力強;
無吸濕性;耐油、耐化學藥品;a射線放出量小;
所采用的物質無公害、無毒性;在使用溫度范圍 內晶體結構不變化;
原材料豐富;技術成熟;制造容易;價格低。
六
陶瓷基板的用途
◆ 大功率電力半導體模塊;半導體致冷器、電子加熱器;功率控制電路,功率混合電路。
◆汽車電子,航天航空及軍用電子組件。
◆太陽能電池板組件;電訊專用交換機,接收系統;激光等工業電子。
七
陶瓷基板的發展趨勢
陶瓷基板產品問世,開啟散熱應用行業的發展,由于陶瓷基板散熱特色,加上陶瓷基板具有高散熱、低熱阻、壽命長、耐電壓等優點,隨著生產技術、設備的改良,產品價格加速合理化,進而擴大LED產業的應用領域,如家電產品的指示燈、汽車車燈、路燈及戶外大型看板等。陶瓷基板的開發成功,更將成為室內照明和戶外亮化產品提供服務,使LED產業未來的市場領域更寬廣。
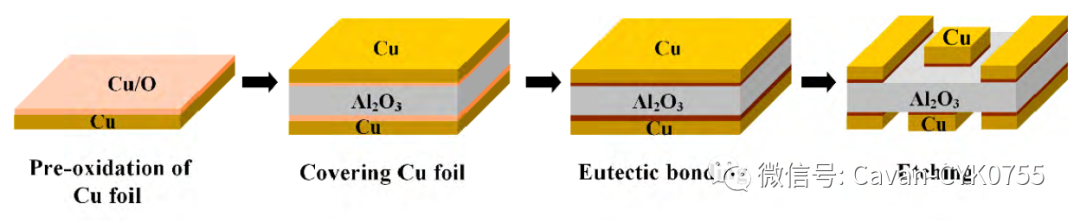
功率模塊DBC陶瓷基板散熱及穩定性功能測試
碳化硅和氮化鎵是寬帶隙(WBG)半導體,也是被認為要求更高功率和更高溫度的電力電子應用最佳材料。由于這些WBG半導體具有優異的性能,如寬禁帶(>3eV)、高臨界電場(>3 MV/cm)和高飽和速度(>2x10cm/s),SiC和在功率轉換效率方面,GaN可以克服基于硅的器件所達到的終極性能。
此外,WBG半導體器件的工作溫度(>250℃)比基于硅的器件(<150℃)如圖1/2/3所示,這意味著可以從功率轉換系統中去除龐大、復雜和沉重的冷卻系統。逆變器和轉換器汽車部件可以通過在高溫環境中的簡單散熱設計變得更小。通常,功率模塊的結構具有半導體芯片和散熱/絕緣板的多層結構,所有層都有不同的材料特性,例如熱膨脹系數(CTE),這會在重復操作過程中引起熱機械應力。
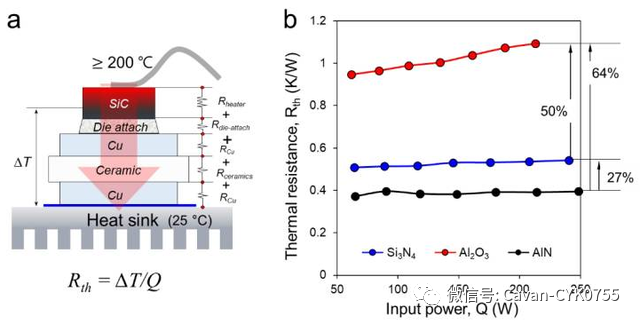
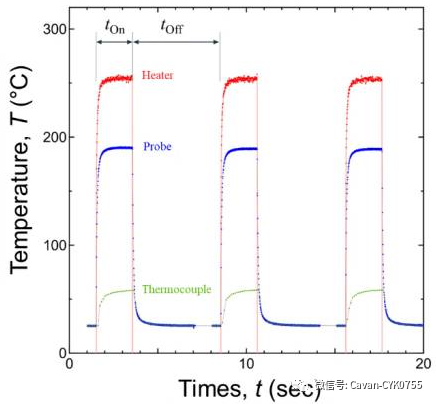
另外為了承受更高的功率和更高的熱密度,如何絕緣和散熱是WBG功率轉換系統的關鍵問題之一。因此,出現了一些問題,例如如何將這些多層互連以在高溫下實現并具有熱穩定可靠性。此外,電力電子陶瓷基板在散熱以防止電力電子模塊故障方面起著重要作用。功率半導體器件與散熱器之間存在直接鍵合銅DBC和直接鍵合鋁DBA的散熱/絕緣陶瓷基板。
熱量從功率半導體器件的表面傳遞到散熱器,DBC和DBA在陶瓷板的兩側金屬化,以提高陶瓷基板的導熱性并形成電路,由于其優異的導熱性、低熱阻和絕緣電壓高。然而,DBC和DBA基板的夾層結構會由于CTE不匹配而引起熱機械應力。據報道,陶瓷基板的耐熱性取決于陶瓷和金屬的類型。在-50℃至250℃的溫度范圍內進行了苛刻的熱沖擊循環測試期間,在各種陶瓷應用的活性金屬釬焊(AMB)DBC陶瓷基板與鍍鎳層的熱機械穩定性。DBC襯底與氮化硅陶瓷中間層在1000次熱沖擊循環內沒有嚴重損壞,而氮化鋁和氧化鋁在相同循環后由于銅層嚴重分層。
結果表明,這些失效可能表明氮化鋁和氧化鋁具有比氮化硅更高的CTE值和更低的韌性的關鍵缺點。由于以前的研發只是觀察了DBC陶瓷基板本身,因此故障必須是由Cu和陶瓷之間的不匹配引起的,這意味著應力來自DBC。這種熱循環僅在陶瓷基板樣品中產生均勻的溫度變化如圖4所示。然而,陶瓷基板中的實際熱分布必須具有較大的溫度梯度,才能將產生的熱量從器件芯片表面傳遞到冷卻系統如圖4所示,在從芯片到冷卻系統的熱傳導過程中,由CTE失配引起的應力比單個DBC陶瓷基板更復雜,因此在設計功率模塊時迫切需要評估這種實際的溫度分布。在這種情況下,功率循環測試是一種非常有用的評估方法,用于評估在類似于實際操作條件下使用的器件封裝的可靠性。
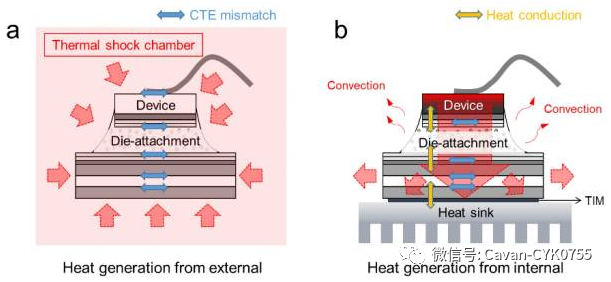
在這個過程中,這種陶瓷基板的傳熱性能主要取決于所采用的陶瓷材料的熱性能,例如氧化鋁、氮化鋁和氮化硅,這些在功率模塊需要導電銅和絕緣陶瓷的全面組合,包括層厚和電路圖案,以同時實現熱管理和最小的功率損耗。通常要在功率循環測試后測量器件的熱阻,需要一個功率循環系統設備和一個T3ster系統,即熱瞬態測試儀系統。它是一種監測通過設備的熱傳輸技術。然而,動力循環系統和T3ster系統非常昂貴,需要占用大量空間。實際上需要一個簡單、快速和小型化的熱測量系統。
在碳化硅微加熱器芯片中,并用于與各種類型的DBC陶瓷基板如氮化鋁和氧化鋁以及氮化硅鍵合。Ag燒結連接被用作連接材料的模具,因為它可以承受高溫應用,并且在許多先前的研究中都有講到,測量了不同類型DBC的SiC微加熱器芯片到冷卻系統的穩態熱阻。此外,還進行了功率循環測試,以研究每種類型DBC陶瓷基板上的SiC微加熱器芯片貼片結構的高溫可靠性。通過微焦點3D計算機斷層掃描(CT) X射線系統分析電源循環后的故障。這種方法可以顯著區別于傳統的熱循環測試,因為可以在重復的熱環境中考慮材料的熱性能。
-
材料
+關注
關注
3文章
1320瀏覽量
27725 -
電子電路
+關注
關注
78文章
1242瀏覽量
67698 -
陶瓷基板
+關注
關注
5文章
234瀏覽量
11741
發布評論請先 登錄
PEEK注塑電子封裝基板的創新應用方案
紫宸激光焊錫機助力陶瓷基板焊接,推動電子行業發展
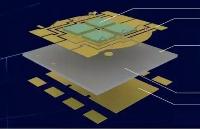
精密劃片機在切割陶瓷基板中有哪些應用場景
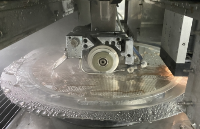
為什么選擇DPC覆銅陶瓷基板?
DPC、AMB、DBC覆銅陶瓷基板技術對比與應用選擇

DOH技術工藝方案解決陶瓷基板DBC散熱挑戰問題

高功率器件設備散熱用陶瓷基板 | 晟鵬耐高溫高導熱絕緣片

DBC陶瓷基板 | 氮化硼耐高溫高導熱絕緣片


高導熱陶瓷基板,提升性能必備
陶瓷基板技術PK:DBC vs DPC,你站哪一邊?






 陶瓷基板介紹熱性能測試
陶瓷基板介紹熱性能測試
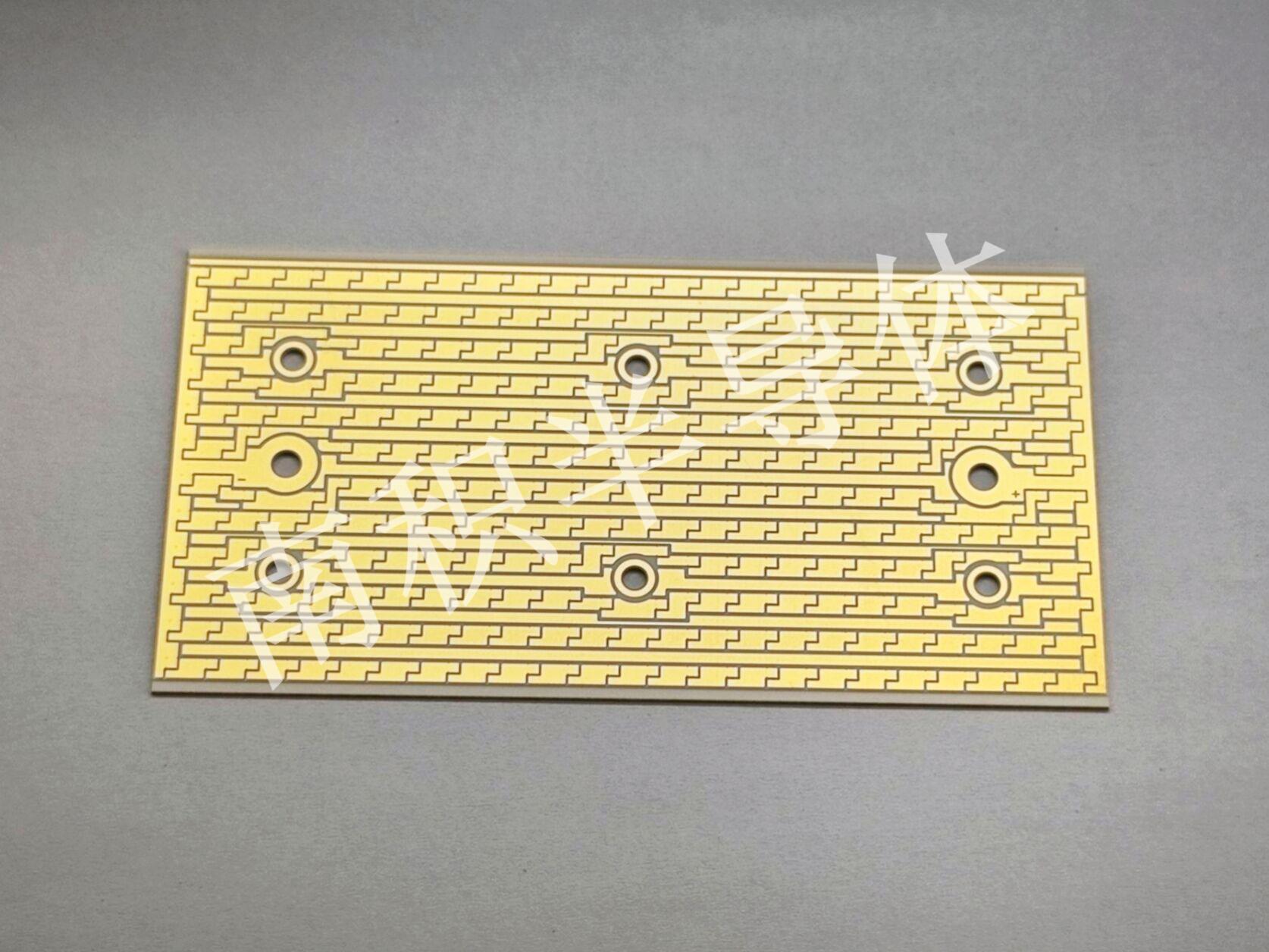
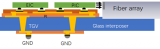












評論