眾所周知,華為是全球備受矚目的“專利大戶”,從5G/6G到通信設(shè)備,再到手機(jī)芯片、操作系統(tǒng)、自動(dòng)駕駛、EVS等均有涉及。而最近,華為又新增了多條專利信息,其中一項(xiàng)便是關(guān)于芯片封裝和制備方法的,這將有利于提高芯片的性能。
根據(jù)企查查公開的信息顯示,這項(xiàng)新專利的名稱為“一種芯片封裝以及芯片封裝的制備方法”,申請(qǐng)日期為2020年12月16日,申請(qǐng)公布日為2023年8月4日,申請(qǐng)公開號(hào)為CN116547791A。

▲圖片來源:企查查
據(jù)悉,這是一種用于簡化芯片堆疊結(jié)構(gòu)及其形成方法的制造技術(shù)。
根據(jù)專利摘要顯示,該芯片封裝包括基板、裸芯片、第一保護(hù)結(jié)構(gòu)和阻隔結(jié)構(gòu);該裸芯片、該第一保護(hù)結(jié)構(gòu)和該阻隔結(jié)構(gòu)均被設(shè)置在該基板的第一表面上;該第一保護(hù)結(jié)構(gòu)包裹該裸芯片的側(cè)面,該阻隔結(jié)構(gòu)包裹該第一保護(hù)結(jié)構(gòu)背離該裸芯片的表面,且該裸芯片的第一表面、該第一保護(hù)結(jié)構(gòu)的第一表面和該阻隔結(jié)構(gòu)的第一表面齊平。
其中,該裸芯片的第一表面為該裸芯片背離該基板的表面,該第一保護(hù)結(jié)構(gòu)的第一表面為該第一保護(hù)結(jié)構(gòu)背離該基板的表面,該阻隔結(jié)構(gòu)的第一表面為該阻隔結(jié)構(gòu)背離該基板的表面。
通過這種芯片堆疊結(jié)構(gòu)的設(shè)計(jì),旨在簡化芯片堆疊結(jié)構(gòu)的制備工藝,并有利于提高生產(chǎn)效率。該專利對(duì)于芯片封裝行業(yè)具有重要意義,可以加快芯片制造的速度、降低生產(chǎn)成本,并提高芯片的性能和可靠性。
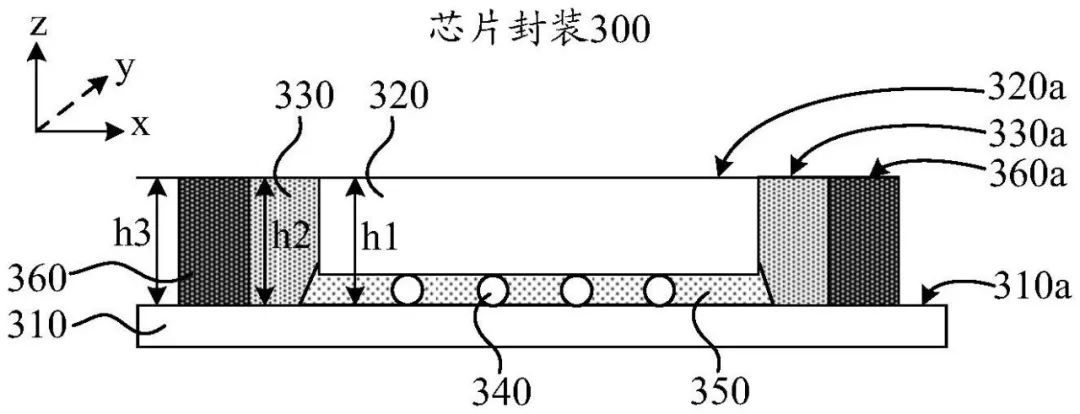
▲專利原理示意圖
該專利一經(jīng)曝光,立即引起了網(wǎng)友的廣泛關(guān)注和討論,例如“華為可以將兩塊14nm制程芯片堆疊在一起,實(shí)現(xiàn)與7nm制程芯片相似的性能和功耗”的說法也隨之流傳開來。
不過,華為官方已經(jīng)多次證實(shí)這是謠傳。因?yàn)椤巴ㄟ^芯片疊加工藝讓兩塊14nm芯片達(dá)到7nm水平”這樣的說法本身就是錯(cuò)誤的,芯片堆疊技術(shù)方案難題包含了熱管理、電氣互聯(lián)、封裝和測試、制造技術(shù)等多個(gè)方面,要想完成這些并非易事。
此外,兩塊14nm芯片堆疊在一起,還要功耗跟7nm相當(dāng),暫且說可以組合,但這樣實(shí)現(xiàn)后也是通過降頻。要知道,14nm芯片達(dá)到7nm的性能水平就必須功耗翻倍,同時(shí)還得進(jìn)一步擴(kuò)大芯片面積才能塞下更多的晶體管,這顯然脫離了芯片發(fā)展規(guī)律。
雖然這項(xiàng)新專利實(shí)現(xiàn)不了7nm工藝,但卻展現(xiàn)了華為在芯片領(lǐng)域的研發(fā)實(shí)力和創(chuàng)新能力,也為全球芯片行業(yè)的發(fā)展提供了更多新的可能。
據(jù)統(tǒng)計(jì),截至2022年,華為持有超過12萬項(xiàng)有效授權(quán)專利,是中國國家知識(shí)產(chǎn)權(quán)局和歐洲專利局2021/2022年度專利授權(quán)量排名第一的公司,也是2022年中國PCT國際專利申請(qǐng)量全球第一的公司。在研發(fā)方面,華為2022年研發(fā)支出超過1600億元,近十年研發(fā)支持超過9700億元。正是這些大手筆研發(fā)投入,讓華為在各領(lǐng)域都能遙遙領(lǐng)先,為消費(fèi)者帶來不斷迭代的新功能、新技術(shù)。
未來,隨著研發(fā)投入的持續(xù)積淀,以及最新芯片堆疊封裝專利技術(shù)的普及與應(yīng)用,我們可以期待華為將在芯片領(lǐng)域取得更多的技術(shù)突破,為中國芯片的發(fā)展注入更多新的動(dòng)力。
-
芯片
+關(guān)注
關(guān)注
459文章
52494瀏覽量
440670 -
華為
+關(guān)注
關(guān)注
216文章
35209瀏覽量
255864 -
堆疊
+關(guān)注
關(guān)注
0文章
37瀏覽量
16868
原文標(biāo)題:突破!華為首次公開芯片堆疊專利,7nm有戲了?
文章出處:【微信號(hào):robotqy,微信公眾號(hào):機(jī)械自動(dòng)化前沿】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
國產(chǎn)化率不足5%!國產(chǎn)7nm座艙芯片最新有哪些突破?

下一代高速芯片晶體管解制造問題解決了!
突破!華為先進(jìn)封裝技術(shù)揭開神秘面紗
廣汽傳祺聯(lián)合華為首次實(shí)現(xiàn)出發(fā)層泊車代駕技術(shù)試點(diǎn)
最新專利曝光,華為要將“雷達(dá)之王”裝到車上?

芯片晶圓堆疊過程中的邊緣缺陷修整

一文詳解多芯片堆疊技術(shù)

北京市最值得去的十家半導(dǎo)體芯片公司
蘋果公開新專利:可折疊設(shè)備鉸鏈
今日看點(diǎn)丨 傳蘋果2025年采用自研Wi-Fi芯片 臺(tái)積電7nm制造;富士膠片開始銷售用于半導(dǎo)體EUV光刻的材料
華為公開量子計(jì)算新專利
所謂的7nm芯片上沒有一個(gè)圖形是7nm的
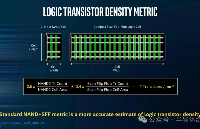
雙芯片磁性位置傳感器中堆疊芯片和并排芯片實(shí)施方案之間的比較






 華為首次公開芯片堆疊專利,7nm有戲了?
華為首次公開芯片堆疊專利,7nm有戲了?












評(píng)論