文章來源:學習那些事
原文作者:趙先生
本文介紹了芯片的堆疊與堆疊產(chǎn)生的應(yīng)力問題。
多芯片堆疊
多芯片堆疊技術(shù)的出現(xiàn),順應(yīng)了器件朝著小型化、集成化方向發(fā)展的趨勢。該技術(shù)與先進封裝領(lǐng)域中的系統(tǒng)級封裝(SIP)存在一定差異。先進封裝涵蓋多種前沿工藝技術(shù),如重布線層(RDL)、硅通孔(TSV)、金屬凸點(Bump)以及晶圓級封裝(WLP)等。晶圓級封裝已突破傳統(tǒng)封裝在劃片、粘片、鍵合和密封等方面的工藝范疇,像芯片再布線、凸點生長與倒裝焊接,芯片通孔、疊層與互連,乃至扇出型晶圓級封裝(FOWLP)、扇入型晶圓級封裝(FIWLP),均屬于廣義上的封裝概念。部分中道線工藝在一些工廠雖被歸為后道工序,但相較于后道封裝工藝,其與前道晶圓制造工藝的聯(lián)系更為緊密。
多芯片堆疊所構(gòu)建的器件,同樣屬于SIP。不過,其采用的是傳統(tǒng)的芯片粘接和引線鍵合工藝,因此本質(zhì)上屬于傳統(tǒng)封裝類型。芯片的疊層粘接能夠大幅節(jié)省空間,但在操作過程中,需確保下層芯片的管腳(Pad)點不會被上層芯片或粘接劑覆蓋,以免對后續(xù)的引線鍵合工序造成影響。多芯片堆疊的形式主要由芯片的大小、形狀以及管腳點的分布決定,常見的堆疊形式如圖1-圖3所示。

圖1 多芯片的錯層堆疊

圖2 多芯片的交叉堆疊

圖3 多芯片的金字塔堆疊
多層芯片堆疊應(yīng)力集中
在多層芯片堆疊過程中,由于芯片正面設(shè)有鈍化層,無法采用合金燒結(jié)的方式進行芯片間的堆疊,一般會選用膠黏劑來實現(xiàn)粘接。具體的粘接工藝流程為,首先將最下層芯片進行粘接;接著在最下層芯片表面涂抹膠黏劑,隨后粘接上層芯片,依此方式逐層疊加粘接。研究顯示,由于膠黏劑與硅芯片的熱膨脹系數(shù)存在差異,多層芯片之間會產(chǎn)生較大應(yīng)力。
有研究人員針對塑封的多層芯片堆疊器件開展建模仿真,識別出應(yīng)力集中的三種主要形式,如圖4所示。
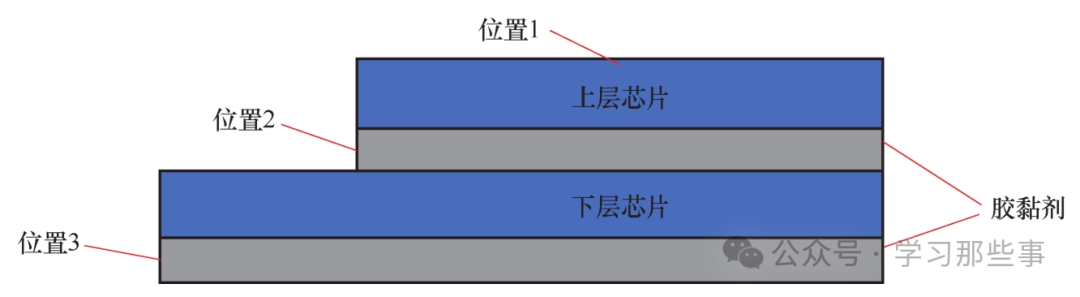
圖4多層堆疊粘片主要失效位置
多層芯片堆疊應(yīng)力集中產(chǎn)生的失效形式:
芯片與環(huán)氧塑封料分層:上層芯片與環(huán)氧塑封料之間會產(chǎn)生應(yīng)力,這一應(yīng)力致使芯片與塑封料界面處出現(xiàn)分層現(xiàn)象。
下層芯片損傷:上下層芯片間的應(yīng)力會在上層芯片的邊角位置高度集中。這種集中應(yīng)力往往會導致下層芯片出現(xiàn)裂紋,嚴重時甚至造成芯片斷裂,對器件造成致命性破壞,具體可參考圖5。
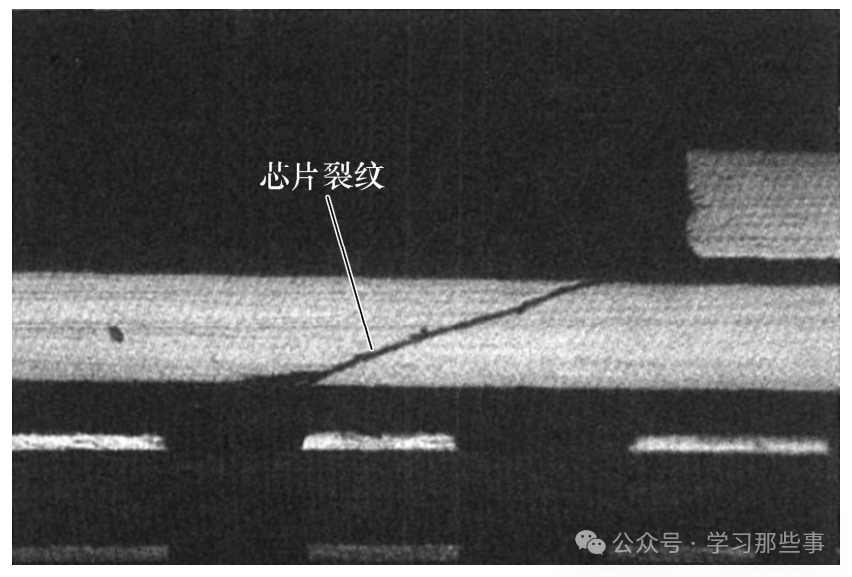
圖5下層芯片裂紋
芯片與膠黏劑整體和環(huán)氧塑封料分層:下層芯片邊緣與環(huán)氧塑封料之間存在應(yīng)力,這種應(yīng)力會使芯片和膠黏劑構(gòu)成的整體,與環(huán)氧塑封料之間發(fā)生分層。
研究表明,上述應(yīng)力的大小,與材料的熱膨脹系數(shù)、芯片厚度等關(guān)鍵參數(shù)緊密相關(guān)。
芯片的裂紋
為了通過目檢清晰觀察膠黏劑從芯片四周溢出的輪廓,通常會在芯片下方懸空部位填充不導電膠。研究人員將硅片切割成與待封裝芯片相同尺寸,并分別堆疊至兩層、三層、四層,隨后開展 -55℃至125℃的溫度循環(huán)試驗。試驗結(jié)果顯示,填充不導電膠的電路出現(xiàn)了熱失配問題。在溫度循環(huán)試驗結(jié)束后,上層芯片均出現(xiàn)了不同程度的裂紋,裂紋首先沿底層芯片邊緣位置擴展,最終有可能貫穿整個芯片,具體現(xiàn)象如圖6所示。
仿真結(jié)果表明,使用不導電膠填充的模型,其最大應(yīng)力位置與實際觀察到的上層芯片裂紋位置一致,均出現(xiàn)在上層芯片、填充的不導電膠、下層芯片邊緣三者的交接面上。而未使用不導電膠填充的模型,上層芯片的最大應(yīng)變相較于使用不導電膠填充的模型,降低了91.7%。由此可見,硅芯片與膠黏劑之間匹配性的差異,是引發(fā)芯片裂紋的主要原因。這些裂紋在溫度循環(huán)等可靠性試驗過程中,會進一步擴展,嚴重時可導致芯片斷裂。底部無填充的堆疊芯片情況,如圖7所示。
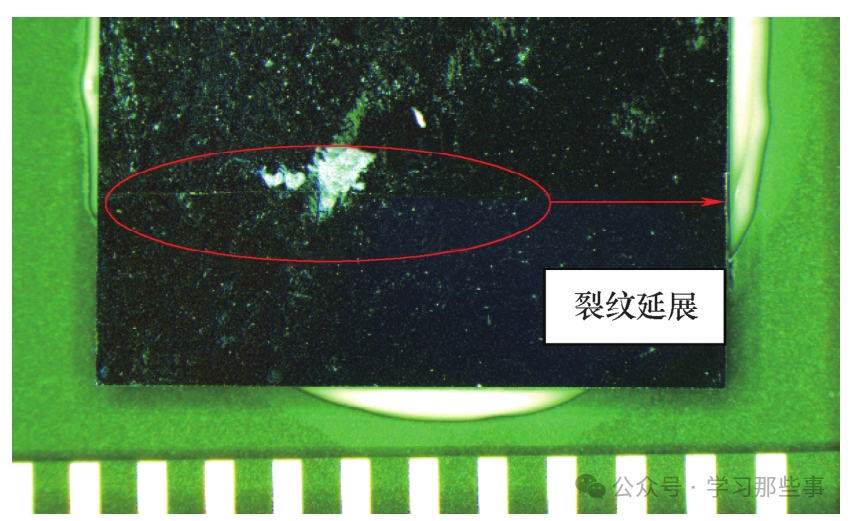
圖6堆疊粘片的裂紋
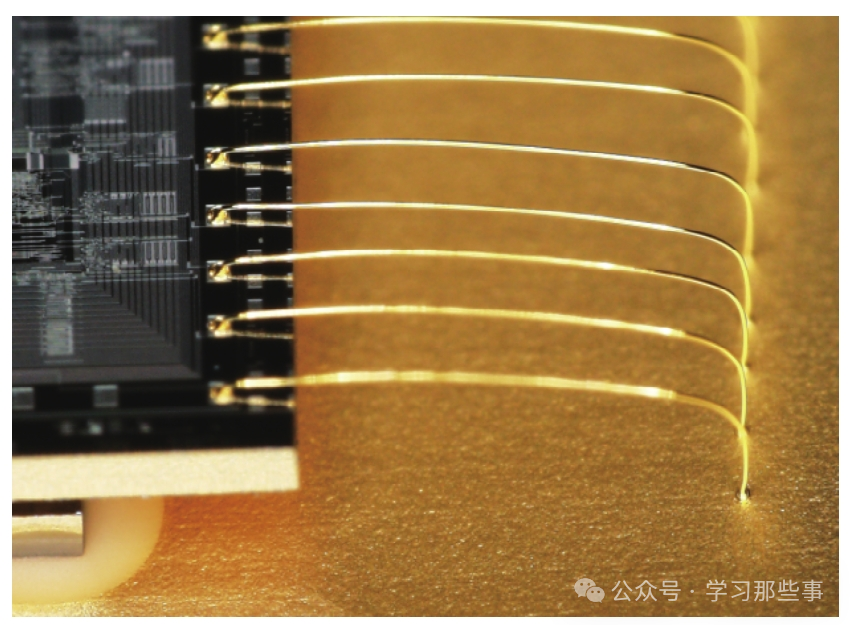
圖7無填充的堆疊芯片
爬膠與膠膜
在傳統(tǒng)封裝工藝里,芯片粘接普遍采用直接涂抹導熱膠的方式。這種導熱膠不僅使用便捷,而且能提供足夠的粘接強度。然而,在多層堆疊芯片的場景下,芯片通常會被減薄至很薄的尺寸,部分芯片厚度甚至達到100μm。當使用常規(guī)導熱膠進行這類超薄芯片間的粘接時,爬膠問題頻繁出現(xiàn)。爬膠會致使部分導熱膠溢出到芯片表面,污染管腳(Pad)點,進而對后續(xù)的鍵合工序造成嚴重影響。
為解決這一難題,材料供應(yīng)商研發(fā)出導熱膠膜,以此替代傳統(tǒng)導熱膠。導熱膠膜具有固定的厚度,借助這一特性,能夠有效控制膠量和粘接厚度,從而避免爬膠現(xiàn)象的發(fā)生。不僅如此,導熱膠膜還能在高度設(shè)計方面提供更大的靈活性。從實際應(yīng)用來看,在民用產(chǎn)品領(lǐng)域,部分多層堆疊結(jié)構(gòu)已經(jīng)實現(xiàn)了百余層的堆疊。圖8展示了一種存儲器芯片的堆疊示意圖。
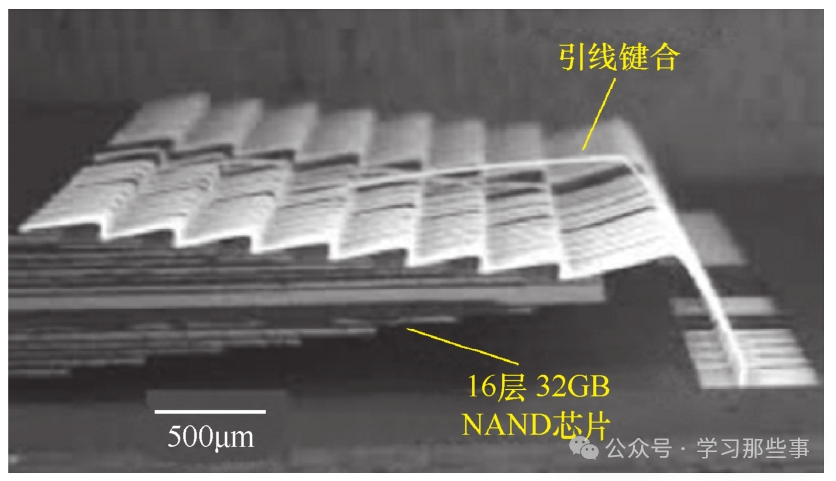
圖8一種存儲器芯片的堆疊示意圖
-
芯片
+關(guān)注
關(guān)注
459文章
52145瀏覽量
435895 -
晶圓
+關(guān)注
關(guān)注
52文章
5113瀏覽量
129147 -
封裝
+關(guān)注
關(guān)注
128文章
8474瀏覽量
144753 -
堆疊
+關(guān)注
關(guān)注
0文章
37瀏覽量
16806
原文標題:芯片的堆疊與堆疊產(chǎn)生的應(yīng)力問題
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
華為公布芯片堆疊專利,能否解缺芯燃眉之急
一文詳解多芯片組件MCM技術(shù)
請問Ultrascale FPGA中單片和下一代堆疊硅互連技術(shù)是什么意思?
一文讀懂交換機堆疊技術(shù)
華為又一專利公開,芯片堆疊技術(shù)持續(xù)進步
華為公布兩項芯片堆疊相關(guān)專利
一文解析多芯片堆疊封裝技術(shù)(上)
一文解析多芯片封裝技術(shù)
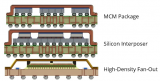





 一文詳解多芯片堆疊技術(shù)
一文詳解多芯片堆疊技術(shù)














評論