手機SIM卡和銀行卡芯片封裝和bga底部填充膠方案由漢思新材料提供
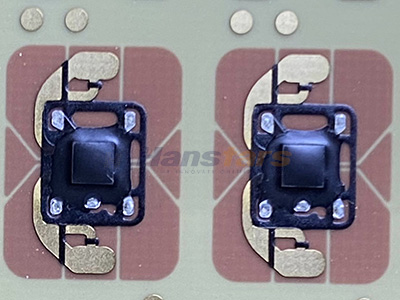
涉及部件:手機SIM卡和銀行卡的CSP芯片封裝和周邊焊點保護
工藝難點:客戶目前出現的問題 在做三輪實驗時出現膠裂 ,在點膠時還有個難題就是膠固化后的厚度不能超過客戶要求的兩個厚度一個530微米和470微米,還有點膠不能益膠到膠圈外面
應用產品:用到我司底部填充膠產品
方案亮點:目前我司產品能夠很好的滿足客戶工藝和測試要求
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
芯片
+關注
關注
459文章
52481瀏覽量
440620 -
SIM卡
+關注
關注
6文章
290瀏覽量
29617 -
芯片封裝
+關注
關注
11文章
577瀏覽量
31449
發布評論請先 登錄
相關推薦
熱點推薦
搭載紫光同芯E450R芯片的銀行卡試點首發
近日,為貫徹落實國家金融科技發展戰略,郵儲銀行北京分行與國金認證聯合發布“金鴻實驗室”,并攜手產業伙伴重磅發布了系列“基于RISC-V的金融IC卡產品”。其中,搭載全球首款開放式軟硬件架構安全芯片E450R的
從原理到實操:SIM卡&銀行卡芯片推力測試全解
在當今快速發展的電子產業中,芯片作為核心組件,其性能和質量直接決定了電子產品的整體表現和使用壽命。無論是日常通訊中不可或缺的SIM卡,還是金融交易中廣泛使用的銀行卡,

芯片封裝膠underfill底部填充膠點膠工藝基本操作流程
一、烘烤烘烤,主要是為了確保主板的干燥。實施底部填充膠之前,如果主板不干燥,容易在填充后有小氣泡產生,在最后的固化環節,氣泡就會發生爆炸,從而影響焊盤與PCB之間的粘結性,也有可能導致






 手機SIM卡和銀行卡芯片封裝和bga底部填充膠方案
手機SIM卡和銀行卡芯片封裝和bga底部填充膠方案





















評論