半導體基材關鍵,劃片切割屬于精密加工。切割機是使用刀片,高精度地切斷硅、玻璃、陶瓷等被加工物的裝置,廣泛用于半導體晶片、EMC導線架、陶瓷薄板、PCB、藍寶石玻璃等材料的精密切割,其中半導體晶片切割機主要用于封裝環節,是將含有很多芯片的wafer晶圓分割成一個一個晶片顆粒的設備,例如用于LED晶片的分割,形成LED芯粒。
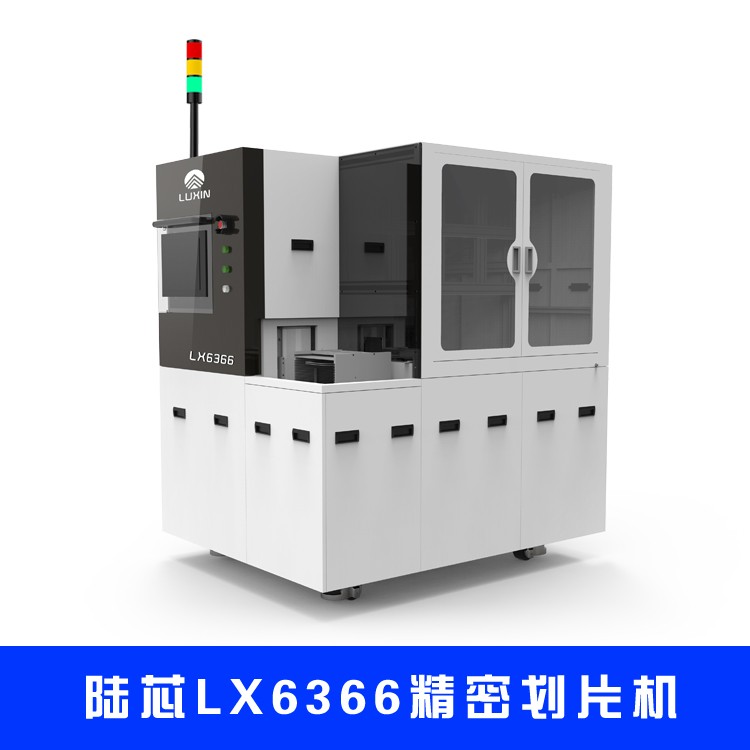
精密劃片機目前以砂輪機械切割為主,激光是重要補充。劃片機主要包括砂輪劃片機和激光劃片機:
(1)砂輪劃片機是綜合了水氣電、空氣靜壓高速主軸、精密機械傳動、傳感器及自動化控制等技術的精密數控設備,在國內也稱為精密砂輪切割機。
(2)激光劃片機是利用高能激光束照射在工件表面,使被照射區域局部熔化、氣化、從而達到劃片的目的。

目前市場以砂輪劃片機為主,主要是:
(1)激光切割不能使用大功率以免產生熱影響區(HAZ)破壞芯片。
(2)激光切割設備非常昂貴。
(3)激光切割不能做到一次切透(因為HAZ問題),因而第二次切割還是用劃片刀來最終完成。

聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
劃片機
+關注
關注
0文章
169瀏覽量
11347
發布評論請先 登錄
相關推薦
熱點推薦
wafer晶圓厚度(THK)翹曲度(Warp)彎曲度(Bow)等數據測量的設備
) 是直接影響工藝穩定性和芯片良率的關鍵參數:
1、厚度(THK) 是工藝兼容性的基礎,需通過精密切割與研磨實現全局均勻性。
2、翹曲度(Warp) 反映晶圓整體應力分布,直接影響光刻和工藝穩定性,需
發表于 05-28 16:12
晶圓切割的定義和功能
Dicing 是指將制造完成的晶圓(Wafer)切割成單個 Die 的工藝步驟,是從晶圓到獨立芯片生產的重要環節之一。每個 Die 都是一個
晶圓中scribe line(劃片線)和saw line(鋸片線)的差異
關鍵的概念,它們在晶圓的后段工藝中扮演著重要的角色。為了方便理解,我們可以把晶圓比作一塊大餅,而每一片芯片就像是從大餅上切下來的薄片,劃片線






 晶圓劃片機:晶圓封測切割精密加工類設備
晶圓劃片機:晶圓封測切割精密加工類設備





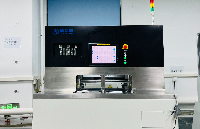

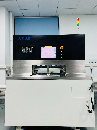
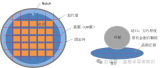












評論