晶圓切割原理及目的:
晶圓切割的目的主要是切割和分離晶圓上的每個芯片。首先在晶圓背面粘上一層膠帶,然后送入晶圓切割機進行切割。切割后,模具將有序排列并粘附在膠帶上。同時,框架的支撐可以防止因膠帶起皺而導致模具碰撞,有利于搬運過程。本實驗有助于了解切割機的結構、用途和正確使用。

芯片劃片機是一種非常精密的設備,其主軸轉速約為30,000至60,000轉/分。由于晶粒之間的距離很小,晶粒相當脆弱,精度要求相當高,必須使用金剛石刀片進行切割,切割方法是通過研磨將晶粒分離。由于切割是通過研磨進行的,因此會產生大量的細小粉塵,因此在切割過程中必須不斷用清水沖洗,以免污染晶粒。除了以上幾點,整個切割過程中還有很多需要注意的地方。例如,模具必須完全分開,但不能切割承受負載的膠帶。切割必須沿著模具和模具之間的切割線。蛇形,切割后不會造成晶粒的塌陷或裂紋等。 為了解決以上諸多問題,機器上將采用各種自動檢測、自動調整和自動清潔設備,以減少因切割造成的損失。切割過程中的錯誤。
-
劃片機
+關注
關注
0文章
169瀏覽量
11346
發布評論請先 登錄
從開槽到分層切割:劃片機階梯式進刀技術對刀具磨損的影響分析

晶圓切割的定義和功能
晶硅切割液潤濕劑用哪種類型?
從晶圓到芯片:劃片機在 IC 領域的應用
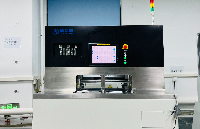
博捷芯劃片機:LED燈珠精密切割的優選解決方案
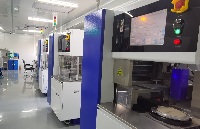
怎么制備半導體晶圓片切割刃料?

Monaco 新款 50W 紫外飛秒激光器,助力晶圓和堆疊 OLED 屏的高效切割






 陸芯精密切割—晶圓切割原理及目的
陸芯精密切割—晶圓切割原理及目的


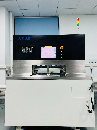

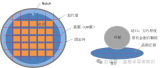













評論