來源:英凱高級材料責任有限公司
領先的高性能電子材料制造商英凱高級材料責任有限公司宣布發布其突破性產品:導熱底部填充膠 - UF 158A2。
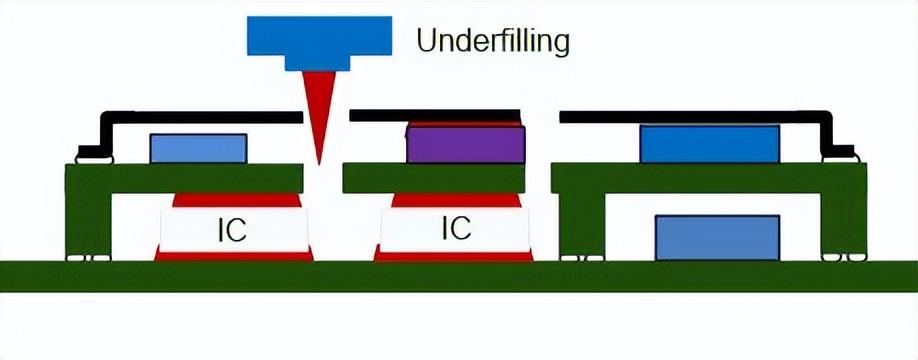
UF 158A2 非常適合用于溫度循環、沖擊和振動會損壞電子元件的高可靠性應用。該產品具有出色的導熱性和高溫穩定性,即使在最苛刻的環境中也能確保最佳性能。
“我們很高興將 UF 158A2 引入我們的產品組合,”YINCAE 首席執行官 Wusheng Yin 博士說。 “我們相信 UF 158A2 將為我們的客戶提供可靠且具有成本效益的解決方案:1). 快速流動且易于使用底部填充 100x100 mm 芯片(20m 間隙);2) 縮短制造過程;3). 高導熱率 3-4W/mk;4). 快速固化和可返工;5). 巨大的成本節約,滿足他們的熱管理需求。”
UF 158A2 有多種配方可供選擇,以滿足不同的應用要求。該產品易于使用,可在低溫下固化,適用于各種電子設備。憑借其卓越的性能、可靠性和易用性,UF 158A2 將成為電子行業的重要參與者。
* * * * * * * * * *
英凱高級材料責任有限公司成立于 2005 年,總部位于紐約奧爾巴尼,是微芯片和光電設備中使用的高性能涂料、粘合劑和電子材料的領先制造商和供應商。 YINCAE 產品提供新技術來支持從晶圓級到封裝級、板級和最終設備的制造過程,同時促進更智能、更快速的生產并支持綠色倡議。
蘇州會議
雅時國際(ACT International)將于2023年5月,在蘇州組織舉辦主題為“2023-半導體先進技術創新發展和機遇大會”。會議包括兩個專題:半導體制造與封裝、化合物半導體先進技術及應用。分別以“CHIP China晶芯研討會”和“化合物半導體先進技術及應用大會”兩場論壇的形式同時進行。詳情點擊鏈接查看:https://w.lwc.cn/s/7jmaMn
聲明:本網站部分文章轉載自網絡,轉發僅為更大范圍傳播。 轉載文章版權歸原作者所有,如有異議,請聯系我們修改或刪除。
審核編輯黃宇
-
導熱
+關注
關注
0文章
320瀏覽量
13258 -
電子材料
+關注
關注
0文章
64瀏覽量
10919
發布評論請先 登錄
漢思新材料取得一種封裝芯片高可靠底部填充膠及其制備方法的專利

先進封裝Underfill工藝中的四種常用的填充膠CUF,NUF,WLUF和MUF介紹

電路板元件保護用膠

芯片封裝膠underfill底部填充膠點膠工藝基本操作流程

底部填充工藝在倒裝芯片上的應用

等離子清洗及點膠軌跡對底部填充膠流動性的影響






 突破性導熱底部填充膠 - UF 158A2
突破性導熱底部填充膠 - UF 158A2


















評論