引言
在過去時(shí)間里,在三維與非型碰撞記憶制造中,氮化硅/氧化硅堆棧的數(shù)量增加,SiNx/SiOy層重復(fù)層的厚度隨著垂直存儲密度的增加而不斷減小。因此,在SiNx/SiOy堆棧中,SiNx層均勻、超高選擇性的對SiOy層的蝕刻越來越具挑戰(zhàn)性。到目前為止,SiNx在SiNx堆/SiOy堆中的選擇性蝕刻是通過使用熱磷酸(h3po4)3-6進(jìn)行濕式蝕刻來實(shí)現(xiàn)的。(江蘇英思特半導(dǎo)體科技有限公司)
此外,一些用于提高SiNx/SiOy蝕刻選擇性的添加劑被發(fā)現(xiàn)會(huì)在蝕刻后引起氧化物再生問題,除非其工藝條件沒有被仔細(xì)控制5。為了解決這些問題,需要開發(fā)一種各向同性和選擇性蝕刻的干法工藝,作為三維非和型碰撞存儲器制造的替代技術(shù)。(江蘇英思特半導(dǎo)體科技有限公司)
實(shí)驗(yàn)
圖1是本研究中使用的一種遠(yuǎn)程型電感耦合等離子體(ICP)蝕刻系統(tǒng)的示意圖。工藝室內(nèi)的Te通過陽極氧化法涂覆了氧化鋁層。用對流計(jì)測量的工藝室的基本壓力保持在3×10-3Torr,用電容壓力計(jì)(氣壓計(jì))監(jiān)測的工作壓力保持在200 mTorr。對腔室上部的平面型ICP線圈施加13.56 MHz射頻功率。(江蘇英思特半導(dǎo)體科技有限公司)
對于SiNx的各向同性蝕刻,在ICP反應(yīng)器中心設(shè)置了半徑為1.5 mm的多孔的雙柵,以防止離子轟擊,并在基底上傳遞自由基。樣品溫度在樣品下方的樣品階段測量,該溫度由熱電偶監(jiān)測,并通過連接到外部電源的碳化硅(碳化硅)加熱器從25調(diào)整到500°C。三氯(ClF3,>99.9%,200 sccm)、H2(>99.999%)和氬(>99.999% Ar,200 sccm)通過圓形氣體分配器融合到工藝室。
結(jié)果和討論
圖2顯示了僅使用三氟化氯氣體和三氟化氯遠(yuǎn)端等離子體的SiNx和SiOy的蝕刻特性。對于三氟化氯遠(yuǎn)端等離子體,在200 sccm的三氟化氯中加入200 sccm,以提高等離子體的穩(wěn)定性。如圖2a所示,隨著射頻功率的增加,由于三氟化氯的解離增強(qiáng),SiNx和SiOy的蝕刻率逐漸增加,分別在~ 90和~ 0.8 nm/min時(shí)達(dá)到SiNx和SiOy的最大蝕刻率。需要注意的是,SiNx對SiOy的蝕刻選擇性對100~400 W的射頻功率沒有明顯變化。如圖2b所示,SiNx和SiOy也可以僅通過混合三氟化氯氣體進(jìn)行蝕刻,而不通過射頻等離子體解離三氟化氯,而底物溫度的升高提高了兩種flms的蝕刻速率。
然而,三氟化氯氣體處理的整體SiNx蝕刻率僅比三氟化氯遠(yuǎn)端等離子體蝕刻要低得多,這表明三氟化氯遠(yuǎn)程等離子體蝕刻比無等離子體熱蝕刻是更有效的SiNx蝕刻方法。同時(shí),盡管兩種材料的蝕刻速率都隨著襯底溫度的升高而提高,但SiNx對SiOy的蝕刻選擇性都降低了。遠(yuǎn)端等離子體蝕刻也有同樣的趨勢。如圖2c所示,在300 W的彎曲射頻功率下,隨著底物溫度升高到500°C,蝕刻選擇性在40以下逐漸降低,而在600 nm/min時(shí)SiNx蝕刻速率增加。(江蘇英思特半導(dǎo)體科技有限公司)
圖1.遠(yuǎn)程型電感耦合等離子體(ICP)蝕刻器示意圖。
圖2.SiNx和SiOy (a)的蝕刻特性作為三氟化氯遠(yuǎn)程等離子體射頻功率的函數(shù),(b)作為基底溫度和三氟化氯氣體化學(xué)蝕刻的函數(shù),(c)作為三氟化氯遠(yuǎn)程等離子體襯底溫度的函數(shù)。
結(jié)論
利用帶有ICP源的ClF3/H2遠(yuǎn)端等離子體,研究了SiNx在SiOy上的各向同性和選擇性蝕刻作用。與僅采用熱蝕刻或等離子體蝕刻相比,采用等離子體輔助熱工藝的Te SiNx蝕刻顯示出最高的蝕刻速率和最光滑的表面形態(tài)。在三氟化氯遠(yuǎn)端等離子體中,SiNx和SiOy的溫度溫度依賴性蝕刻特性表明,SiOy的活化能高于SiNx。
此外,在三氟化氯等離子體中加入H2(20%)提高了SiNx對SiOy的蝕刻選擇性,從130提高到200,盡管SiNx的蝕刻率從83降低到23nm/min。我們相信,快速、超高選擇性的SiNx蝕刻技術(shù)不僅可以應(yīng)用于下一代三維非和型碰撞存儲器制造工藝,還可以應(yīng)用于需要精確的SiNx蝕刻的各種半導(dǎo)體工藝。(江蘇英思特半導(dǎo)體科技有限公司)
審核編輯 黃宇
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28538瀏覽量
231944 -
蝕刻
+關(guān)注
關(guān)注
10文章
424瀏覽量
15925 -
氮化硅
+關(guān)注
關(guān)注
0文章
80瀏覽量
465
發(fā)布評論請先 登錄
通過LPCVD制備氮化硅低應(yīng)力膜
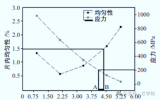
spm清洗會(huì)把氮化硅去除嗎
氮化硅在芯片制造中的核心作用
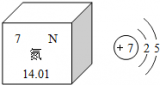
什么是高選擇性蝕刻
等離子體蝕刻工藝對集成電路可靠性的影響

LPCVD氮化硅薄膜生長的機(jī)理

OptiFDTD應(yīng)用:納米盤型諧振腔等離子體波導(dǎo)濾波器
等離子的基本屬性_等離子體如何發(fā)生
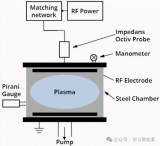
氮化硅薄膜的特性及制備方法

等離子體技術(shù)在航天中的作用
等離子體的定義和特征
等離子體在醫(yī)療領(lǐng)域的應(yīng)用
等離子體清洗的原理與方法
氮化硅薄膜制備方法及用途






 使用 ClF 3 H 2遠(yuǎn)程等離子體在氧化硅上選擇性蝕刻氮化硅
使用 ClF 3 H 2遠(yuǎn)程等離子體在氧化硅上選擇性蝕刻氮化硅










評論