來源:云天半導體
廈門云天半導體繼九月初8&12吋 “晶圓級封裝與無源器件生產線”正式通線后,經過團隊的不懈努力, 8英寸晶圓Fine Pitch光刻工藝開發終破2/2um L/S大關;
以下為部分工藝條件及成果展示:
膠厚均勻性 3.4%
CD開口均勻性 3%
在Test Vehicle光罩下,測試了長線條&短線條,結果不論是在正性光阻還是負性光阻下, 2um的L/S下的線條都是完整而清晰的,而且沒有任何顯影不潔或過顯的外觀異常;
2um 短線條(光刻后)
2um長線條-負膠(光刻后)
2um長線條-正膠(光刻后)
SEM切片效果圖如下,膠厚:3.308um,CD上開口:2.272um,CD下開口:1.716um,側壁垂直度約85.2°;
2um孔徑SEM
2um長線條經過電鍍及種子層刻蝕后,線寬及線距均在工藝管控范圍內,未出現線路Peeling及斷短路等外觀異常;
2um長線條-負膠(電鍍后)
2um長線條-負膠(PVD刻蝕后)
廈門云天半導體目前量產化最小L/S為10/10um,工程樣品能力最小L/S為7/7um,2/2um的L/S工藝的成功開發是二期通線后的一次重大突破。目前2/2um的L/S工藝還需進一步的開拓驗證,為后續量產化的導入做足準備。廈門云天半導體將持續追求“創新、卓越、合作、奮斗”的精神,不斷挑戰極限、勇攀高峰!
審核編輯黃昊宇
-
光刻
+關注
關注
8文章
337瀏覽量
30586
發布評論請先 登錄
【「芯片通識課:一本書讀懂芯片技術」閱讀體驗】芯片怎樣制造
【「芯片通識課:一本書讀懂芯片技術」閱讀體驗】了解芯片怎樣制造
光刻工藝的主要流程和關鍵指標

芯片制造:光刻工藝原理與流程

晶圓表面光刻膠的涂覆與刮邊工藝的研究
光刻掩膜技術介紹
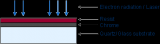
芯片濕法蝕刻工藝
簡述光刻工藝的三個主要步驟
光刻工藝中分辨率增強技術詳解
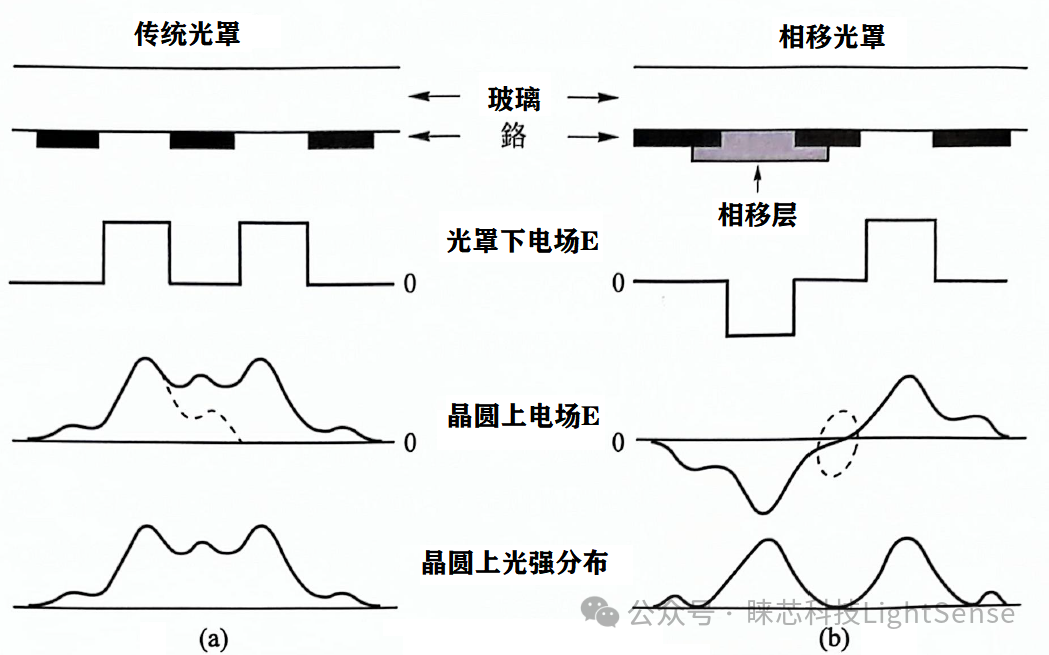
光刻掩膜和光刻模具的關系
光刻工藝的基本知識






 廈門云天Fine Pitch光刻工藝突破2um L/S
廈門云天Fine Pitch光刻工藝突破2um L/S

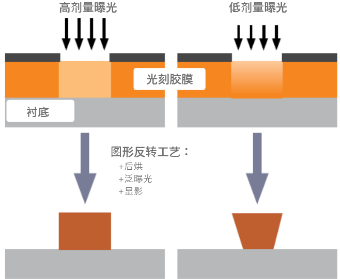










評論