主要的ESD測試是人體模型(HBM),機(jī)器模型(MM)和充電設(shè)備模型(CDM)。
有許多成熟的模型可以針對(duì)ESD事件測試半導(dǎo)體器件的可靠性,以確保有效性和可靠性。主要的ESD測試是人體模型(HBM),機(jī)器模型(MM)和充電設(shè)備模型(CDM)(圖1)。
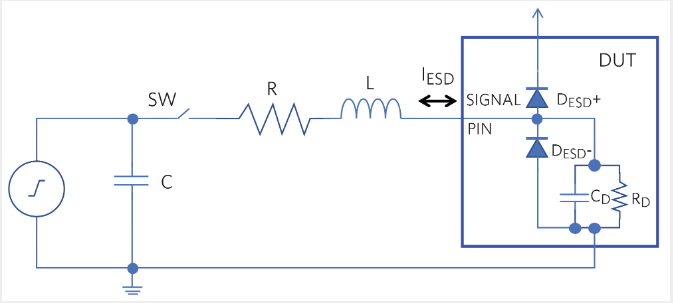
圖1.用于 HBM、MM 和 CDM 測試的 ESD 模型。
JEDEC 標(biāo)準(zhǔn)確保 ESD 測試的有效性和可靠性。這三個(gè)測試的測試配置(圖 1)有五個(gè)要素:V靜電放電、C、SW、R 和 L。輸入V靜電放電在開關(guān)閉合 (SW) 之前對(duì)電容器 C 進(jìn)行電壓充電。隨著SW的閉合,ESD燈具的輸出阻抗(R和L)發(fā)送V靜電放電信號(hào),轉(zhuǎn)換為電流(I靜電放電) 到被測設(shè)備 (DUT) 中。現(xiàn)在的ESD電流流過DUT的ESD二極管;D靜電放電+和 D靜電放電-。如果其中一個(gè)或兩個(gè)ESD二極管發(fā)生故障或缺失,則電流(I靜電放電),從這個(gè)ESD事件中將找到另一條路徑,該路徑多次災(zāi)難性地進(jìn)一步進(jìn)入DUT電路。
公式1表示圖1測試電路的數(shù)學(xué)傳遞函數(shù)。
公式 1
此配置會(huì)導(dǎo)致信號(hào)引腳接合處發(fā)生瞬時(shí)ESD事件,以模擬三個(gè)ESD測試信號(hào)事件之一。DUT 信號(hào)引腳是輸入或輸出器件引腳。對(duì)于這三個(gè)ESD測試,V的值靜電放電、C、R 和 L 組件變化以實(shí)現(xiàn)實(shí)際的 ESD 事件(表 1)。
表 1.HBM、MM、CDM 的可持續(xù)發(fā)展教育活動(dòng)

在表1中,這三種型號(hào)歸結(jié)為串聯(lián)RLC電路和脈沖發(fā)生器,但型號(hào)之間的電路值和脈沖特性不同。然而,所有三項(xiàng)測試都會(huì)產(chǎn)生一個(gè)短而明確的ESD脈沖,從而產(chǎn)生電流(I靜電放電)的水平與實(shí)際可持續(xù)發(fā)展教育事件期間的水平相當(dāng)。
人體模型 (HBM) 表征了電子設(shè)備對(duì)靜電放電 (ESD) 損壞的敏感性。人體模型是一種模擬人類從手指到被測設(shè)備 (DUT) 再到地面的 ESD 路徑的模型。靜電放電電源電壓(V靜電放電) 為測試電路中的電容器充電。標(biāo)準(zhǔn) HBM 測試包括 ±2 kV 的電源電壓、1 至 10 M?的高值電阻和 100 pF 的電容。
機(jī)器模型 (MM) 的目的是創(chuàng)建一個(gè)更嚴(yán)格的 HBM 測試。電荷電容(C)故意變大(200 pF),電荷源電阻值非常低;0 至 10Ω。這種低阻值電阻允許ESD源提供比HBM型號(hào)更高的電流。盡管該模型的目的是表征與最終用戶電子組件相關(guān)的機(jī)器ESD事件,但它并不打算體現(xiàn)半導(dǎo)體最終測試和處理中使用的處理程序。
充電設(shè)備模型 (CDM) 可以作為一次性普遍應(yīng)用的 MM 的替代測試。該CDM測試模擬IC封裝或制造設(shè)備在最終生產(chǎn)操作中處理設(shè)備時(shí)累積的電荷。在制造過程中,設(shè)備處理設(shè)備中存在產(chǎn)生靜電的機(jī)會(huì)。這是IC器件從防靜電管或測試處理器上滑下來的地方,這些防靜電管或測試處理器會(huì)積聚電荷。
當(dāng)前(I靜電放電) 注入 DUT 會(huì)產(chǎn)生熱量。產(chǎn)生的熱量大小取決于峰值ESD脈沖電壓、電容和DUT電阻。在 HBM 測試中,IC 故障模式通常表現(xiàn)為柵極氧化物、觸點(diǎn)尖峰和結(jié)損壞。
靜電放電測試比較
這三個(gè)測試的類似上升時(shí)間約為 10 ns,但 HBM 和 MM 測試的總持續(xù)時(shí)間比 CDM 模型高出約 200 ns(圖 2)。
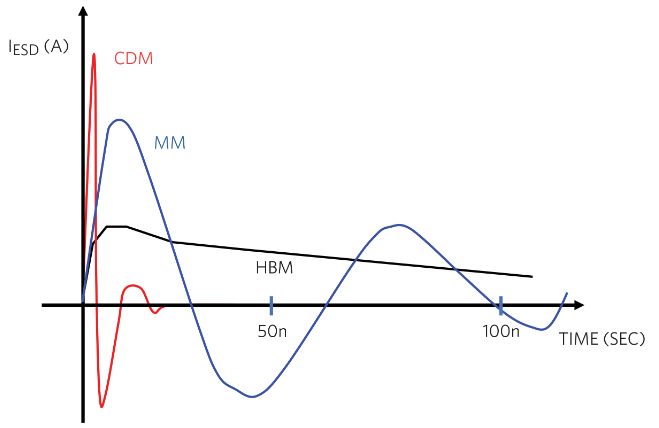
圖2.CDM、MM 和 HBM ESD 電流與時(shí)間的關(guān)系測試。
圖2顯示了電流(I靜電放電) HBM、MM 和 CDM ESD 測試的波形特性。通常,HBM ESD 測試的應(yīng)力水平大約是 MM ESD 測試條件的 10 倍。此外,HBM 測試的保護(hù)電壓水平通常為 2 kV,而 MM 測試的保護(hù)電壓水平為 200 V,CDM 測試的保護(hù)電壓水平為 500 V。CDM、HBM 或 MM 之間沒有相關(guān)性。因此,HBM 和 CDM 測試通常用于 ESD 保護(hù)電路測試。I 的持續(xù)時(shí)間越長靜電放電導(dǎo)致片上ESD結(jié)構(gòu)過熱增加。HBM 和 MM 測試失敗通常表現(xiàn)在柵極氧化物或結(jié)部損壞中。
表 2、3 和 4 顯示了 HBM、CDM 和 MM ESD 抗擾度分類。
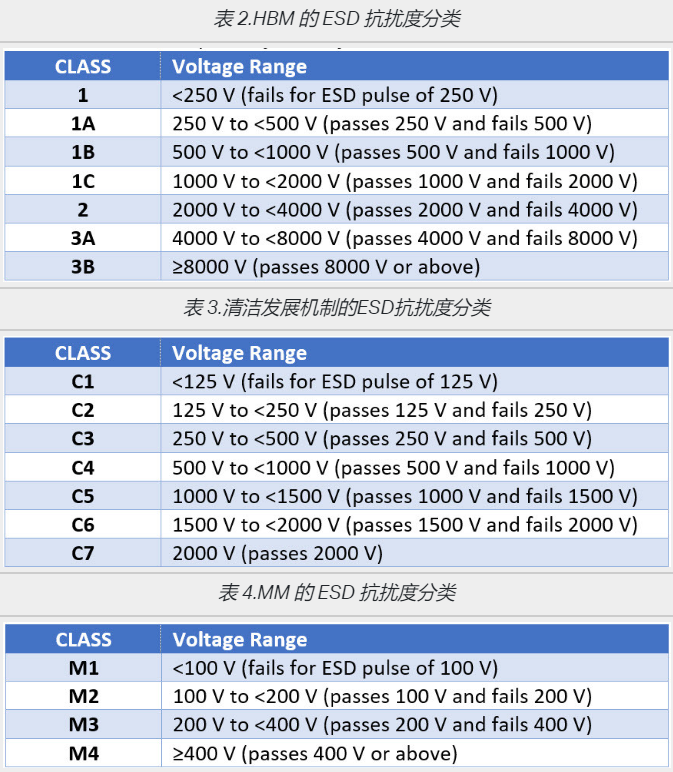
審核編輯:郭婷
-
ESD
+關(guān)注
關(guān)注
49文章
2266瀏覽量
175139 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28609瀏覽量
232595
發(fā)布評(píng)論請(qǐng)先 登錄
季豐電子ESD實(shí)驗(yàn)室新增VFTLP測試能力

用SEI實(shí)現(xiàn)BiSS-C從機(jī)協(xié)議,發(fā)送TIMEOUT期間CDM如何接收?
簡要分析HBM人體放電模型

AEC-Q102之靜電放電測試(HBM)

美光發(fā)布HBM4與HBM4E項(xiàng)目新進(jìn)展
芯片靜電測試之HBM與CDM詳解

芯片的HBM靜電都有哪些測試標(biāo)準(zhǔn),各標(biāo)準(zhǔn)之間有沒有差異

特斯拉也在搶購HBM 4

ESD HBM測試差異較大的結(jié)果分析

ADS1000靜電敏感ESD(HBM)等級(jí)是多少?
ESD測試儀器的使用方法
什么是AEC-Q-CDM測試?
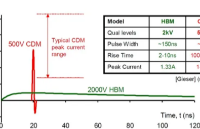
三星否認(rèn)HBM3E芯片通過英偉達(dá)測試
運(yùn)算放大器:4 kV HBM ESD TOLERANCE是什么意思






 HBM、MM和CDM測試基礎(chǔ)
HBM、MM和CDM測試基礎(chǔ)










評(píng)論