翹曲度是實測平面在空間中的彎曲程度,以翹曲量來表示,比如絕對平面的翹曲度為0。計算翹曲平面在高度方向最遠的兩點距離為最大翹曲變形量。
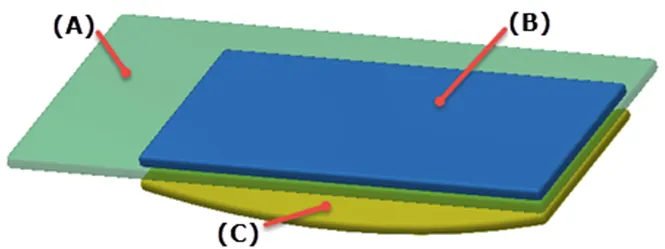
晶圓翹曲度影響著晶圓直接鍵合質量,翹曲度越小,表面越平整,克服彈性變形所做的工就越小,晶圓也就越容易鍵合。晶圓翹曲度的測量既有高精度要求,同時也有要保留其表面的光潔度要求。所以傳統的百分表、塞尺一類的測量工具和測量方法都無法使用。
以白光干涉技術為原理的SuperViewW1光學輪廓儀,專用于超精密加工領域,其分辨率可達0.1nm。非接觸高精密光學測量方式,不會劃傷甚至破壞工件,不僅能進行更高精度測量,在整個測量過程還不會觸碰到表面影響光潔度,能保留完整的晶圓片表面形貌。測量工序效率高,直接在屏幕上了解當前晶圓翹曲度、平面度、平整度的數據。

SuperViewW1光學3D表面輪廓儀
光學輪廓儀測量優勢:
1、非接觸式測量:避免物件受損。
2、三維表面測量:表面高度測量范圍為1nm-10mm。
3、多重視野鏡片:方便物鏡的快速切換。
4、納米級分辨率:垂直分辨率可以達到0.1nm。
5、高速數字信號處理器:實現測量僅需要幾秒鐘。
6、掃描儀:采用閉環控制系統。
7、工作臺:氣動裝置、抗震、抗壓。
8、測量軟件:基于windows操作系統的用戶界面,強大而快速的運算。
審核編輯 黃昊宇
-
測試
+關注
關注
8文章
5626瀏覽量
128290 -
半導體
+關注
關注
335文章
28585瀏覽量
232454 -
晶圓
+關注
關注
52文章
5117瀏覽量
129159
發布評論請先 登錄
wafer晶圓厚度(THK)翹曲度(Warp)彎曲度(Bow)等數據測量的設備
wafer晶圓幾何形貌測量系統:厚度(THK)翹曲度(Warp)彎曲度(Bow)等數據測量
wafer晶圓幾何形貌測量系統:厚度(THK)翹曲度(Warp)彎曲度(Bow)等數據測量

提供半導體工藝可靠性測試-WLR晶圓可靠性測試

半導體測試的種類與技巧

特氟龍夾具的晶圓夾持方式,相比真空吸附方式,對測量晶圓 BOW 的影響






 半導體晶圓翹曲度測試方法
半導體晶圓翹曲度測試方法















評論