一、失效分析的作用
失效分析是根據(jù)失效模式和現(xiàn)象,通過(guò)分析和驗(yàn)證,模擬重現(xiàn)失效的現(xiàn)象,找出失效的原因,挖掘出失效的機(jī)理的活動(dòng)。失效分析是確定芯片失效機(jī)理的必要手段。失效分析為有效的故障診斷提供了必要的信息。失效分析為設(shè)計(jì)工程師不斷改進(jìn)或者修復(fù)芯片的設(shè)計(jì),使之與設(shè)計(jì)規(guī)范更加吻合提供必要的反饋信息。 失效分析可以評(píng)估不同測(cè)試向量的有效性,為生產(chǎn)測(cè)試提供必要的補(bǔ)充,為驗(yàn)證測(cè)試流程優(yōu)化提供必要的信息基礎(chǔ)。
二、常用的芯片失效分析方法
1.X-RAY檢查
X-RAY射線,一種波長(zhǎng)很短的電磁輻射,能透過(guò)許多普通光不能透過(guò)的固態(tài)物質(zhì)。利用可靠性分析室里的X-RAY分析儀,可檢查產(chǎn)品的金絲情況和樹脂體內(nèi)氣孔情況,以及芯片下面導(dǎo)電膠內(nèi)的氣泡,導(dǎo)電膠的分布范圍情況。
2.超聲清洗
清洗僅用來(lái)分析電性能有異常的,失效可能與外殼或芯片表面污染有關(guān)的器件。此時(shí)應(yīng)確認(rèn)封裝無(wú)泄漏,目的是清除外殼上的污染物。清洗前應(yīng)去除表面上任何雜物,再重測(cè)電參數(shù),如仍失效再進(jìn)行清洗,清洗后現(xiàn)測(cè)電參數(shù),對(duì)比清洗前后的電參數(shù)變化。清洗劑應(yīng)選用不損壞外殼的,通常使用丙酮,乙醇,甲苯,清洗后再使用純水清洗,最后用丙酮,無(wú)水乙醇等脫水,再烘干。清洗要確保不會(huì)帶來(lái)由于清洗劑而引起的失效。
3.開(kāi)帽/開(kāi)蓋
高分子的樹脂體在熱的濃硝酸(98%)或濃硫酸作用下,被腐去變成易溶于丙酮的低分子化合物,在超聲作用下,低分子化合物被清洗掉,從而露出芯片表層。
4.內(nèi)部目檢:
視產(chǎn)品不同分別放在200倍或500倍金相顯微鏡下或立體顯微下仔細(xì)觀察芯片表面是否有裂縫,斷鋁,擦傷,燒傷,沾污等異常。對(duì)于芯片裂縫要從反面開(kāi)帽以觀察芯片反面有否裝片時(shí)頂針頂壞點(diǎn),因?yàn)檎骈_(kāi)帽取下芯片時(shí)易使芯片破裂。反面的導(dǎo)電膠可用硝酸慢慢腐,再用較軟的細(xì)銅絲輕輕刮去。
5.外部目檢
是否有樹脂體裂縫,管腳間雜物致短路,管腳是否被拉出樹脂體,管腳根部是否露銅,管腳和樹脂體是否被沾污,管腳是否彎曲變形等不良。
審核編輯:湯梓紅
-
芯片
+關(guān)注
關(guān)注
459文章
52169瀏覽量
436098 -
失效分析
+關(guān)注
關(guān)注
18文章
228瀏覽量
66859 -
x-ray
+關(guān)注
關(guān)注
1文章
121瀏覽量
13742
發(fā)布評(píng)論請(qǐng)先 登錄
離子研磨在芯片失效分析中的應(yīng)用

芯片的失效性分析與應(yīng)對(duì)方法

材料失效分析方法匯總

FIB技術(shù):芯片失效分析的關(guān)鍵工具

顯微鏡在芯片失效分析中的具體應(yīng)用場(chǎng)景及前景
IV測(cè)試助力解芯片失效原因

季豐對(duì)存儲(chǔ)器芯片的失效分析方法步驟
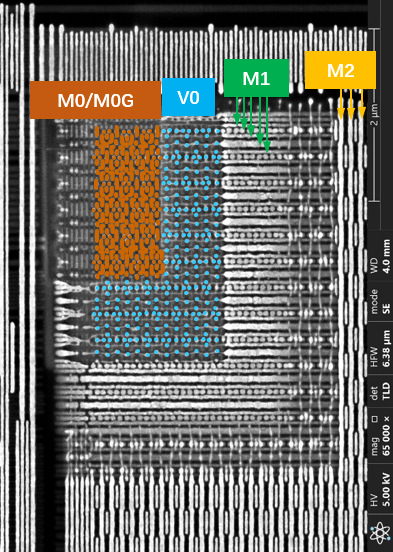
芯片失效分析中常見(jiàn)的測(cè)試設(shè)備及其特點(diǎn)
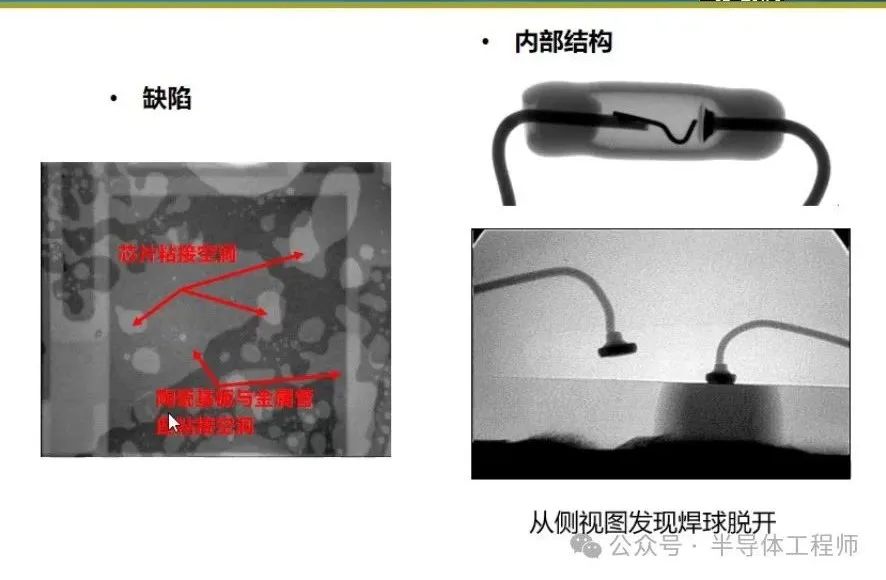
芯片開(kāi)封decap簡(jiǎn)介及芯片開(kāi)封在失效分析中應(yīng)用案例分析
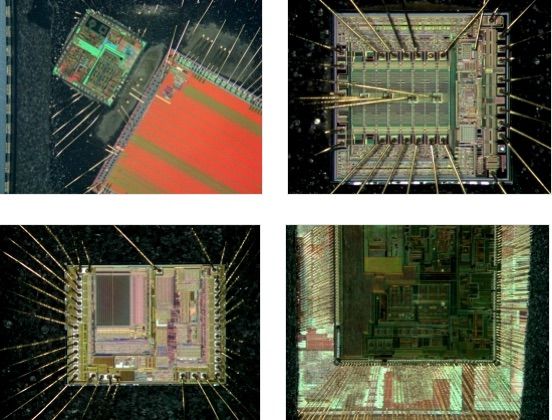





 常用的芯片失效分析方法
常用的芯片失效分析方法
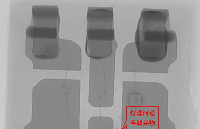

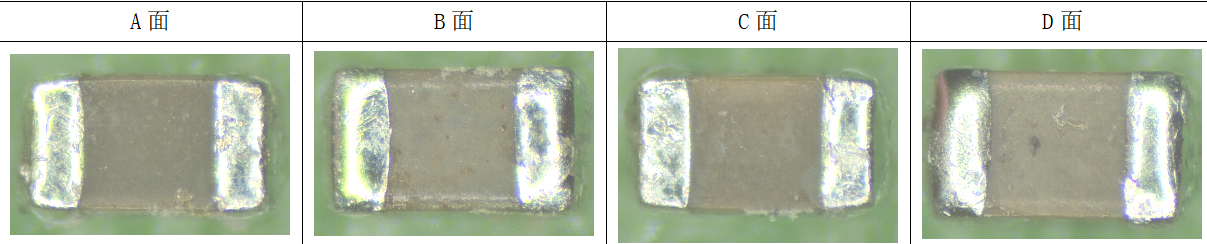










評(píng)論