由于其平行照明,WLI PL非常適合用于測(cè)量具有高深寬比的等離子切割刻蝕溝槽,因?yàn)榇蟛糠止獾竭_(dá)了刻蝕結(jié)構(gòu)的底部,因此可以測(cè)量深度。
隨著經(jīng)典摩爾定律晶體管的優(yōu)勢(shì)在單片芯片上縮小,先進(jìn)封裝的采用正在加速。先進(jìn)的封裝通過高密度互連實(shí)現(xiàn)了多個(gè)不同管芯的異構(gòu)集成,從而提高了設(shè)備性能并減小了占位面積。先進(jìn)的封裝體系結(jié)構(gòu),例如英特爾的嵌入式多芯片互連橋,臺(tái)積電的集成扇出和高帶寬內(nèi)存(HBM),已經(jīng)滿足了摩爾定律的要求,以滿足對(duì)更大的連接性,計(jì)算能力,速度和成本的需求在運(yùn)輸,5G,物聯(lián)網(wǎng),人工智能和高性能計(jì)算中的大趨勢(shì)的有效性。先進(jìn)的封裝使行業(yè)能夠開發(fā)新的倒裝芯片工藝,2.5D中介層和TSV技術(shù),以及最近的2D和3D扇出工藝,它們?cè)谧钚〉目臻g內(nèi)具有高密度的連接。
扇出晶圓級(jí)包裝(FOWLP)是當(dāng)今增長(zhǎng)最快的高級(jí)包裝領(lǐng)域之一。根據(jù)Yole Research,F(xiàn)OWLP預(yù)計(jì)將從2016年的3.2億美元增長(zhǎng)到2022年的$ 2.5B。在FOWLP中,單個(gè)芯片組裝到由低成本聚合物材料制成的人造晶圓中,并具有額外的連接空間。 RDL將芯片上的連接重定向到邊緣區(qū)域。 FOWLP的優(yōu)勢(shì)包括由于更薄的封裝而提高了每瓦性能,并提供了更多的不同設(shè)計(jì),但是這些新器件的制造帶來了新的測(cè)量挑戰(zhàn),包括測(cè)量深蝕刻溝槽的能力。
已建立的設(shè)備MicroProf?系列–來自的多傳感器技術(shù)FRT(FormFactor公司)–結(jié)合白光干涉儀WLI PL和WLI FL,在其他過程達(dá)到極限的生產(chǎn),研究和開發(fā)的高級(jí)包裝領(lǐng)域,提供光學(xué)和非接觸式創(chuàng)新解決方案。例如,等離子切塊刻蝕溝槽的深度為50至200 μm,遠(yuǎn)遠(yuǎn)超出了AFM或輪廓儀尖端的范圍。許多光學(xué)方法(例如共聚焦顯微鏡)也因其孔徑而不適用于此測(cè)量,因?yàn)橛捎趥?cè)壁的陰影,沒有來自溝槽底部的光可以回到傳感器中。另外,蝕刻工藝導(dǎo)致蝕刻溝槽中的表面變粗糙,并因此導(dǎo)致基板表面與溝槽底部之間的反射率的高差異,這可能導(dǎo)致測(cè)量期間的問題。
由于其平行照明,WLI PL非常適合于測(cè)量具有高深寬比的等離子切割蝕刻溝槽,因?yàn)榇蟛糠止獾竭_(dá)蝕刻結(jié)構(gòu)的底部,因此可以測(cè)量深度。根據(jù)表面紋理,可以測(cè)量最小寬度為2到3 μm,長(zhǎng)寬比最高為50:1(深度與寬度)的結(jié)構(gòu)。使用特殊的測(cè)量模式可以分兩個(gè)測(cè)量步驟進(jìn)行測(cè)量。以這樣的方式測(cè)量襯底表面和結(jié)構(gòu)的底部,以使得測(cè)量參數(shù)最佳地適應(yīng)不同的表面條件。
測(cè)量技術(shù)的另一個(gè)問題通常是結(jié)構(gòu)的橫向尺寸小,因?yàn)樵摲椒ǖ墓鈱W(xué)分辨率通常不夠高。例如,溝槽的溝槽寬度可以小于1 μm。 WLI FL使用一種特殊的算法來確定寬度最小為0.7 μm的蝕刻結(jié)構(gòu)的深度。在這種情況下,長(zhǎng)寬比可以達(dá)到3:1。這允許訪問以前未達(dá)到的尺寸。這種方法使得可以測(cè)量所有當(dāng)前使用的TSV變體,包括直徑小于1微米的通孔,這些通孔不再可用光學(xué)方法檢測(cè)。
審核編輯:符乾江
-
芯片
+關(guān)注
關(guān)注
459文章
52481瀏覽量
440556 -
封裝技術(shù)
+關(guān)注
關(guān)注
12文章
578瀏覽量
68595
發(fā)布評(píng)論請(qǐng)先 登錄
溝槽填充技術(shù)介紹
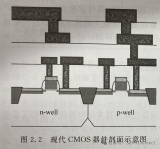
在測(cè)量過程中,發(fā)現(xiàn)粉塵層對(duì)電極有腐蝕現(xiàn)象,該如何應(yīng)對(duì)

玻璃基芯片先進(jìn)封裝技術(shù)會(huì)替代Wafer先進(jìn)封裝技術(shù)嗎

先進(jìn)封裝技術(shù)-19 HBM與3D封裝仿真

先進(jìn)封裝技術(shù)-17硅橋技術(shù)(下)

先進(jìn)封裝技術(shù)-16硅橋技術(shù)(上)

先進(jìn)封裝的核心概念、技術(shù)和發(fā)展趨勢(shì)

CoWoS先進(jìn)封裝技術(shù)介紹

Chiplet在先進(jìn)封裝中的重要性

先進(jìn)封裝技術(shù)-7扇出型板級(jí)封裝(FOPLP)

先進(jìn)封裝技術(shù)- 6扇出型晶圓級(jí)封裝(FOWLP)

先進(jìn)封裝的技術(shù)趨勢(shì)

先進(jìn)封裝的重要設(shè)備有哪些

先進(jìn)封裝技術(shù)的類型簡(jiǎn)述






 采用先進(jìn)的封裝技術(shù)來測(cè)量深腐蝕溝槽
采用先進(jìn)的封裝技術(shù)來測(cè)量深腐蝕溝槽












評(píng)論