先進(jìn)封裝簡介
先進(jìn)封裝技術(shù)已成為半導(dǎo)體行業(yè)創(chuàng)新發(fā)展的主要推動(dòng)力之一,為突破傳統(tǒng)摩爾定律限制提供了新的技術(shù)手段。本文探討先進(jìn)封裝的核心概念、技術(shù)和發(fā)展趨勢[1]。

圖1展示了硅通孔(TSV)技術(shù)的示意圖和實(shí)物照片,顯示了垂直互聯(lián)結(jié)構(gòu)。
XY平面和Z軸延伸的關(guān)鍵技術(shù)
現(xiàn)代先進(jìn)封裝可分為兩種主要方式:XY平面延伸和Z軸延伸。XY平面延伸主要利用重布線層(RDL)技術(shù)進(jìn)行信號(hào)布線,而Z軸延伸則采用硅通孔(TSV)技術(shù)實(shí)現(xiàn)垂直連接。
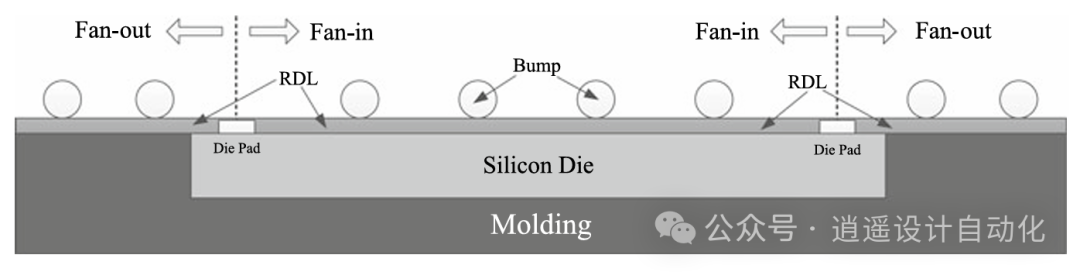
圖2展示了扇入和扇出重布線的示意圖,說明了重新分布芯片連接的不同方法。
扇出技術(shù)及演進(jìn)
扇出晶圓級(jí)封裝(FOWLP)是先進(jìn)封裝的重要發(fā)展之一。該技術(shù)將重布線層擴(kuò)展到芯片區(qū)域之外,在保持緊湊外形的同時(shí)增加輸入/輸出連接數(shù)量。該技術(shù)已發(fā)展出集成扇出(InFO)和面板級(jí)扇出封裝(FOPLP)等變體。
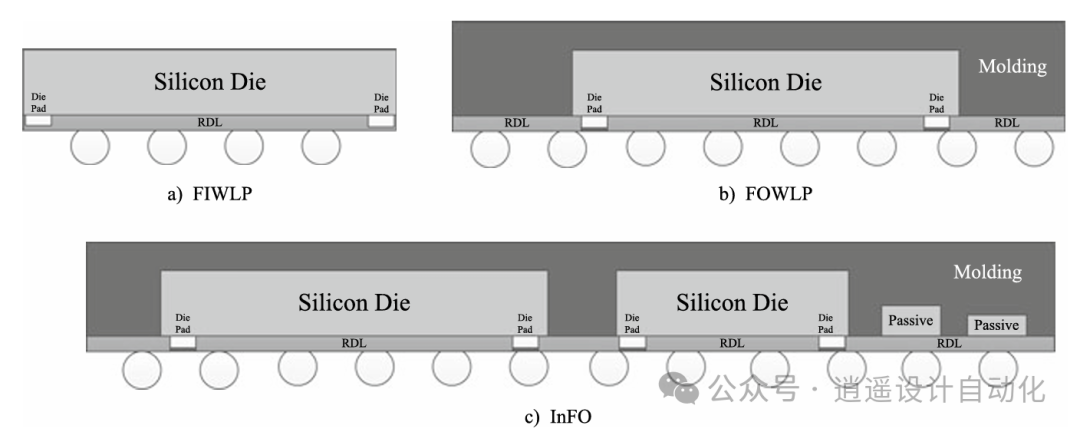
圖3對比了FIWLP、FOWLP和InFO技術(shù),展示其結(jié)構(gòu)差異和演進(jìn)過程。
TSV集成與實(shí)現(xiàn)
TSV技術(shù)實(shí)現(xiàn)了先進(jìn)封裝中的真正3D集成。TSV可以采用3D或2.5D配置實(shí)現(xiàn),每種方法都具有不同應(yīng)用場景的優(yōu)勢。
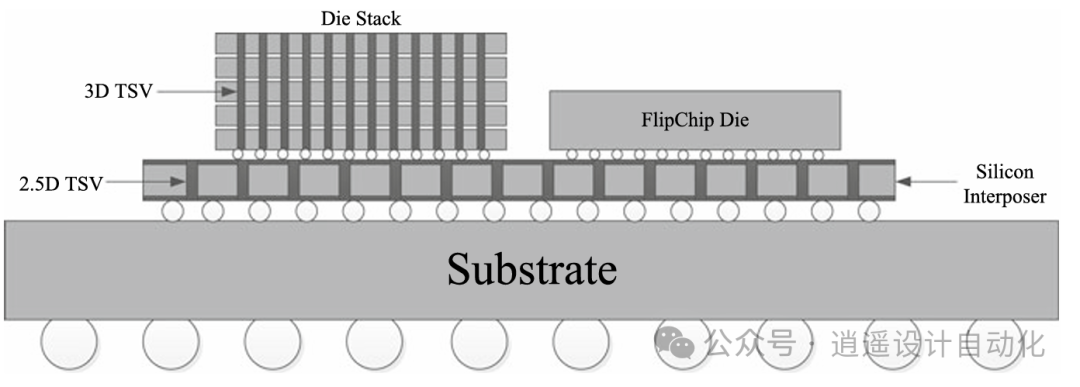
圖4展示了3D TSV和2.5D TSV的示意圖,說明這兩種方法的根本區(qū)別。
行業(yè)領(lǐng)導(dǎo)者及解決方案
主要半導(dǎo)體公司都開發(fā)了自己的先進(jìn)封裝技術(shù)。臺(tái)積電的晶圓級(jí)芯片堆疊(CoWoS)技術(shù)在高性能計(jì)算應(yīng)用中得到廣泛應(yīng)用。
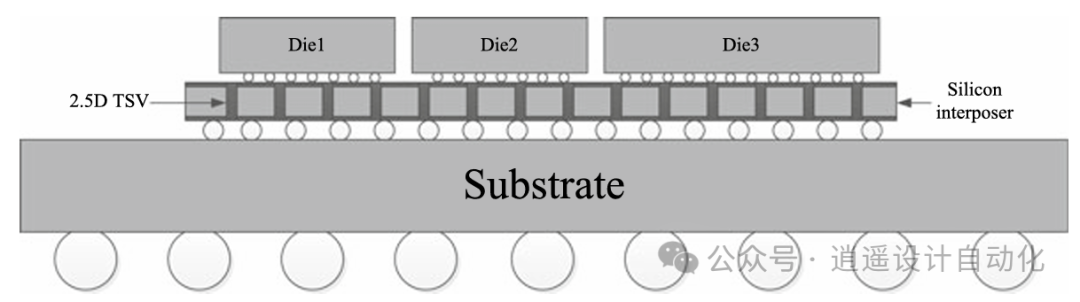
圖5顯示了CoWoS結(jié)構(gòu)示意圖,展示了芯片在硅中介層和基板上的集成方式。
先進(jìn)內(nèi)存集成
高帶寬內(nèi)存(HBM)是先進(jìn)封裝領(lǐng)域的重要突破,特別適用于圖形處理和高性能計(jì)算應(yīng)用。HBM將3D堆疊與高速接口相結(jié)合,實(shí)現(xiàn)了極高的內(nèi)存帶寬。
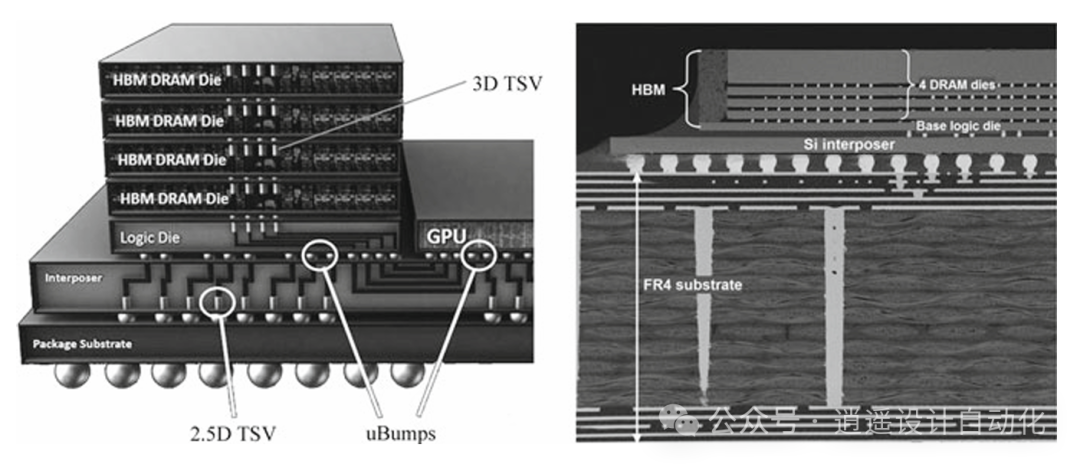
圖6展示了HBM技術(shù)示意圖和實(shí)物剖面,顯示了堆疊內(nèi)存結(jié)構(gòu)和互連方式。
英特爾的先進(jìn)封裝方案
英特爾推出了嵌入式多芯片互連橋接(EMIB)和Foveros等創(chuàng)新技術(shù)。這些方法提供了實(shí)現(xiàn)高密度集成的不同途徑。
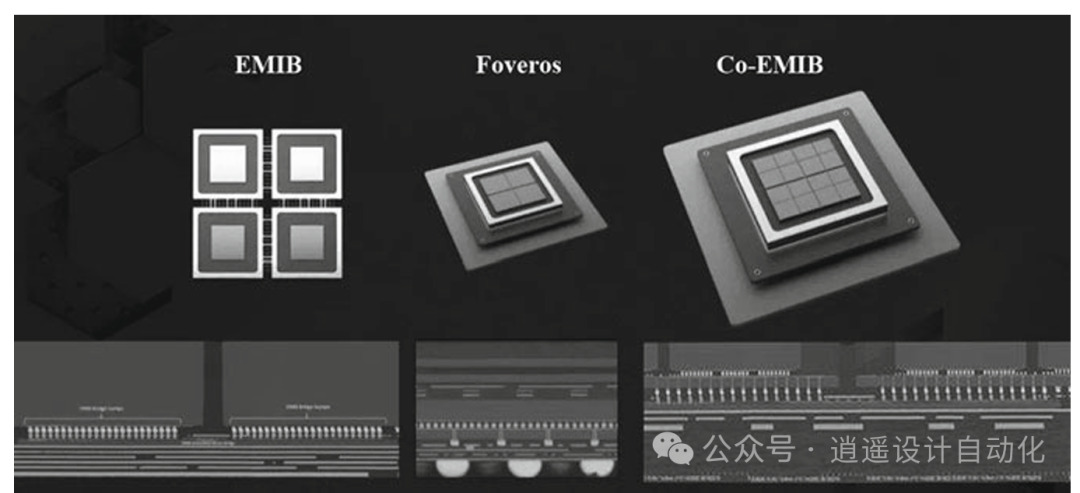
圖7對比了EMIB、Foveros和CO-EMIB的技術(shù)示意圖和產(chǎn)品剖面,展示了英特爾各種先進(jìn)封裝解決方案。
先進(jìn)封裝的基本要素
先進(jìn)封裝的基礎(chǔ)建立在四個(gè)關(guān)鍵要素之上:RDL、TSV、凸點(diǎn)和晶圓。這些要素共同支持各種集成方法和技術(shù)。
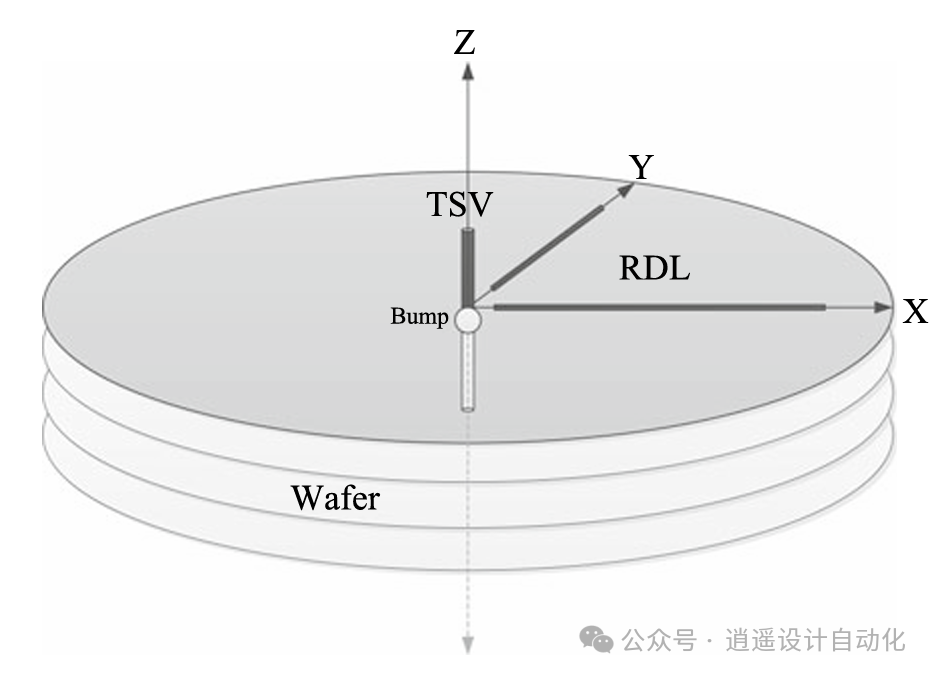
圖8展示了先進(jìn)封裝的四個(gè)要素:RDL、TSV、凸點(diǎn)和晶圓,說明各要素間的相互關(guān)系。
技術(shù)趨勢與演進(jìn)
隨著技術(shù)進(jìn)步,這些要素出現(xiàn)了新的發(fā)展趨勢,特別是凸點(diǎn)技術(shù)逐漸向更細(xì)間距發(fā)展,在硅對硅接口中可能最終被淘汰。
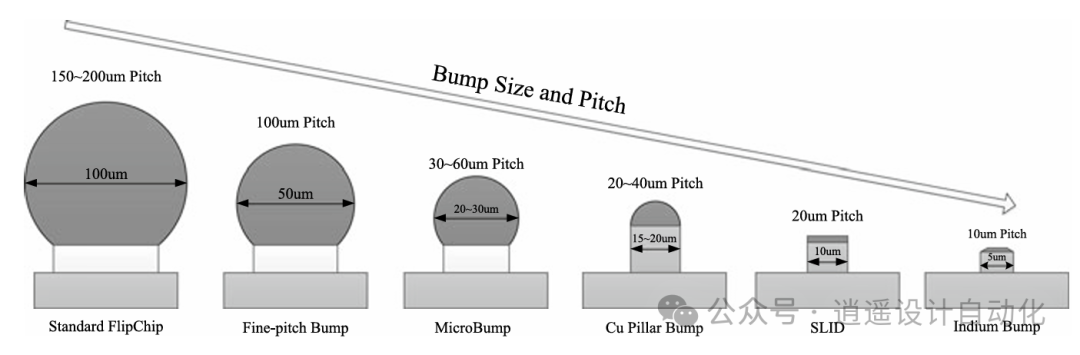
圖9顯示了凸點(diǎn)技術(shù)的發(fā)展趨勢,描述了向更細(xì)間距演進(jìn)并最終在硅接口中消失的過程。
先進(jìn)封裝與SiP的關(guān)系
先進(jìn)封裝與系統(tǒng)級(jí)封裝(SiP)的關(guān)系復(fù)雜,既有重疊又有區(qū)別。雖然所有先進(jìn)封裝解決方案都旨在提高系統(tǒng)密度和性能,但采用的方法和技術(shù)可能不同。
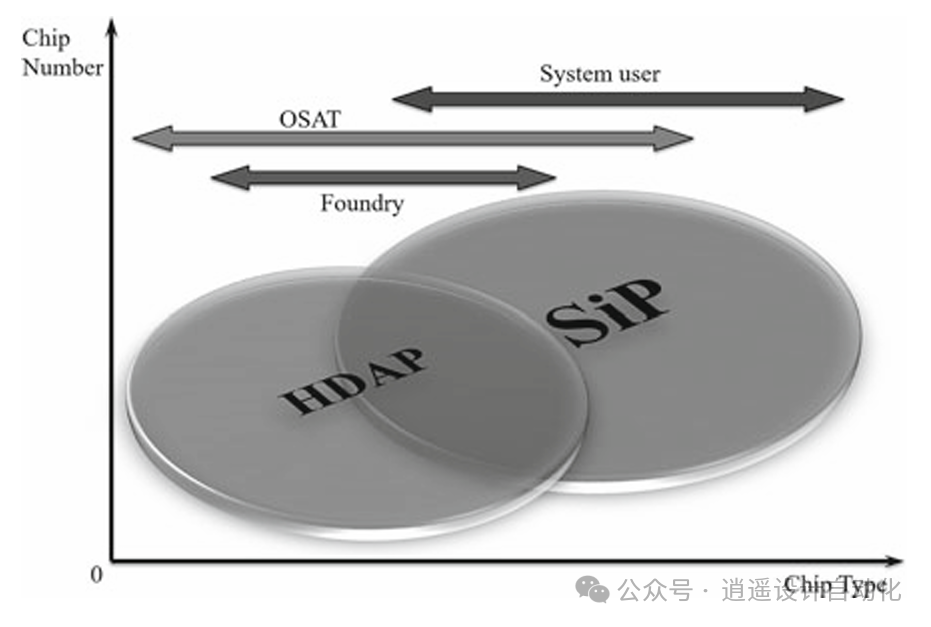
圖10描述了HDAP和SiP的關(guān)系,展示重疊區(qū)域和獨(dú)特特征。
未來展望與行業(yè)影響
先進(jìn)封裝技術(shù)持續(xù)發(fā)展,新技術(shù)不斷涌現(xiàn),以滿足現(xiàn)代電子產(chǎn)品日益增長的需求。從移動(dòng)設(shè)備到高性能計(jì)算,先進(jìn)封裝在推動(dòng)下一代電子系統(tǒng)發(fā)展中發(fā)揮重要作用。
近年來,行業(yè)出現(xiàn)了許多重要?jiǎng)?chuàng)新,如臺(tái)積電的SoIC和三星的X-Cube等技術(shù),推動(dòng)了先進(jìn)封裝技術(shù)的發(fā)展。這些進(jìn)展表明,先進(jìn)封裝將繼續(xù)推動(dòng)半導(dǎo)體創(chuàng)新,提供提升系統(tǒng)性能、降低功耗的新方法。
先進(jìn)封裝代表了半導(dǎo)體技術(shù)從傳統(tǒng)的"重外部"封裝轉(zhuǎn)向"重內(nèi)部"集成。轉(zhuǎn)變促進(jìn)了芯片設(shè)計(jì)團(tuán)隊(duì)和封裝團(tuán)隊(duì)的緊密合作,為現(xiàn)代電子系統(tǒng)提供了更優(yōu)化、更高效的解決方案。
參考文獻(xiàn)
[1] S. Li, "SiP and Advanced Packaging Technology," in MicroSystem Based on SiP Technology. Beijing, China: Publishing House of Electronics Industry, 2022, ch. 5, pp. 117-154.
END
-
TSV
+關(guān)注
關(guān)注
4文章
119瀏覽量
81825 -
FOWLP
+關(guān)注
關(guān)注
1文章
15瀏覽量
10077 -
先進(jìn)封裝
+關(guān)注
關(guān)注
2文章
457瀏覽量
496
原文標(biāo)題:現(xiàn)代半導(dǎo)體先進(jìn)封裝技術(shù)
文章出處:【微信號(hào):深圳市賽姆烯金科技有限公司,微信公眾號(hào):深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄

TPMS技術(shù)與發(fā)展趨勢
廣電業(yè)務(wù)發(fā)展趨勢與業(yè)務(wù)捆綁技術(shù)
PCB發(fā)展趨勢,六大趨勢
先進(jìn)封裝技術(shù)的發(fā)展趨勢
2021年物聯(lián)網(wǎng)有哪些發(fā)展趨勢?
電子技術(shù)在現(xiàn)代汽車上的應(yīng)用及發(fā)展趨勢是什么
探討智能視頻分析技術(shù)的應(yīng)用現(xiàn)狀與發(fā)展趨勢
智能制造中木工機(jī)械發(fā)展趨勢怎樣
先進(jìn)封裝技術(shù)及發(fā)展趨勢






 先進(jìn)封裝的核心概念、技術(shù)和發(fā)展趨勢
先進(jìn)封裝的核心概念、技術(shù)和發(fā)展趨勢










評論