隨著芯片設(shè)計(jì)的異質(zhì)性和應(yīng)用的針對(duì)性越來(lái)越強(qiáng),由此變化帶來(lái)的問(wèn)題也越來(lái)越多,這使得我們很難確定問(wèn)題的根源或預(yù)測(cè)出錯(cuò)的原因以及什么時(shí)候出錯(cuò)。
對(duì)這些變化帶來(lái)的問(wèn)題,一般僅限于最先進(jìn)的節(jié)點(diǎn)工藝。在這種節(jié)點(diǎn)上晶體管密度最高,而且制造工藝仍在微調(diào)中。這就是為什么設(shè)計(jì)規(guī)則隨著新節(jié)點(diǎn)的引入而變得更加嚴(yán)格,而后,隨著這些工藝的成熟而逐漸寬松。但是,隨著新的多芯片架構(gòu)的出現(xiàn),這些變化的來(lái)源和影響的數(shù)量正在增加。
產(chǎn)生變化的原因很多,變化的形式也很多。它可以表現(xiàn)在從光刻到清潔和拋光的所有方面,甚至是用于蝕刻或沉積氣體中。它也可以表現(xiàn)為不同的噪音來(lái)源,影響信號(hào)完整性。它還可能出現(xiàn)在封裝中的芯片之間或封裝本身的互連中。
當(dāng)涉及到封裝中的異質(zhì)芯片時(shí),封裝的形式因素(x,y,z)成為變化的主要來(lái)源。這通常是由于基材的尺寸較大,導(dǎo)致了一系列的工藝挑戰(zhàn)。其中,最大的兩個(gè)是翹曲管理和可靠性管理。
先進(jìn)封裝中使用的鍵合/解鍵和互連也存在差異。"例如,有大規(guī)模回流焊、熱壓焊和激光輔助鍵合互連選擇的線束,或線束加倒裝芯片與各種被動(dòng)元件的組合。對(duì)于每一種工藝,在溫度、應(yīng)力殘留和可能的隱形微裂紋方面都有很多變化。
在某些情況下,這種變化可能是疊加的。因此,雖然EUV中的隨機(jī)性可能不會(huì)在單個(gè)芯片中造成問(wèn)題,但與封裝中的其他芯片/小芯片以及其他變化源結(jié)合起來(lái),它們會(huì)影響產(chǎn)量或影響設(shè)備的長(zhǎng)期可靠性。
更麻煩的是,這些設(shè)計(jì)中有許多是針對(duì)特定領(lǐng)域的。比如,汽車CPU的AI芯片與服務(wù)器或AR耳機(jī)芯片的設(shè)計(jì)有很大的不同。它們很可能得不到更大規(guī)模的產(chǎn)量,進(jìn)而推進(jìn)最先進(jìn)節(jié)點(diǎn)開(kāi)發(fā)芯片的誕生;而那些產(chǎn)量數(shù)以億計(jì)的芯片則需要經(jīng)過(guò)許多周期的測(cè)試,由此,我們必須區(qū)分隨機(jī)的問(wèn)題和系統(tǒng)性的問(wèn)題。
幾十年前,我們已經(jīng)能充分理解封裝的變化;但在先進(jìn)節(jié)點(diǎn)和先進(jìn)封裝中,變化的影響正在增長(zhǎng)和擴(kuò)大。Amkor公司先進(jìn)封裝和技術(shù)副總裁Mike Kelly指出,隨著工作電壓的降低,變異的影響也在增加,因?yàn)楣罡鼑?yán)格。節(jié)點(diǎn)越老,它對(duì)電壓變化等事情的容忍度就越高。"
隨著我們走向更多的定制封裝,有更多的I/O,更細(xì)的間距,以及更少的空間來(lái)放置這些器件,這使我們可以進(jìn)行更多的定制。
對(duì)于處理異質(zhì)性問(wèn)題,我們需要進(jìn)行權(quán)衡。關(guān)鍵是如何將影響降到最低。在90納米或45納米工藝制程時(shí),我們可能沒(méi)有被注意到是,當(dāng)同一芯片或小芯片與其他相同或不同節(jié)點(diǎn)的器件,一起被放入先進(jìn)封裝時(shí)可能會(huì)出現(xiàn)問(wèn)題。若僅用3D工藝進(jìn)行晶圓的表面檢查,這遠(yuǎn)遠(yuǎn)不夠。因?yàn)榇蟛糠值膶?dǎo)電性是垂直于圖像平面的,而電氣在線檢查非常重要。
系統(tǒng)設(shè)計(jì)者可以選擇不同的封裝類型,并將功能集成到一個(gè)封裝中。每種軟件包都有優(yōu)點(diǎn)和缺點(diǎn),而且軟件包的價(jià)格也不同。因此,對(duì)于系統(tǒng)設(shè)計(jì)者來(lái)說(shuō),決定哪種類型的封裝適合特定的應(yīng)用很重要,如果決定錯(cuò)了,就很難再回到設(shè)計(jì)過(guò)程中去,因?yàn)楹芏嘣敿?xì)設(shè)計(jì)部分已經(jīng)就位。先進(jìn)封裝變得復(fù)雜,也包括芯片的移動(dòng),單個(gè)芯片在晶圓水平上粘合在一起時(shí)的翹曲,以及材料的變化,如薄膜和基材。其中一些微小的變化,檢查難以發(fā)現(xiàn)它們。
在芯片制造中,性能、功率、面積和成本是我們必須考慮的因素。我們?nèi)绾蔚玫阶罴训钠胶猓總€(gè)人的方法不一。我們可以采用不同元素組合的化合物半導(dǎo)體制作晶圓。這些化學(xué)元素組合非常靈活,而且其配比并非都一樣。它們有的非常堅(jiān)硬,在某些情況下能高度受力和被扭曲,而在另外某些情況下則不然。我們必須處理所有這些問(wèn)題。工藝方案以及我們的材料和工藝技術(shù)存在不同的變異性。這種變化也會(huì)因其他變異而變得更加復(fù)雜。比如,如果開(kāi)始有翹曲,那么就用某種限制技術(shù)或粘合技術(shù)來(lái)處理,但他們?nèi)匀粺o(wú)法消除,現(xiàn)在又在這個(gè)基礎(chǔ)上做別的事情,給這種復(fù)雜性又增加了一成。
這些變化帶來(lái)的一個(gè)更大挑戰(zhàn)是封裝中部件的不均勻老化。這可能因終端應(yīng)用、個(gè)人使用情況或位置以及開(kāi)發(fā)不同芯片或芯片組的工藝節(jié)點(diǎn)而不同。但是,對(duì)于為汽車等應(yīng)用開(kāi)發(fā)的封裝來(lái)說(shuō),它變得更具挑戰(zhàn)性,這些車規(guī)器件需要10~20年的保障期。
在最先進(jìn)的工藝幾何上,同構(gòu)計(jì)算的成本變得高昂。僅僅在單一芯片上放置更多的晶體管,使得性能、功率和面積/成本等方面不會(huì)有顯著的的改善。但是,構(gòu)建具有多個(gè)芯片的復(fù)雜定制包可能是一項(xiàng)復(fù)雜而昂貴的工作。
隨著封裝行業(yè)的成熟,該行業(yè)可能會(huì)圍繞某些架構(gòu)和平臺(tái),選擇許多特性良好的元件來(lái)解決。但是,變化將繼續(xù)成為一個(gè)問(wèn)題,因?yàn)樵谶@些封裝內(nèi)發(fā)生的事情更多。隨著封裝越來(lái)越密集,變異將產(chǎn)生一些意外的影響,這些影響需要在設(shè)計(jì)、制造流程、甚至進(jìn)入現(xiàn)場(chǎng)的所有階段加以識(shí)別和處理。這將需要更好的EDA工具、更統(tǒng)一的封裝方法--基本上是新的平臺(tái)--以及更多的可追溯性和對(duì)所涉及的各個(gè)部分的監(jiān)控的組合。
先進(jìn)封裝是未來(lái)的趨勢(shì),這將需要整個(gè)芯片行業(yè)做出巨大的集體努力,以使其能夠持續(xù)、可靠、快速地工作,從而在應(yīng)用領(lǐng)域中進(jìn)入市場(chǎng)窗口。
審核編輯:湯梓紅
-
芯片
+關(guān)注
關(guān)注
460文章
52543瀏覽量
441619 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28963瀏覽量
238753 -
封裝
+關(guān)注
關(guān)注
128文章
8705瀏覽量
145596
發(fā)布評(píng)論請(qǐng)先 登錄
功率半導(dǎo)體器件——理論及應(yīng)用
先進(jìn)碳化硅功率半導(dǎo)體封裝:技術(shù)突破與行業(yè)變革

瑞沃微先進(jìn)封裝:突破摩爾定律枷鎖,助力半導(dǎo)體新飛躍

全面剖析倒裝芯片封裝技術(shù)的內(nèi)在機(jī)制、特性優(yōu)勢(shì)、面臨的挑戰(zhàn)及未來(lái)走向
砥礪創(chuàng)新 芯耀未來(lái)——武漢芯源半導(dǎo)體榮膺21ic電子網(wǎng)2024年度“創(chuàng)新驅(qū)動(dòng)獎(jiǎng)”
芯和半導(dǎo)體將參加重慶半導(dǎo)體制造與先進(jìn)封測(cè)產(chǎn)業(yè)發(fā)展論壇
倒裝芯片封裝:半導(dǎo)體行業(yè)邁向智能化的關(guān)鍵一步!

制局半導(dǎo)體先進(jìn)封裝模組制造項(xiàng)目開(kāi)工

倒裝封裝(Flip Chip)工藝:半導(dǎo)體封裝的璀璨明星!

探秘GaN功率半導(dǎo)體封裝:未來(lái)趨勢(shì)一網(wǎng)打盡!

玻璃基板:半導(dǎo)體封裝領(lǐng)域的“黑馬”選手

齊力半導(dǎo)體先進(jìn)封裝項(xiàng)目一期工廠啟用
人工智能半導(dǎo)體及先進(jìn)封裝技術(shù)發(fā)展趨勢(shì)

晶圓廠與封測(cè)廠攜手,共筑先進(jìn)封裝新未來(lái)

探尋玻璃基板在半導(dǎo)體封裝中的獨(dú)特魅力
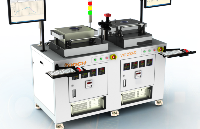





 半導(dǎo)體先進(jìn)封裝的未來(lái)挑戰(zhàn)
半導(dǎo)體先進(jìn)封裝的未來(lái)挑戰(zhàn)











評(píng)論