蘋果在本月初發布了最新一代的M1 Ultra芯片,采用了獨特的 UltraFusion 芯片架構。借助橋接工藝,這款Ultra芯片擁有 1,140 億個晶體管,數量達到了M1的 7 倍之多。雖然芯片還是采用與上一代M1 max一樣的5nm工藝節點,但在新架構加持下,兩顆 Max 之間的互連頻寬可達 2.5TB/s。這種架構的好處是運行在目前M1芯片上的軟件無需修改相關的指令就可以直接運行,省去了應用端更新軟件或開發新應用層命令的需求。同時,增加一個芯片后,對內存處理的帶寬也直接翻倍,收獲的性能提升非常顯著,特別是針對GPU處理能力方面,是極具爆發力的。
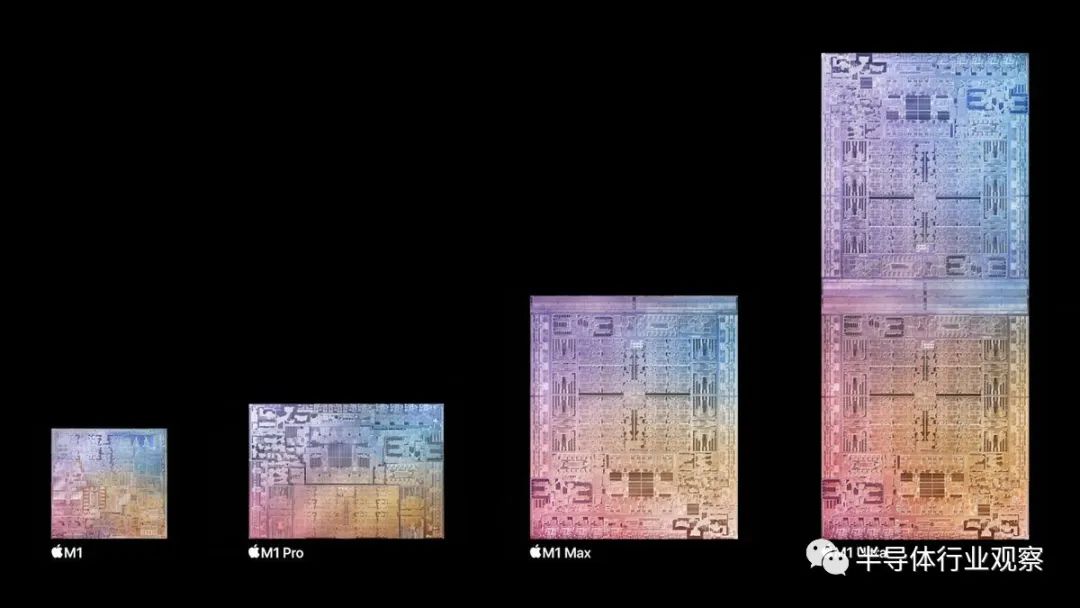
蘋果M1芯片進化 (Source:Apple) 近日,評測機構也對比了幾款主流芯片與M1 Ultra的性能。在單核處理能力上,Ultra并不比Max優秀。但在多核多線程的性能上,性能翻倍,可以說是秒殺上一代芯片。但相關的功耗并無披露,在之后的評測中可以繼續關心相關性能。
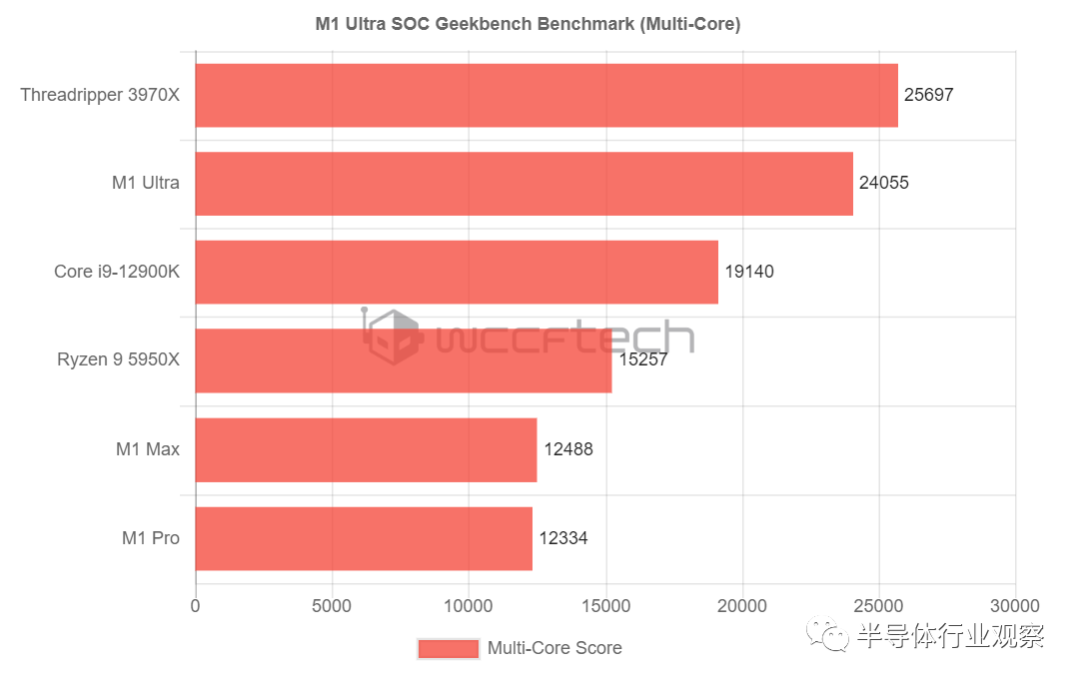
M1 Ultra多核多線程處理能力對比 (Source:WCCFtech) 從目前透露的信息,并不能確定M1 Ultra來源于哪種橋接工藝(估計隨后的Teardown即可見分曉),因為目前包括TSMC和Intel都有埋入硅橋的類似量產工藝。但由于使用的是2個同樣的芯片,從芯片設計角度來說并不能算嚴格意義的Chiplet,更多是一個Multi-die package的設計。作者觀點,考慮到臺積電為Apple主力代工的關系,采用臺積電埋入硅橋的可能性較大。從臺積電宣傳介紹了解到LSI在去年Q1還在做驗證,而M1 Max在去年10月左右推出,M1 Ultra今年3月推出,在開發時間上雖然很緊湊但也并非不可匹配。M1 Max在推出的時候也預留了橋接的I/O,加快了M1 Ultra的開發周期。由此可見Ultra早已在1年前或更早時間就已經在蘋果的計劃中。
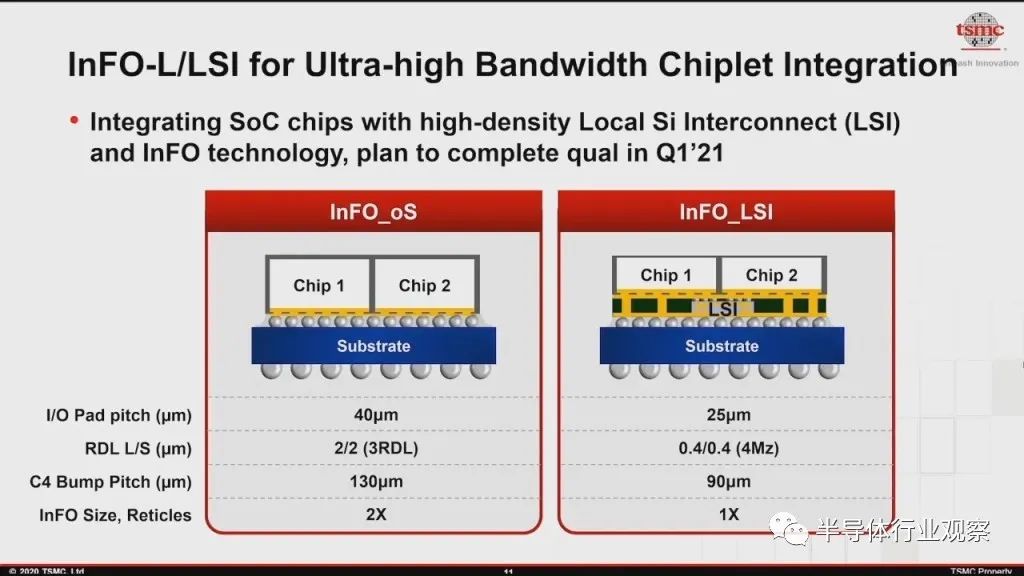
臺積電的局部硅橋(local silicon interconnect) (Source: 臺積電) 臺積電的硅橋技術分為硅通孔橋和硅上RDL橋。所謂硅通孔橋就是在埋入的硅橋中有TSV,信號穿過硅通孔,通過TSV進行橋接。而RDL橋就是在硅上進行RDL制備,而為了確保可靠性和工藝兼容,目前主要的絕緣層材料大多采用ABF或低熱膨脹EMC。
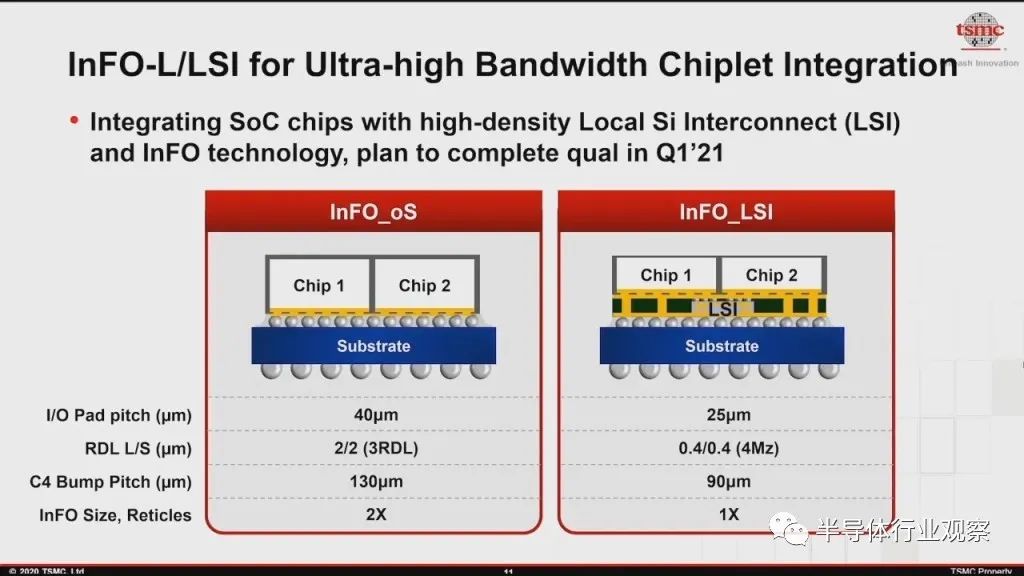
臺積電局部硅橋(local silicon interconnect) (Source: TSMC) 臺積電局部硅橋基于晶圓級硅工藝,比如金屬化和鈍化層形成等仍然是采用IC制造機臺,因此其RDL精度非常高,可以輕松實現2微米線寬。這與Intel的Embedded Multi-Tile Interconnect Bridge(EMIB)工藝完全不同,因為EMIB是使用板級基板工藝機臺,雖說硅橋本身可以做到2微米線寬,但埋入的后期工藝配合上有些挑戰,本文后面會介紹。
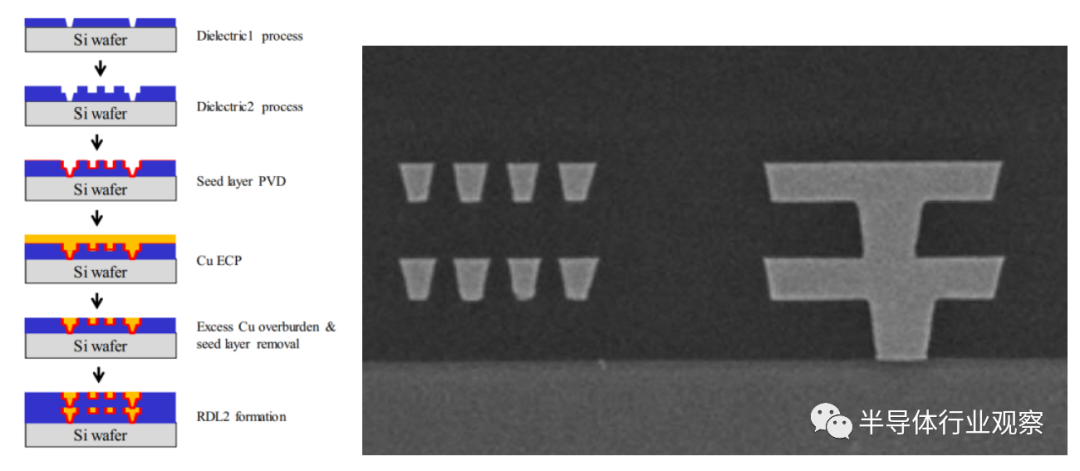
臺積電高密度RDL (Source: TSMC) 臺積電的InFO/CoW我們接收的信息比較多了,很多文章有介紹過,這里不進行詳述。接下來我們重點看看Intel的EMIB技術。 早在2011年的一個封裝國際會議上【1】, Intel的工程師就提出了用硅橋連接2個硅處理器的概念。而當時的版本還未提及埋入這一概念,只是展示了橋接后較好的電性能。對如何封裝,如何大規模生產,以及如何保證封裝體的可靠性等都是未知數。

硅橋連接【1】 但很快,Intel在次年(2012)的一份專利中將目前版本的雛形進行了描述【2】。而這份專利直到2015年授權之后才被公開。所以,我們其實能看到的最早對EMIB的詳細描述是Intel在2016年ECTC發表的論文【3】。在這篇論文中,Intel展示了EMIB的結構,工藝,樣品性能等。通過這一技術,EMIB可以實現與CoWoS類似的I/O數量和帶寬。然而,開發結合封裝基板技術與芯片制備技術的混合芯片封裝體充滿挑戰,即使強大如Intel也花費了不少時間,至今才達到了能量產的程度。接下來我們結合Intel發表的一些公開的論文,試圖管中窺豹。

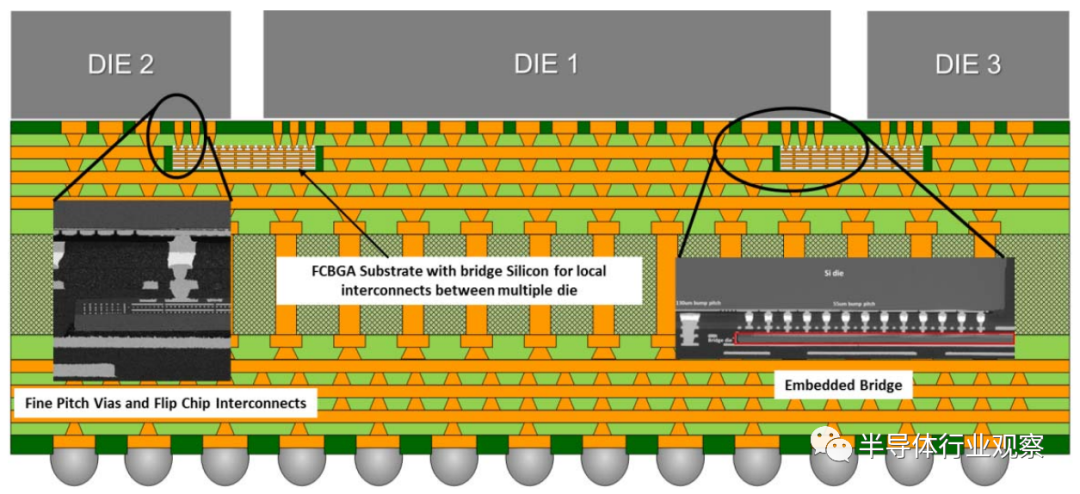
EMIB內部結構示意圖【3】 相對于其他2.5D/3D封裝技術,EMIB的主要技術優勢有以下幾點【4】:
| 1 | 利用先進有機基板工藝實現局部高密度布線。區別于需要更大尺寸硅中介層和高密度硅通孔(TSV)的其他2.5D多芯片封裝技術,能針對I/O需求實現局部高密度布線。 |
| 2 | 無光罩尺寸限制。由于要保證曝光顯影的精準度和數值孔徑,光刻工藝的光罩尺寸范圍通常有其限制,例如M1 Max的芯片最大可用尺寸在19.05mmx22.06mm(約420mm2),已經是臺積電硅橋CoWoS工藝的一半。EMIB則無需限制芯片尺寸,可以通過局部硅橋實現相對自由的芯片尺寸搭配(InFO-LSI也是干這個事) |
| 3 | 相對硅TSV而言,EMIB的制造工藝更簡單,成本也相對更低(如果良率相等的情況)。同時,減少更多硅的浪費,只在需要互聯的地方放置硅橋。 |
然而主要的挑戰在板級工藝。因此EMIB缺點主要集中在工藝實現【4】:
| 1 | 引入了更復雜的有機基板制備工藝,在精準度控制上遠高于目前的有機基板布線。由此需要針對這一系統進行特殊材料和工藝的開發。 |
| 2 | 跟普通的倒裝芯片類似,由于有機基板的熱膨脹系數(CTE)與硅橋芯片的CTE存在失配,使得表面貼裝的芯片引腳,芯片背面和填充熱界面材料之間產生較大的應力。 |
EMIB工藝由于搭配了硅和有機基板工藝,所以在技術上體現了目前先進封裝的一個主流趨勢 - 融合,特別是前段硅制程與后端封裝制程的融合。從硅橋部分來看,通常,硅橋的尺寸在2-8毫米左右,而芯片厚度在75微米以下,從而保證跟基板工藝所匹配,同時實現較高精準度的布線和對準工藝。目前Intel針對的是4層布線結構的開發,能滿足大多數I/O需要。雖然,目前硅橋上的金屬布線的線間距可以穩定實現2微米,進一步進行細微化也是非常可行的,因為金屬布線的結構都是在目前成熟的硅后端工藝中進行制造。然而,隨著布線寬度的減小,線電阻會急劇增加,線間的電容也會改變,這給信號的完整性(integrity)增加了挑戰。因此,在進行硅橋走線設計時,需要非常詳細的架構設計和模擬工作來保證最終的產品性能。另外,介電層的材料介電常數和高頻損耗對布線也有影響。因此,硅橋的設計工作是非常挑戰的,它完全不同于目前的硅芯片設計師們的日常設計理念,而需要懂材料,懂封裝,懂制程和懂信號完整性的資深工程師(們)來共同實現。
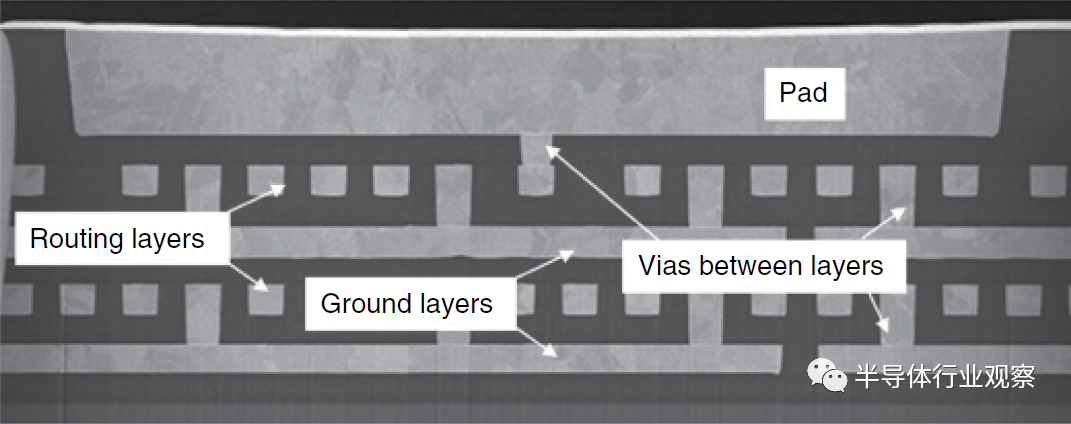
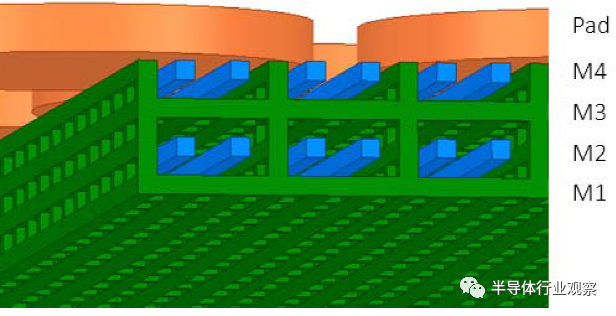
硅橋內部結構示意圖【4,5】 從硅橋的集成部分來看大概的工藝流程涉及到幾個關鍵步驟:基板的壓合,銅制程,激光以及芯片貼裝的埋入工藝。針對特殊工藝,Intel開發了自家的埋入封裝(embedded)制程。其實在當時埋入封裝已經不是什么新東西,日本的廠家在早年曾做過針對電阻電容的埋入封裝。但由于那時還是PCB工藝,用的是CO2激光,非常粗糙;鍍銅工藝也相對落后,根本沒法做2微米的線寬,自然也不會有人想到用基板工藝去做芯片的高密度連接。Intel在10年前能想到用硅橋技術結合埋入封裝確實是一個大膽之舉。在加成法(Additive)鍍銅工藝和Coreless基板工藝成熟后,EMIB的實現也就水到渠成了。
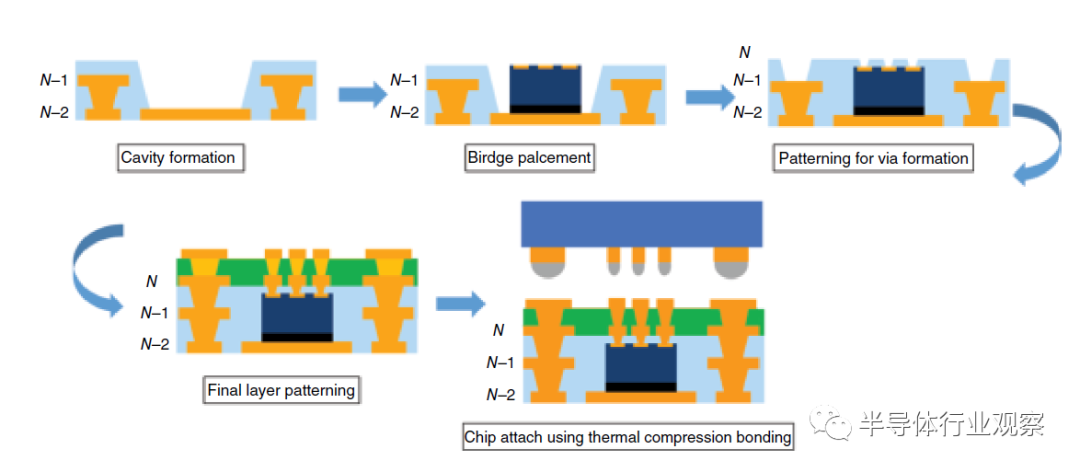
EMIB工藝示意圖【4】 埋入的過程由于采用有機基板工藝,對公差的控制提出了更高的要求,例如芯片的厚度,芯片的切割,芯片的貼裝,和薄片的轉移等都是及其挑戰的,需要獨有機器進行配合。另外,整體的基板制備是扇出型的大板(FOPLP)封裝形式(500mm X 500mm),對板級的工藝一致性要求非常高。然而,在達到相對成熟的工藝良率后,產出的成本是相對較低的。同時,大板封裝有其先天優勢,適合制造非常大的集成芯片,這與目前的小芯片(Chiplet)技術上的需求是吻合的。與普通FOPLP不同的是,EMIB并不需要將芯片從臨時的載板上取下,當芯片被貼上之后就是永久固定的,減小了芯片在后續工序中位移的風險。
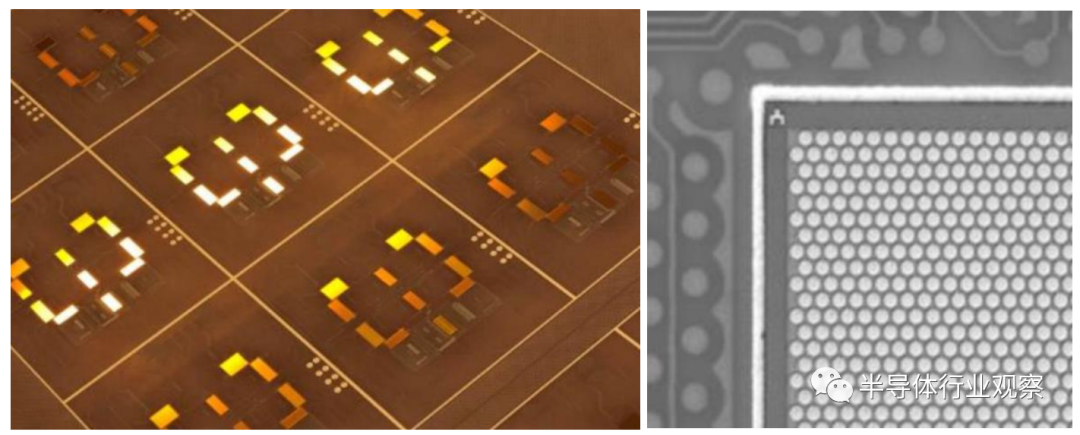
埋入在有機基板中的硅橋【6】 硅橋的芯片雖然只有2-8mm,但是小于75微米的薄片會由于內部的Cu布線結構產生芯片翹曲。另外,芯片貼裝膜(DAF)的存在也會直接導致切割后的芯片產生翹曲。因此,如何控制貼裝之后的芯片不產生孔洞及分層,乃至芯片破裂又是一個挑戰所在。針對這一要求,Intel開發了針對這一工序的DAF材料,并通過優化基板銅層的表面,貼裝材料固化工藝和有機材料的疊層工藝,實現了可接受的過程。

無分層的芯片貼裝截面【6】 在除了以上跟芯片貼裝相關的精準控制要求之外,在進行大面積高數量激光鉆孔的對準上也極其挑戰。硅橋表面的銅引腳尺寸在50微米左右(或更小),而間距(pitch)可能在70微米(或更小)。因此對激光鉆孔機器本身的對準要求極高。如激光開口無法與硅橋上的銅引腳對應(部分對應也不行),在之后的阻抗匹配和信賴性的表現上就有可能會出現問題。當然,除了激光通孔,也可以使用掩膜版光刻的形式去形成對位孔,采用物理刻蝕的方式去形成通孔,而Intel采用何種工藝估計會根據孔的密度來進行選擇。

埋入的硅橋需要精準的激光鉆孔對位【6】 在實現上下通孔后,要實現互聯的工序就是進行化學及電化學銅沉積,這在基板工藝中是成熟工藝。但通孔的尺寸實在是很小,對填銅工藝是有挑戰的,當液體無法進行充分的離子交換,填銅的速度在整個500mmx500mm的大板中沉積的速度不一樣時就會導致不同的填充厚度。同時水平和垂直電鍍線的藥水和工藝能力也存在較大差異,相信Intel在開發過程中在這一工序上沒少嘗試。
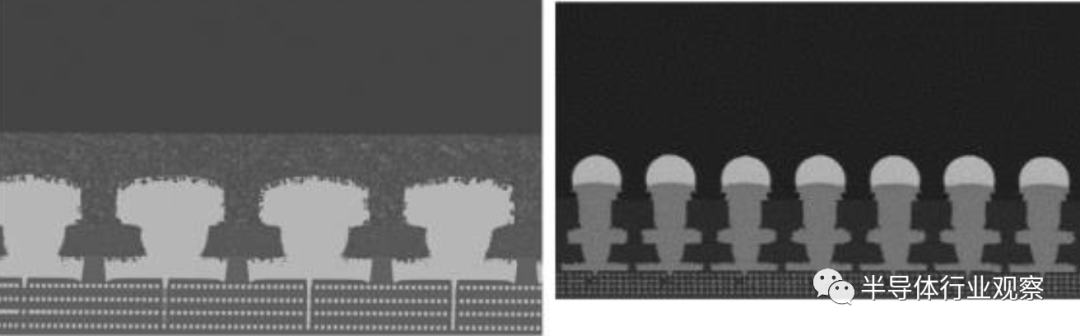
硅橋上填充的銅通孔【6】 Intel自家的技術自然也在自家的產品上積極運用。針對超級計算機和人工智能應用,Intel在2019年公布了基于Xe架構的芯片系統-真的是一個芯片系統,非常多芯片。該系統被命名為Ponte Vecchio,是用于高性能計算的下一代加速器。它結合47個Magical Tiles,主要由Compute Tiles、Base Tiles、Rambo Cache tile和Xe Link Tiles組成,每個Tiles都使用不同的制程制造。關于該芯片的命名,來源于意大利佛羅倫薩最古老的橋韋基奧橋(Ponte Vecchio),橋最初是以建筑師的名字命名的,類似我們中國貴州的風雨廊橋。而Intel以此橋為名字,想必是為了體現該系統的經典和復雜,因為在現實中這座橋和周圍的建筑是一個拜占庭式的龐然大物,橋的兩邊是當地的特色建筑,它們通過這座橋以巧妙的方式相互連接,形成這么一個古老而又有特殊建筑風格的大師級作品。
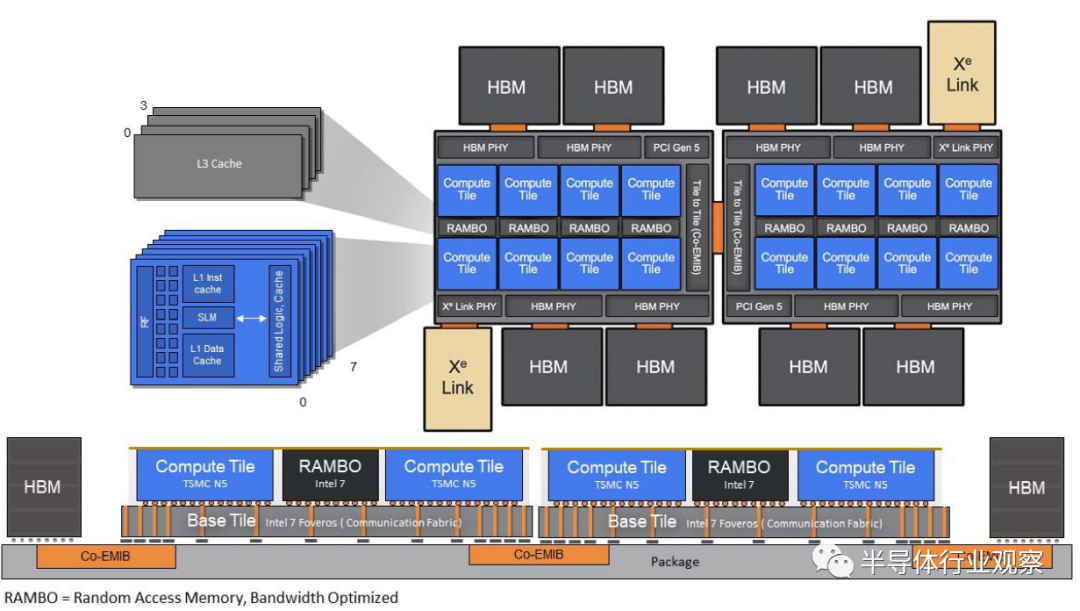
Intel芯片架構及Ponte Vecchio集成 (Source: Intel) 在Ponte Vecchio芯片中,不僅有EMIB,還有FOVEROS,可謂是當今3D集成度頂尖的芯片案例。美國能源部超級計算機Aurora將以Ponte Vecchio為核心的,每個Ponte Vecchio系統每秒能夠進行超過45萬億次32位浮點運算。四個這樣的系統與兩個Sapphire Rapids CPU一起構成一個完整的計算系統。超過54000個Ponte Vecchios和18000個SapphireRapids組合在一起,形成Aurora。
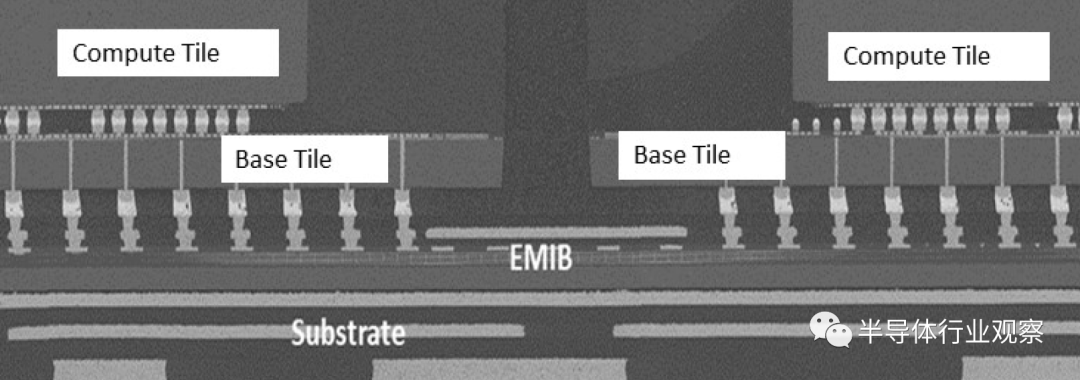
Ponte Vecchio高性能加速器GPU 及其EMIB結構【7】 當芯片節點來到5nm,僅僅通過硅工藝來延續摩爾定律似乎已經捉襟見肘。臺積電和Intel用先進封裝結合硅工藝給半導體行業帶來了新的范式,通過先進封裝系統集成給摩爾定律的延續,提供了一種新的方向。
審核編輯 :李倩
-
芯片
+關注
關注
459文章
52160瀏覽量
436070 -
封裝技術
+關注
關注
12文章
573瀏覽量
68436
原文標題:摩爾定律的延續,從蘋果M1 Ultra看先進封裝技術
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
M3 Ultra 蘋果最強芯片 80 核 GPU,32 核 NPU
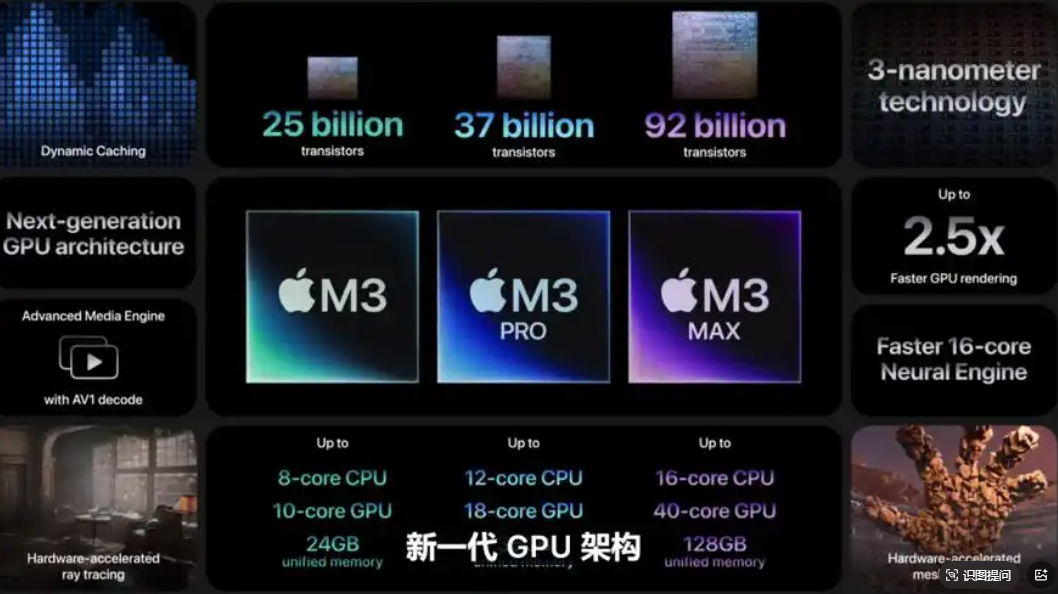





 從蘋果M1 Ultra看先進封裝技術
從蘋果M1 Ultra看先進封裝技術



















評論