雖然在商用化學(xué)氣相沉積設(shè)備中可以在一次運(yùn)行中實(shí)現(xiàn)多片4H-SiC襯底的同質(zhì)外延生長(zhǎng),但是必須將晶片裝載到可旋轉(zhuǎn)的大型基座上,這導(dǎo)致基座的直徑隨著數(shù)量或者外延晶片總面積的增加而增加。在這項(xiàng)工作中,我們展示了一種簡(jiǎn)便的方法,通過(guò)自制的常規(guī)單晶片化學(xué)氣相沉積設(shè)備,在沒(méi)有大型基座的情況下,在簡(jiǎn)單的支架上放置多片4H-SiC襯底。
本文中通過(guò)光學(xué)顯微鏡,AFM,SEM和拉曼光譜研究了在每個(gè)晶片上獲得的4H-Si薄膜的結(jié)構(gòu)性質(zhì)。結(jié)果表明,在每個(gè)晶片的內(nèi)部區(qū)域可以獲得高質(zhì)量的同質(zhì)外延生長(zhǎng)4H-SiC薄膜;而在外部區(qū)域,由于受到簡(jiǎn)單支架的機(jī)械部件影響,質(zhì)量下降。最后,我們利用晶片支架進(jìn)一步減少了不利的外部區(qū)域,展示出整個(gè)晶圓的同質(zhì)外延生長(zhǎng),從而大大提高了生產(chǎn)效率,降低了能耗。
圖1:(a)CVD室和(b)帶有晶片的特定支架,(c)生長(zhǎng)過(guò)程的示意圖
我們?cè)谧灾频牡蛪夯瘜W(xué)氣相沉積反應(yīng)器中進(jìn)行了4H-SiC同質(zhì)外延生長(zhǎng)。CVD反應(yīng)器具有垂直的熱壁室。 圖1(a)顯示了腔室的示意圖。圖1(b)顯示了裝有晶片的特定晶片夾持器。在圖1(b)中,我們固定了三片4H-SiC襯底。槽之間的距離(d),典型值為1 cm,可根據(jù)實(shí)際情況定制。生長(zhǎng)過(guò)程如圖1(c)所示。在生長(zhǎng)之前,將晶片在20kPa和1400℃下進(jìn)行H2蝕刻處理30分鐘,以消除污染和襯底表面損傷。外延生長(zhǎng)在10kPa和1600℃下進(jìn)行60分鐘。SiH4和C2H4的流速分別為20sccm和12sccm。生長(zhǎng)后,通過(guò)光學(xué)顯微鏡,AFM,SEM和拉曼光譜表征樣品。
圖2:(a)在20kPa和1400℃下蝕刻30分鐘的襯底表面的光學(xué)圖像,(b) - (d)分別在10kPa, 1600℃ 下生長(zhǎng)60分鐘外延晶片1,2和3的表面的光學(xué)圖像。
4H-SiC薄膜內(nèi)部區(qū)域的典型形態(tài)如圖2所示。圖2(a)顯示了在外延之前用于比較的H2蝕刻的襯底的圖像。圖2(b) - (d)表明外延晶片1,2和3的表面都顯示出明顯的臺(tái)階。據(jù)報(bào)道,外延生長(zhǎng)期間鄰近的4H-SiC表面上的臺(tái)階形成是由表面動(dòng)力學(xué)和能量學(xué)之間的相互作用引起的。我們可以看到圖2(b)和(c)中的臺(tái)階寬度小于圖2(d)中的臺(tái)階寬度。
圖3:(a)晶片1,(b)晶片2和(c)晶片3的外延表面的AFM圖像,(d)晶片3的表面臺(tái)階輪廓圖,(e)表面臺(tái)階階距示意圖
外延層的表面形態(tài)也通過(guò)AFM進(jìn)行了測(cè)量(圖3)。 AFM圖像進(jìn)一步證實(shí)了圖2中觀察到的明顯臺(tái)階。在4H-SiC薄膜中的存在兩種調(diào)節(jié)。一種臺(tái)階小且均勻,密集地填充在外延晶片1和晶片2的表面上(圖3(a)和(b))。 這是同質(zhì)外延4H-SiC薄膜的典型形態(tài)。 另一種臺(tái)階是復(fù)合的,由所謂的雙山谷結(jié)構(gòu)組成(圖3(c)和(d))。 該結(jié)構(gòu)包括高巨臺(tái)階1和低巨臺(tái)階2(圖3(e))。盡管AFM形態(tài)各不相同,但宏觀臺(tái)階結(jié)構(gòu)都是由于臺(tái)階階距造成的。
圖4:外延晶片上的生長(zhǎng)速率分布。 左側(cè)插圖:晶片3的橫截面SEM圖,右側(cè)插圖:厚度測(cè)量的所選位置的示意圖。
圖4顯示了外延晶片上的生長(zhǎng)速率及其分布。選擇每個(gè)晶片上的九個(gè)位置進(jìn)行厚度測(cè)量。結(jié)果表明外延晶片1和2的生長(zhǎng)速率與晶片3的生長(zhǎng)速率很不相同。晶片1和晶片2的生長(zhǎng)速率非常相似,約為14μm/ h,僅是晶片3的40%。圖4左圖顯示了晶片3的橫截面SEM圖像。測(cè)量的厚度為約37μm。這主要是因?yàn)檫@兩個(gè)晶片被限制在其頂部晶片而使晶片1和晶片2受到較少的氣流。相比之下,裝載在晶片夾持器頂部的晶片3受到充分氣流的作用而沒(méi)有任何限制。由此,晶片1和晶片2的中心區(qū)域的生長(zhǎng)速率最慢,因?yàn)闅饬髯畈豢赡艿竭_(dá)。
圖5:在晶片3上生長(zhǎng)的外延層的拉曼光譜
我們對(duì)晶片3上生長(zhǎng)的外延層進(jìn)行了拉曼光譜測(cè)試(圖5)。圖中顯示的所有拉曼峰均為是4H-SiC的峰,這意味著在我們的外延生長(zhǎng)中具有優(yōu)異的4H單型體穩(wěn)定性。此外,在低波數(shù)(<700 cm-1)的峰也有出現(xiàn)(圖5插圖),這進(jìn)一步表明4H-SiC外延層是高質(zhì)量結(jié)晶的。
-
SiC
+關(guān)注
關(guān)注
31文章
3222瀏覽量
65168 -
碳化硅
+關(guān)注
關(guān)注
25文章
3064瀏覽量
50450
發(fā)布評(píng)論請(qǐng)先 登錄
TSSG法生長(zhǎng)SiC單晶的原理
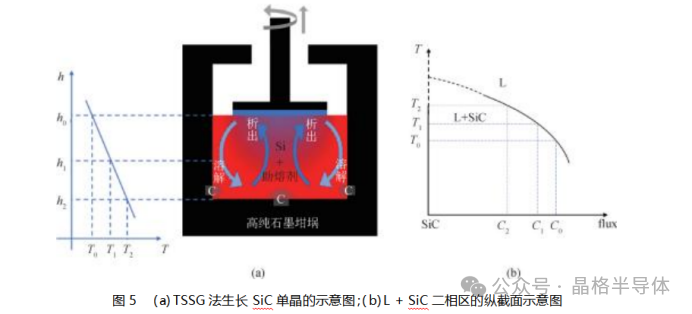
去除碳化硅外延片揭膜后臟污的清洗方法

SiC外延片的化學(xué)機(jī)械清洗方法

有效抑制SiC外延片掉落物缺陷生成的方法

應(yīng)力消除外延生長(zhǎng)裝置及外延生長(zhǎng)方法

提高SiC外延生長(zhǎng)速率和品質(zhì)的方法
用于半導(dǎo)體外延片生長(zhǎng)的CVD石墨托盤結(jié)構(gòu)

鐘罩式熱壁碳化硅高溫外延片生長(zhǎng)裝置

高溫大面積碳化硅外延生長(zhǎng)裝置及處理方法

8英寸單片高溫碳化硅外延生長(zhǎng)室結(jié)構(gòu)

磨料形貌及分散介質(zhì)對(duì)4H碳化硅晶片研磨質(zhì)量有哪些影響

一文詳解SiC單晶生長(zhǎng)技術(shù)
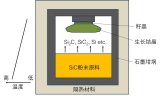
SiC外延生長(zhǎng)技術(shù)的生產(chǎn)過(guò)程及注意事項(xiàng)






 基于簡(jiǎn)單的支架多片4H-SiC化學(xué)氣相沉積同質(zhì)外延生長(zhǎng)
基于簡(jiǎn)單的支架多片4H-SiC化學(xué)氣相沉積同質(zhì)外延生長(zhǎng)

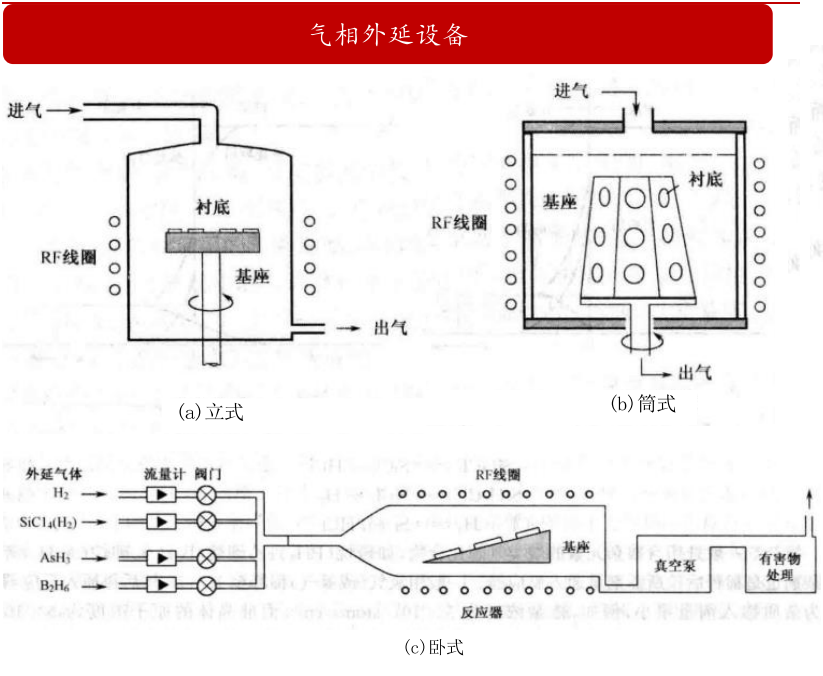










評(píng)論