11月30日消息摩爾定律還沒有結(jié)束。日媒報道,由于新型冠狀病毒的傳播,近期日本ITF于11月18日在日本東京舉行了網(wǎng)上發(fā)布會。
IMEC公司首席執(zhí)行官兼總裁Luc Van den hove首先發(fā)表了主題演講,介紹了公司研究概況,他強調(diào)通過與ASML公司緊密合作,將下一代高分辨率EUV光刻技術(shù)——高NA EUV光刻技術(shù)商業(yè)化。IMEC公司強調(diào),將繼續(xù)把工藝規(guī)模縮小到1nm及以下。
包括日本在內(nèi)的許多半導(dǎo)體公司相繼退出了工藝小型化,聲稱摩爾定律已經(jīng)走到了盡頭,或者說成本太高,無利可圖。在日本眾多光刻工具廠商紛紛退出EUV光刻開發(fā)階段的同時,半導(dǎo)體研究機(jī)構(gòu)IMEC和ASML一直在合作開發(fā)EUV光刻技術(shù),而EUV光刻技術(shù)對于超細(xì)鱗片來說至關(guān)重要。
在ITF Japan 2020上,IMEC提出了3nm、2nm、1.5nm以及1nm以下的邏輯器件小型化路線圖。
上行技術(shù)節(jié)點名稱下標(biāo)注的PP為多晶硅互連線的節(jié)距(nm),MP為精細(xì)金屬的布線節(jié)距(nm)。需要注意的是,過去的技術(shù)節(jié)點指的是最小加工尺寸或柵極長度,現(xiàn)在只是“標(biāo)簽”,并不指某一位置的物理長度。這里介紹的結(jié)構(gòu)和材料,如BPR、CFET和使用二維材料的通道等,已經(jīng)單獨發(fā)表。
EUV的高NA對進(jìn)一步小型化至關(guān)重要
據(jù)臺積電和三星電子介紹,從7nm工藝開始,部分工藝已經(jīng)推出了NA=0.33的EUV光刻設(shè)備,5nm工藝也實現(xiàn)了頻率的提高,但對于2nm以后的超精細(xì)工藝,需要實現(xiàn)更高的分辨率和更高的光刻設(shè)備NA(NA=0.55)。
據(jù)IMEC介紹,ASML已經(jīng)完成了作為NXE:5000系列的高NA EUV曝光系統(tǒng)的基本設(shè)計,但商業(yè)化計劃在2022年左右。這套下一代系統(tǒng)將因其巨大的光學(xué)系統(tǒng)而變得非常高大,很有可能頂在傳統(tǒng)潔凈室的天花板下。
ASML過去一直與IMEC緊密合作開發(fā)光刻技術(shù),但為了開發(fā)使用高NA EUV光刻工具的光刻工藝,在IMEC的園區(qū)里成立了新的“IMEC-ASML高NA EUV實驗室”,以促進(jìn)共同開發(fā)和開發(fā)使用高NA EUV光刻工具的光刻工藝。該公司還計劃與材料供應(yīng)商合作開發(fā)掩模和抗蝕劑。
Van den hove最后表示:“邏輯器件工藝小型化的目的是降低功耗、提高性能、減少面積、降低成本,也就是通常所說的PPAC。除了這四個目標(biāo)外,隨著小型化向3nm、2nm、1.5nm,甚至超越1nm,達(dá)到亞1nm,我們將努力實現(xiàn)環(huán)境友好、適合可持續(xù)發(fā)展社會的微處理器。”他表示,將繼續(xù)致力于工藝小型化,表現(xiàn)出了極大的熱情。
本文由電子發(fā)燒友綜合報道,內(nèi)容參考自ASML、IT之家,轉(zhuǎn)載請注明以上來源。
-
光刻機(jī)
+關(guān)注
關(guān)注
31文章
1167瀏覽量
48194 -
ASML
+關(guān)注
關(guān)注
7文章
729瀏覽量
42302
發(fā)布評論請先 登錄
光刻機(jī)巨頭ASML業(yè)績暴雷,芯片迎來新一輪“寒流”?
ASML官宣:更先進(jìn)的Hyper NA光刻機(jī)開發(fā)已經(jīng)啟動
ASML杯光刻「芯 」勢力知識挑戰(zhàn)賽正式啟動

電子直寫光刻機(jī)駐極體圓筒聚焦電極
光刻圖形轉(zhuǎn)化軟件免費試用
成都匯陽投資關(guān)于光刻機(jī)概念大漲,后市迎來機(jī)會
如何提高光刻機(jī)的NA值

光刻機(jī)的分類與原理

組成光刻機(jī)的各個分系統(tǒng)介紹
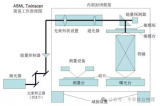
用來提高光刻機(jī)分辨率的浸潤式光刻技術(shù)介紹






 ASML已基本完成 1nm 光刻機(jī)設(shè)計
ASML已基本完成 1nm 光刻機(jī)設(shè)計












評論