簡單的說用一定波長的波刻蝕材料就是光刻技術,集成電路制造中利用光學- 化學反應原理和化學、物理刻蝕方法,將電路圖形傳遞到單晶表面或介質層上,形成有效圖形窗口或功能圖形的工藝技術。
隨著半導體技術的發展,光刻技術傳遞圖形的尺寸限度縮小了2~3個數量級(從毫米級到亞微米級),已從常規光學技術發展到應用電子束、 X射線、微離子束、激光等新技術;使用波長已從4000埃擴展到 0.1埃數量級范圍。光刻技術成為一種精密的微細加工技術。
常規光刻技術是采用波長為2000~4500埃的紫外光作為圖像信息載體,以光致抗蝕劑為中間(圖像記錄)媒介實現圖形的變換、轉移和處理,最終把圖像信息傳遞到晶片(主要指硅片)或介質層上的一種工藝(圖1)。在廣義上,它包括光復印和刻蝕工藝兩個主要方面。
①光復印工藝:經曝光系統將預制在掩模版上的器件或電路圖形按所要求的位置,精確傳遞到預涂在晶片表面或介質層上的光致抗蝕劑薄層上。
②刻蝕工藝:利用化學或物理方法,將抗蝕劑薄層未掩蔽的晶片表面或介質層除去,從而在晶片表面或介質層上獲得與抗蝕劑薄層圖形完全一致的圖形。集成電路各功能層是立體重疊的,因而光刻工藝總是多次反復進行。例如,大規模集成電路要經過約10次光刻才能完成各層圖形的全部傳遞。
在狹義上,光刻工藝僅指光復印工藝。
曝光方式
常用的曝光方式分類如下:
接觸式曝光和非接觸式曝光的區別,在于曝光時掩模與晶片間相對關系是貼緊還是分開。接觸式曝光具有分辨率高、復印面積大、復印精度好、曝光設備簡單、操作方便和生產效率高等特點。但容易損傷和沾污掩模版和晶片上的感光膠涂層,影響成品率和掩模版壽命,對準精度的提高也受到較多的限制。一般認為,接觸式曝光只適于分立元件和中、小規模集成電路的生產。
非接觸式曝光主要指投影曝光。在投影曝光系統中,掩膜圖形經光學系統成像在感光層上,掩模與晶片上的感光膠層不接觸,不會引起損傷和沾污,成品率較高,對準精度也高,能滿足高集成度器件和電路生產的要求。但投影曝光設備復雜,技術難度高,因而不適于低檔產品的生產。現代應用最廣的是 1:1倍的全反射掃描曝光系統和x:1倍的在硅片上直接分步重復曝光系統。
直接分步重復曝光系統 (DSW)
超大規模集成電路需要有高分辨率、高套刻精度和大直徑晶片加工。直接分步重復曝光系統是為適應這些相互制約的要求而發展起來的光學曝光系統。主要技術特點是:①采用像面分割原理,以覆蓋最大芯片面積的單次曝光區作為最小成像單元,從而為獲得高分辨率的光學系統創造條件。②采用精密的定位控制技術和自動對準技術進行重復曝光,以組合方式實現大面積圖像傳遞,從而滿足晶片直徑不斷增大的實際要求。③縮短圖像傳遞鏈,減少工藝上造成的缺陷和誤差,可獲得很高的成品率。④采用精密自動調焦技術,避免高溫工藝引起的晶片變形對成像質量的影響。⑤采用原版自動選擇機構(版庫),不但有利于成品率的提高,而且成為能靈活生產多電路組合的常規曝光系統。這種系統屬于精密復雜的光、機、電綜合系統。它在光學系統上分為兩類。一類是全折射式成像系統,多采用1/5~1/10的縮小倍率,技術較成熟;一類是1:1倍的折射-反射系統,光路簡單,對使用條件要求較低。
 電子發燒友App
電子發燒友App


















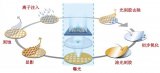
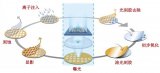

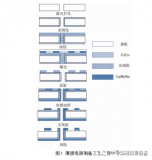

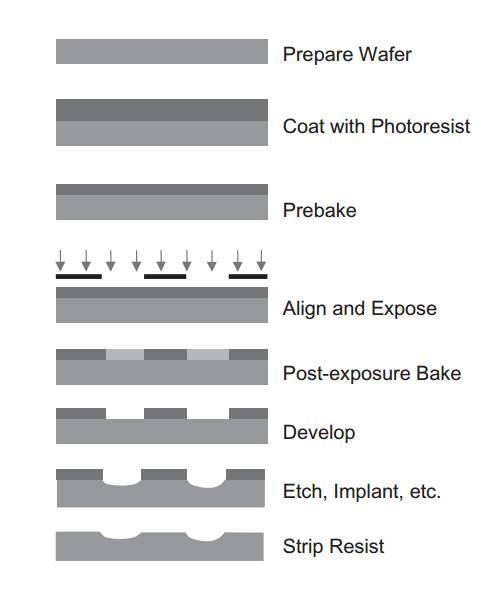


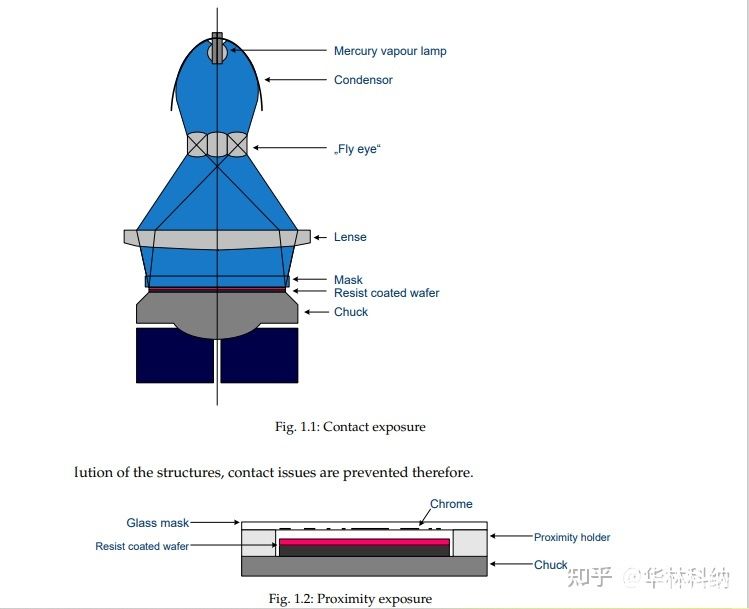
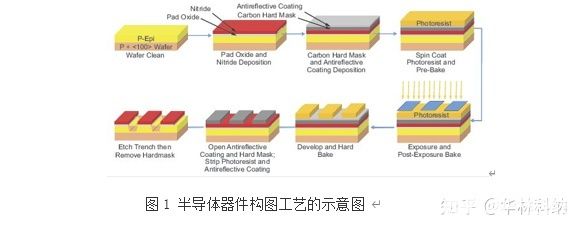
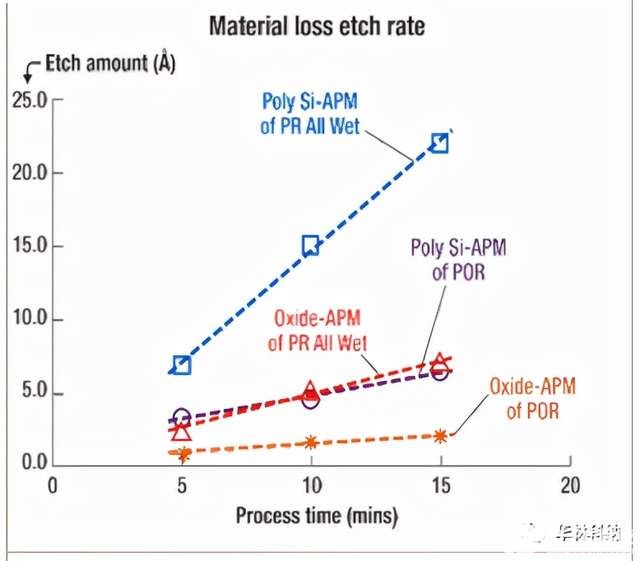
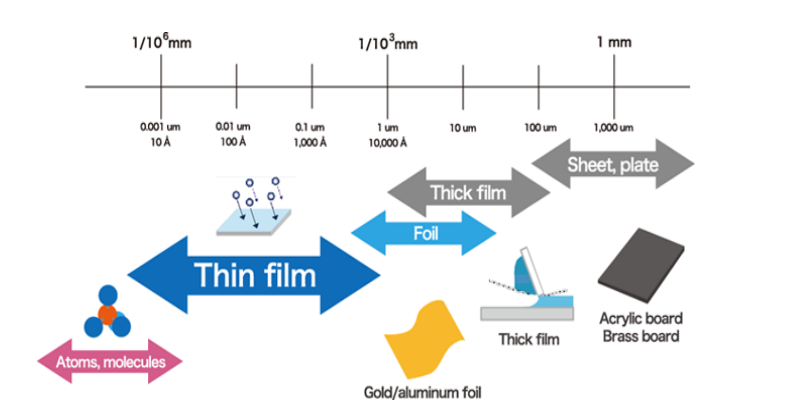



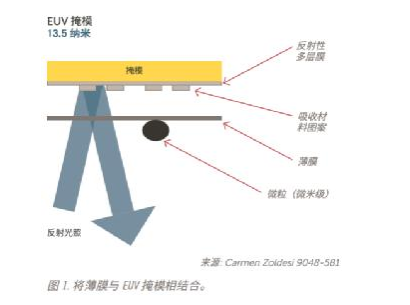
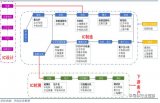










評論