1 Photolithographie
1.1博覽會方法
1.1.1概述
根據(jù)所使用的輻射,有不同類型的光刻方法用于曝光的:光刻(光刻)、電子束光刻、x射線光刻、光刻和離子束光刻。在光學光刻技術中,有部分不透明和部分不透明的圖案掩模(光片)半透明區(qū)域被使用。紫外線輻射或氣體激光的照射以1:1的比例完成或者以4:1或10:1的比例減少。
1.1.2接觸接觸
接觸暴露是最古老的方法。掩模直接與抗阻層,結(jié)構按1:1的比例轉(zhuǎn)移。因此破壞性的散射或者衍射效應只出現(xiàn)在結(jié)構的邊緣。這種方法允許只有中等大小的特征。因為所有的芯片都同時暴露在晶圓上生產(chǎn)能力非常高,光刻裝置結(jié)構簡單。然而,缺點是明顯的:掩膜被污染,因為它的contact抵抗,可以劃傷以及抵抗層可以被損壞。如果有在掩模和抗蝕劑之間有微粒存在,光學成像會退化。
1.1.3近距離接觸
在近距離曝光中,掩模和抗蝕劑沒有直接接觸。因此只有一個陰影投影在晶圓上,導致結(jié)構的分辨率更差,因此避免了接觸問題
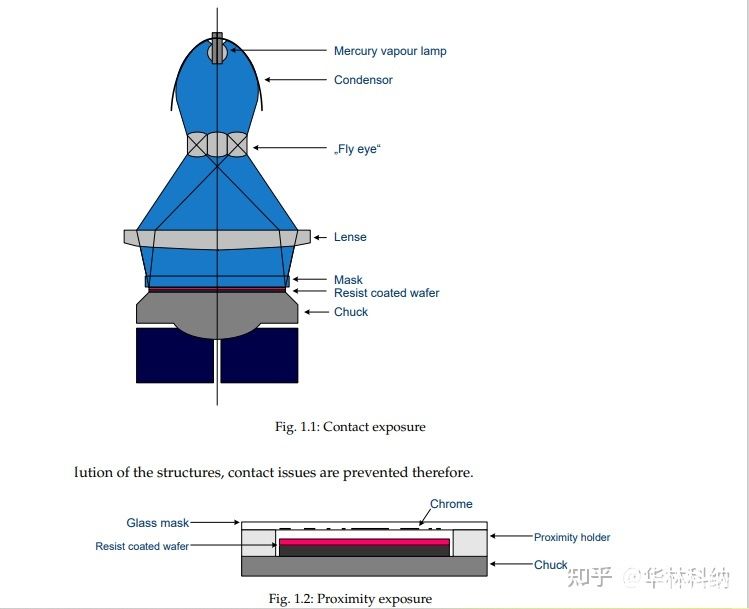
1.1.4投影
投影曝光采用所謂的步驟-重復技術。因此只有一次一個或幾個模具投射到晶圓上。整個晶圓露出來一步一個腳印,死一個腳印。
這種方法的優(yōu)點是將十字線上的結(jié)構放大4倍或10倍。如果這些結(jié)構以縮小的尺寸投射到晶圓上,像粒子這樣的缺陷也會減少。與其他曝光方法相比,分辨率是im證明。此外,面罩上還附著一層薄薄的薄膜,因此微粒就會附著在面罩上遮住面罩,在投影時失去焦距。除了用透鏡投影外,還用一套復雜的鏡子系統(tǒng)投影可以使用(比例1:1)。與透鏡相比,它沒有色差和熱差掩模的展開度可以調(diào)節(jié)。然而,鏡像可以被扭曲。由于1:1的比例,分辨率有限。
審核編輯:湯梓紅
-
光刻
+關注
關注
8文章
346瀏覽量
30686 -
曝光
+關注
關注
0文章
23瀏覽量
18477
發(fā)布評論請先 登錄
壓電納米技術如何輔助涂膠顯影設備實踐精度突圍
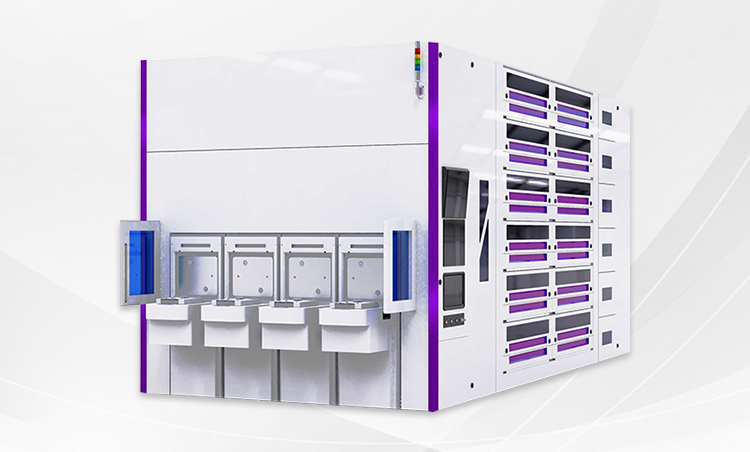
MEMS制造領域中光刻Overlay的概念
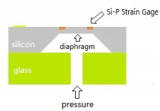
光刻工藝中的顯影技術
最全最詳盡的半導體制造技術資料,涵蓋晶圓工藝到后端封測
【「芯片通識課:一本書讀懂芯片技術」閱讀體驗】芯片怎樣制造
【「芯片通識課:一本書讀懂芯片技術」閱讀體驗】了解芯片怎樣制造
光刻工藝的主要流程和關鍵指標

芯片制造:光刻工藝原理與流程

晶圓表面光刻膠的涂覆與刮邊工藝的研究
芯片濕法蝕刻工藝
【「大話芯片制造」閱讀體驗】+芯片制造過程工藝面面觀
簡述光刻工藝的三個主要步驟
光刻工藝中分辨率增強技術詳解
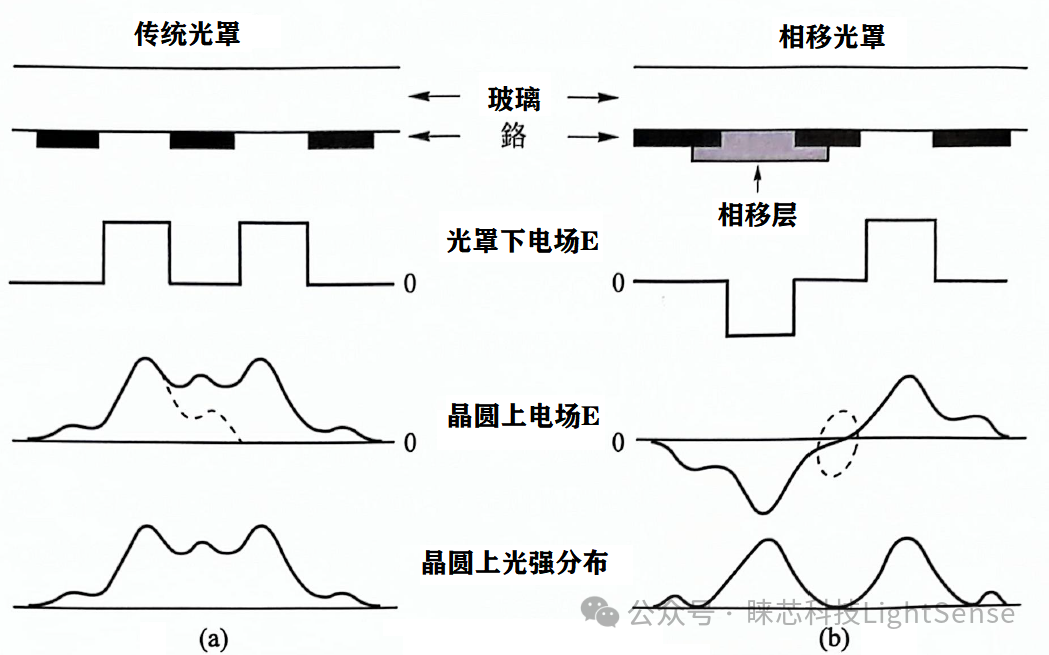
光刻掩膜和光刻模具的關系
光刻工藝的基本知識






 光刻工藝中使用的曝光技術
光刻工藝中使用的曝光技術











評論