文章來源:芯學知
原文作者:芯啟未來
本文介紹了MEMS制造領域中光刻Overlay的概念,以及控制優化的方法。
在MEMS(微機電系統)制造領域,光刻工藝是決定版圖中的圖案能否精確 “印刷” 到硅片上的核心環節。光刻Overlay(套刻精度),則是衡量光刻機將不同層設計圖案對準精度的關鍵指標。光刻Overlay指的是芯片制造過程中,前后兩次光刻工藝形成的電路圖案之間的對準精度。
對于MEMS器件而言,Overlay的精準度至關重要。以壓力芯片為例,需要進行正反套刻,精確的對準是保證壓力敏感元件與振動膜片相對位置正確的基礎,任何Overlay誤差都可能導致壓力感知偏差,影響芯片對壓力變化的精確測量。陀螺儀芯片中,Overlay精度決定了微機械振動結構與檢測電極的相對位置關系,若出現較大誤差,會使陀螺儀的靈敏度和穩定性大幅下降,無法為慣性導航等應用提供可靠的角度測量數據。
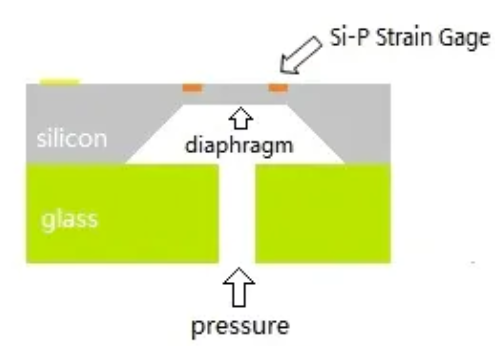
壓力傳感器壓阻與膜片相對位置Overlay
Overlay誤差來源于光刻對準誤差,曝光時,光刻機需要對準前一層的對準標記,但由于光學系統的誤差,可能導致輕微偏移。例如,光學元件的制造精度限制以及長時間使用后的磨損,都可能使對準過程中出現偏差,使得當前光刻層的圖案與前一層不能精確重合。
除了光刻對準誤差,MEMS工藝誤差也會引起Overlay。沉積SiO?、Si?N?或金屬層時,材料的應力可能導致晶圓局部變形。不同材料在沉積過程中會產生不同程度的內應力,當這些應力積累到一定程度,就會使晶圓發生彎曲或翹曲,使得后續光刻層在對準和圖案轉移時出現偏差。高溫工藝(如氧化、退火)可能導致晶圓膨脹或翹曲。在高溫環境下,晶圓材料的熱膨脹系數不同,會使得晶圓內部產生熱應力,從而發生形變。這種形變會影響后續光刻層的對準精度,導致圖案錯位。
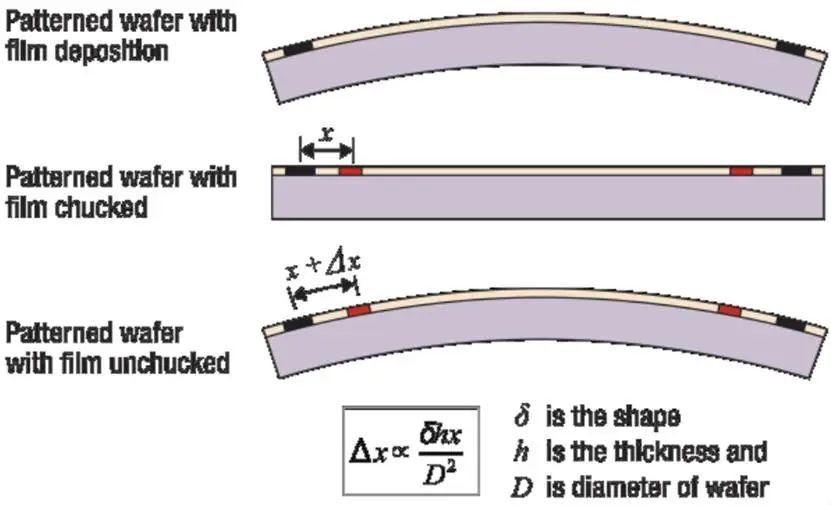
MEMS工藝中翹曲對Overlay的影響圖示
如何進行Overlay誤差的控制和優化呢?在IC工藝中,光學鄰近效應修正(Optical Proximity Correction,OPC)就是使用計算方法對掩模版上的圖形做修正,使得投影到光刻膠上的圖形盡量符合設計要求,從而對Overlay誤差進行控制。在MEMS工藝中,很少用到OPC,MEMS器件都是微米或者亞微米的線寬,光學補償使用較少。在MEMS工藝中,主要還是通過高精度光刻機提升Overlay精度的。在工藝層面,選用熱膨脹系數相近的材料,能夠有效降低溫度變化引起的層間錯位。例如,在沉積SiO?、Si?N?或金屬層時,合理搭配材料,減少因材料熱膨脹差異產生的內應力,進而降低晶圓的形變程度,提高Overlay精度。
-
芯片
+關注
關注
459文章
52294瀏覽量
437657 -
mems
+關注
關注
129文章
4088瀏覽量
192877 -
光刻工藝
+關注
關注
1文章
35瀏覽量
1958
原文標題:什么是MEMS中的Overlay?
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
光刻圖形轉化軟件免費試用
MEMS傳感器是什么?mems的工藝是什么?
光刻膠在集成電路制造中的應用
MEMS傳感器四大應用領域詳解
關于MEMS的技術簡介
MEMS制造技術
通信領域中的MEMS器件及發展動態
為什么需要Overlay網絡?Overlay網絡是如何形成的?Overlay網絡的應用有哪些?

半導體制造領域光刻膠的作用和意義






 MEMS制造領域中光刻Overlay的概念
MEMS制造領域中光刻Overlay的概念












評論