Connectec Japan在其總部(日本新瀉縣妙高市)向相關(guān)人士及媒體召開(kāi)了事業(yè)戰(zhàn)略說(shuō)明會(huì),該公司社長(zhǎng)平田勝則先生介紹說(shuō),通過(guò)運(yùn)用其獨(dú)特的技術(shù)已經(jīng)可以在80℃的低溫環(huán)境下進(jìn)行Flip Chip封裝,目前正在開(kāi)發(fā)30℃低溫下的封裝技術(shù)。同時(shí)還表示說(shuō)“為了實(shí)現(xiàn)IoT,低溫、低負(fù)荷絕對(duì)是必須的!”
對(duì)IoT來(lái)說(shuō),低溫、低負(fù)荷是必不可缺的
Connectec Japan社長(zhǎng) 平田勝則(圖片出自:eetimes.jp)
Connectec Japan是由原就職于Panasonic(原松下電器)半導(dǎo)體事業(yè)部的平田先生創(chuàng)立。通過(guò)利用現(xiàn)有技術(shù),在需要高溫、高負(fù)荷的半導(dǎo)體Flip Chip封裝方面,開(kāi)發(fā)出了一種低溫、低負(fù)荷、無(wú)損的Damage Free封裝技術(shù)——“MONSTER PAC”,全面提供“外包半導(dǎo)體封裝開(kāi)發(fā)(OSRDA:Out Sourced Research&Development Assemble)”服務(wù),即半導(dǎo)體元件、模組的基板設(shè)計(jì)和結(jié)構(gòu)設(shè)計(jì)、試做、信賴性測(cè)評(píng)、分析、量產(chǎn)。

據(jù)說(shuō)“可以對(duì)應(yīng)所有的OSRDA方面的封裝要求”(圖表出自:Connectec Japan)
2017年7月,Connectec Japan成為了第一家參加美國(guó)加利福尼亞“Next Flex”機(jī)構(gòu)的日本公司,“Next Flex”是一家負(fù)責(zé)柔性混合電子(Flexible Hybrid Electronics)創(chuàng)新和商業(yè)化的機(jī)構(gòu)。Connectec Japan不斷在美國(guó)、中國(guó)大陸、中國(guó)***、韓國(guó)設(shè)立辦事處,自2017年以來(lái)2年間收到了全球各地3,000多起的咨詢,業(yè)務(wù)在日本國(guó)內(nèi)外不斷擴(kuò)大。2018年6月被日本經(jīng)濟(jì)產(chǎn)業(yè)省扶持的“J-Startup”項(xiàng)目選為項(xiàng)目企業(yè)。
目前,外包半導(dǎo)體封裝業(yè)務(wù)的銷售額中70%來(lái)自海外,平田先生表示說(shuō),“一年前日本國(guó)內(nèi)的銷售額近乎為零,但在日本國(guó)內(nèi),積極嘗試著做新業(yè)務(wù)的公司不斷在增加。”
1/40的設(shè)備投資,1/30的設(shè)備面積,1/1000的電力消耗
據(jù)平田先生透露說(shuō),預(yù)計(jì)在2025年全球IoT市場(chǎng)規(guī)模將會(huì)擴(kuò)大到610億日元(約人民幣36.6億元),其中亞太地區(qū)將會(huì)占據(jù)45%的份額,另外,預(yù)計(jì)2023年半導(dǎo)體傳感器的出貨數(shù)量將會(huì)達(dá)到10,000億個(gè),未來(lái)將會(huì)爆發(fā)式增長(zhǎng)至100,000億個(gè)。同時(shí)平田先生還表示說(shuō):“隨著用途和使用情況的增多,所有東西上都需要安裝半導(dǎo)體”。
而且,使用現(xiàn)有錫膏進(jìn)行倒裝芯片時(shí),由于需要260℃的高溫、每個(gè)端子承受2.4gf(克力)粘合負(fù)荷壓力,所以對(duì)采用了易受損材料“Low-k”的元件、MEMS芯片會(huì)產(chǎn)生嚴(yán)重的影響,因此限制了封裝芯片、基板材料。“為了實(shí)現(xiàn)萬(wàn)物互聯(lián)(IoT),低溫、低負(fù)荷絕對(duì)是必須的!”

要發(fā)展IoT,必須進(jìn)行低溫封裝。(圖片出自:Connectec Japan)
MONSTER PAC采用了與現(xiàn)有方法完全不同的方式解決了上述問(wèn)題。具體如下,首先,使用印刷技術(shù)將導(dǎo)電錫膏(Paste)涂到基板的線路(Pattern)上,形成芯片與基板之間的導(dǎo)電電路;而且,在下一道工序注入非導(dǎo)電性的Paste(NCP: Non Conductive Paste),放上芯片并進(jìn)行封裝,于是,芯片這一側(cè)的端子接觸到導(dǎo)電錫膏(Paste),多余的NCP被擠到線路中間,當(dāng)周邊溫度上升時(shí),NCP就會(huì)硬化,NCP硬化產(chǎn)生的“硬化收縮力”促使芯片端子和導(dǎo)電錫膏相互擠壓、結(jié)合。
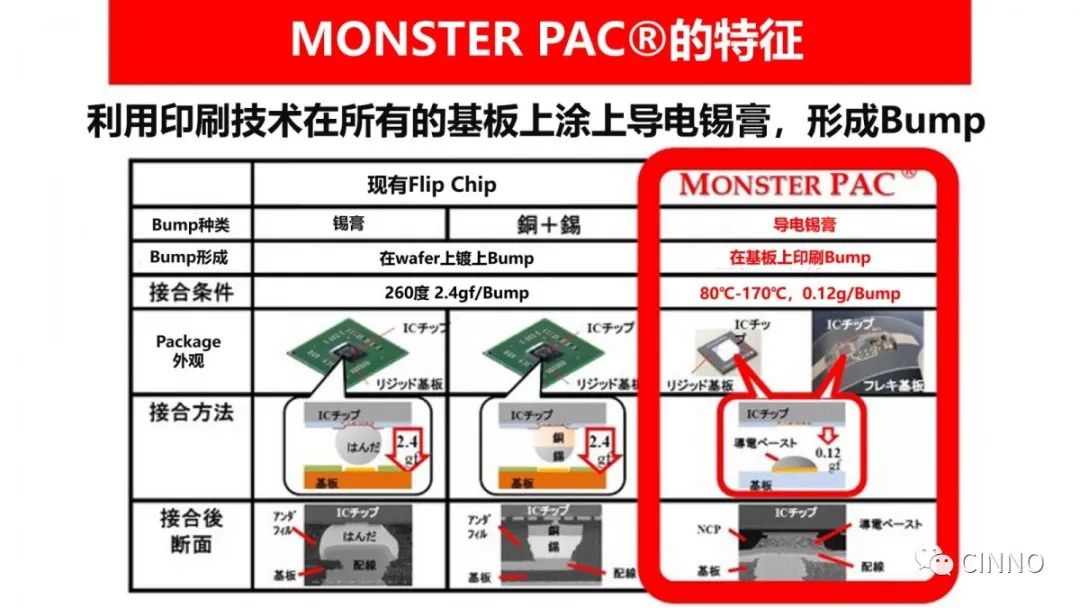
MONSTER PAC的特征(圖片出自:Connectec Japan)
另外,使用傳統(tǒng)封裝方法的話,在一間大型的潔凈室里配置了將近20臺(tái)大型生產(chǎn)設(shè)備,需要34道工序,6天時(shí)間,如果使用MONSTER PAC,只需銀膏印刷、NCP涂層、Flip Chip Bonding 三道工序,2天時(shí)間就可以完成,據(jù)說(shuō)是“1/40的設(shè)備投資,1/30的設(shè)備面積,1/1,000的電力消耗”。另外,隨著IoT機(jī)器的擴(kuò)展,一臺(tái)設(shè)備將能支持各種材料的基板,也就是可以滿足“量少品種多”的要求。
Connectec Japan還開(kāi)發(fā)了“MONSTER DTF(Desktop Factory)”,它集成三道工序并將設(shè)備控制到Desktop Size,現(xiàn)在Connectec Japan已經(jīng)開(kāi)始利用“MONSTER DTF”稼動(dòng)6條產(chǎn)線。

右圖:MONSTER DTF,左圖:實(shí)際的生產(chǎn)車間。(圖片出自:Connectec Japan)
力求實(shí)現(xiàn)30℃溫度環(huán)境下的封裝
Connectec Japan正在推進(jìn)開(kāi)發(fā)MONSTER PAC的進(jìn)一步低溫化,目前已經(jīng)實(shí)現(xiàn)了80℃低溫及1/20壓力的封裝。因此,除了可以進(jìn)行各種MEMS傳感器等低應(yīng)力封裝之外,還可以進(jìn)行PET、PEN、聚氨酯等基板的封裝,以及內(nèi)置電池模塊的PET等材料的封裝。據(jù)說(shuō)已經(jīng)開(kāi)始接受客戶的外包開(kāi)發(fā)業(yè)務(wù),同時(shí)也介紹了相關(guān)業(yè)務(wù)。
(圖片出自:Connectec Japan)
上圖在120℃環(huán)境下,同時(shí)封裝600個(gè)耐熱140℃的磁感應(yīng)芯片(Sensor Chip),且進(jìn)行組件,背面直接封裝驅(qū)動(dòng)IC(Driver IC),達(dá)到節(jié)約面積的功效。
(圖片出自:Connectec Japan)
上圖80 ℃溫度環(huán)境下,封裝到PET薄膜上的元件(右側(cè)),使用現(xiàn)有封裝方法進(jìn)行封裝后,基本都變形了(左側(cè))。(圖片出自:Connectec Japan)
(圖片出自:Connectec Japan)
在80℃環(huán)境下進(jìn)行封裝,把電池、無(wú)線、溫度傳感器一體化的小型模塊。體積減小50%。據(jù)說(shuō)按照現(xiàn)行的封裝方法,無(wú)法進(jìn)行內(nèi)置電池;也實(shí)現(xiàn)了小型AOC(Active Optical Cable)。也可以把VICSEL、PD 芯片直接封裝到內(nèi)置光導(dǎo)波路的FPC。采用現(xiàn)有方法的話,高溫引起的基板膨脹會(huì)導(dǎo)致錯(cuò)位發(fā)生,因此需要對(duì)照著光軸進(jìn)行修正,而80℃環(huán)境下的封裝則可以獲得較高的精度。
另外, 據(jù)說(shuō)Connectec Japan現(xiàn)在正在研發(fā)30℃環(huán)境下的封裝技術(shù)。據(jù)平田先生透露說(shuō),如果可以成功研發(fā)出30℃環(huán)境下封裝技術(shù)的話,就在可耐熱40℃的生物芯片(Biochip)、柔性聚氨酯(Stretchable Polyurethane)等材料上直接封裝傳感器、無(wú)線通信芯片,而且也可以運(yùn)用于內(nèi)埋式封裝等更廣闊的封裝范圍。

30℃環(huán)境下封裝的未來(lái)構(gòu)想圖,在耐熱40℃的生物芯片上集成傳感器(圖片出自:Connectec Japan)
這是30℃環(huán)境下封裝的事例,把內(nèi)置電池的傳感模組安裝在創(chuàng)可貼上,如果技術(shù)獲得成功,只需貼一張創(chuàng)可貼,就可以進(jìn)行感應(yīng)。(圖片出自:Connectec Japan)

用傳統(tǒng)方法進(jìn)行封裝,MEMS振蕩器、MEMS過(guò)濾器會(huì)由于熱應(yīng)力而引起特性的變化;如果在30℃環(huán)境下進(jìn)行封裝,產(chǎn)品特性不受影響。(圖片出自:Connectec Japan)

在30℃環(huán)境下,可進(jìn)行Reuse、Disposal、Wearable等各種傳感器的封裝。(圖片出自:Connectec Japan)
實(shí)現(xiàn)10μm線距基板的封裝
此外,Connectec Japan也在推進(jìn)較窄排線間距(Pitch)的研發(fā),由于基板受熱膨脹等因素的影響,40℃環(huán)境是傳統(tǒng)封裝方法的極限,然而ONSTER PAC可進(jìn)行27.5μm線距產(chǎn)品的封裝。Connectec Japan已經(jīng)成功實(shí)現(xiàn)了10μm線距產(chǎn)品的封裝,而且介紹了事例。因此,可以大幅度縮小封裝面積、節(jié)約成本。

現(xiàn)有的封裝方法與MONSTERPAC(線距為10μm)的比較。(圖片出自:Connectec Japan)
10μm排線情況下,制作凸形Master Mold(左)后,又制作了凹形的Replica Mold(中間),把排線和Bump一起印刷在基板上(右)(圖片出自:Connectec Japan)

通過(guò)運(yùn)用10μm線距的基板,就不再需要以往的TSV Silicon Interposer,可以降低成本。(圖片出自:Connectec Japan)
開(kāi)發(fā)中的應(yīng)用了10μm線距的HBM 模組樣品。(圖片出自:Connectec Japan)
此外,Connectec Japan還計(jì)劃在2020年以后上市,發(fā)揮“生產(chǎn)面積僅如一家便利店”這樣小規(guī)模生產(chǎn)的特點(diǎn),今后可能討論特別經(jīng)營(yíng)權(quán)(Franchise)的方式。
-
封裝
+關(guān)注
關(guān)注
128文章
8568瀏覽量
144919 -
IOT
+關(guān)注
關(guān)注
187文章
4291瀏覽量
200890
原文標(biāo)題:半導(dǎo)體封裝 | Connectec Japan力求實(shí)現(xiàn)30℃低溫環(huán)境下的Flip Chip封裝
文章出處:【微信號(hào):CINNO_CreateMore,微信公眾號(hào):CINNO】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
低溫酸奶全流程數(shù)據(jù)采集遠(yuǎn)程監(jiān)控系統(tǒng)

三相異步電機(jī)缺相運(yùn)行分析與實(shí)驗(yàn)

高低溫試驗(yàn)箱:探索溫度邊界的測(cè)試?yán)?/a>

電機(jī)缺相故障特征和原理分析及處理方法
低溫工業(yè)冰箱:工業(yè)生產(chǎn)的 “冷靜守護(hù)者”? ? ? ?

耐低溫鎧裝網(wǎng)線有哪些
導(dǎo)電線路修補(bǔ)福音:低溫燒結(jié)銀漿AS9120P,低溫快速固化低阻值
探秘低溫鋰電池組:極寒中的能量守護(hù)者

耐高低溫對(duì)于工業(yè)級(jí)連接器為什么“不可或缺”?解讀DH系列連接器寬域耐高低溫性能

儲(chǔ)能電源中必不可缺的電路保護(hù)
電廠負(fù)荷率最簡(jiǎn)單三個(gè)步驟
精密機(jī)器中的交叉導(dǎo)軌負(fù)荷與容許負(fù)荷的差異!






 對(duì)IoT來(lái)說(shuō),低溫、低負(fù)荷必不可缺!
對(duì)IoT來(lái)說(shuō),低溫、低負(fù)荷必不可缺!










評(píng)論