材料的顯微分析能獲得材料的組織結(jié)構(gòu),揭示材料基本性質(zhì)和基本規(guī)律,在材料測(cè)試技術(shù)中占重要的一環(huán)。對(duì)各種顯微分析設(shè)備諸如SEM、TEM、AFM、STM等,各位材料屆的小伙伴一定不會(huì)陌生。最近小編發(fā)現(xiàn)一些電鏡動(dòng)畫(huà),被驚艷到,原來(lái)枯燥無(wú)味的電鏡可以變得這么生動(dòng),閑言少敘,下面就和大家一起來(lái)分享。
掃描電子顯微鏡(SEM)
掃描電鏡成像是利用細(xì)聚焦高能電子束在樣件表面激發(fā)各種物理信號(hào),如二次電子、背散射電子等,通過(guò)相應(yīng)的檢測(cè)器來(lái)檢測(cè)這些信號(hào),信號(hào)的強(qiáng)度與樣品表面形貌有一定的對(duì)應(yīng)關(guān)系,因此,可將其轉(zhuǎn)換為視頻信號(hào)來(lái)調(diào)制顯像管的亮度得到樣品表面形貌的圖像。
SEM工作圖
入射電子與樣品中原子的價(jià)電子發(fā)生非彈性散射作用而損失的那部分能量(30~50eV)激發(fā)核外電子脫離原子,能量大于材料逸出功的價(jià)電子從樣品表面逸出成為真空中的自由電子,此即二次電子。
電子發(fā)射圖
二次電子探測(cè)圖
二次電子試樣表面狀態(tài)非常敏感,能有效顯示試樣表面的微觀形貌,分辨率可達(dá)5~10nm。
二次電子掃描成像
入射電子達(dá)到離核很近的地方被反射,沒(méi)有能量損失;既包括與原子核作用而形成的彈性背散射電子,又包括與樣品核外電子作用而形成的非彈性背散射電子。
背散射電子探測(cè)圖
用背反射信號(hào)進(jìn)行形貌分析時(shí),其分辨率遠(yuǎn)比二次電子低。可根據(jù)背散射電子像的亮暗程度,判別出相應(yīng)區(qū)域的原子序數(shù)的相對(duì)大小,由此可對(duì)金屬及其合金的顯微組織進(jìn)行成分分析。
EBSD成像過(guò)程
透射電子顯微鏡(TEM)
透射電鏡是把經(jīng)加速和聚焦的電子束投射到非常薄的樣件上,電子與樣品中的原子碰撞,而改變方向,從而產(chǎn)生立體角散射。散射角的大小與樣品的密度、厚度相關(guān),因此,可以形成明暗不同的影像,影像將在放大、聚焦后在成像器件上顯示出來(lái)。
TEM工作圖
TEM成像過(guò)程
STEM成像不同于平行電子束的TEM,它是利用聚集的電子束在樣品上掃描來(lái)完成的,與SEM不同之處在于探測(cè)器置于試樣下方,探測(cè)器接收透射電子束流或彈性散射電子束流,經(jīng)放大后在熒光屏上顯示出明場(chǎng)像和暗場(chǎng)像。
STEM分析圖
入射電子束照射試樣表面發(fā)生彈性散射,一部分電子所損失能量值是樣品中某個(gè)元素的特征值,由此獲得能量損失譜(EELS),利用EELS可以對(duì)薄試樣微區(qū)元素組成、化學(xué)鍵及電子結(jié)構(gòu)等進(jìn)行分析。
。。。。
本文來(lái)源于尋材問(wèn)料?,以上內(nèi)容僅為全部報(bào)告的1/3,由于內(nèi)容過(guò)多就不一一上傳如果大家想要完整版的可以再找我。
發(fā)布評(píng)論請(qǐng)先 登錄
什么是聚焦離子束掃描電鏡(FIB-SEM)?

掃描電鏡(SEM)的工作原理和主要成像模式

透射電鏡與 FIB 制樣技術(shù)解析

sem掃描電鏡是測(cè)什么的?哪些學(xué)科領(lǐng)域會(huì)經(jīng)常使用到掃描電鏡?

聚焦離子束掃描電鏡雙束系統(tǒng)(FIB-SEM)
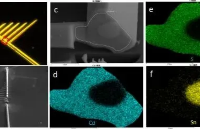
雙束聚焦離子束-掃描電鏡(FIB):TEM樣品制備

SEM是掃描電鏡嗎?

掃描電鏡SEM是什么?

透射電鏡(TEM)要點(diǎn)速覽

透射電鏡(TEM)樣品制備方法

場(chǎng)發(fā)射掃描電鏡(FESEM)與常規(guī)掃描電鏡(SEM):技術(shù)對(duì)比及優(yōu)勢(shì)分析
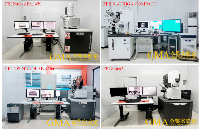
什么是掃描電鏡(SEM)?

什么是透射電鏡(TEM)?
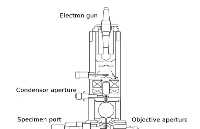
10張動(dòng)圖:秒懂各種常用通信協(xié)議原理

TEM樣品制備中載網(wǎng)的選擇技巧
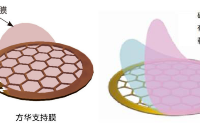





 【尋材問(wèn)料】超逼真20張動(dòng)圖,秒懂四大電鏡原理(SEM, TEM, AFM, STM)!
【尋材問(wèn)料】超逼真20張動(dòng)圖,秒懂四大電鏡原理(SEM, TEM, AFM, STM)!











評(píng)論