一、高階電子產品有較高之I/O接口數及較大體積
全球電子終端產品日新月異,不論是手機/無線通訊應用、消費性電子應用或是高速運算應用等,都可觀察到電子產品朝向高整合度發展趨勢,其中越高性能和多功能產品,除伴隨之半導體芯片I/O數越高多,其所需芯片之數量也越高,整體封裝芯片之面積亦越大。

圖1 :電子應用產品之封裝晶片之I/O數及面積關系。資料來源: Yole(2017/02)
二、終端產品推動封裝技術進化
當終端產品由手持式產品、物聯網消費性產品、車用電子再發展到高速運算處理器發展過程中,產品之復雜度激增情況下,能選擇的芯片封裝方式亦逐漸受限,這主要是因為高效能產品同時搭配先進制程芯片,同時需高整合度(細線寬線距)之封裝技術,而高整合之封裝技術往往伴隨著低制程良率議題(Low Yield Issue),因此高效能產品能選擇的封裝技術甚至是能提供此製程技術的從業者亦甚是稀少,大多數封裝業者亦會擔心低封裝良率傷害昂貴芯片所付出之代價甚大,此乃反應現今高階2.5D中介層封裝大多在晶圓廠進行的原因,因晶圓廠具備提供芯片之能力,相較專業封測廠具產業鏈優勢。

圖2 :終端產品推動封裝技術進化。資料來源: Amkor(2017/09)
先進封裝技術中,大多具備芯片整合能力,如目前不論是量或產值最大的覆晶封裝技術,或是發展快速之扇出型及2.5D/3D封裝技術等,其2015至2021年之產值年複合成長率分別高達49%及43%, 相對之下覆晶封裝之5%年複合成長率確實遜色許多,此亦反應覆晶封裝之載板不論在整合度,亦或在價格上都存在著技術瓶頸,因此對高頻寬及高速運算需求之電子產品帶動扇出型封裝甚至更高階之2.5D/3D封裝需求興起。

圖3 :先進封裝技術之產值及年複合成長率趨勢。資料來源:Yole(2018/03)
三、扇出型封裝逐漸挑戰覆晶封裝之地位
覆晶封裝(Flip Chip)技術起源于1960年代,最早是IBM在大型主機上研發出之覆晶技術,而扇出型封裝技術主要是源于星科金朋在2008年與意法半導體((STMicroelectronics))、英飛凌(Infineon)協議在英飛凌第一代嵌入式晶圓級球閘陣列(Wafer-Level Ball Grid Array;eWLB)技術基礎上,共同合作開發新一代的eWLB技術,開發時程及設備機臺落差導致扇出型封裝之發展落后覆晶封裝許久,而覆晶封裝主要使用的設備之一是面板級載板製程,亦即其繞線層是載板製程,目前已可融合單一或多晶片以覆晶或打線方式整合在載板上,但載板之線寬(Line)線距(Space)在10/10 um以下之製程受挑戰;另一方面,扇出型封裝發展時程雖較覆晶封裝短,但因其製程主要以晶圓級封裝設備進行,其繞線層主要是薄膜(Thin film)製程,因此具發展高密度線寬線距(Line/Space<8/8 um)製程之優勢,唯目前主要仍以單一晶片扇出型封裝(Single die fan-out)為主,在以扇出型封裝進行多晶片整合製程仍備受重佈線層(RDL)良率挑戰。
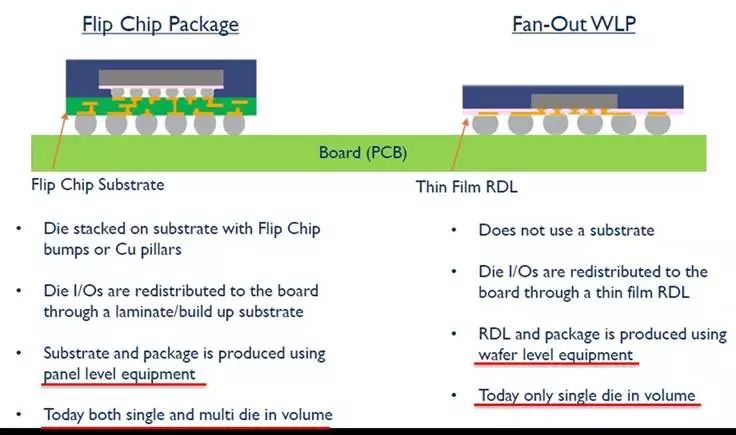
圖4: 覆晶封裝與扇出型封裝之比較。資料來源:Yole;工研院IEK (2018/03)
現今之覆晶封裝技術較扇出型封裝技術成熟,許多覆晶封裝面積大于15*15mm^2以上,同時搭配上百個I/O數,而具備晶片整合之覆晶封裝(FCBGA;Flip Chip Ball Grid Array)更是大于55*55mm^2以上,同時I/O數大于3000個以上,而扇出型封裝目前則主要仍以單一晶片封裝為主,封裝面積小于15*15mm^2,同時I/O數小于1500個,主要以手機通訊等相關應用為主。
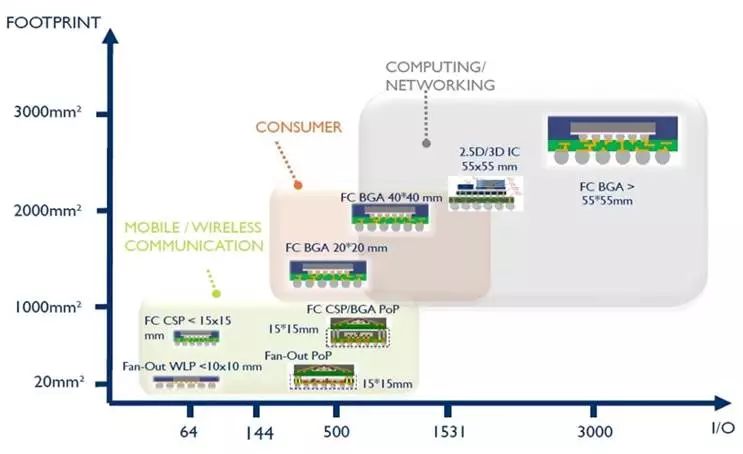
圖5: 現今之覆晶仍較扇出型封裝技術成熟。資料來源:Yole(2017/09)
未來五年扇出型封裝將逐漸走向多晶片系統級封裝(Multi-die System-in-Package),同時扇出型封裝亦朝向高密度(High I/O Density)-亦即細線寬線距發展,并併隨朝向更大的扇出型多晶片系統級封裝發展,但封裝面積大于40*40 mm^2之封裝將仍以覆晶封裝為主,而覆晶封裝之載板亦朝向細線寬線距發展。
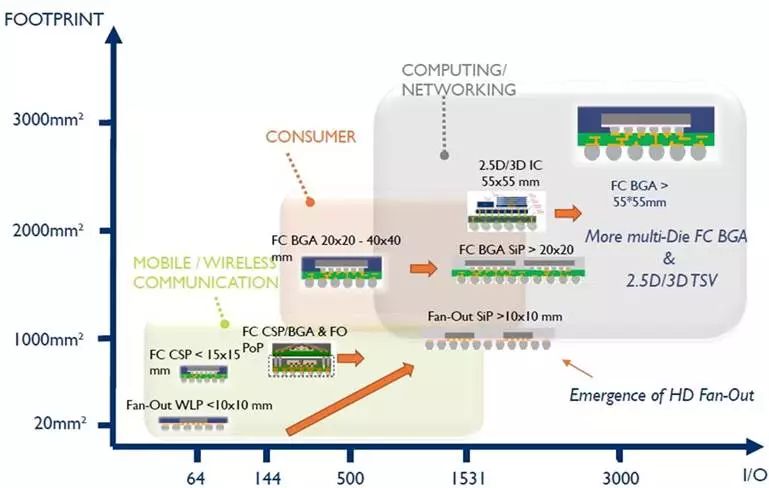
圖6 未來五年扇出型封裝走向多晶片SiP封裝。資料來源:Yole(2017/09)
未來十年后多晶片系統級扇出型封裝SiP,已逐漸可與覆晶封裝技術競爭,同時線寬/線距<10/10 um之載板亦逐漸發展成熟,而FOSiP亦逐漸發展成熟,覆晶封裝與扇出型封裝之競爭將加遽,在高密度扇出型封裝逐漸發展成熟趨勢下,將嚴重侵蝕單一或多晶片覆晶封裝(FCCSP-Single die/FCBGA-Multi die)之市場份額,在兩種技術之成本及效能接近同時,其封裝大小(Package Form Factor)、產業鏈與客戶關系將是決定要使用哪種封裝的重要關鍵所在。
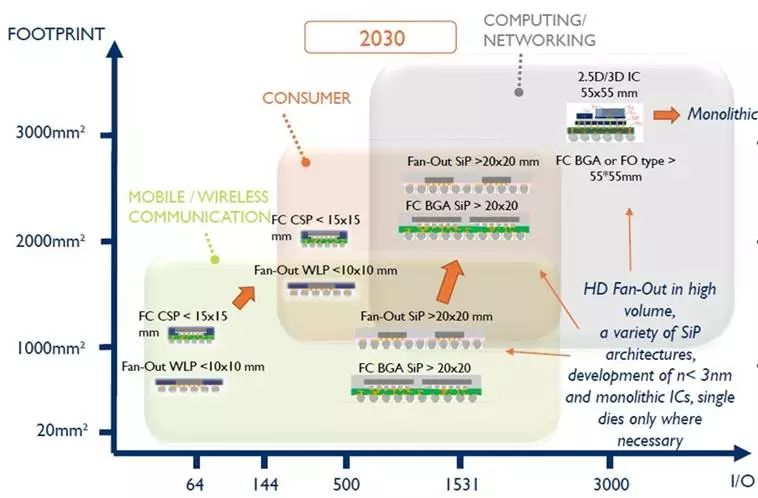
圖7 未來十年扇出型封裝之SiP已可與覆晶封裝競爭。資料來源:Yole(2017/09)
四、產業發展趨勢
在電子終端產品需求帶動下,晶片同質/異質整合趨勢已成市場共識,而整合度由過去從PCB及載板提升至薄膜制程或2.5D中介層等高度晶片整合方式,以產業鏈而言,即將面臨的是載板廠與封測廠甚至晶圓廠之競爭關系,但載板廠一直以來都是封測廠之重要合作伙伴,也因此即便客戶對高整合度封裝有興趣,但已俱備覆晶封裝產能之封測廠是否會愿意拋棄發展已久之覆晶封裝技術,改以再投入資金成本購買大量薄膜製程發展扇出型封裝技術呢?亦或是以既有之覆晶產能,協同載板廠進行高密度載板之開發?很明顯后者可能性較高,因前者再投資成本以封測廠為主,但因覆晶產能可能因此空缺,故未必對封測廠獲利有益處,而后者之投資成本以載板廠為主,而載板廠為取得競爭優勢,勢必得持續朝高密度載板發展,因此,除非無覆晶封裝技術及產能包伏之封測廠較有可能積極發展扇出型封測技術外,具覆晶產能之封測廠則對扇出型封裝之再投資意愿相對較低。
-
封裝
+關注
關注
128文章
8526瀏覽量
144827 -
晶片
+關注
關注
1文章
407瀏覽量
31938
原文標題:【技術專欄】電子產品正在顛覆先進封裝的競爭格局!
文章出處:【微信號:Anxin-360ic,微信公眾號:芯師爺】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
電子產品設計與調試
一種新型RDL PoP扇出晶圓級封裝工藝芯片到晶圓鍵合技術

揭秘PoP封裝技術,如何引領電子產品的未來?






 電子產品覆晶封裝與扇出型封裝之間的競爭分析
電子產品覆晶封裝與扇出型封裝之間的競爭分析
















評論