芯片封裝的定義與重要性
芯片是現代電子系統的核心組件,其功能的實現離不開與外部電路的連接。芯片封裝作為芯片制造的最后環節,起著至關重要的作用。芯片主要以硅為載體,具有高精度的集成功能,但由于硅材料易脆裂,芯片本身無法直接與印刷電路板(PCB)形成電互連。
封裝技術通過使用合適的材料和工藝,對芯片進行保護,同時調整芯片焊盤的密度,使其與PCB焊盤密度相匹配,從而實現芯片與PCB之間的電連接。
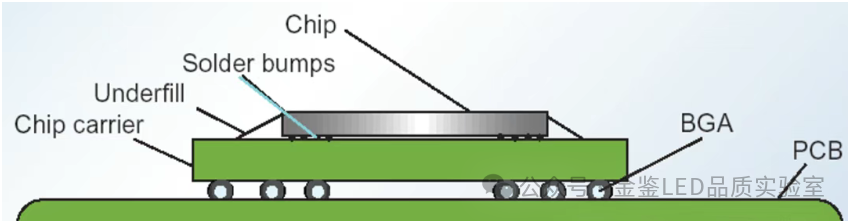
封裝技術的發展與芯片集成度的提升密切相關。在過去50多年中,芯片集成度按照摩爾定律持續提高,其關鍵尺寸急速縮小,而PCB的關鍵尺寸縮小速度相對較慢,導致芯片與PCB之間的尺寸差異不斷擴大。
封裝技術作為芯片與PCB之間的“橋梁”,必須不斷演進,以適應芯片集成度和性能的提升需求。
以存儲芯片為例,其封裝技術從早期的雙列直插式封裝(DIP)發展到小尺寸J形引腳封裝(SOJ)、薄型小尺寸封裝(TSOP),再到芯片堆疊封裝,以及近年來廣泛應用的倒裝芯片和硅穿孔(TSV)技術,封裝技術的進步顯著提升了存儲容量、速度,并降低了功耗
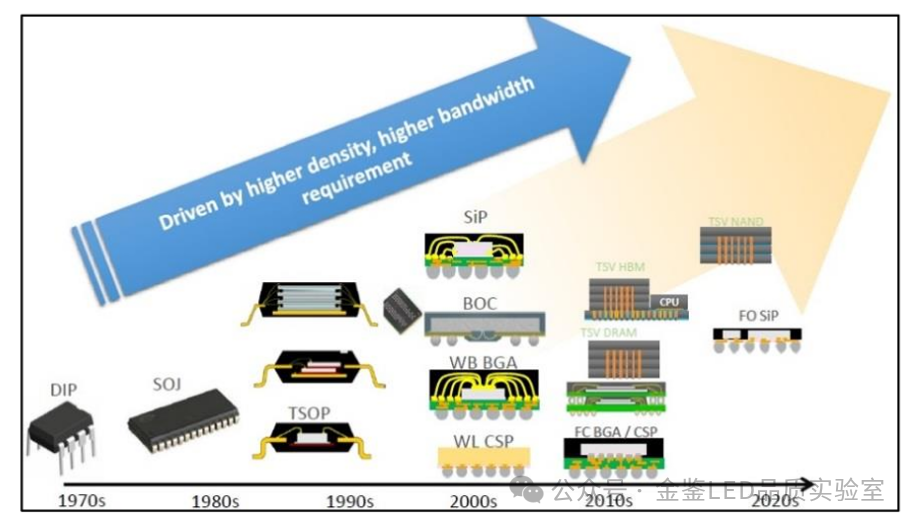
引線鍵合技術及其對封裝技術的支撐
封裝技術的核心功能之一是實現芯片與封裝體之間、芯片與芯片之間的電互連。
引線鍵合(Wire Bonding)是封裝工藝中最常用的電互連方式之一。其原理是通過加熱、加壓和超聲等方式去除焊盤金屬表面的氧化層和污染物,使金屬細絲與焊盤金屬面接觸,達到原子間的引力范圍,從而實現界面間原子擴散并形成焊接。
引線鍵合技術有三種主要方式:熱壓鍵合、超聲鍵合和熱超聲鍵合。
目前,熱超聲鍵合工藝因其高效的焊接效果而被廣泛應用于約90%的引線鍵合封裝中。

在集成電路發展的早期階段,由于芯片集成度較低,焊盤數量少且節距較大,引線鍵合技術成為芯片與封裝體電互連的主要方式。當時的封裝外形主要包括晶體管外形封裝(TO)、雙列直插式封裝、小外形封裝(SOP)、帶引線的塑料芯片載體封裝(PLCC)、方型扁平式封裝(QFP)和方型扁平無引腳封裝(QFN),芯片載體主要以銅制引線框架為主。
到上世紀90年代,以有機基板為載體的球柵陣列封裝(BGA)逐漸成為主流。這種封裝形式的出現,標志著封裝技術從傳統的引線框架向有機基板的轉變。為了滿足BGA封裝初期的要求,引線鍵合技術不斷創新,發展出了低弧線倒打、多層焊盤引線、堆疊芯片引線和多芯片間引線等技術,極大地提升了引線密度,從而推動了封裝技術的進步。
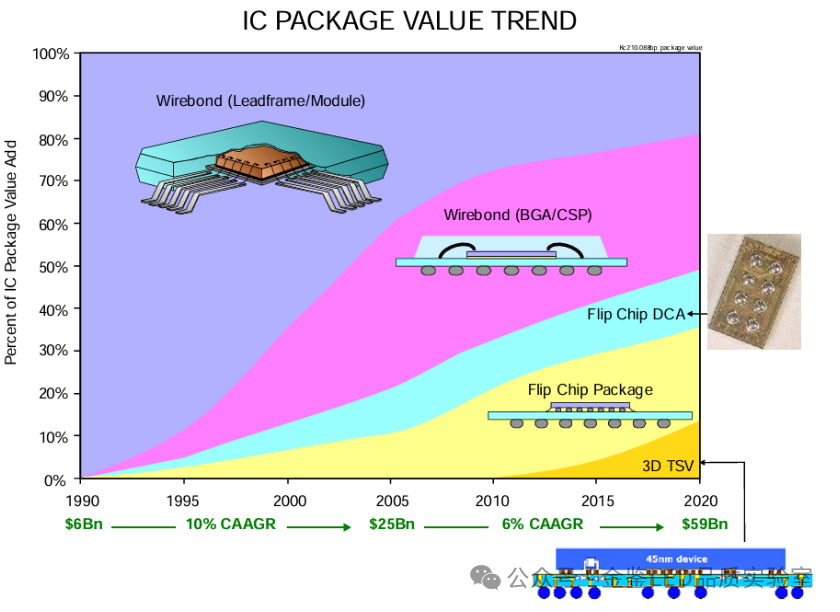
焊球凸塊技術在先進封裝中的應用
焊球凸塊技術是近年來先進封裝領域的重要技術之一。隨著芯片集成度的進一步提高,芯片與封裝體之間的連接密度需求不斷增加,傳統的引線鍵合技術逐漸無法滿足高性能封裝的要求。焊球凸塊技術通過在芯片表面形成微小的焊球,實現了芯片與封裝體之間的高密度、低電阻連接。
焊球凸塊技術的核心優勢在于其能夠顯著提高封裝的引腳密度和信號傳輸速度。
與傳統的引線鍵合相比,焊球凸塊技術減少了連接路徑的長度,降低了信號傳輸延遲,同時提高了封裝的可靠性。此外,焊球凸塊技術還可以與倒裝芯片技術相結合,進一步優化封裝結構,實現更小的封裝尺寸和更高的集成度。
封裝技術的未來發展趨勢
隨著芯片技術的不斷發展,封裝技術也在持續演進。未來,封裝技術將朝著更高密度、更高性能、更低功耗和更小尺寸的方向發展。一方面,封裝技術將與芯片制造技術深度融合,通過協同設計和優化,實現芯片與封裝的無縫銜接。另一方面,封裝技術將不斷引入新的材料和工藝,如新型封裝基板、納米材料、光刻技術等,以滿足高性能封裝的要求。
同時,封裝技術也將更加注重綠色環保和可持續發展。隨著電子產品的普及和更新換代速度的加快,封裝廢棄物的處理成為一個重要的環境問題。未來的封裝技術將更加注重材料的可回收性和環境友好性,以減少對環境的影響。
此外,封裝技術還將與人工智能、物聯網、5G通信等新興技術相結合,為這些技術的發展提供有力支持。例如,在5G通信中,封裝技術需要滿足高頻、高速信號傳輸的要求;在物聯網中,封裝技術需要實現低功耗、高可靠性和小型化的設計。
總結
芯片封裝技術作為連接芯片與外部電路的關鍵環節,其發展與芯片集成度的提升密切相關。從早期的引線鍵合技術到現代的焊球凸塊技術,封裝技術不斷演進,以滿足芯片與封裝體之間高密度、高性能的電互連需求。
未來,封裝技術將繼續朝著更高密度、更高性能、更低功耗和更小尺寸的方向發展,并與新興技術相結合,為電子技術的進步提供有力支持。
-
芯片
+關注
關注
459文章
52355瀏覽量
438749 -
封裝
+關注
關注
128文章
8618瀏覽量
145137 -
倒裝芯片
+關注
關注
1文章
104瀏覽量
16561
發布評論請先 登錄
什么是倒裝芯片 倒裝芯片技術的優點 倒裝芯片封裝工藝流程


倒裝芯片和晶片級封裝技術及其應用
倒裝芯片技術觸發了北美先進封裝市場的進一步增長
倒裝芯片(flip chip)算先進封裝嗎?未來發展怎么樣?






 一文了解先進封裝之倒裝芯片技術
一文了解先進封裝之倒裝芯片技術


















評論