文章來源:老千和他的朋友們
原文作者:孫千
本文介紹了聚焦離子束(FIB)的原理、分析系統和附件。
聚焦離子束(FIB)在材料科學和微納加工領域內的重要性日益顯現,離子束的傳輸過程由多個關鍵組件構成,包含離子源、透鏡和光闌等,而其性能的提升則依賴于光學元件的校正和功能擴展。此外,FIB技術的功能可通過附加設備加以增強,例如,電子束鏡筒、氣體注入系統以及激光干涉儀臺等,極大地提升了操作的精確度和效率。
離子束的傳輸,其主要組成部分如圖1所示,從離子源到樣品的傳輸過程需要經過多個關鍵部件。左側標簽代表標準儀器中的基本組件,而右側標簽則標示了額外組件。以下將對此過程及各個組件的職能進行詳細總結。
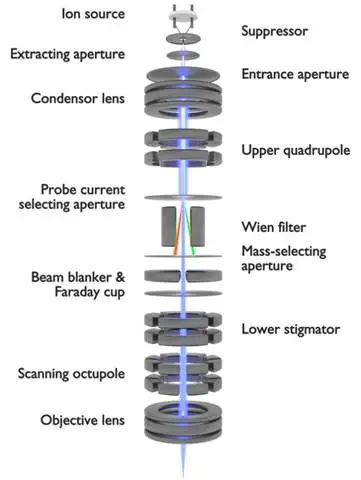
FIB鏡筒中束流傳輸的主要成分(不按比例縮放)
左側標記的組件在標準的Ga-FIB鏡筒中可以找到,而右側的標記則表示通常只在特定用途的鏡筒中找到的組件。
離子束的傳輸開始于離子源,離子通過聚光透鏡(Condenser lens)的提取形成束流,接著通過一個入口光闌(Entrance aperture),之后在四極桿(quadrupole)的引導下,經過探針電流選擇光闌(Probe current selecting aperture)。選擇光闌的作用在于定義探針電流,它能夠選取一小部分束流并有效地降低離子束的角度發散。束流電流的監測是通過將束流偏轉至法拉第杯(Faraday cup)實現的。
此外,整個運輸系統的下部通常配備整形器,負責最后的束流整形。同時,八極桿(Scanning octopole)的引入使得束流掃描成為可能,而物鏡(Objective lens)則用于束流的聚焦。在更為先進的儀器中,Wien filter用于選擇特定的同位素,即特定的質量-電荷比離子,以便于實現更精確的測量。

Veloce和iVeloce鏡筒就是配置了Wien filter的聚焦離子束鏡筒,可選擇特定質荷比的離子用于離子注入,拓寬了FIB在材料科學中的應用場景
聚光透鏡和物鏡是圓鏡筒幾何形狀的靜電透鏡,其主要功能在于引導和聚焦離子束。這些透鏡通常由多個電極組成,電極通過電氣偏置產生電場,從而利用力公式F=qE改變離子的軌跡(見圖2)。靜電透鏡可以運行在兩種模式下:減速模式和加速模式。在減速模式中,透鏡內的離子能量得到降低,而在加速模式下,離子的能量則會增加。圖2展示了一個在減速模式下工作的透鏡實例。

電靜透鏡(Einzel透鏡)的示例
顯示了三個圓柱形電極(橙色),其中中央電極帶有偏壓,以將離子聚焦到給定位置。等勢線用紅色表示,離子軌跡用藍色表示,黑色箭頭指示電靜力的方向和大小。
由于靜電透鏡內場線的曲線形狀,作用于離子的電力不僅包含軸向的減速和加速成分,還包括徑向成分,后者對離子的聚焦效應至關重要。靜電透鏡的焦距受多個因素的影響,包括離子能量、離子電荷狀態、施加到透鏡上的電壓及透鏡的幾何形狀。不同于磁透鏡,靜電透鏡的焦距與離子的質量無關。在相同電壓下,減速模式下的焦距通常小于加速模式下的焦距。
束流消隱器(Beam blanker)配備靜電偏轉器,能夠將離子束快速偏轉至法拉第杯。這個功能使得用戶可以根據需要阻止束流,以防止離子撞擊樣品,同時對探針電流進行測量。束流消隱功能在諸如FIB銑削或FIBID等標準應用中顯得尤為重要,它同樣適用于離子注入任務。在特殊情況下,束流消隱的速度需要足夠快,以實現從一個不確定的離子源中進行單離子注入。以假定的1 pA入射離子電流為例,需傳遞10 ns的離子脈沖,以確保滿足泊松統計,即每個脈沖不超過一個離子。
快速的束流消隱通過專用電子設備和鏡筒內部特定位置的電極實現,保證了束流在極短時間內的消失,而不會留下尾部偽影。此外,樣品上的檢測系統也必須具備單個離子的計數能力,以保證數據精度。
幾乎所有FIB鏡筒都設有其他光學元件,如四極和八極元件,用于引導束流并對齊束流相對于主要光學元件(如透鏡和光闌)的位置信息。這些元件由兩組靜電偏轉器組成,允許施加相互抵消的偏轉,使束流傾斜并移動至后續光學元件的垂直軸上。鏡筒下部,靠近物鏡的區域通常裝備有整形器,用戶可以施加電場以壓縮或擴展束流形狀,進而校正束流的缺陷。綜合這三種元件(四極/八極和整形器)的作用,使得能夠有效補償透鏡缺陷所帶來的像差,從而校正鏡筒的機械對準。
然而,當前商業FIB儀器在色差和球面像差的校正方面并未進行非常規的改進,主要原因是這兩種像差的大小往往由離子源的特性所決定。盡管理論研究已表明這種校正的潛在好處,但在實際操作中,這些效果仍未得到最大化利用。
在高級FIB鏡筒中,Wien filter的引入進一步提升了束流的選擇性。通過施加垂直的電場和磁場,Wien filter能夠根據質量-電荷比有效分離主束中的不同類型離子,尤其在離子源產生多種元素和不同電荷狀態的情況下,能夠顯著提升束流質量。此外,為了防止中性原子影響樣品,束流可通過靜電S形偏轉器進行消隱,確保只有帶電粒子達到樣品。
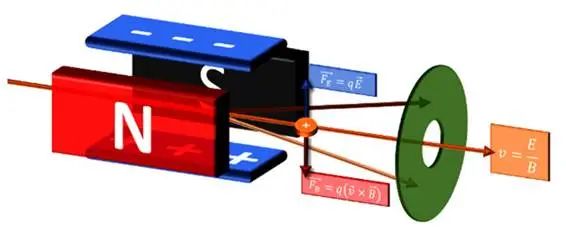
Wien filter的原理
具有正交的電場和磁場,并設有一個光闌選擇所需的離子速度。
盡管FIB儀器的性能受離子源規格的直接影響,但由于許多光學元件并未校正束流像差,固有或制造缺陷仍可能引發一些像差問題。如果離子源質量不足,這些問題將不可避免地傳播至樣品,導致整體性能的降低。因此,調整FIB的束流傳輸元件往往只能帶來微小的改進。
尤其在低能束流(低于2 keV)領域,當前FIB儀器的性能與預期之間存在明顯差距。隨著器件和樣品結構越來越復雜,離子束與樣品之間的相互作用愈發重要。為了降低離子在材料內的穿透深度和散射,必須采取減小束流能量的策略,但這又不可避免地導致束流點尺寸的增大,進而加劇由于離子能量分布帶來的色差。
最后,當前FIB系統的功能受到可實現處理速度的限制,尤其是在樣品處理效率和空間分辨率之間的權衡。傳統的使用單個聚焦束流進行掃描的方法,雖然可以獲得較高的分辨率,卻往往需要通過變化曝光與移動或消隱序列來實現,導致了一種基本的串行處理模式。這種模式在高通量應用中顯得相對緩慢,因此急需更加高效的解決方案。
近年來,寬離子束模板遮蔽技術作為一種替代方案,提供了更高的吞吐量,但同時卻降低了靈活性與空間分辨率。因此,研究者們積極探索結合寬束遮蔽與單束流完全控制的多束技術,以顯著提高納米應用的整體吞吐量。該技術的核心在于可控的離子束小束陣列的設計理念,該方案的工作概念已在實驗中得到了驗證。
具體而言,通過光闌板,寬平行離子束被分裂成大量寬度為2.5μm的束流小束,約3000個小束能夠通過相鄰的靜電電極獨立偏轉。這些電極采用互補金屬氧化物半導體(CMOS)技術制造,從而實現高效的束流操控。最終,所有的小束在200倍縮減光學系統中進行選擇性輻射,分辨率可達到小于20納米的水平。這一多束技術已經針對電子輻射進行了優化,并作為掩模寫入器在商業上推出,未來也值得期待其在多種離子類型上的應用。
FIB系統的分析工具與檢測器
除了提升處理速度外,FIB系統的分析工具與檢測器的開發同樣重要.利用離子束照射樣品,可以有效觸發并測量樣品的響應,進而實現成像、局部照射和銑削等復雜操作。FIB設備通常配備各類配件,以支持多種分析能力。以成像為例,樣品表面發射的二次電子(SE)通常由Everhardt-Thornley檢測器(ETD)進行捕獲并轉化為光子,之后通過光導管傳輸至外部光電倍增管進行測量。作為補充,二次離子(SI)也可以通過總離子計(TIC)進行檢測,通常在正SI檢測模式下使用法拉第杯或通道透視計。
在眾多分析技術之中,二次離子質譜(SIMS)尤為突出,該技術能夠以二維或三維圖像形式映射元素或化學組分,展現出極高的靈敏度(可低至ppm級)以及寬廣的動態范圍。原則上,所有元素及其同位素均可被檢測。然而,在進行有效的定量分析時,需要將樣品的基質效應考慮在內,因為離子化效率往往受到樣品局部環境的影響。
隨著FIB技術的發展,許多SIMS系統的實現得到了廣泛探討。本文描述了三種主要的SIMS系統類型,分別適用于安裝在FIB和FIB- SEM儀器上的模塊化單元。
這三種系統包括四極質譜儀(QMS)、正交和線性飛行時間質譜儀(TOF),以及磁場扇區SIMS系統,它們各具優勢與劣勢,適應不同的應用需求。
四極質譜儀(QMS):歷史上,由于其設計簡單、重量輕和成本較低,在FIB平臺上得到了廣泛應用。QMS系統的基本原理是僅允許特定質量與電荷比的離子通過施加的四極場,從而實現質量選擇。然而,QMS的缺點也十分明顯,系統不支持并行檢測,導致在需要檢測多種質量時必須依賴順序分析,進而影響整體的循環時間。同時,在靈敏度方面,QMS的表現相對較差,限制了其在高精度分析中的應用。
正交和線性飛行時間質譜儀(TOF)系統:這些系統能夠通過測量離子的飛行時間實現質量分離,因而具備并行檢測的優勢。不同質量與電荷比的離子將在TOF系統中以不同速度運動,這種特性使得TOF系統能夠同時檢測多種離子,從而提高分析效率。然而,由于TOF系統需要對主或二次離子施加脈沖,這一特性可能導致循環時間的延長,進而影響實時分析的需求。

EXOTOF是二次離子提取鏡筒和正交飛行時間質譜OTOF的組合
磁場扇區SIMS系統:通過采用連續焦平面探測器,實現了高靈敏度和并行檢測的功能。離子在磁場的作用下沿圓形軌道運動,其曲率半徑取決于離子的質量與電荷比。這類系統結合了焦平面探測器和合適的質譜儀幾何形狀,使其能夠對所有質量的離子進行并行檢測。得益于其直流模式,磁場扇區系統具備100%的循環時間,極大提高了分析的經濟性和效率。然而,這些系統通常體積較大,且因集成電磁鐵而顯得笨重。
通過將氣體注入系統(GIS)與FIB-SIMS結合,可以進一步提升分析性能。例如,在結合FIB-TOF-SIMS與GIS的研究中,發現電離概率及其二次離子信號顯著提高了2-3個數量級。這一提高不僅改善了2D和3D化學圖的質量,還允許收集更全面的化學信息。此外,研究亦表明,離子轟擊期間注入XeF2能夠減少質量干擾,并將負電荷二次離子的極性反轉為正電荷,這為更深入的化學分析創造了可能。結合Cs沉積和O2淹沒這一策略,磁場扇區SIMS儀器同樣實現了二次離子產額的增強。
與SIMS相關的二次中性質譜(SNMS)能夠獲得類似的信息,通過基于激光的后電離分析噴射的中性粒子,并且具有基質獨立的離子產額的優勢。然而,盡管共振后電離是一個高效過程,非共振電離的產額卻較低;因此,SNMS需要較大的實驗努力,導致其成本較高。
掃描透射離子顯微鏡(STIM)是一種先進的顯微技術,利用輕元素的離子進行樣品分析,能夠提供有關質量-厚度襯度和晶體結構信息的深入洞察。近年來,STIM的多種實現方案得到了廣泛的研究,主要可分為兩類:一種基于來自透射離子撞擊轉化板生成的二次電子收集,另一種則是采用透射離子的直接檢測。作為一種準非破壞性成像技術,STIM在生物樣品的結構對比方面與掃描透射電子顯微鏡(STEM)相當,但其樣品厚度要求同樣嚴格,需小于100納米。
STIM的獨特優勢在于,它不僅可以獲得與二次離子質譜(SIMS)測得的元素或化學圖相關的高分辨率圖像,還能夠在極小的樣品區域內進行高效的元素分析。在FIB儀器中,STIM通過背散射光譜與Rutherford背散射光譜(RBS)的結合,使得在數十電子伏特的低能量下探測散射事件成為可能。這種相對較大的核散射截面導致了多個散射事件的發生,進而使得獲取定量結果的過程變得復雜,但背散射光譜的方法依然證明了其有效性,能夠與時間飛行(TOF)系統耦合,實現無損的元素組成分析。
背散射光譜的信號水平較好,因為該方法對在主離子轟擊過程中產生的大量中性粒子也具有敏感性。這種靈敏性允許研究人員分析背散射的主要粒子產額,提高了信號強度,通過在物鏡下方放置環形微通道板(MCP),實現了更大的固體角和更高的信號獲取。在氦離子顯微鏡(HIM)中,背散射產額的表現尤為顯著,主要氦離子與重元素的相互作用可以產生足夠高的背散射產額,從而在主離子束造成的損傷相對較小的情況下進行有效分析。
背散射方法的有效性還體現在揭示埋層元素對比方面,已被成功應用于生物樣品。此外,由于離子通道效應對背散射產額的強烈影響,研究人員不僅可以繪制晶體取向,還能夠實施基于二次電子檢測的晶體方向映射。這種技術的便利性和效率,使其成為可視化薄膜合金中界面納米級位錯網絡的一個簡單且可靠的替代方案。
離子誘導的二次電子光譜(SE)是一種利用二次電子能量變化映射樣品表面化學變化的有效技術。該方法的顯著優勢在于能夠最大化成像對比,從而縮短束曝光時間,這對于束敏感樣品尤其重要。然而,目前SE光譜方法在定量應用方面受到獲取數據的復雜性質及缺乏合適參考數據庫的限制。
離子誘導的俄歇電子光譜(IIAES)通過精確能量分辨,檢測在內殼電子躍遷后發射的俄歇電子,使得對表層化學成分及其鍵結構的識別成為可能。針對周期表第三周期的元素,IIAES展現出相較于電子束基的俄歇電子光譜(AES)更優越的信噪比,顯著提高了分析的準確性和可靠性。
在FIB儀器中的離子/粒子誘導X射線發射(PIXE),其本質上是SEM中EDS的等價物,特征X射線由粒子轟擊產生,用于元素映射。然而,在FIB情況下,PIXE受到極低X射線產額的困擾,其實際可行性尚未得到驗證。
表1中的離子光致發光(IL)已在多種材料中進行了測試。相關研究表明,該技術的優點主要體現在原位表征束誘導缺陷和稀土元素定位等應用領域中。
表1.基于FIB的分析方法概述

FIB的附件
FIB技術以其高精度和多功能性在材料科學及納米技術領域中扮演著越來越重要的角色。除了FIB儀器核心組件外,多種附加配件被廣泛開發并應用,以增強和擴展FIB儀器的功能。這些附加裝置不僅提高了操作的靈活性,還顯著提升了實驗的精確度和效率。
首先,電子束鏡筒(SEM)被認為是最常見的FIB附加裝置之一。這種鏡筒的引入,使得相關成像、原位銑削過程監測、FIB-SEM體積重構以及基于SEM的EDS分析得以順利實施。通過使用電子束而非離子束進行樣品成像,能夠有效降低樣品的束損傷,從而改善樣品的導航與觀察。此外,一些FIB-SEM的實施方案還支持自動測量和分析,使得數據獲取的效率大幅提升。
其次,針對高分辨率和大面積直接圖案化需求,激光干涉儀臺成為了不可或缺的工具。標準機械臺在定位精度與穩定性方面常常存在不足,而激光干涉儀臺結合專用樣品夾具能夠在幾百毫米的橫向范圍內實現納米級的樣品定位,這在高端應用場景中顯得尤為重要。
氣體注入系統(GIS)是另一常見的附加裝置,專門用于實現集束離子束誘導沉積(FIBID)。當與電子束鏡筒結合使用時,可以進一步拓展至集束電子束誘導沉積(FEBID)。另外,FIB鏡筒也可以配合電子中和槍,通過低能電子照射絕緣樣品,達到原位電荷中和的目的。在HIM等先進設備中,這一創新不僅使得無導電涂層成像成為可能,還為絕緣樣品的FIB銑削提供了便利。

EnerGIS是新開發的帶有三個儲罐和一個噴嘴的氣體注入系統
在微/納米操縱方面,多種微/納米機械手被研發出來,以便于對微至納米尺度的對象進行直觀控制和機械操縱。這包括原位提取薄片樣品用于TEM以及支持各類原位實驗的局部電氣連接方案。
此外,添加飛秒激光燒蝕系統能夠有效去除目標區域周圍的多余材料,為后續的精細FIB銑削提供便利。這一技術不僅提升了先進封裝故障分析的能力,還為半導體行業的工藝優化提供了更高的處理能力。
制造商與研究者們也開發了多種原位表征實驗的附加模塊。諸如電氣(electrical probing)探測站、基于帕爾貼元件的樣品加熱或冷卻系統、原位機械測試以及自動激光高度傳感器等,均為提升實驗能力而設計。此外,惰性氣體轉移箱的開發,使得在缺氧環境下能夠安全加載和卸載易氧化樣品。將原子力顯微鏡(AFM)整合到FIB和FIB-SEM儀器中,特別是在與FIB分析結合的情況下,能夠評估樣品表面粗糙度,從而提高3D重構的準確性。
-
材料科學
+關注
關注
0文章
15瀏覽量
7601 -
離子束
+關注
關注
0文章
88瀏覽量
7768 -
信號探測
+關注
關注
0文章
10瀏覽量
7436
原文標題:FIB專題|?離子束的傳輸與信號探測
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
FIB聚焦離子束電路修改服務
失效分析:離子束剖面研磨
Dual Beam FIB(雙束聚焦離子束)
聚焦離子束應用介紹
離子束注入技術應用
聚焦離子束技術介紹
KRi 射頻離子源 IBSD 離子束濺射沉積應用
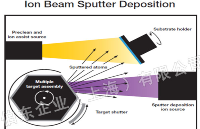
離子束技術在多領域的應用探索
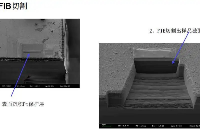
聚焦離子束系統的結構、工作原理及聚焦離子束雙束系統
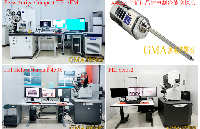
什么是聚焦離子束(FIB)?

FIB聚焦離子束切片分析

聚焦離子束技術:納米加工與分析的利器

聚焦離子束技術的崛起與應用拓展
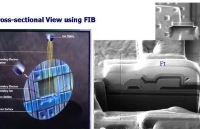





 離子束的傳輸與信號探測
離子束的傳輸與信號探測













評論