文章來源:半導體與物理
原文作者:jjfly686
本文介紹了自對準雙重圖案化技術的優勢與步驟。
在芯片制造中,光刻技術在硅片上刻出納米級的電路圖案。然而,當制程進入7納米以下,傳統光刻的分辨率已逼近物理極限。這時,自對準雙重圖案化(SADP)的技術登上舞臺,氧化物間隔層切割掩膜,確保數十億晶體管的精確成型。
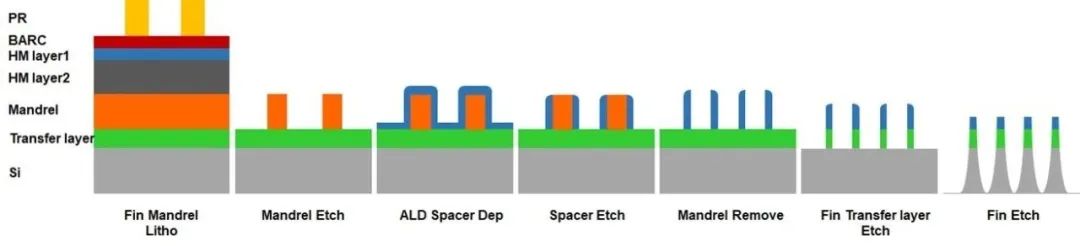
光刻的困境
傳統光刻機使用193 nm波長的深紫外光(DUV),理論上最小只能刻出約50 nm寬的線條。但現代5納米芯片的晶體管鰭片(Fin)寬度已縮至10 nm,這相當于要用一把“鈍刀”刻出比刀刃更細的紋路。
SADP技術的突破:通過兩次圖案化,將光刻分辨率提升一倍。其核心在于利用氧化物間隔層(Oxide Spacer)作為“模板的模板”,但若不對間隔層進行精細修剪,最終結構可能扭曲變形。
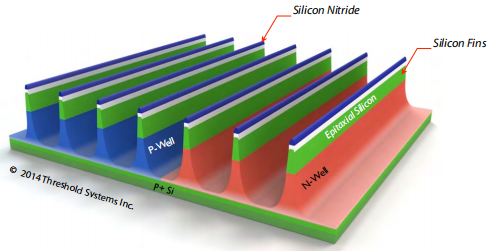
SADP技術
1.第一步:制作核心模板(Mandrel)
材料選擇:無定形碳膜因其易刻蝕、耐高溫,成為理想模板材料。光刻成型:在硅片上涂覆光刻膠,曝光顯影后刻蝕出初始線條。
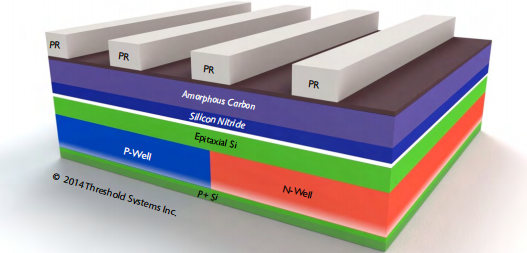
2.第二步:包裹氧化物間隔層
沉積工藝:通過原子層沉積(ALD)在碳模板兩側包裹一層均勻的二氧化硅(SiO?),厚度精確控制。去除核心:用氧等離子體刻蝕掉中間的碳模板,留下成對的氧化物間隔層,間距縮小至目標尺寸。
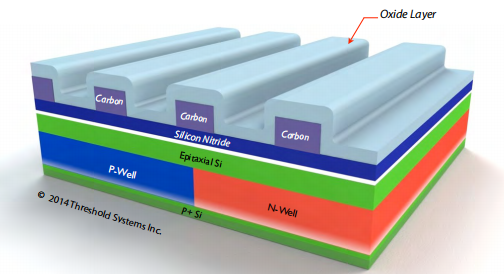
3.缺陷
若不對間隔層兩端進行修剪,后續刻蝕硅形成鰭片時,邊緣會因應力不均變成橢圓形。
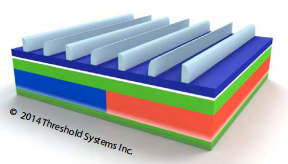
4.切割掩膜
為了將彎曲的間隔層變成筆直的線條,工程師引入切割掩膜(Cut Mask)技術:
1.光刻定位:在間隔層兩端涂覆光刻膠,通過光刻機曝光,定義需要修剪的區域。
2.刻蝕:用等離子體刻蝕精確切除間隔層兩端多余部分,確保直線結構。
3.定向擴展:修剪后的間隔層作為硬掩膜,刻蝕下方的硅襯底,形成筆直的鰭片陣列。
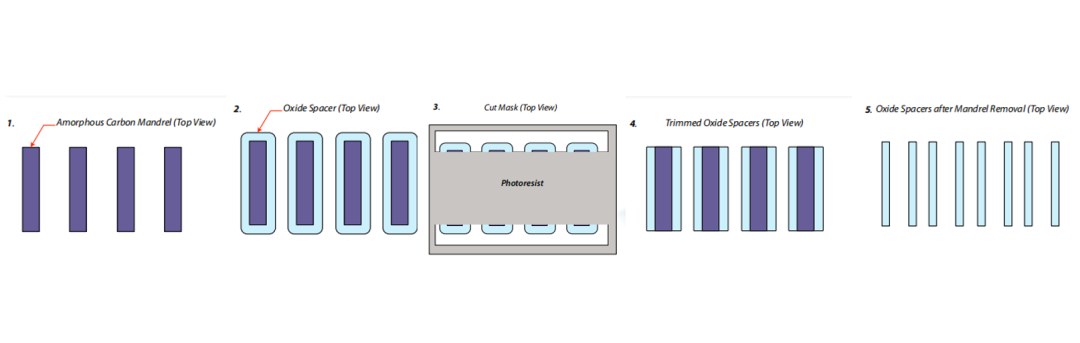
-
芯片制造
+關注
關注
10文章
687瀏覽量
29719 -
光刻技術
+關注
關注
1文章
151瀏覽量
16194
原文標題:雙重圖案化掩膜層
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
12:1 DC/DC轉換器兼具技術上和商業上的雙重優勢(上)
12:1 DC/DC轉換器兼具技術上和商業上的雙重優勢(下)
基于DCT和混沌的雙重圖像水印算法
引入 FinFET晶體后的多重圖案拆分布局和布線

關于FinFET與集成電路的對比分析介紹
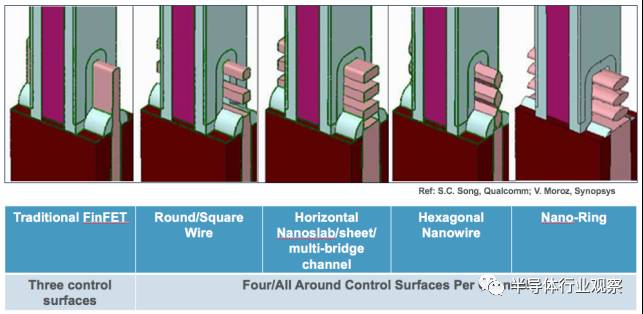
SEMulator3D能提供哪些功能?
雙重圖形化技術(Double Patterning Technology,DPT)
ASML考慮推出通用EUV光刻平臺
IBC技術新突破:基于物理氣相沉積(PVD)的自對準背接觸SABC太陽能電池開發

基于激光摻雜與氧化層厚度調控的IBC電池背表面場區圖案化技術解析

自對準硅化物工藝詳解
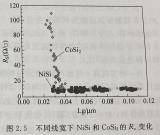





 自對準雙重圖案化技術的優勢與步驟
自對準雙重圖案化技術的優勢與步驟

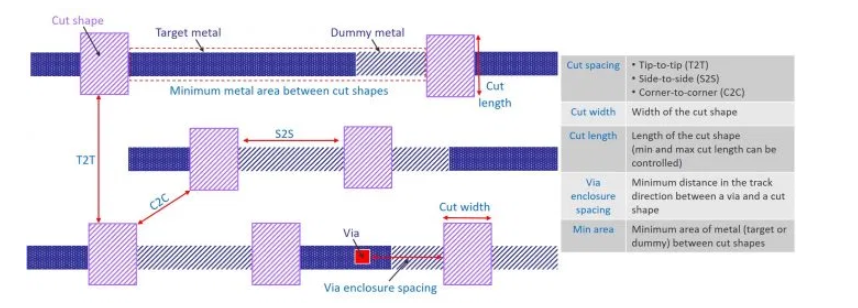

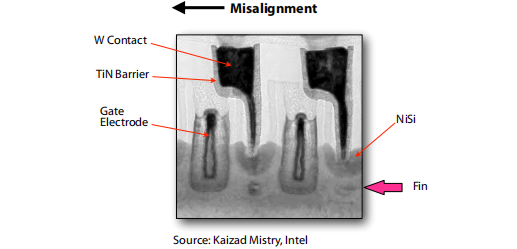










評論