文章來源:學習那些事
原文作者:前路漫漫
本文介紹了球柵陣列封裝的結構、分類、應用和發展趨勢。
概述
在集成電路封裝技術的演進歷程中,球柵陣列封裝(Ball Grid Array,BGA)憑借卓越性能與顯著優勢脫穎而出,成為當今高集成度芯片的主流封裝形式,廣泛應用于各類高端IC產品。自20世紀90年代初問世以來,BGA封裝快速發展,極大地推動了電子產業的變革。
球柵陣列(BGA)封裝是在PGA和OFP的基礎上發展而來的,融合了PGA(針柵陣列封裝)與QFP(四邊扁平封裝)的技術優勢:借鑒PGA的陣列布局理念,將傳統針腳替換為用于鍵合的微球;采用QFP成熟的SMT(表面貼裝技術)工藝,通過回流焊實現可靠連接。這種創新設計使BGA封裝具備占用空間小、對引腳間距要求靈活的特點,能夠輕松實現高密度封裝,同時擁有出色的電學與機械性能。
作為高引腳數、高性能IC的理想封裝方案,BGA廣泛應用于芯片組、圖形處理芯片、專用集成電路(ASIC)、微處理器等核心器件。其核心特征在于芯片I/O端以球形凸點呈面陣分布,凸點材料可選用Sn-Pb焊料或有機導電樹脂,這一技術革新為集成電路封裝帶來了重大突破,顯著提升了芯片的集成度與可靠性 。

BGA結構圖
BGA封裝的結構與分類
一、結構組成
BGA封裝主要由芯片、封裝基板、焊球陣列三部分組成。芯片作為核心器件,承載著電路功能;封裝基板通常采用陶瓷、有機材料(如BT樹脂/玻璃層壓板)或柔性材料(如聚酰亞胺),起到電氣互連和機械支撐的作用;焊球陣列由錫、鉛或其他金屬合金制成,作為芯片與印刷電路板(PCB)之間的連接橋梁。在芯片與基板的連接方式上,主要有引線鍵合和倒裝焊兩種。引線鍵合是通過金屬絲將芯片引腳與基板上的焊盤連接起來;倒裝焊則是將芯片有源面朝下,通過芯片表面的導電凸點直接與基板相連,省略了長金屬鍵合線,進一步縮短了信號傳輸路徑 。
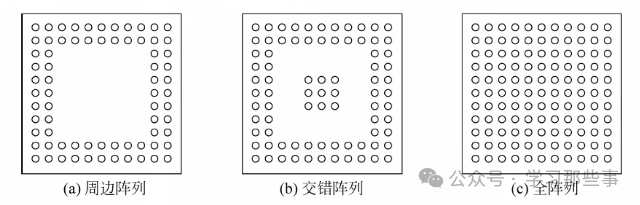
BGA的焊球分布方式
二、分類及特點
根據不同的標準,BGA封裝可進行多種分類:
1. 按基板材料分類
塑料球柵陣列封裝(PBGA,Plastic Ball Grid Array):PBGA采用塑料材料與塑封工藝,是應用最廣泛的BGA封裝類型,也稱整體模塑陣列載體(OMPAC)封裝。它以BT樹脂/玻璃層壓板作為PCB基板,先通過芯片鍵合固定裸芯片,經引線鍵合連接焊盤與基板焊區,再注塑成型,最后在基板底面制作焊球陣列作為外引腳。早期焊球使用63Sn - 37Pb低熔點共晶合金,直徑約1mm,間距1.27 - 2.54mm,與封裝體連接無需額外焊料。PBGA成本低、電性能好,對焊球共面度要求寬松,但對潮氣敏感,回流焊時易因受潮出現“爆米花”現象導致器件失效。
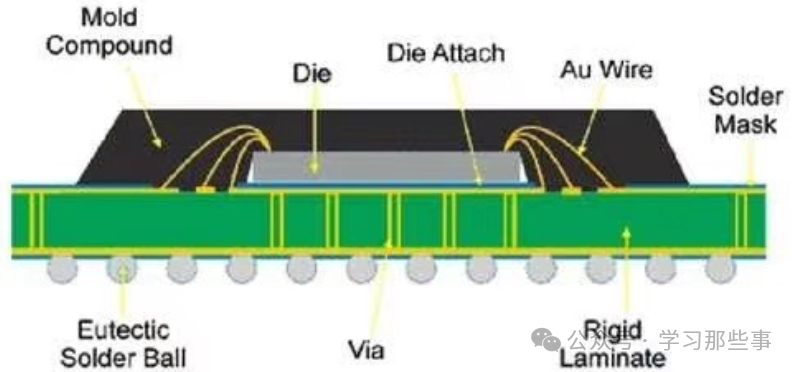
PBGA結構圖
陶瓷球柵陣列封裝(CBGA,Ceramic Ball Grid Array):CBGA將裸芯片安裝在多層陶瓷布線基板上,通過倒裝或引線鍵合實現電氣連接,再用金屬蓋板密封焊接保護內部結構,玻璃封接或焊料焊接的封蓋工藝可實現氣密封裝。其焊球采用90Pb - 10Sn等高熔點焊料,與封裝體底部連接使用63Sn - 37Pb低溫共晶焊料。CBGA具有抗潮性強、可靠性高、散熱與電性能優良等優勢,且適合倒裝芯片技術提升互連密度,但封裝成本較高,與塑料基板熱膨脹系數匹配性較差。陶瓷柱柵陣列封裝(CCGA)作為CBGA的延伸技術,以焊球柱替代焊球,在器件面積大于32mm2 時可提供更好的可靠性與抗疲勞性能。
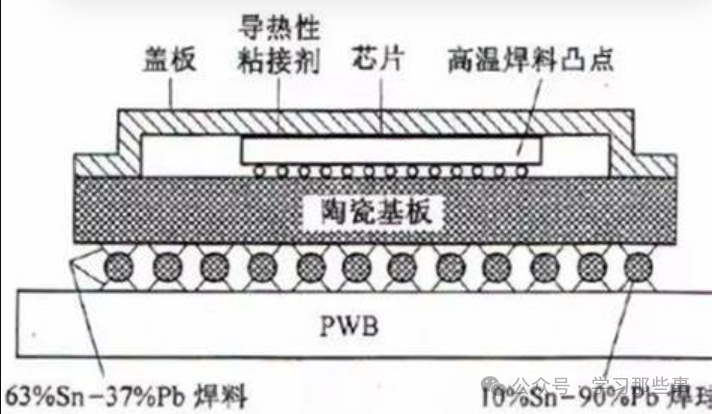
CBGA

PBGA與CBGA焊點對比
載帶BGA(TBGA,Tape Ball Grid Array):包含銅/聚酰亞胺撓性載帶和與載帶電性連接的芯片,具有密封蓋板,芯片貼合在密封蓋板的空腔中,芯片外圍蓋板下方的載帶底部設置有焊球陣列。載帶兩側通常有金屬層,頂部金屬層為統一接地層,底部金屬層為銅線路,可制成雙層或多層線路載帶,通過銅線路將芯片與焊球陣列連接。引線鍵合、回流焊或載帶自動焊(熱壓/熱超聲內引腳鍵合)均可用于芯片與銅線路的連接。TBGA熱阻低,散熱性能好,載帶與環氧樹脂等塑料基板CTE匹配性好,電性能比PBGA優良,封裝更薄,但不是氣密封裝,對濕氣敏感,成本高于PBGA。
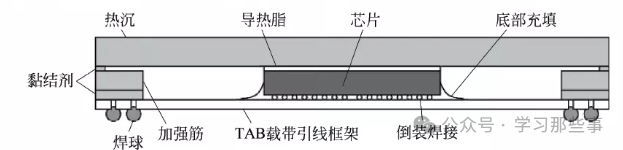
一種采用倒裝芯片的TBGA
金屬BGA(MBGA,Metal Ball Grid Array):不使用獨立的柔性層或載帶層,以鋁圓片或鋁面板作為基板。鋁表面生長18mm的陽極氧化鋁層作為介電層,沉積由銅、鎳和金組成的薄膜金屬并圖形化,特征尺寸精細。傳統阻焊設置在金屬薄膜表面定義焊盤位置,電介質也可采用聚酰亞胺或苯并環丁烯(BCB)等聚合物材料,利于多層設計及使用低介電常數材料。芯片鍵合、引線鍵合以及塑封在鋁圓片或面板上進行,封裝完成后分離成單個封裝。MBGA同TBGA一樣具有良好的散熱性和電性能,隨著薄膜加工技術進步,成本不斷降低 。
2.按氣密性分類:陶瓷BGA可分為氣密BGA和非氣密BGA,除陶瓷BGA外,其他類型均為非氣密BGA 。
3.按芯片與基板互連方式分類:主要分為引線鍵合和倒裝焊。目前,采用引線鍵合的BGA的I/O數常為50 - 540個,采用倒裝焊方式的I/O數常大于540個。PBGA互連常用引線鍵合方式,CBGA常用倒裝焊方式,TBGA兩種互連方式均有使用 。當I/O數小于600個時,引線鍵合成本低于倒裝焊,但倒裝焊更適宜大批量生產,若圓片成品率提高,可降低單個器件成本,且能進一步縮小封裝體體積。
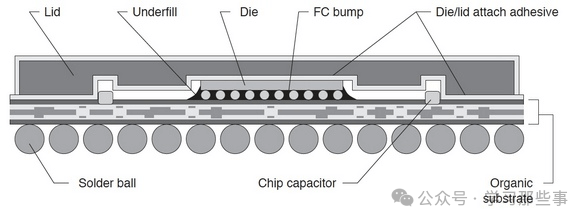
FCBGA
此外,根據結構特點,還有一些特殊類型的BGA,如FBGA(細間距球柵陣列)、FCBGA(倒裝BGA)、EBGA(散熱增強BGA)等 。
BGA封裝的技術優勢
一、高引腳密度與空間利用率
BGA封裝利用芯片的整個底部面積來布置I/O端口,相較于傳統封裝形式,極大地提高了芯片的引腳密度和空間利用率。在相同的芯片面積和引出端數目情況下,BGA封裝能夠提供更大的焊盤,減少了焊點間短路搭橋的故障,提高了引出電極的載流量和焊接可靠性 。例如,一些高端處理器的BGA封裝可以容納數千個引腳,滿足了大規模集成電路對信號傳輸的需求。
二、優異的電氣性能
BGA封裝的引出端短,芯片和基板的互連路徑短,產生的寄生參數小。其寄生電感小,使得器件能夠獲得很高的工作頻率,同時降低了噪聲。與傳統引線鍵合封裝相比,BGA封裝的電阻降低了75%,信號傳輸延遲和失真大幅減少,能夠有效避免信號間的串擾,保證了信號傳輸的完整性和穩定性,非常適合高頻、高速信號的傳輸 。
三、良好的散熱性能
焊料凸點作為BGA封裝的熱量導出路徑,有利于提高功率密度。BGA封裝與單板之間的連接點呈二維分布,連接面更廣,相當于增大了傳熱面積,因此結板熱阻相對較低。此外,還可以通過在基板上施加熱過孔,或在基板底側正對芯片結處施加銅片等方式進一步降低熱阻 。裸Die封裝的BGA芯片,其結直接暴露在外,最大程度地降低了結殼熱阻,為芯片提供了良好的散熱條件 。
四、小型化與輕薄化
BGA封裝器件尺寸小、體薄,占用基板面積小。以BGA封裝MOSFET為例,其封裝比達到60% - 70%,而小型表面貼裝器件的封裝比通常為25% - 30%,部分僅接近15% 。這種小型化和輕薄化的特點,使得BGA封裝非常適合應用于對體積和重量要求苛刻的便攜式電子設備,如智能手機、平板電腦等 。
五、生產制造優勢
BGA封裝具有自對準效應,對貼片精度要求相對較低,降低了生產過程中的難度和成本 。同時,BGA封裝廣泛應用于微電子封裝的倒裝芯片技術和表面貼裝技術,使用回流焊接可實現多個焊點的一次性貼裝,大大提高了生產效率 。
BGA封裝的應用領域
計算機領域:常用于CPU、GPU、芯片組等核心部件的封裝。例如,Intel和AMD的主流處理器均采用BGA封裝,以滿足高性能計算對引腳密度、電氣性能和散熱性能的嚴格要求 。
通信領域:應用于高速通信芯片、網絡處理器等,確保信號的高速、穩定傳輸,支持5G、數據中心等通信基礎設施的建設 。
消費電子領域:在智能手機、平板電腦、智能手表等設備中,BGA封裝幫助實現了產品的小型化和高性能化,提升了用戶體驗 。
航空航天領域:CBGA等氣密型BGA封裝由于可靠性高,常用于對環境適應性和穩定性要求極高的航空航天電子設備 。
其他領域:還廣泛應用于FPGA(現場可編程門陣列)、ASIC(專用集成電路)等高性能集成電路,以及汽車電子、工業控制等領域 。
挑戰與發展
盡管BGA封裝具有諸多優勢,但在實際應用中也面臨一些挑戰:
焊接與檢測難度大:BGA焊點位于封裝底部,難以直接觀察和檢測焊接質量,需要借助X射線檢測等特殊手段 。焊接過程中,對工藝控制要求嚴格,一旦出現焊接不良,返修難度大,成本高 。
熱管理問題:隨著芯片集成度和功率密度不斷提高,BGA封裝的散熱需求日益增加。雖然其本身具有一定的散熱優勢,但在一些極端工況下,仍需進一步優化散熱設計,以防止芯片過熱 。
成本問題:部分BGA封裝類型,如CBGA,由于采用陶瓷基板和復雜的制造工藝,成本較高,限制了其在一些對成本敏感領域的應用 。
未來,BGA封裝技術將朝著更高引腳密度、更低成本、更優散熱性能和更高可靠性的方向發展。例如,進一步縮小焊球間距,開發新型封裝材料和工藝,以滿足不斷增長的集成電路封裝需求 。同時,與其他先進封裝技術(如3D封裝、系統級封裝等)的融合也將成為重要趨勢,為電子產業的發展提供更強大的技術支持 。
-
集成電路
+關注
關注
5416文章
11936瀏覽量
366917 -
封裝技術
+關注
關注
12文章
573瀏覽量
68417 -
BGA
+關注
關注
5文章
564瀏覽量
48117 -
BGA封裝
+關注
關注
4文章
121瀏覽量
18395
原文標題:球柵陣列封裝介紹
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
7個步驟教你如何快速從pcb板中移除塑封球柵陣列封裝 (PBGA)
印刷電路板 (PCB) 移除塑封球柵陣列封裝 (PBGA) 的建議程序






 一文詳解球柵陣列封裝技術
一文詳解球柵陣列封裝技術
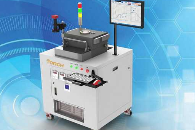










評論