一、引言
隨著集成電路技術(shù)的飛速發(fā)展,器件尺寸不斷縮小,性能不斷提升。然而,這種縮小也帶來了一系列挑戰(zhàn),如柵極漏電流增加、多晶硅柵耗盡效應等。為了應對這些挑戰(zhàn),業(yè)界開發(fā)出了高K金屬柵(High-K Metal Gate,簡稱HKMG)工藝。HKMG工藝作為現(xiàn)代集成電路制造中的關(guān)鍵技術(shù)之一,對提升芯片性能、降低功耗具有重要意義。本文將詳細介紹HKMG工藝的基本原理、分類、應用以及發(fā)展趨勢。
二、HKMG工藝的基本原理
HKMG工藝的核心在于使用高K材料替代傳統(tǒng)的二氧化硅(SiO2)作為柵介質(zhì)層,并使用金屬材料替代多晶硅作為柵極電極。這一變革旨在解決傳統(tǒng)柵極結(jié)構(gòu)在尺寸縮小過程中面臨的柵極漏電流過大、閾值電壓難以精確控制等挑戰(zhàn)。
高K材料:高K材料具有較高的介電常數(shù),可以有效減少柵極漏電流,提高晶體管的工作效率。常用的高K材料包括鉿基氧化物(如HfO2、HfSiO、HfSiON等)、鋁基氧化物(Al2O3)、鋯基氧化物(ZrO2)等。其中,HfO2以其較高的介電常數(shù)和相對穩(wěn)定的物理化學性質(zhì),成為目前主流的高K金屬柵極電介質(zhì)材料。
金屬柵極:金屬柵極材料具有良好的導電性和熱穩(wěn)定性,能夠更好地控制閾值電壓,提升器件的開關(guān)速度。常用的金屬柵極材料包括鈦(Ti)、鉭(Ta)、鋁(Al)等金屬及其化合物,如TiN、TaAlN等。
三、HKMG工藝的分類
HKMG工藝根據(jù)柵極制作的順序分為先柵工藝(Gate First)和后柵工藝(Gate Last)兩大類。
先柵工藝(Gate First):
- 在先柵工藝中,柵極的制作是在源漏區(qū)離子注入和高溫退火步驟之前完成的。
- 先柵工藝相對簡單,只需要按部就班一層一層往上做即可。然而,其HK介質(zhì)層和金屬柵均需經(jīng)歷源漏退火工藝時的高溫,這會影響HK層質(zhì)量(如純的HfO2在溫度超過500℃會發(fā)生晶化,產(chǎn)生晶界缺陷)及金屬柵功函數(shù)(影響閾值電壓)。因此,通常會對HfO2進行摻雜處理(如摻Si或氮化,形成HfSiO或HfSiON)以改善高溫性能,但摻雜會降低K值,等效氧化層厚度(EOT)會變厚,影響閾值電壓。
后柵工藝(Gate Last):
- 在后柵工藝中,柵極的制作是在源漏區(qū)離子注入和高溫退火步驟完成之后進行的。
- 后柵工藝可以避免金屬柵經(jīng)歷源漏退火高溫,從而保護金屬柵的功函數(shù)和HK層的質(zhì)量。后柵工藝又分為先HK(High-K First)和后HK(High-K Last)兩種工藝。
- 先HK工藝:先淀積SiO2作為界面層,再淀積HK層,然后淀積金屬柵的虛擬柵(Dummy Si),后續(xù)進行源漏區(qū)離子注入和高溫退火等步驟,最后去除虛擬柵并淀積實際的金屬柵。
- 后HK工藝:先淀積SiO2作為界面層,再淀積虛擬柵和虛擬介質(zhì)層(Dummy SiO2),后續(xù)進行源漏區(qū)離子注入和高溫退火等步驟,最后去除虛擬柵和虛擬介質(zhì)層,再淀積HK層和金屬柵。
四、HKMG工藝的應用
HKMG工藝因其獨特的優(yōu)勢,被廣泛應用于高性能集成電路的制造中,特別是在運算速度取向的高階電子產(chǎn)品中,如CPU、FPGA、存儲器等。隨著器件尺寸的不斷縮小,傳統(tǒng)柵極結(jié)構(gòu)已無法滿足性能提升和體積縮小的要求。HKMG工藝通過引入高K材料和金屬柵極,不僅解決了傳統(tǒng)柵極結(jié)構(gòu)存在的問題,還進一步提升了晶體管的性能,使得更小、更快、更節(jié)能的電子設(shè)備成為可能。
CPU:CPU作為計算機的核心部件,對性能要求極高。HKMG工藝的應用使得CPU的晶體管尺寸不斷縮小,性能不斷提升,同時功耗得到有效控制。
FPGA:FPGA作為一種可編程邏輯器件,廣泛應用于各種嵌入式系統(tǒng)中。HKMG工藝的應用使得FPGA的集成度更高,性能更強,功耗更低。
存儲器:存儲器是電子設(shè)備中不可或缺的部分。HKMG工藝的應用使得存儲器的存取速度更快,存儲容量更大,功耗更低。例如,三星推出的全球首個基于HKMG技術(shù)的512GB DDR5內(nèi)存模塊,就顯著降低了漏電流現(xiàn)象,并減少了能耗。
五、HKMG工藝的優(yōu)勢與挑戰(zhàn)
優(yōu)勢:
提升性能:HKMG工藝通過引入高K材料和金屬柵極,顯著提升了晶體管的性能,使得芯片的速度更快、功耗更低。
降低功耗:柵極漏電流的減少使得芯片的功耗得到有效控制,這對于移動設(shè)備和物聯(lián)網(wǎng)設(shè)備等低功耗應用具有重要意義。
提高集成度:隨著晶體管尺寸的縮小,芯片的集成度不斷提高,使得更多功能可以集成在一個芯片上。
挑戰(zhàn):
工藝復雜性:HKMG工藝涉及多個復雜的工藝步驟,如高K材料的淀積、金屬柵極的制作等。這些步驟需要精確控制參數(shù),以確保工藝的穩(wěn)定性和可靠性。
材料兼容性:高K材料與襯底之間的界面問題以及金屬柵極與多晶硅柵極之間的兼容性問題需要解決。例如,HfO2與Si直接接觸會顯著降低載流子遷移率,因此需要插入一層極薄的SiON薄膜作為過渡層。
成本問題:HKMG工藝需要引入新的材料和設(shè)備,這會增加生產(chǎn)成本。然而,隨著技術(shù)的不斷成熟和產(chǎn)量的提高,成本問題有望得到緩解。
六、HKMG工藝的發(fā)展趨勢
隨著集成電路技術(shù)的不斷發(fā)展,HKMG工藝也在不斷創(chuàng)新和完善。以下是HKMG工藝未來的發(fā)展趨勢:
新材料的應用:為了進一步提高晶體管的性能和降低功耗,未來可能會引入更多新型的高K材料和金屬柵極材料。例如,一些具有更高介電常數(shù)和更好熱穩(wěn)定性的高K材料正在被研究和開發(fā)。
工藝技術(shù)的優(yōu)化:隨著工藝技術(shù)的不斷進步,HKMG工藝的各個步驟將得到進一步優(yōu)化和改進。例如,通過改進高K材料的淀積技術(shù)和金屬柵極的制作技術(shù),可以進一步提高晶體管的性能和降低功耗。
三維集成技術(shù)的應用:隨著三維集成技術(shù)的發(fā)展,HKMG工藝有望在三維集成領(lǐng)域得到更廣泛的應用。通過引入三維集成技術(shù),可以進一步提高芯片的集成度和性能。
與先進封裝技術(shù)的結(jié)合:HKMG工藝與先進封裝技術(shù)的結(jié)合將成為未來集成電路制造的重要趨勢。通過引入先進封裝技術(shù),可以進一步提高芯片的可靠性和性能。
七、結(jié)論
HKMG工藝作為現(xiàn)代集成電路制造中的關(guān)鍵技術(shù)之一,對提升芯片性能、降低功耗具有重要意義。通過引入高K材料和金屬柵極,HKMG工藝解決了傳統(tǒng)柵極結(jié)構(gòu)在尺寸縮小過程中面臨的柵極漏電流過大、閾值電壓難以精確控制等挑戰(zhàn)。隨著技術(shù)的不斷成熟和產(chǎn)量的提高,HKMG工藝有望在更廣泛的領(lǐng)域得到應用,并推動集成電路技術(shù)的不斷發(fā)展。然而,HKMG工藝也面臨著工藝復雜性、材料兼容性、成本問題等挑戰(zhàn),需要進一步研究和解決。未來,隨著新材料的應用、工藝技術(shù)的優(yōu)化、三維集成技術(shù)的應用以及與先進封裝技術(shù)的結(jié)合,HKMG工藝將迎來更加廣闊的發(fā)展前景。
-
芯片
+關(guān)注
關(guān)注
459文章
52190瀏覽量
436227 -
集成電路
+關(guān)注
關(guān)注
5420文章
11954瀏覽量
367164 -
HKMG
+關(guān)注
關(guān)注
0文章
10瀏覽量
12948
發(fā)布評論請先 登錄
CMOS超大規(guī)模集成電路制造工藝流程的基礎(chǔ)知識

中國集成電路大全 接口集成電路
概倫電子集成電路工藝與設(shè)計驗證評估平臺ME-Pro介紹

法動科技EMOptimizer解決模擬/射頻集成電路設(shè)計難題

CMOS集成電路的基本制造工藝

集成電路工藝中的金屬介紹
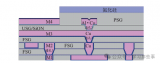
集成電路外延片詳解:構(gòu)成、工藝與應用的全方位剖析
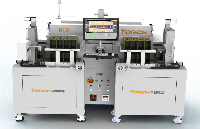
高性能集成電路應用 集成電路封裝技術(shù)分析
單片集成電路有哪些組成
集成電路工藝學習之路:從零基礎(chǔ)到專業(yè)水平的蛻變






 集成電路新突破:HKMG工藝引領(lǐng)性能革命
集成電路新突破:HKMG工藝引領(lǐng)性能革命















評論