2024年,全球半導(dǎo)體行業(yè)雖然未像預(yù)期那般出現(xiàn)全面復(fù)蘇,但生成式人工智能(AIGC)、汽車電子和通信技術(shù)的快速發(fā)展,卻奠定了底層技術(shù)在2025年的基礎(chǔ),為半導(dǎo)體行業(yè)在新一年中回暖帶來了新的希望。
在這一年中,我們見證了碳化硅(SiC)功率器件在電動汽車中的廣泛應(yīng)用,芯粒(Chiplet)技術(shù)在高性能AI芯片設(shè)計中的創(chuàng)新應(yīng)用,以及RISC-V架構(gòu)在汽車電子和其他領(lǐng)域的快速崛起。此外,第四代半導(dǎo)體材料——如氧化鎵(Ga2O3)和氮化鋁(AlN)也開始嶄露頭角,展現(xiàn)出巨大的潛力。
在市場方面,盡管全球經(jīng)濟(jì)面臨諸多挑戰(zhàn),但半導(dǎo)體行業(yè)依然保持了強勁的增長勢頭。根據(jù)世界半導(dǎo)體貿(mào)易統(tǒng)計組織數(shù)據(jù)預(yù)測,2024年全球半導(dǎo)體市場規(guī)模預(yù)計將達(dá)到6112億美元,同比增長7%。特別是在汽車電子、工業(yè)自動化和消費電子等領(lǐng)域,市場需求持續(xù)旺盛,推動了整個行業(yè)的快速發(fā)展。
展望2025年,預(yù)計全球半導(dǎo)體市場將增長12.5%,估值將達(dá)到6870億美元。《電子工程專輯》基于這一年中與業(yè)內(nèi)專家和廠商的交流,總結(jié)分析后挑選出了2025年全球半導(dǎo)體將出現(xiàn)或高速發(fā)展的10大技術(shù)趨勢,本文將探討這些先進(jìn)技術(shù)的發(fā)展方向和市場前景。
SiC、Chiplet和RISC-V聯(lián)手推動汽車半導(dǎo)體發(fā)展
芯片作為搶占汽車智能化賽道的制高點,已成為全球智能汽車競爭的關(guān)鍵核心。2025年,SiC、Chiplet和RISC-V三大技術(shù)將有望繼續(xù)聯(lián)手推動汽車半導(dǎo)體產(chǎn)業(yè)的發(fā)展(圖1)。

圖1:SiC、Chiplet和RISC-V三大技術(shù)有望繼續(xù)推動汽車半導(dǎo)體產(chǎn)業(yè)的發(fā)展。(來源:IDC)
“800V+SiC”將成為高端電動汽車標(biāo)配
目前看到的一個明顯趨勢,是隨著汽車制造商對更高能效和續(xù)航能力的追求,整車廠在接下來的兩三年里會發(fā)布更多搭載800V平臺的車型,對SiC功率器件的需求會進(jìn)一步增加。可以說,“800V+SiC”已經(jīng)基本成為高端電動汽車標(biāo)配。
我們從三個方面對碳化硅技術(shù)未來的發(fā)展趨勢做一些判斷。首先,從材料來看,基于成本、良率的需求,晶圓材料正在向大尺寸、低缺陷SiC襯底及外延制備的方向發(fā)展;從器件來看,追求更低的SiC MOSFET比導(dǎo)通電阻,同時在可靠性、魯棒性更接近硅基IGBT水準(zhǔn);從工藝來看,繼續(xù)研究制約SiC MOSFET發(fā)展的基礎(chǔ)科學(xué)問題,比如通過采用高純度SiC襯底、改進(jìn)柵氧化層制作工藝來提升溝道遷移率等。
Chiplet芯片成為汽車高性能SoC開發(fā)新突破口
作為搭積木芯片設(shè)計的技術(shù)代表,Chiplet是一種降本增效、解決汽車高性能SoC芯片需求的創(chuàng)新性方案,其功能獨立成Chiplet,通過選擇成熟工藝和芯片就能提高生產(chǎn)良率,縮短開發(fā)周期。但挑戰(zhàn)也很明顯。例如,不同廠商不同芯片之間的通信接口存在差異;隨著芯片集成度的提高,功耗、散熱和數(shù)據(jù)傳輸安全都面臨更高要求。
RISC-V成為Arm架構(gòu)之后的新選擇
與x86和Arm相比,RISC-V的指令集更為精簡,沒有歷史遺留問題,且功耗很低。這些特點使得RISC-V非常適合用于提升汽車系統(tǒng)的整體性能,同時降低制造成本。具體應(yīng)用方面,RISC-V處理器可被廣泛應(yīng)用于車載信息娛樂系統(tǒng)、自動駕駛控制系統(tǒng)、電池管理系統(tǒng)和車輛網(wǎng)絡(luò)通信等關(guān)鍵領(lǐng)域,未來3至5年內(nèi),RISC-V架構(gòu)芯片在汽車行業(yè)的出貨量預(yù)計將以每年66%的速度增長。
第四代半導(dǎo)體材料,氧化鎵將直接挑戰(zhàn)碳化硅
第四代半導(dǎo)體材料包括超寬禁帶半導(dǎo)體和超窄禁帶半導(dǎo)體,前者包括氧化鎵、金剛石和氮化鋁,后者包括銻化鎵和銻化銦等。其中,氧化鎵的禁帶寬度達(dá)到4.9eV,超越了SiC的3.2eV和GaN的3.39eV;此外其導(dǎo)通特性約為SiC的10倍,理論擊穿場強約為SiC的3倍,理論損耗僅為硅的1/3000、SiC的1/6、GaN的1/3;從成本角度,基于同樣6英寸襯底的最終器件成本,氧化鎵約為SiC的1/5,與硅基產(chǎn)品的成本相差無幾。
中國科學(xué)院院士郝躍在兩年前就曾預(yù)測,氧化鎵器件有望在未來10年內(nèi)成為有競爭力的電力電子器件,并直接與SiC器件競爭。氧化鎵領(lǐng)軍企業(yè)日本FLOSFIA公司則預(yù)計,到2025年氧化鎵功率器件市場規(guī)模將開始超過GaN,2030年將達(dá)到15.42億美元,占SiC的40%,是GaN的1.56倍。
盡管氧化鎵在成本和性能上具有顯著優(yōu)勢,但其大尺寸單晶制備面臨挑戰(zhàn),如高熔點、高溫分解以及易開裂等特性。目前,中國的氧化鎵產(chǎn)出僅限于實驗室與高校,而日本在氧化鎵量產(chǎn)方面走在前列。例如,日本東北大學(xué)成立的FOX公司,采用無貴金屬單晶生長技術(shù),目標(biāo)是以比SiC更低的成本生產(chǎn)出低缺陷程度與硅相當(dāng)?shù)摩?Ga2O3襯底(圖2)。

圖2:Si、4H-SiC、GaN和β-Ga2O3基本材料特性的雷達(dá)圖,所有參數(shù)均已規(guī)范化。(來源:MDPI)
氮化鋁作為另一種第四代半導(dǎo)體材料,以其大的擊穿電場和低損耗特性,被視為實現(xiàn)超低損耗功率器件和高溫電子器件的首選材料。NTT Corporation已于2024年初利用金屬有機化學(xué)氣相沉積(MOCVD)成功生產(chǎn)出高質(zhì)量的氮化鋁,并開發(fā)了歐姆和肖特基接觸的形成方法,首次展示了氮化鋁晶體管的運行。
展望2025年,隨著技術(shù)的進(jìn)步和量產(chǎn)難題的逐步攻克,氧化鎵和氮化鋁等第四代半導(dǎo)體材料不僅將挑戰(zhàn)現(xiàn)有的SiC和GaN市場,還有可能因其獨特的性能優(yōu)勢,在特定應(yīng)用領(lǐng)域?qū)崿F(xiàn)超越。
從設(shè)計制造到應(yīng)用,AI與半導(dǎo)體深度融合
AI正在引發(fā)新一輪科技革命。從語言模型、多模態(tài)模型的單體智能,到能夠使用思維鏈CoT(Chain of Thinking)進(jìn)行推理的OpenAl o1,再到使用工具完成復(fù)雜任務(wù)的智能體(AIAgent),AI基礎(chǔ)能力正在快速演進(jìn),并迅速融入生產(chǎn)和生活的每個環(huán)節(jié),重塑千行百業(yè),引發(fā)新一輪科技和產(chǎn)業(yè)革命。
于是,在這一輪技術(shù)超級周期中,半導(dǎo)體行業(yè)也與AI形成了一種相互促進(jìn)的關(guān)系。
例如,在芯片設(shè)計領(lǐng)域,AI通過機器學(xué)習(xí)、深度學(xué)習(xí)等智能算法,不斷提高設(shè)計的效率與準(zhǔn)確性,幫助設(shè)計師在設(shè)計初期就能預(yù)測并優(yōu)化芯片的性能和功耗,減少設(shè)計迭代的次數(shù),縮短產(chǎn)品上市時間。
在智能制造領(lǐng)域,通過采用AI機器視覺的自動化檢測設(shè)備,不僅提升了生產(chǎn)線的速度,還顯著提高了制造精度。同時,通過收集和分析生產(chǎn)數(shù)據(jù),AI算法能夠預(yù)測設(shè)備故障,減少意外停機時間,并優(yōu)化制造參數(shù),減少原材料浪費和能耗。
在各種云端AI訓(xùn)練和推理應(yīng)用服務(wù)的推進(jìn)下,2024年全球AI服務(wù)器出貨量預(yù)計將達(dá)到165萬臺,占比提高至12.1%。其整體資本支出預(yù)計將有50%左右的增長,并將在2025年繼續(xù)保持兩位數(shù)增幅。AI服務(wù)器不但需要高性能的GPU、CPU、TPU和存儲等硬件支持,一些頭部云服務(wù)提供商甚至還構(gòu)建了專門用于運行AI模型的定制芯片,這些都對半導(dǎo)體產(chǎn)業(yè)起到了拉升作用。
同時,我們也要重視智能手機、AI PC、車載終端和工業(yè)物聯(lián)網(wǎng)等端側(cè)AI技術(shù)創(chuàng)新,因為端側(cè)AI擁有龐大的市場規(guī)模、清晰的商業(yè)模式和豐富的應(yīng)用場景,更容易實現(xiàn)AI規(guī)模化落地,從而加速助推高性能SoC、NPU、射頻、電源管理、模擬信號鏈組件的市場需求。
AI在給上游芯片設(shè)計企業(yè)帶來機遇的同時,也讓下游的封裝技術(shù)獲得了增量空間。畢竟生成式AI模型需要數(shù)百萬或數(shù)億級別參數(shù)才能進(jìn)行推理,對芯片的處理速度、容量和帶寬都提出了更高的要求,這將推動以Chiplet為代表的先進(jìn)封裝技術(shù)進(jìn)一步發(fā)展,帶來封裝行業(yè)的生態(tài)變化。
光通信技術(shù)朝大容量、高速率和集成化方向發(fā)展
隨著全球數(shù)據(jù)流量的增長,特別是在視頻流、云計算、物聯(lián)網(wǎng)和5G網(wǎng)絡(luò)領(lǐng)域的發(fā)展,對高速光通信解決方案的需求日益增加。
過去一年中,光通信技術(shù)取得了顯著進(jìn)展。首先,在傳輸速率方面,400Gbps甚至800Gbps接口已成為現(xiàn)實,標(biāo)志著光收發(fā)器性能的新里程碑。華為和諾基亞等公司在相干光學(xué)技術(shù)和硅光子學(xué)方面的創(chuàng)新是這一成就的關(guān)鍵因素,這些新技術(shù)不僅提升了數(shù)據(jù)傳輸速度,還降低了功耗,增強了可靠性和可擴(kuò)展性。密集波分復(fù)用(DWDM)技術(shù)的應(yīng)用進(jìn)一步擴(kuò)大了單根光纖的數(shù)據(jù)承載能力,支持更多用戶同時在線,滿足了不斷增長的數(shù)據(jù)需求。
同步光網(wǎng)絡(luò)(SONET)技術(shù)在高帶寬需求場景中表現(xiàn)出色,尤其適合金融交易系統(tǒng)和醫(yī)療健康等領(lǐng)域,其高度可靠性使其成為關(guān)鍵應(yīng)用的理想選擇(圖3)。數(shù)據(jù)中心內(nèi)部及之間的高效互連也成為了研究熱點,推動了新型光交換機和路由器的研發(fā),以實現(xiàn)更快速度和更低延遲的數(shù)據(jù)交換。

圖3:SONET/同步數(shù)字體系(SDH)與DWDM對比。(來源:QSFPTEK)
展望2025年,光通信技術(shù)將繼續(xù)朝著更高容量、更快傳輸速率、更低的成本以及更廣泛的部署方向發(fā)展:
更高容量與更快傳輸速率:行業(yè)將探索如何利用先進(jìn)的調(diào)制格式和技術(shù)來達(dá)到Tbps級別的數(shù)據(jù)傳輸速率。
邊緣計算與光互連:針對分布式架構(gòu)優(yōu)化的光互連解決方案將成為研究重點,提供低延遲、高帶寬的連接能力,支撐實時處理要求高的應(yīng)用。
集成化與模塊化設(shè)計:更加緊湊且節(jié)能高效的光通信模塊將是未來發(fā)展的關(guān)鍵方向之一,有助于降低運營成本并提高整體能效。
盡管前景光明,高昂的初始部署成本仍然是阻礙光通信技術(shù)廣泛采用的主要障礙之一。為此,產(chǎn)業(yè)界正通過爭取政府政策支持、技術(shù)創(chuàng)新降低成本以及加快標(biāo)準(zhǔn)化進(jìn)程等方式尋求解決之道,以促進(jìn)不同廠商產(chǎn)品間的兼容性,從而降低用戶的總體擁有成本。
HBM4量產(chǎn)時間提前,5納米成新工藝節(jié)點
盡管作為最新一代高帶寬內(nèi)存技術(shù),HBM4在各大存儲芯片巨頭技術(shù)路線圖里已有相關(guān)的量產(chǎn)時間表,但在AI終端需求的拉動下,或迫使存儲原廠撥快量產(chǎn)時間表。從量產(chǎn)進(jìn)度來看,三星、SK海力士、美光科技三大存儲原廠的HBM4量產(chǎn)時間表都在2025至2026年。
HBM4最大的應(yīng)用優(yōu)勢在于通過增加堆棧層數(shù)和通道數(shù),顯著提升了內(nèi)存的帶寬和容量。不過,HBM4內(nèi)存接口從1024位擴(kuò)展到2048位,意味著HBM4內(nèi)存的設(shè)計和生產(chǎn)將面臨新的挑戰(zhàn),需要采用更先進(jìn)的工藝節(jié)點和更具挑戰(zhàn)性的封裝技術(shù)。
從技術(shù)進(jìn)展來看,5納米已經(jīng)成為HBM4的新工藝節(jié)點。同時,芯片封裝仍然是HBM4面臨的最大挑戰(zhàn)之一。由于無凸塊的混合鍵合技術(shù)尚不成熟,傳統(tǒng)有凸塊方案預(yù)計仍將是16層堆疊HBM4的主流鍵合技術(shù)。要保證堆棧高度維持在一定范圍內(nèi),HBM4需要進(jìn)一步地壓縮層間間隙,而且還需提高熱管理能力。而在HBM鍵合工藝上,三大HBM內(nèi)存原廠正對無助焊劑鍵合等工藝進(jìn)行相關(guān)的測試和研究,以推動HBM4的量產(chǎn)。
從量產(chǎn)進(jìn)度和計劃來看,三星電子已經(jīng)成功制造了基于混合鍵合技術(shù)的16層堆疊HBM3內(nèi)存,并計劃將該技術(shù)用于HBM4內(nèi)存量產(chǎn)。同時,三星正在建立專門的HBM4生產(chǎn)線,目前進(jìn)入試生產(chǎn)階段,預(yù)計在2025年下半年量產(chǎn)12層HBM4堆疊。SK海力士也在開發(fā)16層堆疊的HBM4內(nèi)存,并計劃于2025年量產(chǎn)(圖4)。該公司與臺積電合作,使用臺積電的5納米工藝來創(chuàng)建HBM4封裝底部的基底芯片。SK海力士還計劃引入混合鍵合技術(shù)以減少存儲芯片堆疊縫隙的高度,從而實現(xiàn)更多層數(shù)的堆疊。美光科技量產(chǎn)時間表略晚,預(yù)計將在2026年推出12和16層堆疊的HBM4產(chǎn)品。
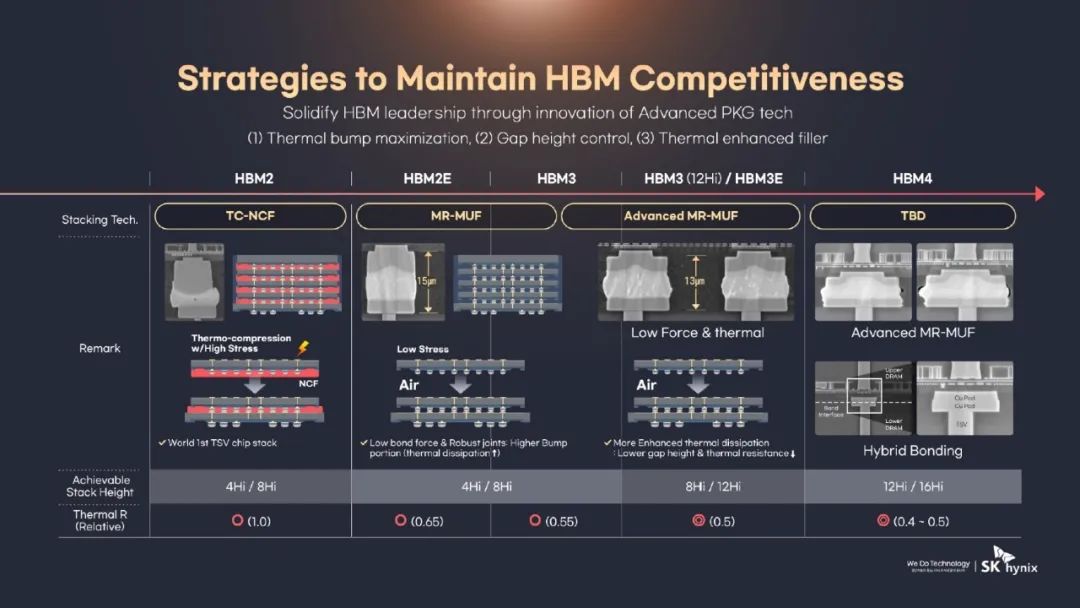
圖4:HBM堆疊技術(shù)發(fā)展趨勢。(來源:SK海力士)
而對于SK海力士、三星和英偉達(dá)等企業(yè)的技術(shù)訴求,臺積電也將利用其N12FFC+和N5兩種工藝技術(shù),以及InFO和CoWoS等先進(jìn)封裝解決方案。
艙駕一體中央計算架構(gòu)與大模型融合,助推自動駕駛技術(shù)發(fā)展
自通用人工智能(AGI)大火后,車用大模型也隨之大熱,特別是端到端車用大模型,有可能成為L2駕駛輔助或者L3自動駕駛的最佳路線(圖5)。特斯拉FSD V12版本的推出是這一趨勢的顯著標(biāo)志,意味端到端自動駕駛技術(shù)在量產(chǎn)車型上的應(yīng)用已成為現(xiàn)實。這個方案也得到了多家車企的認(rèn)可,在中國,華為、小鵬、商湯科技和元戎啟行等企業(yè)也在積極跟進(jìn)。

圖5:端到端自動駕駛架構(gòu)演進(jìn)示意圖。(來源:辰韜資本《端到端自動駕駛行業(yè)研究報告》,信達(dá)證券研發(fā)中心)
隨著大模型的應(yīng)用,自動駕駛芯片對算力的需求也在不斷提升,2024年被視為跨域融合的元年。多家公司已經(jīng)發(fā)布了支持中央計算平臺的SoC芯片,例如英偉達(dá)的DRIVE Thor和高通的Snapdragon Ride Flex SoC都具有高達(dá)2000TOPS的算力,能夠支持L4/L5級自動駕駛能力,同時兼顧更高端的智能座艙體驗。多家車企和一級供應(yīng)商正在積極推進(jìn)這一方向,艙駕一體將成為近兩年的主流趨勢。
智駕端到端大模型在未來能否上車是個關(guān)鍵,這個技術(shù)的發(fā)展可以分為四個階段:感知端到端、決策規(guī)劃模型化、模塊化端到端和One Model端到端。中國自動駕駛公司的模塊化端到端方案預(yù)計將在2025年實現(xiàn)量產(chǎn)上車。
從市場方面,有研究機構(gòu)表示,2029年汽車半導(dǎo)體市場規(guī)模將達(dá)到1000億美元,在這些數(shù)字背后,高級輔助駕駛系統(tǒng)(ADAS)和安全將以14%的年復(fù)合增長率在2023至2029年期間實現(xiàn)最高增長。用于自動駕駛的高性能SoC、智能座艙、電力電子,以及用于未來E/E架構(gòu)的MCU,也是OEM在汽車半導(dǎo)體投資中的重點方向。
2.5D與3D先進(jìn)封裝持續(xù)深入,在嵌入式領(lǐng)域展現(xiàn)潛力
2.5D封裝技術(shù)通過在中介層集成多個芯片,實現(xiàn)了高效的芯片間通信;3D封裝技術(shù)則更進(jìn)一步,將芯片垂直堆疊,不僅極大地減小了設(shè)備體積,還顯著提升了性能。這些技術(shù)的發(fā)展不僅滿足了各類應(yīng)用高性能計算和強大處理能力的需求,也為小型化趨勢提供了強有力的支持。
在全球電子封裝行業(yè)中,2.5D與3D集成電路封裝正以迅猛的速度發(fā)展,成為推動整個市場向前邁進(jìn)的關(guān)鍵力量。
根據(jù)The Business Research Company發(fā)布的3D IC和2.5D IC封裝市場研究報告,預(yù)計從2023年的486億美元起,到2024年這一市場規(guī)模將達(dá)到543.9億美元,展現(xiàn)出11.9%的年復(fù)合增長率。
在技術(shù)細(xì)分方面,3D和2.5D集成電路封裝技術(shù)涵蓋了3D晶圓級芯片級封裝、3D硅通孔(TSV)和2.5D等多種技術(shù)。
目前,這些技術(shù)已經(jīng)在高性能計算、5G通信基礎(chǔ)設(shè)施和自動駕駛汽車等前沿科技領(lǐng)域發(fā)揮重要作用,此外,2.5D和3D先進(jìn)封裝技術(shù)也正逐步滲透到更多嵌入式應(yīng)用中,如微機電系統(tǒng)(MEMS)、CMOS圖像傳感器(CIS)和閃存等,并且正在向圖形處理器(GPU)、多核CPU、電源管理單元(PMU)、功率放大器以及現(xiàn)場可編程門陣列(FPGA)等領(lǐng)域擴(kuò)展其影響力,顯示出它們在未來電子封裝領(lǐng)域的巨大潛力(圖6)。
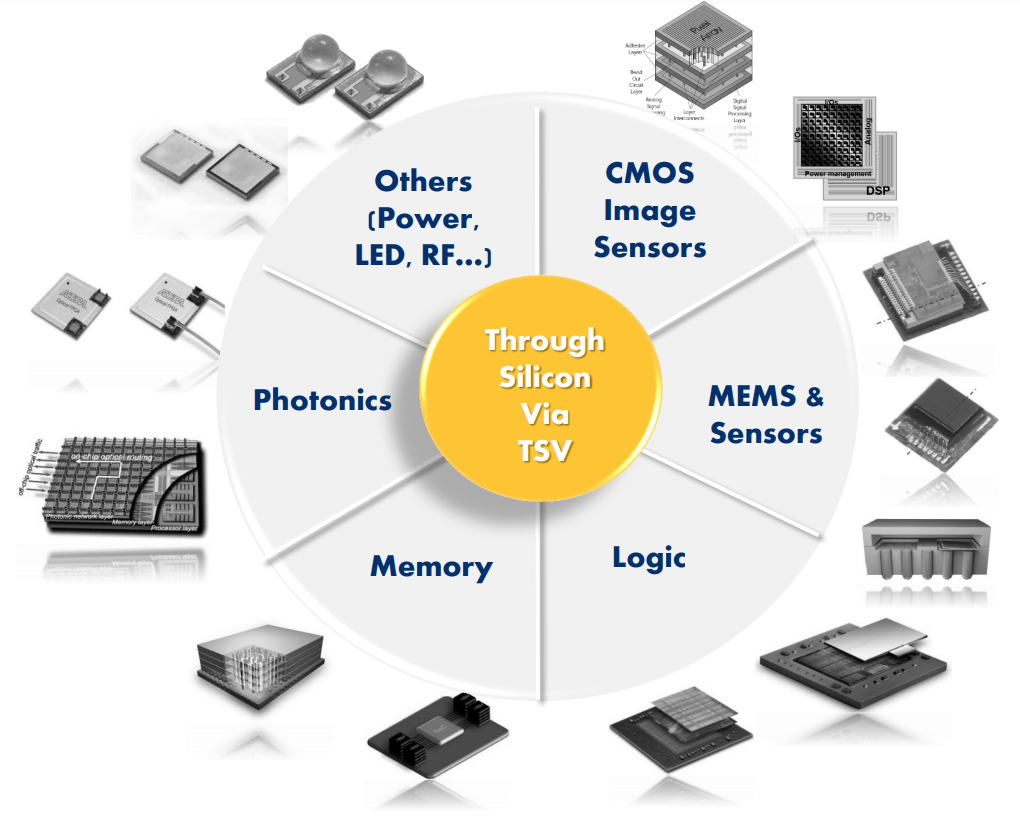
圖6:3D TSV應(yīng)用廣泛且持續(xù)增長。(來源:Yole développement)
盡管在射頻(RF)微型系統(tǒng)方面,2.5D/3D封裝技術(shù)尚未形成規(guī)模化應(yīng)用,但相關(guān)研究報道的數(shù)量正在不斷增加。
預(yù)測表明至2028年時,3D和2.5D集成電路封裝市場的規(guī)模有望達(dá)到816.7億美元,保持約10.7%的年均增長速度。隨著相關(guān)技術(shù)持續(xù)進(jìn)步與市場需求的增長,可以預(yù)見,在接下來幾年里,2.5D和3D封裝技術(shù)將在商業(yè)上取得更加廣泛的應(yīng)用。
AI需求激增推動服務(wù)器液冷技術(shù)發(fā)展
隨著中國人工智能企業(yè)對智算中心基礎(chǔ)設(shè)施建設(shè)和算力供給需求越來越高,導(dǎo)致此類數(shù)據(jù)中心的IT設(shè)備能耗大幅上升,迫切需要高效的冷卻系統(tǒng)來維持適宜的操作溫度,否則將對大模型產(chǎn)品的周期管理和運維難度產(chǎn)生巨大挑戰(zhàn)。另一方面,各國政府也在不斷提高數(shù)據(jù)中心的節(jié)能減排標(biāo)準(zhǔn),加快綠色節(jié)能算力部署。因此,液冷解決方案正從以前數(shù)據(jù)中心建設(shè)和改造的“可選項”,逐步演變成為“必選項”。
以中國市場為例,中國液冷服務(wù)器市場在2024年上半年繼續(xù)快速增長。市場規(guī)模達(dá)12.6億美元,與2023年同期相比增長98.3%,其中液冷解決方案仍以冷板式為主,占到95%以上。預(yù)計2023至2028年,中國液冷服務(wù)器市場年復(fù)合增長率將達(dá)到47.6%,2028年市場規(guī)模將達(dá)到102億美元。
互聯(lián)網(wǎng)行業(yè)依然是2024上半年中國液冷服務(wù)器市場最大買家,占整體市場超60%的份額,其中云服務(wù)提供商(CSP)對于加速建設(shè)大集群的液冷數(shù)據(jù)中心是最積極的。除此以外,電信運營商在逐步落實2023年發(fā)布的《電信運營商液冷技術(shù)白皮書》3年行動計劃,積極探索基礎(chǔ)設(shè)施解耦方案,對液冷數(shù)據(jù)中心的建設(shè)保持較快的增長,也是未來液冷服務(wù)器需求的主要來源。
液冷技術(shù)主要分為直接液冷(DLC)和浸沒式液冷兩大類型(圖7)。直接液冷將冷卻液直接引導(dǎo)至設(shè)備的熱源上,通過冷卻板或冷卻管道將熱量帶走;浸沒式液冷則將整個設(shè)備完全浸泡在絕緣冷卻液中,實現(xiàn)更大范圍的熱傳導(dǎo)效果,適用于超高密度和大功率設(shè)備的散熱。目前來看,冷板式液冷憑借更高的技術(shù)成熟度和完善的產(chǎn)業(yè)鏈,具備更高的建設(shè)和維護(hù)便利性。
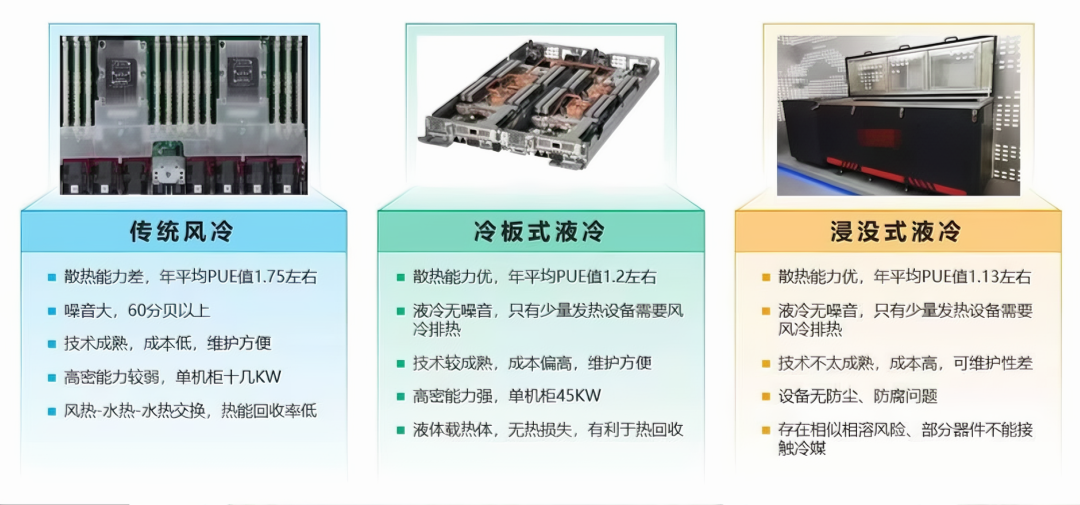
圖7:不同冷卻技術(shù)對比——電信運營商現(xiàn)階段主要推進(jìn)冷板式液冷與單相浸沒式液冷兩種技術(shù)路線。
集成化、小型化和多通道設(shè)計,讓生物傳感器更強大
電化學(xué)生物傳感器是一種將生物識別元件(如酶、抗體或DNA)與電化學(xué)換能器相結(jié)合的分析裝置,能夠特異性地識別目標(biāo)生物分子,并將其濃度變化轉(zhuǎn)化為可測量的電信號。它在生物醫(yī)學(xué)、環(huán)境監(jiān)測、食品安全等領(lǐng)域具有廣泛的應(yīng)用前景。
近年來隨著人們健康意識的不斷提高,電化學(xué)生物傳感器技術(shù)有了顯著進(jìn)展。全球市場規(guī)模在2023年估計達(dá)到了28.9億美元,預(yù)計到2030年將以8.0%的年復(fù)合增長率增長。
過去一年在技術(shù)進(jìn)展方面,蘋果的無創(chuàng)血糖監(jiān)測技術(shù)雖然還處于可行的“概念驗證”階段,但為電化學(xué)生物傳感器的發(fā)展帶來了曙光;還有團(tuán)隊開發(fā)出的便攜式生物傳感器,能夠在短時間內(nèi)檢測出血清中極低濃度的生物標(biāo)志物。此外,微納制造技術(shù)的進(jìn)步使得集成化和小型化成為可能,為可穿戴設(shè)備和即時檢測(POCT)應(yīng)用提供了技術(shù)支持,而多通道設(shè)計的引入使得傳感器可以同時檢測多種目標(biāo)物質(zhì),提高了檢測效率和準(zhǔn)確性。
未來一年,更多的新型材料將有望被應(yīng)用,如二維材料、金屬有機框架(MOF)和共軛聚合物等都有望成為新的研究熱點。時下大火的AI技術(shù)也有望與電化學(xué)生物傳感器深度融合,通過機器學(xué)習(xí)算法實現(xiàn)對復(fù)雜信號的智能分析和處理,提高檢測的準(zhǔn)確性和可靠性。在可穿戴設(shè)備等具體應(yīng)用領(lǐng)域,電化學(xué)生物傳感器與智能設(shè)備的融合,將實現(xiàn)對人體健康狀況的實時、長期和多項生理指標(biāo)的同時監(jiān)測。
然而,電化學(xué)生物傳感器在商業(yè)化進(jìn)程中也面臨一些挑戰(zhàn),例如穩(wěn)定性和重復(fù)性需要進(jìn)一步提高,以確保測量結(jié)果的可靠。此外,成本和全球醫(yī)療保健機構(gòu)嚴(yán)格的法規(guī)也是限制其大規(guī)模應(yīng)用的一個重要因素。這需要業(yè)界在優(yōu)化傳感器的設(shè)計和制備工藝,提高其性能和穩(wěn)定性的同時,探索新的材料和技術(shù)以降低制造成本。
應(yīng)用導(dǎo)向的芯片設(shè)計,牽一發(fā)動全身
EDA企業(yè)過去一年都在談系統(tǒng)設(shè)計的重要性,或者說以應(yīng)用為導(dǎo)向的芯片設(shè)計時代正在到來——不僅是板級系統(tǒng),也在于深入到應(yīng)用特定需求的系統(tǒng)技術(shù)。
以汽車為例,當(dāng)代汽車的不同設(shè)計域之間存在著更強的依賴和相互關(guān)聯(lián)性。某一部分的變化可能會影響到其他組成部分,可謂牽一發(fā)而動全身。對于系統(tǒng)設(shè)計、優(yōu)化、驗證、實施、制造和部署全流程,組件之間的關(guān)聯(lián)都變得無比重要。
對于特定的軟件來說,需要特定的芯片配置才能達(dá)成理想的運行效率;改變軟件,也就意味著芯片需要做出對應(yīng)變更;隨之而來的就是芯片的熱等物理特性變化,封裝及系統(tǒng)也要做出改變;留給電池的空間或許就會不一樣,底盤設(shè)計也要跟著變,乃至影響到制動系統(tǒng)和引擎。
于是芯片設(shè)計與制造,不再單純是制造工藝驅(qū)動,也不只是受到先進(jìn)封裝等制造封裝層面的變革影響,而是軟件定義、應(yīng)用導(dǎo)向的系統(tǒng)設(shè)計中的一環(huán)。芯片設(shè)計需要放到整個系統(tǒng)之中進(jìn)行,衡量系統(tǒng)所有其他組成部分,包括真實運營環(huán)境內(nèi)的資產(chǎn)。
芯片設(shè)計的數(shù)字孿生置于運營系統(tǒng)的數(shù)字孿生之中;基于對系統(tǒng)內(nèi)芯片的監(jiān)測,理解運營系統(tǒng)的性能,并將信息再反饋到設(shè)計環(huán)節(jié)。
這一趨勢的發(fā)生,不僅是摩爾定律停滯或放緩,以及全社會數(shù)字化轉(zhuǎn)型、AI技術(shù)發(fā)展對算力提出更高的要求而不得不為之;也是軟件、AI、IoT和通信等相關(guān)技術(shù)發(fā)展到一定高度才可達(dá)成的。
文章來源于電子工程專輯,作者EETimes China
-
傳感器
+關(guān)注
關(guān)注
2565文章
52971瀏覽量
767167 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28886瀏覽量
237513 -
SiC
+關(guān)注
關(guān)注
31文章
3222瀏覽量
65172 -
RISC-V
+關(guān)注
關(guān)注
46文章
2562瀏覽量
48779
發(fā)布評論請先 登錄
全球半導(dǎo)體市場持續(xù)增長 2025年5月銷售額達(dá)590億美元

佳恩半導(dǎo)體亮相2025慕尼黑上海電子展
砥礪創(chuàng)新 芯耀未來——武漢芯源半導(dǎo)體榮膺21ic電子網(wǎng)2024年度“創(chuàng)新驅(qū)動獎”
“開放·連接 ”2025玄鐵 RISC-V 生態(tài)大會議程公布!
2025年全球半導(dǎo)體市場將增至7050億美元
DeepSeek:2025年激光雷達(dá)技術(shù)與行業(yè)應(yīng)用趨勢

2025年全球半導(dǎo)體市場將增長11.2%

2025年半導(dǎo)體行業(yè)將啟動18個新晶圓廠項目
萬年芯:2025年中國半導(dǎo)體行業(yè)的 “變” 與 “機”

2025年全球半導(dǎo)體產(chǎn)業(yè)十大看點
2025年,半導(dǎo)體行業(yè)三大技術(shù)熱點

2025年全球半導(dǎo)體行業(yè)10大技術(shù)趨勢,一項傳感器技術(shù)進(jìn)入

2025年全球半導(dǎo)體八大趨勢,萬年芯蓄勢待發(fā)

2025年全球半導(dǎo)體市場八大趨勢預(yù)測

全球半導(dǎo)體代工龍頭企業(yè)齊聚上海,共同探討半導(dǎo)體代工趨勢與技術(shù)革新






 2025年全球半導(dǎo)體行業(yè)10大技術(shù)趨勢
2025年全球半導(dǎo)體行業(yè)10大技術(shù)趨勢











評論