塑料封裝盡管在散熱性、耐熱性和密封性方面稍遜于陶瓷封裝和金屬封裝,但其憑借低成本、薄型化、工藝簡(jiǎn)便及高度自動(dòng)化生產(chǎn)的優(yōu)勢(shì),已成為微電子工業(yè)中使用最廣泛的封裝方法。本文聚焦于塑料封裝這一廣泛應(yīng)用的封裝形式,聊一聊它的技術(shù)特點(diǎn)、發(fā)展歷程、工藝挑戰(zhàn)以及未來(lái)趨勢(shì)。
一、塑料封裝的廣泛應(yīng)用與技術(shù)演進(jìn)
塑料封裝的應(yīng)用范圍極為廣泛,從日常生活中的消費(fèi)性電子產(chǎn)品,到精密的超高速計(jì)算機(jī),幾乎無(wú)處不在。這一技術(shù)的普及,得益于其成本效益和靈活性,使得電子產(chǎn)品能夠迅速普及并滿足多樣化的市場(chǎng)需求。盡管早期塑料封裝的成品可靠度與陶瓷封裝相比存在差距,但隨著材料科學(xué)與工藝技術(shù)的不斷進(jìn)步,這一差距已顯著縮小。現(xiàn)代塑料封裝技術(shù)不僅提高了耐熱性和密封性,還通過(guò)創(chuàng)新設(shè)計(jì)滿足了高性能、高可靠性的要求,使其在電子封裝技術(shù)中的地位日益重要。
塑料封裝的歷史可以追溯到DIP(Dual In-line Package,雙列直插式封裝)的發(fā)明。隨后,塑料雙列式封裝(PDIP)憑借其低成本和易于自動(dòng)化的優(yōu)勢(shì),迅速成為IC封裝的主流方法。隨著IC技術(shù)的快速發(fā)展,對(duì)封裝的多腳化、薄型化需求日益迫切,塑料封裝技術(shù)也迎來(lái)了新一輪的創(chuàng)新。SOP(Small Outline Package,小外形封裝)、SOJ(Small Outline J-leaded Package,J形引腳小外形封裝)、SIP/ZIP(Single In-line Package/Zigzag In-line Package,單列直插/鋸齒形引腳封裝)、POFP(Plastic Open Grid Flat Package,塑料開(kāi)柵式扁平封裝)、PBGA(Plastic Ball Grid Array,塑料球柵陣列)以及FCBGA(Flip Chip Ball Grid Array,倒裝焊球柵陣列)等一系列新型塑料封裝形式應(yīng)運(yùn)而生,滿足了不同應(yīng)用場(chǎng)景下的需求。
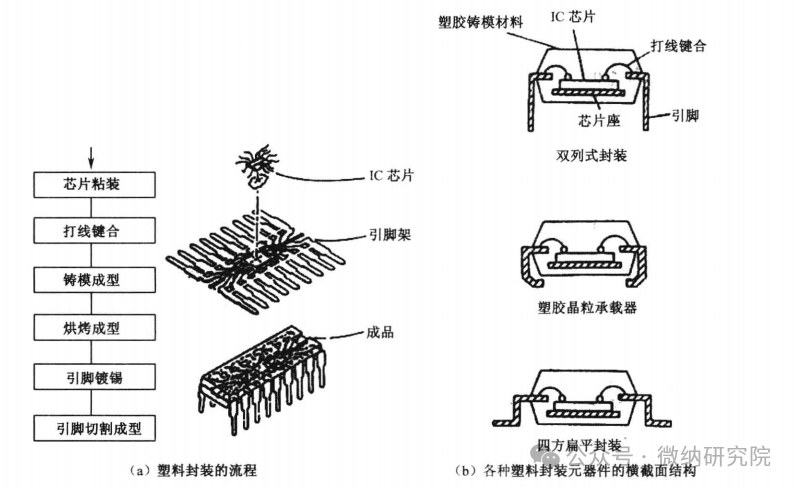
二、塑料封裝的工藝挑戰(zhàn)與整體設(shè)計(jì)考量
盡管塑料封裝相較于陶瓷封裝在工藝上更為簡(jiǎn)單,但其封裝的成功實(shí)現(xiàn)卻受到眾多工藝和材料因素的深刻影響。這些因素包括但不限于:
封裝配置與IC芯片尺寸
合理的封裝配置能夠最大化利用空間,同時(shí)確保良好的散熱和機(jī)械強(qiáng)度。IC芯片尺寸的變化要求封裝設(shè)計(jì)進(jìn)行相應(yīng)調(diào)整,以保持最佳的封裝效率和性能。
導(dǎo)體與鈍化保護(hù)層材料的選擇
導(dǎo)體材料的選擇需考慮導(dǎo)電性、耐腐蝕性和成本等因素;鈍化保護(hù)層則用于保護(hù)芯片免受環(huán)境侵害,其材料的選擇需兼顧透氣性、耐熱性和化學(xué)穩(wěn)定性。
芯片黏結(jié)方法
芯片與封裝基板的黏結(jié)是封裝過(guò)程中的關(guān)鍵步驟,直接影響封裝的可靠性和穩(wěn)定性。常用的黏結(jié)方法包括環(huán)氧樹(shù)脂黏結(jié)、銀漿黏結(jié)和玻璃化黏結(jié)等,每種方法都有其獨(dú)特的優(yōu)勢(shì)和適用場(chǎng)景。
鑄膜樹(shù)脂材料
鑄膜樹(shù)脂是塑料封裝中的主要材料,其性能直接影響封裝的耐熱性、密封性和機(jī)械強(qiáng)度。隨著材料科學(xué)的進(jìn)步,新型鑄膜樹(shù)脂不斷涌現(xiàn),如環(huán)氧樹(shù)脂、聚酰亞胺等,為塑料封裝提供了更多選擇。
引腳架的設(shè)計(jì)
引腳架作為封裝與外部電路的連接橋梁,其設(shè)計(jì)需考慮引腳數(shù)量、排列方式、引腳間距以及引腳的材料和形狀等因素,以確保良好的電氣連接和機(jī)械支撐。
鑄膜成型工藝條件
溫度、壓力、時(shí)間和烘烤硬化條件是鑄膜成型過(guò)程中的關(guān)鍵參數(shù),它們共同決定了封裝的質(zhì)量和性能。精確控制這些參數(shù)對(duì)于實(shí)現(xiàn)高質(zhì)量封裝至關(guān)重要。
塑料封裝的設(shè)計(jì)必須綜合考慮上述因素之間的相互影響,以實(shí)現(xiàn)整體性能的最優(yōu)化。塑料封裝的流程涵蓋了從芯片準(zhǔn)備、黏結(jié)、引線鍵合、鑄膜成型到后處理等多個(gè)環(huán)節(jié),每個(gè)環(huán)節(jié)都需嚴(yán)格控制以確保最終產(chǎn)品的質(zhì)量和可靠性。同時(shí),不同塑料封裝元器件的橫截面結(jié)構(gòu)也展示了其多樣化的設(shè)計(jì)特點(diǎn),如PDIP的引腳排列、SOP的緊湊外形、PBGA的球柵陣列等,這些設(shè)計(jì)都是為了滿足特定應(yīng)用場(chǎng)景下的需求。
三、塑料封裝技術(shù)的持續(xù)創(chuàng)新
隨著5G、物聯(lián)網(wǎng)、人工智能等技術(shù)的快速發(fā)展,對(duì)封裝技術(shù)的要求將更加嚴(yán)格,如更高的數(shù)據(jù)傳輸速率、更低的功耗和更好的散熱性能等。新材料、新工藝的不斷涌現(xiàn)也為塑料封裝技術(shù)的創(chuàng)新提供了可能。例如,采用高性能聚合物材料、納米復(fù)合材料以及先進(jìn)的成型技術(shù),可以進(jìn)一步提升塑料封裝的耐熱性、密封性和機(jī)械強(qiáng)度;而3D封裝、系統(tǒng)級(jí)封裝等新型封裝技術(shù)的引入,則有望解決傳統(tǒng)封裝在引腳數(shù)量、集成度和互連密度等方面的限制。
塑料封裝作為微電子工業(yè)中使用最廣泛的封裝方法,其重要性不言而喻。未來(lái),塑料封裝技術(shù)必定將不斷創(chuàng)新與發(fā)展,為電子產(chǎn)品的小型化、高性能化和智能化提供堅(jiān)實(shí)的支撐。
-
封裝
+關(guān)注
關(guān)注
128文章
8662瀏覽量
145432 -
塑料封裝
+關(guān)注
關(guān)注
0文章
16瀏覽量
7330
原文標(biāo)題:【芯片封裝】使用最廣泛的封裝方法——塑料封裝
文章出處:【微信號(hào):深圳市賽姆烯金科技有限公司,微信公眾號(hào):深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
物聯(lián)網(wǎng)未來(lái)發(fā)展趨勢(shì)如何?
先進(jìn)封裝工藝面臨的挑戰(zhàn)
工業(yè)電機(jī)行業(yè)現(xiàn)狀及未來(lái)發(fā)展趨勢(shì)分析
全面剖析倒裝芯片封裝技術(shù)的內(nèi)在機(jī)制、特性優(yōu)勢(shì)、面臨的挑戰(zhàn)及未來(lái)走向
倒裝芯片封裝:半導(dǎo)體行業(yè)邁向智能化的關(guān)鍵一步!

半導(dǎo)體封裝革新之路:互連工藝的升級(jí)與變革

揭秘PoP封裝技術(shù),如何引領(lǐng)電子產(chǎn)品的未來(lái)?

倒裝封裝(Flip Chip)工藝:半導(dǎo)體封裝的璀璨明星!

BGA芯片封裝凸點(diǎn)工藝:技術(shù)詳解與未來(lái)趨勢(shì)






 塑料封裝技術(shù)特點(diǎn)、發(fā)展歷程、工藝挑戰(zhàn)以及未來(lái)趨勢(shì)
塑料封裝技術(shù)特點(diǎn)、發(fā)展歷程、工藝挑戰(zhàn)以及未來(lái)趨勢(shì)

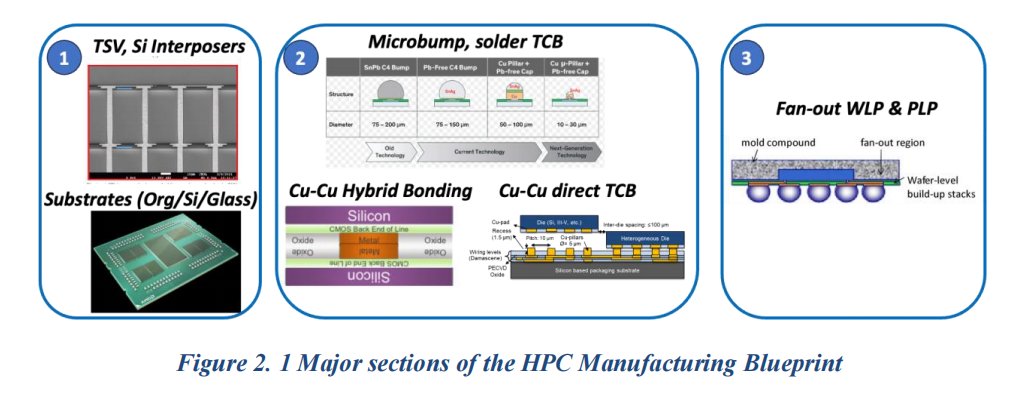










評(píng)論